金属基复合材料在微波封装领域的研究进展*
周明智,许业林,雷党刚,卢海燕
(中国电子科技集团公司第三十八研究所, 安徽 合肥 230088)
金属基复合材料在微波封装领域的研究进展*
周明智,许业林,雷党刚,卢海燕
(中国电子科技集团公司第三十八研究所, 安徽 合肥 230088)
电子信息技术的发展对封装材料的性能提出了苛刻的要求。金属基复合材料具有轻质、高导热、低膨胀等优异的热物性能,是一种理想的电子封装材料。电子封装用金属基复合材料增强体含量高,因而研制困难,工程应用的技术难度大。文中综述了国内外电子封装用金属基复合材料的性能及研究现状,指出了当前复合材料在应用中的主要问题,并针对这些问题给出了建议。
金属基复合材料;封装;研究进展
引 言
随着雷达技术的不断发展,电子元器件的组装密度越来越高,对组件封装壳体及热沉材料的性能要求也愈发苛刻,不仅要求材料具有低密度、低膨胀、高导热、高致密等优良的热物性能,还要求能够解决材料加工成型、表面改性、气密封焊等一系列关键工艺技术问题。从性能方面来看,传统材料如以Al、Cu、Kovar、Invar Mo-Cu等为代表的第1代、第2代封装材料已无法满足航空航天新领域及高集成电子器件对封装材料综合性能的高要求。而以高导热碳材料(金刚石、碳纤维、热解石墨、碳纳米管、石墨烯)、碳化硅颗粒、硅颗粒为增强体,与铝、铜、银等金属复合得到的金属基复合材料(Metal Matrix Composites,MMCs),具有高导热率、轻质、低膨胀等优良的热物性能,是高性能组件封装壳体的优选材料,正成为国内外相关领域的研究热点[1-5]。
1 封装材料性能对比及国内外研究现状
高体分SiC颗粒增强铝(SiCp/Al)是第3代电子封装材料的代表,在发达国家已进入实用阶段。从20世纪开始,美国休斯公司、西屋公司为机载预警雷达开发、使用了该材料,成功改进了美军机载电子系统的效能。随后,它又作为新型轻质电子封装及热控材料在一系列为世人所瞩目的先进航空航天器上获得了正式应用[5]。
国内在SiCp/Al材料制备方面也展开了大量的研究,目前已掌握不同体积分数复合材料的制备方法,具备了工程化应用能力。文献[6]通过熔铝无压浸渗复合工艺,解决了高体积分数碳硅铝研制过程中低热阻、低电阻SiC与Al界面的获得等技术难点,制备了高致密铝基复合材料。国防科技大学[6]、西北工业大学等科研单位分别开展了采用压力浸渗法制备高体分SiCp/Al电子封装材料的研究工作,且取得了重要进展。目前,国内制备的高体分SiCp/Al材料的热导率已超过180 W/(m·K),膨胀系数为6 × 10-6/ K~10 × 10-6/ K,组织致密(如图1所示),气密性达到国军标中的相关标准,满足封装壳体对材料性能的要求。与此同时,我国于2005年颁布了国家军用标准《高体积分数碳化硅颗粒/铝基复合材料规范》。该军标的形成为SiCp/Al复合材料在电子封装领域的推广应用奠定了基础。在应用领域,北京航空材料研究院研制的微波功率管底座(如图2所示)是国内首次通过军用电子元器件质量认证鉴定并得到验证应用的SiCp/Al产品[5,7]。此外,高体分SiCp/Al作为基板或热沉材料在国内封装领域已得到批量应用。

图1 电子级SiCp/Al金相显微组织
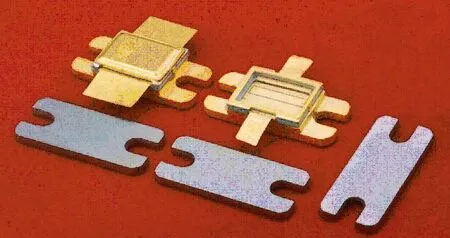
图2 无压浸渗SiCp/Al微波功率管底座
高体分SiCp/Al材料虽然具有优良的热物性能,但在实际应用中,其加工、涂覆及封焊均存在一定的困难。近年来,针对膨胀系数可控制(Controlled Expansion,CE)高硅含量的Al-Si合金的研究和应用十分活跃。英国SANDVIK OSPREY 公司在该种材料的研制和推广应用过程中发挥了重要的作用[8]。OSPREY先后用喷射沉积法研制出了硅含量为27% ~ 70%的系列高硅铝合金,图3为其CE7金相显微组织。该合金的显著特点是密度低(小于2.7 g/cm3)、热传导性好(膨胀系数为11的CE合金热导率接近150 W/(m·K))、膨胀系数可根据硅的含量进行调节。同SiCp/Al材料相比,它具有良好的机械加工性能,易于镀覆,且其硅质量分数低于50%,具有激光熔焊性能,是一种较为理想的封装材料。据公开报道,由OSPREY公司研制的高硅铝已成功应用于机载、星载等领域的微波组件壳体封装,如图4所示。

图3 CE7金相显微组织[8]

图4 CE合金在星载封装领域的应用
国内的北京有色金属研究总院、中南大学、江苏豪然喷射成形公司等科研单位也开展了相关方面的研究,并分别采用喷射沉积、粉末冶金等方法制备出了高硅含量的Al-Si 合金[9-10]。目前生产的材料主要有Si质量含量为22%、27%、42%、50%的铝硅材料,但同国外同类材料相比,在材料内部组织质量方面还存在一定的差距。在国内,高硅铝材料已经在地面、舰载、机载等领域得到了初步应用。
从增强体的性能来看,采用低膨胀和超高导热的碳纤维、高定向热解石墨(APG)、金刚石、碳纳米管(CNT)、石墨烯等高导热碳材料具有更加明显的优势。如气相生长碳纤维的轴向热导率可达1 950 W/(m·K),高定向热解石墨的平面热导率可达1 600 ~2 000 W/(m·K),具有各向同性天然金刚石的热导率大于2 100 W/(m·K),单壁CNT的热导率则高达3 000 W/(m·K)[3],远大于Si (150 W/(m·K))和SiC(80~200 W/(m·K))。
在高导热碳纤维增强复合材料的研制方面,美国MMCC公司开发了系列短石墨纤维增强铝(铜)基复合材料[2],其中AlGrafh4-230的平面CTE约为4 × 10-6/ K,热导率为230 W/(m·K),密度为2.4 g/cm3。石墨纤维含量为30%的AlGrafh7材料,其平面CTE约为7 × 10-6/ K,热导率为200 W/(m·K)。在高导热APG增强金属基复合材料的研制方面,为发挥APG材料的平面热物性能,材料通常被设计成三明治结构形式,如图5所示,即用金属铝(铜或铝基复合材料)将高导热石墨包覆,形成一种平面热扩展能力很强的材料。目前,国外K-CORE、MINTEQ、MOMENTIVE等公司研制的三明治材料平面热导率已超过1 100 W/(m·K)。在金刚石颗粒增强复合材料方面,美国的Plansee公司研制的Diamond/Al和Diamond/Cu具有各向同性导热性能,热导率分别可达500 W/(m·K)、700 W/(m·K),膨胀系数小于9 × 10-6/ K[9]。在碳基复合材料应用方面,MMCC公司的AlGrafh材料已成功应用于Bowing公司相控阵天线的T/R组件壳体的制造[2],如图6所示。具有超高平面热导率的三明治材料则已应用于SPY-3 及AN/TPS-99 T/R组件的封装。
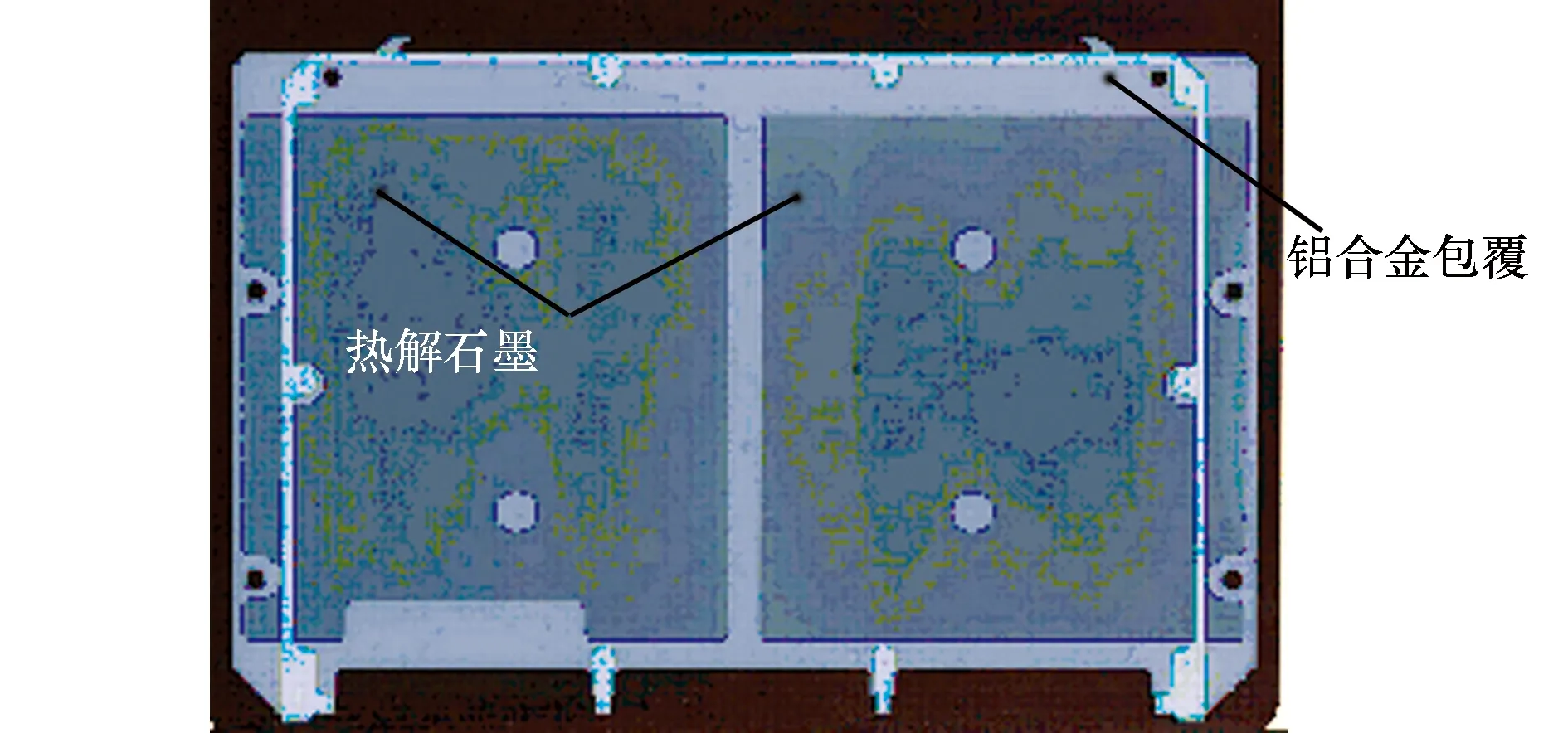
图5 APG增强的三明治复合结构材料
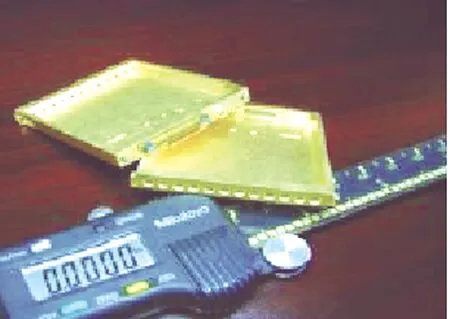
图6 AlGrafh材料在星载封装领域的应用[2]
与国外发达国家相比,国内在高导热碳材料增强金属基复合材料用于封装领域的研究应用方面还存在较大差距,特别是在高导热碳材料方面,现阶段国内尚不能提供高导热碳纤维。在高导热碳材料的研究方面,中科院山西煤化所采用热压工艺制备高导热石墨材料,其制备的大块石墨材料的导热率可达650 W/(m·K);中科院沈阳金属研究所从20世纪60年代开始从事化学气相沉积热解石墨及热解炭材料研究,其研制的高定向热解石墨的平面热导率已超过1 400 W/(m·K)。在高导热碳铝材料的制备上,上海大学通过在碳纤维上气相沉积(CVD)高导热炭的方法预制C-Cf纤维丝,制成C-Cf预制件,然后通过压力浸渗铝合金的方法制备了高导热C-Cf/Al复合材料,其组织如图7所示。据报道,该材料的导热性能与MMCC材料AlGrafh4-230相当。

图7 C-Cf/Al金相结构
近年来,在金刚石增强金属基复合材料制备方面,北京有色金属研究院、北京科技大学等单位开展了相关领域的研究,制备的Diamond / Cu热导率可达650 ~750 W/(m·K),膨胀系数为4.8 × 10-6/ K ~ 6.8 × 10-6/ K,密度约为5.4~5.5 g/cm3。目前,国内在高导热碳材料及其复合材料在封装领域的应用方面还处于探索阶段,主要采用高导热Diamond / Cu 作为大功率微波器件的封装热沉材料[11]。 Diamond / Cu热沉如图8所示。

图8 Diamond/Cu热沉
2 MMCs应用中存在的主要问题
虽然MMCs在封装材料领域已经得到了一定的应用,但也存在一些急待解决的问题:一是需进一步优化材料的制备工艺,以批量提供满足性能要求的材料,特别是以增强体高导热碳材料为代表的金属基复合材料的制备技术研究还需加强;二是需解决复合材料工程应用中的技术问题,以促进材料的推广应用。当前,工程应用技术是制约复合材料推广应用的瓶颈之一。增强体的作用给MMCs的应用带来了一定的困难。在封装领域,就MMCs应用而言,需要解决精密加工、表面改性和高可靠连接等3大工艺技术难题。从材料的机械加工性能来说,同传统的金属材料相比,由于增强体的作用,MMCs具有高的硬度和耐磨性,用传统的机械加工方法加工时,刀具磨损严重,表面粗糙度易加大,形位公差难以保证,效率低下。为了获得与陶瓷基板相近的CTE值,电子封装用MMCs增强体的陶瓷体积组分含量高(如SiCp/Al、Sip/Al、Dimond/Cu中增强体含量为50%~70%),在加工圆孔、螺纹孔、薄壁型腔时都存在较大的困难,而含有金刚石的金属基复合材料采用常规的机械加工方法则无法实现。此外,复合材料的表面改性也存在问题,表现为涂覆镀层附着力不高,高温考核后镀层出现变色、鼓泡等质量问题。连接是困扰金属基复合材料应用的另一大难题。由于增强体与基体合金之间的物理和化学性能(如熔点、导电性、导热性和线膨胀系数等)存在巨大差异,采用普通的焊接方法无法焊接成型或连接质量无法满足使用要求[12]。
3 主要解决办法
针对MMCs在工程应用中的问题,国内外进行了大量的研究并提出了相应的解决方法。如针对高体分Dimond /Cu、SiCp/Al材料难以加工的问题,采用无(少)切削加工量的(无)压熔渗近净成形技术[6,13],来解决MMCs连接问题的超声钎焊、高能束焊等[12],这些技术对金属基复合材料的推广应用起到了积极的推动作用。但从应用的角度看,由于MMCs的特性,单一的工艺方案往往无法完美地解决实际应用问题。因此,必须针对MMCs的应用寻求一种系统解决办法。复合材料“同步设计与制造技术”是一种较为有效的方案,其核心思想是在初始设计阶段就系统考虑产品材料性能及结构设计、材料制备工艺、构件成形等方面的综合要求,是一种能有效解决后续加工制造问题或降低难度的新方法。其前提是需要材料制备方与实际工程应用方进行全方位细致的交流和沟通,通过对具体产品研制过程各技术环节的梳理和权衡,基于产品的结构和性能特点,尽量将材料后续加工难题放在材料制备的源头来解决。研究表明,同步设计与制造技术在MMCs的推广应用中发挥了重要作用。
发达国家先后成功采用同步设计与制造技术加工出了多种产品。如采用局部增强结合近净成型的方法设计加工汽车发动机活塞;为降低热应力,采用梯度设计的思想设计发动机活塞材料;在封装领域,采用在制备高体分SiCp/Al时在表面预留铝层的方法解决材料的电镀和焊接问题,在需要打孔的地方预留铝合金以解决螺纹孔加工的问题,直接把元件如引线、密封环等嵌入成型的预制件中,通过浸渗直接连接成形,实现金属元件(引线、密封环)与熔融状态的基体“原位”连接[14]。
国内在复合材料的同步制造方面也开展了研究。文献[15]和文献[13]研究了带金属镶嵌件T/R组件的SiCp/Al近净成型工艺;文献[16]和[17]分别研究了铝合金与SiC预制件复合时与钛合金和FeNi合金的同步连接问题;文献[18] 采用梯度结构思想设计了梯度硅铝材料,同步解决了壳体膨胀系数匹配性和激光封焊问题。虽然国内在复合材料的同步设计与制造方面取得了一定的成果,但深入研究和实用化还有待进一步开展。
4 结束语
随着材料制备和加工技术的发展和成熟,以高导热、轻质、低膨胀为代表的金属基复合材料的性能和应用将得到不断提高和推广。在MMCs应用于封装领域方面,我国已经开展了一些开发和验证工作,但与国外先进水平相比还有一定的差距。因此,很好地借鉴国外已经验证的先进材料和制造技术,进一步加强材料研制方与应用单位的交流和沟通,对加快我国航空航天等领域组件先进封装材料的开发和应用具有非常重要的意义。
[1] 童震松, 沈卓身. 金属封装材料的现状与发展[J]. 电子与封装, 2005, 5(3): 6-15.
[2] Alltek Company: Aluminum Graphite 材料介绍[EB/OL]. [2015-08-10]. http: // www.alltekusa.com.
[3] 高晓晴, 郭全贵, 刘朗, 等. 高导热炭材料的研究进展[J]. 功能材料, 2006(2): 173-177.
[4] 高文迦, 贾成广, 褚克, 等. 金刚石/金属基复合新型热管理材料的研究与进展[J]. 材料导报, 2011, 25(2): 17-22, 26.
[5] 崔岩. 碳化硅颗粒增强铝基复合材料的航空航天应用[J]. 材料工程, 2002(6): 3-6.
[6] CUI Y, WANG L F, REN J Y. Multi-functional SiC/Al composites for aerospace applications[J]. Chinese Journal of Aeronautics, 2008(21): 576-584.
[7] 张韧, 王子良, 崔岩. 无压浸渗SiC/Al的电镀和应用[J]. 电子与封装, 2004, 4(5): 26-30.
[8] Sandvik Materials Technology Incorporated. Osprey CE alloys for thermal management[EB/OL]. [2015-08-12]. http: // www. smt. sandvik.com/osprey.
[9] 刘红伟, 张永安, 朱宝宏, 等. 喷射成形70Si30Al 电子封装材料致密化处理及组织性能研究[J]. 稀有金属, 2007, 31(4): 446-450.
[10] 田冲, 陈桂云, 杨林, 等. 喷射沉积硅铝电子封装材料的组织与性能[J]. 功能材料与器件学报, 2006, 12(1): 54-58.
[11] 牛通, 韩宗杰, 张梁娟, 等. 金刚石/铜复合散热材料的制备和检测[J]. 电子与封装, 2014(2): 9-12.
[12] 王少刚, 徐九华, 姜澄宇. 铝基复合材料焊接中的若干技术问题[J]. 宇航材料工艺, 2006(4): 1-6.
[13] 熊德赣, 刘希从, 堵永国, 等. 小批量铝碳化硅T/R组件封装壳体的研制[J]. 电子与封装, 2004, 4(4): 29-32.
[14] ADAMS R W, NOVICH B E, FENNESSY K Y. Concurrent Integration TM of Al / SiC MMIC Packages[C] // ISHM′95 Proceedings. Los Angeles, USA: 1995.
[15] 熊德赣, 刘希从, 赵恂, 等. 铝碳化硅复合材料T/R 组件封装外壳的研制[J]. 电子元件与材料, 2003, 22(2): 17-19.
[16] 崔岩, 张磊, 赵会友. Ti合金与SiCp/Al复合材料在无压浸渗同步复合过程中的相容性[J]. 航空材料学报, 2009(6): 43-47.
[17] 张志庆, 于家康. Al/SiCp电子封装材料嵌入金属元件的组织与性能研究[J]. 材料热处理技术, 2008, 37(2): 1-4.
[18] 周明智, 高永新, 樊建中, 等. 一种基于梯度设计的T/R封装壳体材料研制[J]. 电子机械工程, 2012, 28(3): 54-57.
周明智(1973-),男,博士,主要研究方向为先进材料制备、精密成形及加工过程数值模拟。
Research Progress of Metal Matrix Composites for Microwave Packaging
ZHOU Ming-zhi,XU Ye-lin,LEI Dang-gang,LU Hai-yan
(The38thResearchInstituteofCETC,Hefei230088,China)
With the development of electronic and information technology, the performance of the electronic packaging material is becoming even more critical. The metal matrix composites (MMCs) is an ideal electronic packaging material for its excellent thermal physical properties such as light weight, high thermal conductivity, low expansion coefficient. The MMCs is designed with high volume fraction of reinforcement for electronic packaging, which makes its manufacturing and application very difficult. In this paper the research status and application of the MMCs are summarized and the key problems in application are pointed out. The solutions to these problems are also suggested.
metal matrix composites; packaging; research progress
2015-08-18
TB333.1
A
1008-5300(2015)05-0001-04

