单芯片大功率RF LDMOS晶体管设计与实验
刘武平,周 星,韩鹏宇,邓小川
(电子科技大学微电子与固体电子学院,成都 610054)
1 引言
射频横向双扩散效应管晶体管(RF LDMOS)广泛应用于通信、雷达和导航等领域。与双极型器件相比,RF LDMOS器件具有线性增益高、输出功率大、效率高、耐久性好等优点。同时RF LDMOS器件基于成熟的硅工艺,使得其制作成本较低,现已发展为射频大功率器件的主流技术[1]。对于传统RF LDMOS晶体管,器件的源极通过p+sinker连接到器件的衬底,以减小源极外接引线电感,增大射频增益,但缺点是源电阻不易降低以及源区占据芯片面积较大。本文中的槽型sinker RF LDMOS器件的主要特点是通过在源极刻蚀贯通外延层的沟槽并填充金属的方法来实现背面源结构。该工艺过程不仅减少了高能离子注入推结的热预算,而且减小sinker源区的面积1/3以上[2]。
本文采用上海华虹宏力半导体制造有限公司的0.35 μm RF LDMOS工艺平台,得到栅宽200 μm器件的饱和电流为170 mA/mm,击穿电压120 V,截止频率和最大振荡频率分别为5.5 GHz和10 GHz;栅宽345 mm单芯片器件在50 V工作电压、1 090 MHz时的峰值输出功率为362 W,功率增益15.6 dB,漏极效率38.1%。
2 器件结构
槽型sinker RF LDMOS器件结构如图1(a)所示。器件制作在p-外延层上,通过自对准工艺和双扩散工艺技术形成沟道。器件n+源区通过金属和槽型sinker与重掺杂p+衬底相连。器件的耐压主要由轻掺杂漏区(Lightly Doped Drain,LDD)承受,通过调节LDD区的注入剂量可以有效调节器件的击穿电压。为了优化RF LDMOS器件的表面电场分布,器件采用两层shield场板,shield场板通过金属与源极相连。该结构不仅可以减小栅极边缘的电场,也可以降低栅极与漏极之间的反馈电容,从而增加LDD区掺杂浓度以提高器件的效率和功率密度[3]。器件的栅长为0.65 μm,LDD区长度为5.5 μm,采用上海华虹宏力半导体制造有限公司的0.35 μm RF LDMOS工艺平台。流片实验得到的器件SEM剖面图如图1(b)所示。
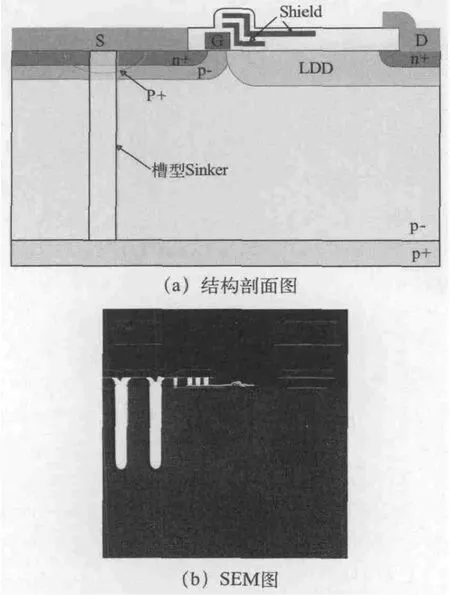
图1 槽型sinker RF LDMOS器件结构剖面图和SEM图
3 实验结果分析与讨论
流片的RF LDMOS器件直流特性采用吉时利的半导体参数测试仪器4200完成测试。图2为栅宽200 μm RF LDMOS器件的直流测试曲线。从测试结果可以看到,栅压VG= 6 V时,器件的饱和电流密度为170 mA/mm;当栅压VG=5 V/6 V时,器件饱和电流随着漏源电压继续增大而减小。其原因是器件在栅压比较高时器件电流大,其产生的热量导致载流子的迁移率降低,从而衰退了饱和电流。

图2 栅宽200 μm RF LDMOS器件的直流特性曲线
图3为RF LDMOS器件的转移及跨导特性曲线,测试条件为漏源电压VD=10 V,栅源电压VG从0 V扫描到6 V。器件阈值电压VT=2.1 V,最大跨导gm-max=67 ms/mm。图4所示为器件反向击穿电压测试曲线,器件的击穿电压为120 V,这是通过LDD区和shield结构优化后得到的结果。优化后器件LDD区的表面电场更加均匀,电场峰最大值出现在顶层shield边缘,栅极边缘以及漏极边缘的电场值较弱。电场分布情况见图5,同时此电场分布对器件的可靠性和耐久性有一定提高[4]。

图3 栅宽200 μm RF LDMOS器件转移及跨导特性曲线
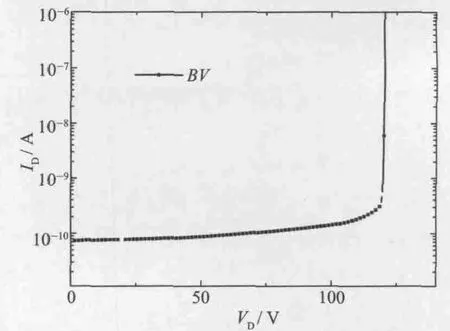
图4 栅宽200 μm RF LDMOS器件反向击穿电压测试曲线
图6所示为栅宽200 μm RF LDMOS器件的S参数,测试条件为栅源电压VG=4 V,漏源电压VD=40 V,频率从800 MHz扫描到20 GHz。由S参数测试结果得到器件的截止频率fT=5.5 GHz,最高振荡频率fMAX=10 GHz;在频率为1 GHz时器件的功率增益达到29 dB,高增益的原因是器件采用了双层shield结构。

图5 RF LDMOS器件表面电场分布曲线

图6 栅宽200 μm器件小信号测试S参数
表1为栅宽345 mm单芯片RF LDMOS器件功率测试结果,测试条件为漏源电压VD=50 V,器件静态工作电流IDQ=50 mA,脉冲信号频率为1 090 MHz,脉冲宽度为128 μs,信号占空比为10%。输入功率5 W,单芯片器件的峰值输出功率为299 W,功率增益为17.8 dB,漏极效率为36.2%;输入功率10 W,单芯片器件的峰值输出功率达362 W,功率增益为15.6 dB,漏极效率为38.1%。测试中发现器件在工作时的漏极效率偏低,这是器件在工作时热量分布不均匀所致。改善器件的热量情况可有效提高器件的漏极效率,同时也可增大器件的输出功率。
4 结论
本文完成了一种槽型sinker RF LDMOS器件的实验研究。槽型sinker结构通过挖槽填金属实现,将源区sinker面积减小1/3以上。通过流片实验,得到饱和电流为170 mA/mm、击穿电压为120 V、截止频率和最大振荡频率分别为5.5 GHz和10 GHz的RF LDMOS器件。栅宽345 mm单芯片RF LDMOS器件在频率1 090 MHz、工作电压50 V时的峰值输出功率为362 W,功率增益为15.6 dB,漏极效率为38.1%,实现了单芯片RF LDMOS器件的大功率输出。
致谢
感谢上海华虹宏力半导体制造有限公司为本次流片提供了工艺指导,同时感谢中国电子科技集团公司第13研究所为本次实验提供功率测试指导。
[1]F.van Rijs.Status and trends of silicon LDMOS base station PA technologies to go beyond 2.5 GHz applications[J].RWS 2008: 69-72.
[2]CheonSoo Kim,Sung Do Kim,Mun-Yang Park,et al.Trenched-Sinker LDMOSFET (TS-LDMOS) Structure for 2 GHz Power Amplifiers[C].Electron Devices Meeting,2001: 40.2.1-40.2.4.
[3]S J C H Theeuwen,J H Qureshi.LDMOS Technology for RF Power Amplifiers[J].Microwave Theory and Techniques,2012,60(6): 1755-1763.
[4]S J C H Theeuwen,W J A M Sneijers,J G E Kiappe,et al.High Voltage RF LDMOS Technology for Broadcast Applications[C].Microwave Integrated Circuit Conference,2008: 24-27.

