GaAs MMIC功率放大器加速寿命试验及可靠性评估
苏兴荣,尹聚文
(空军装备研究院,北京 100085)
1 试验假设
某型GaAs MMIC功率放大器是用于某型装备的新研大功率芯片,要求在正常结温150℃的条件下,失效率>10-6/h,可靠寿命≥15年。为考核其可靠性指标是否达到要求,采用恒定温度应力加速寿命试验的方法进行验证。根据理论分析,失效机理主要为栅下沉[1-2],满足最弱环节寿命特征模型。因此作以下假定。
1)器件在正常应力水平θ0和加速应力水平θi下的寿命都服从威布尔分布,其分布函数为[3-4]:

式中:m为形状参数,mi>0;ηi为特征寿命,ηi>0。此假定表明,改变应力水平不会改变寿命分布类型。
2)在θ0和θi下,产品的失效机理不变,由于威布尔分布的形状参数反映失效机理,故此假定意味着:m0=mi。
3)产品的特征寿命ηi与所加的温度应力水平θi间有如下的加速模型,它们之间的关系符合阿伦
尼斯方程,即:ηi=ea+b/θi或 l nηi=a+b/θi。
2 试验结果及分布假设检验
2.1 试验过程及数据
根据国内外相关资料和该芯片的生产工艺,确定在结温225,240,255,270℃等4个加速温度应力下进行1200 h的定时截尾试验,每个温度应力下投入10个样品,在试验过程中实时监测漏源电流变化量(ΔIDS≤20%),定时测试输出功率(下降≤1 dB)。在225℃的温度下无失效,各温度应力下的失效情况见表1。

表1 各温度应力下失效情况Table 1 Failure time at each temperature level
2.2 分布假设检验
首先利用表1的数据,用Matlab绘制威布尔分布图[5-6](如图 1所示)。从图 1中可以看出,θ2(240℃)和θ3(255℃)温度应力下2条威布尔分布直线基本平行,θ4(270℃)时直线斜率出现显著变化。可以初步判断各温度应力下器件的寿命服从威布尔分布,但在高温度应力270℃时失效机理发生了变化。
进一步利用范-蒙特福特检验法检验各温度应力下器件的寿命是否服从威布尔分布[7],这种方法比图估法更为精确。假设H0:器件的寿命分布为威布尔分布W(m,η),令:
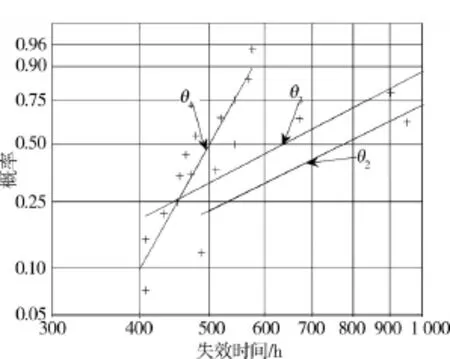
图1 各温度应力下的威布尔分布曲线Fig.1 Weibull distribution curve at each temperature level



表2 温度应力为240℃下范-蒙特福特检验计算表Table 2 Calculation table of Van-Montfort test at 240℃
1)240℃时的分布检验。温度应力为240℃时,Gi的值见表2。
表2中的E(Zi)可通过查《可靠性试验用表》E(Zr,n)得到[8]。把Gi均分为2组,则统计量为:

对于给定的显著水平α=0.1,如果上述F值满足以下条件,则认为假设成立:

由于F=0.8386,介于F0.95(2,4)和F0.05(2,4)之间,所以不能拒绝H0,即可以认为该温度应力下的寿命分布是威布尔分布。
2)255,270℃时的分布检验。同理,温度应力为255℃时,F=3.8525,F0.9(56,6)=0.2336,F0.0(56,6)=4.28;温度应力为 270 ℃时,F=2.023,F0.95(8,8)=0.290 7,F0.0(58,8)=3.44。因此,在255,270℃温度应力下的寿命分布都是威布尔分布。
3 估计各应力水平下的μi和σi
利用阿伦尼乌斯方程估算寿命曲线,需要3个温度应力下的参数。在试验中,虽然270℃下的失效数据服从威布尔分布,但其曲线斜率与前2个温度有明显变化,故认为失效机理发生了变化,不能使用该温度下的失效数据,而225℃下又无失效。为此,先用经典方法对θ2,θ3参数进行估计,再使用贝叶斯公式对225℃时的参数进行估计。
3.1 温度240,255℃下μ和σ的近似无偏估计
在240,255℃温度下,用以下公式求得μi和σi的近似无偏估计[1]:

式中:k(ri,ni)和Ec(Zri,ni)的数值由样本总量n、失效数r查近似无偏估计系数表(极值分布)得到。
温度为 240 ℃时,k(4,10)=4.496 7,Ec(Z4,10)=-0.966 385;温度为255 ℃时,k(7,10)=9.135 356,Ec(Z7,10)=-0.013 997。
3.2 形状参数m的估计

3.3 用贝叶斯原理估计225℃下的参数
下面用贝叶斯原理估算θ1(温度应力225℃)水平下参数[9-15]。
设有n1个产品进行寿命试验,截尾时间为τ1,在时刻t1前有r1个产品失效,其中每个产品的失效概率均设为p1,其似然函数可用二项分布表示:

其中p1为产品在τ1前失效的概率,即:

试验中,10个产品在时刻1 200 h前无一失效,即r1=0,则似然函数为:
L(0|p1) =(1-p1)10
现确定参数p1的先验分布,p1总界于0与1之间,由于加速寿命试验产品的失效概率不会很大,因此,p1靠近于0。另外,低温度应力下的失效概率不可能超过高温度应力的失效概率,所以p1的一个上限λ可以由240℃下的试验信息确定:。
若取(0,λ)上的均匀分布作为p1的先验分布,再联系到上述似然函数,由Bayes定理可得p1的后验分布为:

其中,0<p2<0.3744,利用数值积分法得 ln的后验期望为:


4 可靠性指标估计
4.1 加速寿命方程η=ea+b/T的计算
利用3种估计的参数,在温度225,240,255℃等3个应力水平下,加速寿命方程中a和b的计算按表3进行。
按下列公式计算a和b:

4.2 在150℃时可靠性指标估计
1)在正常工作情况下,结温Tj=150℃时的特征寿命:

2)如果按10年计算,在温度150℃的正常工作温度下,平均失效率为:

3)在正常工作温度为150℃的条件下,平均寿命:

表3 计算加速寿命试验方程中的系数a和bTable 3 Calculation of coefficients a and b in the accelerate life test equation

4)产品在某温度150℃条件下,可靠度为0.9时的可靠寿命为:

5 结论
从试验结果及以上分析和计算结果,可以得出以下结论。
1)该GaAs MMIC功率放大器在结温270℃时的失效机理与正常温度应力下相比已经发生改变,不能使用该温度应力下的失效数据对芯片的可靠性指标进行估计。
2)利用器件在低温度应力下失效概率应小于高温度应力下的物理经验,采用均匀分布作为先验布,利用贝叶斯公式,可估算出低温度应力下无失效数据的威布尔分布参数。
3)在150℃正常温度应力下,该功率放大器使用10年的平均失效率小于10-6/h,可靠度0.9时的可靠寿命达到30年以上,满足使用指标要求。
参考文献:
[1] 崔晓英,许燕,黄云.GaAs PHEMT器件高温加速寿命试验及物理分析[J].电子器件,2010,33(1):22-26.CUI Xiao-ying,XU Yan,HUANG Yun.High Temperature Accelerant Life Test and Physical Analysis of GaAs PHEMT Device[J].Chinese Journal of Electron Device,2010,33(1):22-26.
[2] 王蕴辉,莫郁薇,吴海东,等.砷化镓微波单片集成电路可靠性预计模型研究[J].电子产品环境与可靠性试验,2007,25(2):43-48.WANG Yun-hui,MO Yu-wei,WU Hai-dong,et al.The Research on Reliability Prediction Model for MMIC[J].Electronic Product Reliability and Environmental Testing,2007,25(2):43-48.
[3] 茆诗松,王玲玲.可靠性统计[M].上海:华东师范大学出版社,1984.MAO Shi-song,WANG Ling-ling.The Statistics of Reliability[M].Shanghai:East China Normal University Publishing House,1984.
[4] 刘海涛.氦氖激光器加速寿命试验理论研究[D].西安:西安电子科技大学,2008.LIU Hai-tao.The Theory Study of He-Ne Lasers Accelerated Life Test[D].Xi'an:Xi'an Electronic Technology University,2008.
[5] GB 2689.1-1981,寿命试验和加速寿命试验方法总则[S].GB 2689.1-1981,The General Life Test and AcceleratedLife Test Method[S].
[6] GB 2689.2-1981,寿命试验和加速寿命试验的图估计法(用于威布尔分布)[S].GB 2689.2-1981,The Probability Paper Estimation for Life Test and Accelerated Life Test(for Weibull Distribution)[S].
[7] 茆诗松,王玲玲.加速寿命试验[M].上海:华东师范大学出版社,1984.MAO Shi-song,WANG Ling-ling.The Acceleration Life Test[M].Shanghai:East China Normal University Publishing House,1984.
[8] 中国电子标准化研究所.可靠性试验用表(增订本)[M].北京:国防工业出版社,1987.The Chinese Electronics Standardization Institute.Tables for Reliability Test(Revised and Enlarged Book)[M].Beijing:National Defense Industry Press,1987.
[9] 茆诗松,李亿民,陆淑兰,等.恒定应力加速寿命试验中无失效数据的处理[J].应用概率统计,1993,9(2):216-218.MAO Shi-song,LI Yi-min,LU Shu-lan,et al.Data Processing for Accelerated Life Test in Constant Stress[J].Chinese Journal of Applied Probability and Statistics,1993,9(2):216-218.
[10] GB 2689.4-1981,寿命试验和加速寿命试验的最好线性无偏估计[S].GB 2689.4-1981,The Best Linear Unbiased Estimation for Life Test and Accelerated Life Test[S].
[11] 徐健.定时截尾恒加寿命试验下无失效数据的Bayes处理方法[J].上饶师范学院学报,2007,27(3):1-7.XU Jian.Bayesian Statistical Method for Non-failure Data under Accelerated Life Test Based on Type I Censoring[J].Journal of Shangrao Normal College,2007,27(3):1-7.
[12] 王乃生,王玲玲.恒定应力加速寿命试验数据缺失时的统计分析[J].华东师范大学学报(自然科学版),2002(1):35-44.WANG Nai-sheng,WANG Ling-ling.Statistical Analysis of Constant Stress Accelerated Life Testing under Multiply Type-II Censoring[J].Journal of East China Normal University(Natural Science),2002(1):35-44.
[13] 李亿民.恒加寿命试验中无失效数据的处理[J].山东工程学院学报,1996,10(4):55-59.LI Yi-min.A Method for Processing Non-failure Data in Constant Stress Accelerating Life Test[J].Journal of Shandong Institute of ENG,1996,10(4):55-59.
[14] 严栓航,师义民.恒应力加速寿命试验中无失效数据的处理[J].纯粹数学与应用数学,2006,22(2):145-148.YAN Shuan-hang,SHI Yi-min.Zero-failure Data Process of Constant Stress Accelerated Life Testing[J].Pure and Applied Mathematics,2006,22(2):145-148.
[15] 唐彦峰,王森,刘祥凯,等.基于Bayes方法的无失效数据寿命分布研究[J].军事交通学院学报,2011,13(9):58-60.TANG Yan-feng,WANG Sen,LIU Xiang-kai,et al.On Bayesian Method for Life Distribution of Zero-failure Data[J].Journal of Military Transportation University ,2011,13(9):58-60.

