N+缓冲层对PT-IGBT通态压降影响的研究
关艳霞,凌 宇
(沈阳工业大学 信息科学与工程学院,沈阳 110870)
N+缓冲层对PT-IGBT通态压降影响的研究
关艳霞,凌 宇
(沈阳工业大学 信息科学与工程学院,沈阳 110870)
N+缓冲层设计对PT-IGBT器件特性的影响至关重要。文中利用Silvaco软件对PT-IGBT的I-V特性进行仿真。提取相同电流密度下,不同N+缓冲层掺杂浓度PT-IGBT的通态压降,得到了通态压降随N+缓冲层掺杂浓度变化的曲线,该仿真结果与理论分析一致。对于PT-IGBT结构,N+缓冲层浓度及厚度存在最优值,只要合理的选取可以有效地降低通态压降。
Silvaco;PT-IGBT;N+缓冲层;通态压降;仿真
IGBT因为拥有输入阻抗高、损耗低、开关速度快、通态压降低、通态电流大等优势而成为现今功率器件发展的主流产品[1-2]。我国市场对IGBT的需求庞大,但国内还不能大规模生产自主设计的IGBT,大部分仍依靠进口,这是我国电力电子技术发展中面临的重大瓶颈之一[3],IGBT的研发设计工作对我国各项事业的发展有十分重大的战略意义。
与 NPT-IGBT(非穿通型 IGBT)相比,PT-IGBT(穿通型IGBT)因具有更好的开关速度及更小的功率损耗而被广泛应用。PT-IGBT中N+缓冲层的结构参数对其特性的影响至关重要,因此要对其进行优化设计。在进行N+缓冲层设计中,原则上是在保证正向转折电压的前提下选择合理的N+缓冲层的掺杂浓度和厚度,降低通态压降。文中使用Silvaco软件,在保证阻断电压的前提下,对不同N+缓冲层掺杂浓度的PT-IGBT的通态压降进行了仿真分析,对PT-IGBT缓冲层的优化设计提供了有价值的参考。
1 PT-IGBT的结构与工作原理
1.1 PT-IGBT的结构
IGBT是在VD-MOSFET结构基础上发展而来的器件[4],IGBT用P+层取代了VD-MOSFET漏极中的N+型掺杂区。PTIGBT就是在阳极侧的P+区和N基区间加入一个N+区,如图1所示,加入的这个N+区称为N+缓冲层,缓冲层的作用是阻挡IGBT在正向阻断时耗尽层的扩展[5-6],使得PT-IGBT能够用较小的N基区宽度实现与NPT-IGBT相同的正向阻断能力,提高开关速度的同时保持了较低的通态压降[7]。
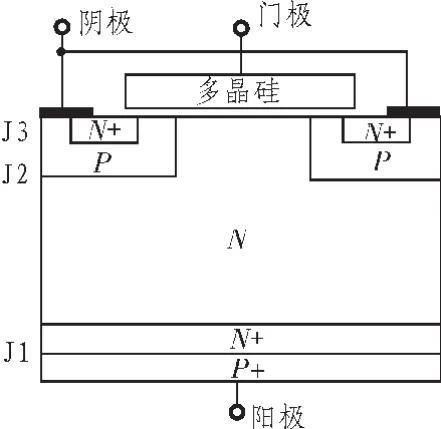
图1 PT-IGBT结构Fig.1 Punch-through type IGBT structure
1.2 PT-IGBT的工作原理
当栅极电压大于阈值电压时,IGBT开始导通。在P基区表面形成导电MOS沟道,电子经MOS沟道注入N基区,同时推动了阳极P+的空穴注入。由于N基区宽度很大,大部分空穴在N基区中与从MOS沟道注入进来的电子复合。剩余的空穴从N基区扩散到 J2结,由于J2结轻微反偏,空穴被电场捕获通过空间电荷区进入P基极。由于N基区为实现高阻断电压能力而采用了低掺杂浓度,所以中等电流密度下的空穴浓度甚至超过了N基区的掺杂浓度。因此,N基区处于大注入的状态,伴随着很强的电导调制效应[8-10]。这使得IGBT通态下得以保持很好的低通态压降和高电流密度。
2 PT-IGBT的通态V-I特性
2.1 通态模型
当栅极电压足够大时,IGBT中所包含的MOSFET结构工作在线性模式下,IGBT的通态特性类似于PIN二极管的通态特性。因此用于分析PT-IGBT通态特性的等效模型可简化为:一个PIN二极管串联一个工作在线性区域的MOSFET。较大的正向栅极电压促使导通状态下的IGBT结构在栅极下面形成堆积层,与N基区重叠。通态时的电子电流通过MOSFET的沟道到达堆积层,可以被视作是在向N基区注入。相应地,空穴从阳极P+区注入,在N基区内形成大注入。栅极下N基区内的电子和空穴浓度分布与PIN二极管相似。此时IGBT的等效电路如图2所示。

图2 IGBT的MOSFET/PIN通态等效电路结构Fig.2 MOSFET/PIN equivalent circuit for the On-state IGBT structure
本次仿真使用的PT-IGBT结构参数:
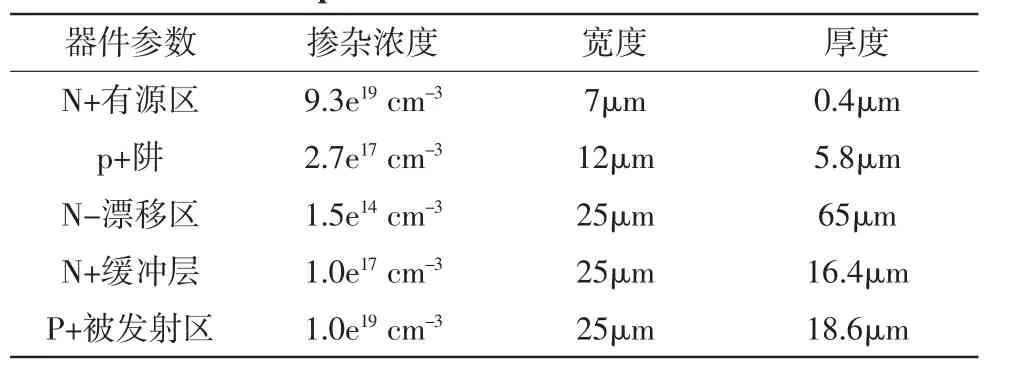
表1 600V PT-IGBT的仿真参数Tab.1 Simulation parameters of the 600 V PT-IGBT structure
2.2 通态特性的仿真
根据表1所示的结构参数,利用Silvaco软件对PT-IGBT进行仿真。为了分析该结构的通态特性,施加不同的栅极电压以扫描集电极电压。仿真结果如图3所示,该结构参数下IGBT的阈值电压约5 V左右,IGBT的开启电压约为0.8 V。通态压降随栅极电压的增加而减小,在较大的栅压下,通态特性与PIN二极管相似。
3 N+缓冲层对通态压降的影响
PT-IGBT结构中N+缓冲层的设计原则是:N+缓冲层的宽度大于正向转折电压下空间电荷区在其中的展宽。因此,N+缓冲层的浓度越高,保证阻断特性所需要的宽度就越小,但N+缓冲层的浓度又影响着PT-IGBT的通态压降,下面仿真分析N+缓冲层的浓度对通态压降的影响。
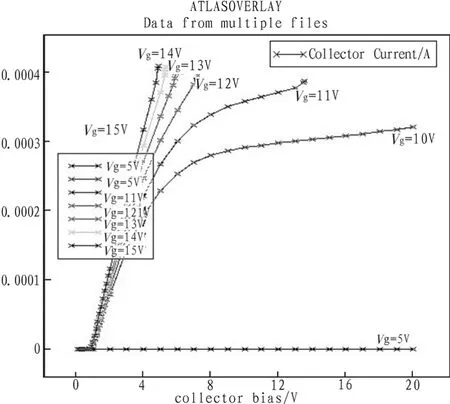
图3 PT-IGBT的I-V输出特性曲线Fig.3 Output I-V characteristics of the 600 V PT-IGBT structure
在其他参数不变的情况下,只改变N+缓冲层浓度,栅压为15 V,阳极电压从0 V逐渐增大到15 V,N+缓冲层浓度依次取 1e16、1e17、5e17、1e18、5e18及 1e19cm-3,仿真 IGBT 的转移特性曲线,如图4所示。提取相同电流3e-6A下的通态压降,并绘制成曲线,如图5所示。从图5中我们可以观察到,N+缓冲层掺杂浓度超过5e17cm-3时通态压降迅速增加。由此可见,在缓冲层保持很窄的情况下,虽然可以提高N+缓冲层的掺杂浓度,使得电场在缓冲层区内降到零。但N+缓冲层掺杂浓度的上限不可能不受限制,因为过高的掺杂浓度将使J1结注入效率降低,导致正向导通特性变坏。所以N缓冲层的最佳掺杂浓度和厚度分别在 1e16~1e17cm-3和 10~15 μm。
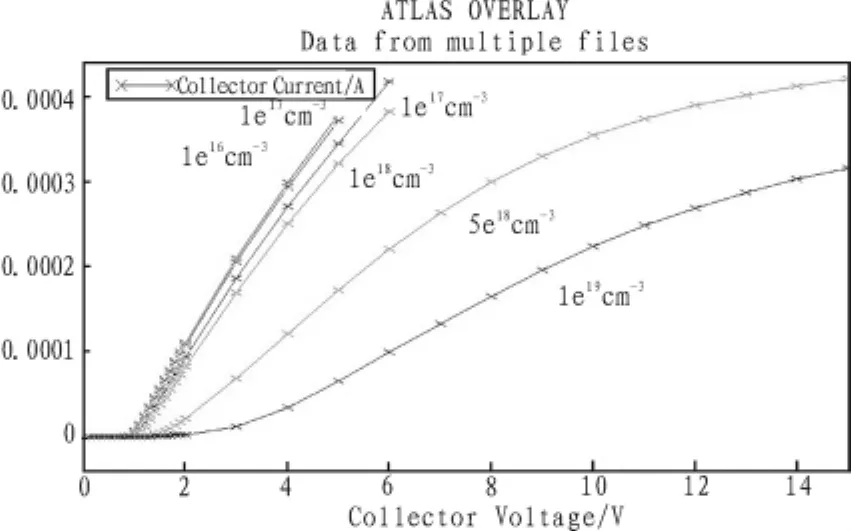
图4 不同N+缓冲层浓度下的输出I-V特性曲线Fig.4 Output I-V characteristics under different doping concentration of N+buffer

图5 通态压降随N+缓冲层掺杂浓度变化的曲线Fig.5 Curve of on-state voltage drop varied with different doping concentration of N+buffer
4 结 论
IGBT是结构复杂的集成功率器件,微小的结构参数变化都可能会给器件性能带来巨大影响。通过优化结构参数可以实现PT-IGBT在性能上的改进。在保证正向阻断电压的前提下选择合理的N+缓冲层的掺杂浓度和厚度。N+缓冲层的最佳掺杂浓度和厚度分别在 1e16~1e17cm-3和 10~15 μm。 文中针对缓冲层掺杂浓度的改变仿真分析了PT-IGBT的通态特性,探讨了缓冲层的优化问题,给PT-IGBT在缓冲层方面的优化设计提供了有价值的参考。
[1]王倩,钟传杰.150 V IGBT工艺模型设计[J].微计算机信息,2009,25(4-2):296-297.
WANG Qian,ZHONG Chuan-jie.Design of 150 V IGBT process model[J].Control and Automation,2009,25(4-2):296-297.
[2]王丹,关艳霞.功率器件的新结构及其性能特点[J].电子设计工程,2010,18(2):118-120.
WANG Dan,GUAN Yan-Xia.Thenew structureand performance characteristic of power devices[J].Electronic Design Engineering,2010,18(2):118-120.
[3]王树振,单威,宋玲玲.IGBT绝缘栅双极性晶体管发展简述[J].微处理机,2008,29(2):41-46.
WANG Shu-zhen,SHAN Wei,SONG Ling-ling.Development of IGBT[J].Microprocessors,2008,29(2):41-46.
[4]王瑞,赵亚辉.IGBT Pspice静态模型的建立与仿真[J].宝鸡文理学院学报:自然科学版,2010,30(2):65-73.
WANG Rui,ZHAO Ya-hui.Establishment and simulation of pspice static model for IGBT[J].Journal of Baoji University of Arts and Sciences:Natural Science,2010,30(2):65-73.
[5]高琰,亢宝位,程序.一种具有新耐压层结构的IGBT[J].半导体技术,2003,28(7):64-68.
GAO Yan,KANG Bao-wei,CHENG Xu.A kind of IGBT with the new structure ofvoltage-sustaining layer[J].Semiconductor Technology,2003,28(7):64-68.
[6]周文定,亢宝位.不断发展中的IGBT技术概述[J].中国集成电路,2009,18(1):23-28.
ZHOU Wen-ding,KANG Bao-wei.The summary on continuous development of IGBT technology[J].China Integrated Circuit,2009,18(1):23-28.
[7]唐勇,胡安,陈明.IGBT栅极特性与参数提取[J].电工技术学报,2009,24(7):76-80.
TANG Yong,HU An,CHEN Ming.IGBT Gate Characteristics and parameter extraction methods[J].Transactions of China Electrotechnical Society,2009,24(7):76-80.
[8]许平.IGBT器件和相关制备工艺技术评述[J].电力电子,2010(2):6-13.
XU Ping.An overview of IGBT device and its process and Technology[J].Power Electronic,2010(2):6-13.
[9]叶立剑,邹勉,杨小慧.IGBT技术发展综述[J].半导体技术,2008,33(11):937-951.
YE Li-jian,ZOU Mian,YANG Xiao-hui. Review on DevelopmentofIGBT Technology [J].Semiconductor Technology,2008,33(11):937-951.
[10]程序,吴郁,刘兴明,等.一种高性能的新结IGBT[J].半导体学报,2003,24(6):138-143.
CHENG Xu,WU Yu,LIU Xing-ming,et al.A new structure IGBT With high performance[J]. Chinese Journal of Semiconductors,2003,24(6):138-143.
Research of the N+buffer effect on state voltage drop of PT-IGBT
GUAN Yan-xia,LING Yu
(College of Information Science and Engineering, Shenyang University of Technology, Shenyang 110870, China)
The design of N+buffer plays an important role in characteristics of PT-IGBT devices.The I-V characteristics of PT-IGBT were simulated Using'Silvaco'in the paper.Comparing with the different values of on-state voltage drop under different doping concentration of the N+buffer at the same current density,the curves of on-state voltage drop with different doping concentration of the N+buffer was gained.The simulation results coincided with theoretical analysis.For PT-IGBT structure, there was an optimal value of the doping concentration of the N+buffer, and the on-state voltage drop would reduce through reasonable design.
Silvaco; PT-IGBT; N+buffer; on-state voltage drop; simulation
TN386.2
A
1674-6236(2013)07-0191-03
2012-11-28稿件编号201211241
关艳霞(1963—),女,辽宁海城人,博士,副教授。研究方向:电力半导体器件和微机电系统。

