航空发动机测温晶体的退火特性研究
张 兴,张志学,薛秀生,张羽鹏,赵迎松
(中航工业沈阳发动机设计研究所,沈阳110015)
航空发动机测温晶体的退火特性研究
张 兴,张志学,薛秀生,张羽鹏,赵迎松
(中航工业沈阳发动机设计研究所,沈阳110015)
针对航空发动机关键构件高温测试的技术难题,研究了1种用晶体作为传感器的测温技术,阐述了晶体的退火特性和缺陷观察方法,利用X射线衍射(X RD)研究中子辐照SiC晶体的退火特性,发现辐照后晶体的X RD峰的半高宽(Full W idth at H alf M aximum, FW H M)增大,又随退火温度的升高,在700~1230℃呈线性规律的回复。基于此发展了1种适合测量高温和复杂温度场的技术方法。采用添加K2CO3的K O H为腐蚀剂,对辐照前、后以及辐照后退火的SiC单晶进行位错腐蚀观察,结果表明:经中子辐照的晶体中位错面积比随退火温度的变化趋势与FW H M的变化趋势基本一致,由此认为经中子辐照所产生的位错可能是导致X RD峰的FW H M变化的1个重要因素。
测温;晶体;退火;缺陷;半高宽;航空发动机
0 引言
航空发动机向高推重比发展和内流计算流体热力学的广泛工程应用,对发动机试验和测试技术提出了新要求。发动机在整机试验、耐久性试验、部件试验、高空台试验和飞行试验等大量试验中需要测量多种参数的数据,以获得发动机工作的压力、温度、流量、振动和应力等有关信息,其中,温度是进行发动机设计分析的重要数据[1],由于发动机结构的复杂性和受到测试改装引线的限制,传统的热电偶测温方法已不能满足涡轮叶片、加力部件的壁温及燃气温度的某些测试要求。目前,俄罗斯在发动机关键构件测温中采用了1种无引线的晶体作为传感器的测温技术,并获得了大量的试验测试数据。“晶体测温”技术具有明显的非侵入特征,不损伤测试对象,不需现场测试(因利用了温度记忆效应),且测温范围宽、温度上限高(采用适当晶体可测到1800℃)、操作简便,并可在热电偶无法实现测试的部分情况中应用。目前该技术已经应用于世界先进国家的航空发动机研究。
本文针对晶体测温先进技术,介绍航空发动机测温晶体的退火特性及缺陷分析方法。
1 测温原理
选用SiC晶体材料,经高能射线辐照后产生缺陷,但在高温下可被恢复,恢复的程度依赖于温度和时间。在被测物达到测定温度时,测温晶体也达到同样温度,并在此温度下对晶格缺陷进行复原。利用X射线衍射检测晶格缺陷的恢复程度,对比事先标定好了的温度曲线,可知待测物体的温度(即测定温度),测温范围为700~1300℃。
2 缺陷试验方法
单晶片SiC呈淡绿色透明状,晶体被切成尺寸为5 mm×5 mm×0.5 mm的晶片,但部分腐蚀样品的尺寸略小。晶体辐照是在核反应堆上进行。辐照时通道中的温度为60~80℃,通量率为2.3×1013n/ (cm2·s),其中快的通量率为5× 1012n/(cm2·s),辐照总剂量(通量)为1.72×1019n/cm2。辐照后样品颜色变为灰黑色,且不透明。在空气中对辐照和未辐照样品进行从室温到1230℃的等时退火,退火时间为20 min,升温速率为10℃/min。
由于SiC是1种高稳定性材料,通常的酸、碱腐蚀剂并不能使之腐蚀,这给SiC的缺陷观测分析带来了很大不便。最终用于位错观察的样品均进行了抛光,并采用KOH和K2CO3的混合熔融体作腐蚀剂[2-3]。以未辐照的SiC晶片为样品,在不同腐蚀剂的配比、腐蚀温度和腐蚀时间下对样品进行腐蚀,并观察腐蚀坑位错。腐蚀剂的配比是30 g的KOH,不添加或分别添加了 0.75、1.50 g的 K2CO3(即 30 g KOH+0.75 g K2CO3,30 g KOH+1.50 g K2CO3)。腐蚀温度为380~440℃,升温步长为10℃,升温速率为10℃/min。腐蚀时间分别为10、20、30 min。
对辐照前、后及辐照后退火的SiC晶片进行腐蚀蚀坑观察和对比,用DH-CG400型金相显微镜观察了位错形貌。用美国Media Cy Bernetics公司的图像分析软件包Image-Proplus计算了各腐蚀图像的位错面积比。
3 退火温度特性
对辐照、未辐照以及辐照后退火的SiC晶体样品进行了缺陷观察。发现经辐照后的晶体,因产生大量缺陷导致其X射线衍射(XRD)峰半高宽(WFHM)增大、以及随退火温度的升高WFHM在一定温度范围内呈线性规律的恢复,以此特性为依据,可发展1种适合高温和复杂温度场测试的温度测量方法。同时,试图以所观察到的结果对辐照的SiC晶体的退火行为作出解释。
未辐照和辐照后的SiC晶体样品面XRD峰的WFHM随退火温度T的变化曲线如图1所示。从图1中可见,测得未辐照样品的WFHM约为0.066°,辐照后WFHM增大为0.260°左右。说明辐照导致样品中产生了大量缺陷,使晶格发生了严重的畸变[4],造成晶格有序度显著降低,因而WFHM增大。经室温到1300℃的退火后,未辐照样品的WFHM基本保持不变;而辐照的WFHM随退火温度的变化呈现2个阶段:在低于700℃时,其WFHM基本保持不变;在700~1230℃时,WFHM随退火温度升高呈线性下降。说明当退火温度高于700℃时,辐照诱导的部分缺陷达到其迁移所需的激活能,开始移动,并逐渐淹灭,晶格有序度随之增大,并表现为WFHM的逐渐降低。
试验表明,图1中的晶体缺陷的恢复曲线可作为温度传感的方式用来发展1种用于苛刻和封闭工作系统的“非侵入式”测温技术。

图1 未辐照和辐照的SiC晶体的XRD峰的WFHM随退火温度的变化曲线
这种测温技术首先是将辐照后的SiC晶体作为测温晶体,经不同温度的退火处理后,再用XRD分别测试退火后各晶体的WFHM,然后以WFHM为纵坐标,T为横坐标,绘制出WFHM与T的标准曲线(图1)备用;其次,选择与绘制WFHM与T曲线所用的晶体相同批次、相同辐照剂量的SiC晶体,将其埋设于待测物件的表层或表面,并随包含该待测物件的工作系统进行高温运转;然后,从待测物件中取出晶体并测试其WFHM,通过对比WFHM与的标准曲线找出对应的温度值,此温度值即为待测物件的最高工作温度。该技术测温范围为700~1300℃(加大辐照剂量,测温上限可以更高),具有不需现场测试、且有精度高、操作简便等优点,特别是其所具有的“非侵入式”特征以及测温范围上限高的特点,是其他测温方法不可替代的。
4 缺陷观测
因腐蚀剂对SiC晶体C面和Si面的腐蚀速率不同,导致C面的腐蚀效果各向同性,而Si面的腐蚀效果各向异性,而各向异性更容易显示出结构特征,因此,以下针对Si面进行观察。
4.1 腐蚀效果影响因素
不同的腐蚀剂配比、腐蚀温度和腐蚀时间对腐蚀效果均有不同的影响。未辐照的SiC晶片在不同腐蚀剂熔融体中腐蚀后的光学显微照片如图2所示,其腐蚀温度为410℃,腐蚀时间为20 min。
从图2中可见,用纯KOH作为腐蚀剂时,晶片表面只出现了极少且不明显的腐蚀坑,更多的是抛光留下的划痕(图2(a)),腐蚀效果较差。当腐蚀剂配比为30 g KOH+0.75 g K2CO3时,因加入适量K2CO3可以得到较高且稳定的腐蚀速率[5],因此出现明显的腐蚀坑,效果较好(图2(b));当腐蚀剂为30 g KOH+1.50 g K2CO3时,腐蚀效果也不理想(图2(c))。因此,最佳的腐蚀剂配比为30 g KOH+0.75 g K2CO3。
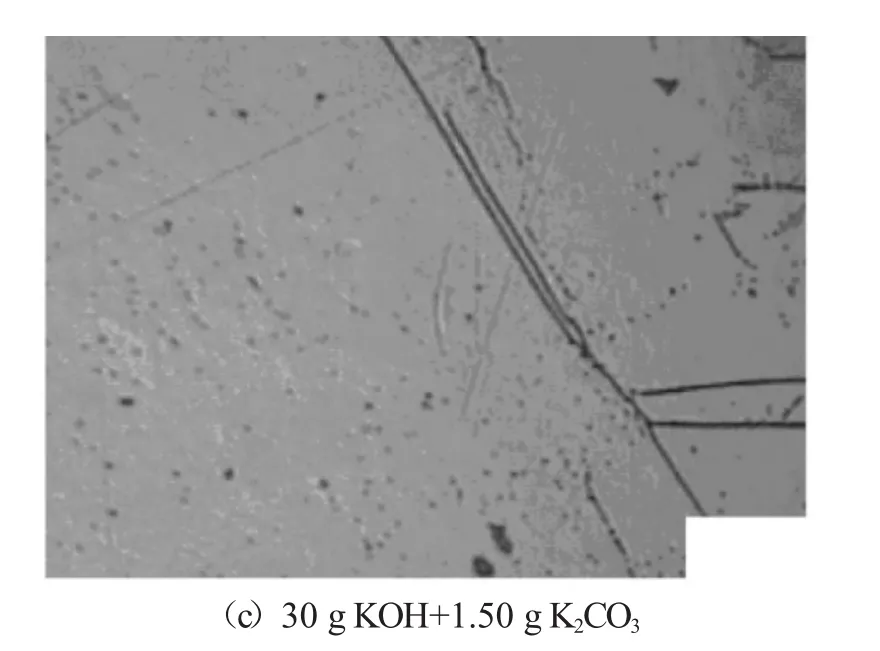
图2 在不同腐蚀剂中未辐照SiC晶片腐蚀的光学显微图像
采用30 g KOH+0.75 g K2CO3腐蚀剂,腐蚀时间为20 min时,温度对未辐照SiC晶片腐蚀的影响[6]如图3所示。从图中可见,当腐蚀温度为380℃时,晶片表面并未出现形状较规则的腐蚀坑(图3(a));当腐蚀温度为410℃时,Si面出现了大小和形状都适中的腐蚀坑(图3(b))。当腐蚀温度为420℃时,从整体看腐蚀效果与410℃出现的腐蚀坑很相似(图3 (c)),但从这2个温度下腐蚀坑的放大图(图3(f)、(g))中可见,在410℃时的腐蚀坑是规则的正六边形,即出现与SiC晶体Si面的密堆积原子排列形状相似的腐蚀坑;而在420℃时腐蚀坑已成圆形,说明此时腐蚀已过度。在430和440℃时,腐蚀坑之间已经交叠,并出现了明显的过腐蚀现象,这说明腐蚀温度过高使腐蚀速率过大(图3(d)、(e))。因此,较佳腐蚀温度为410℃。
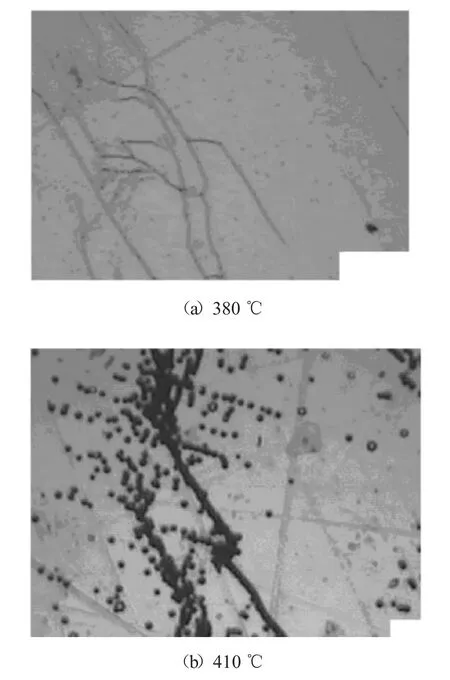
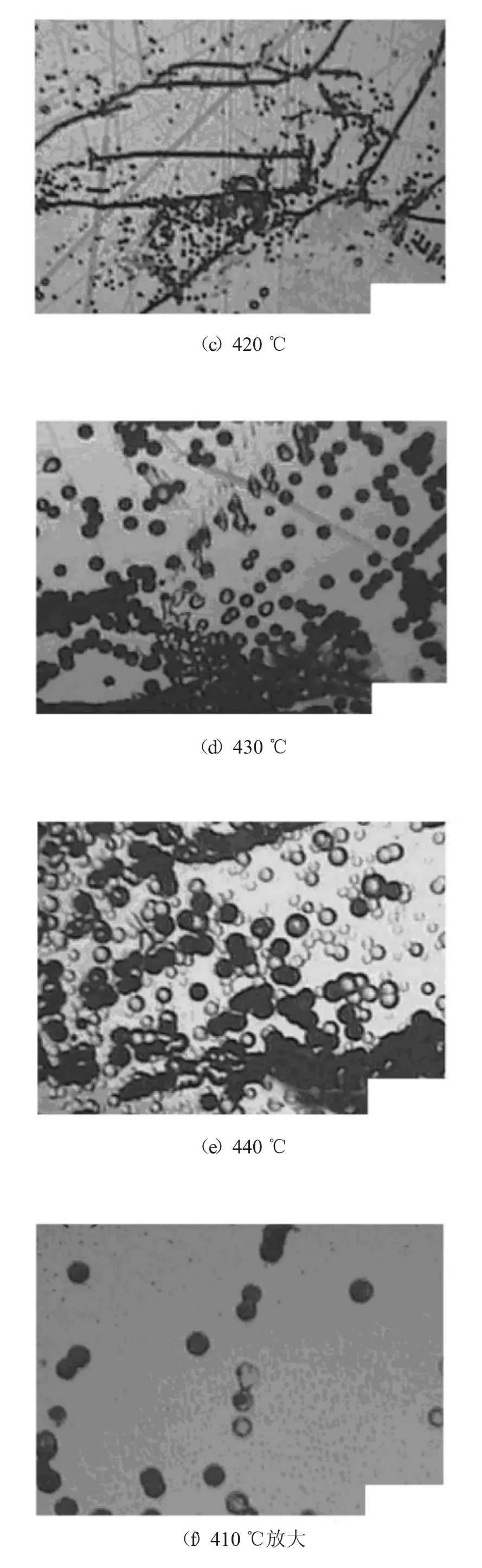
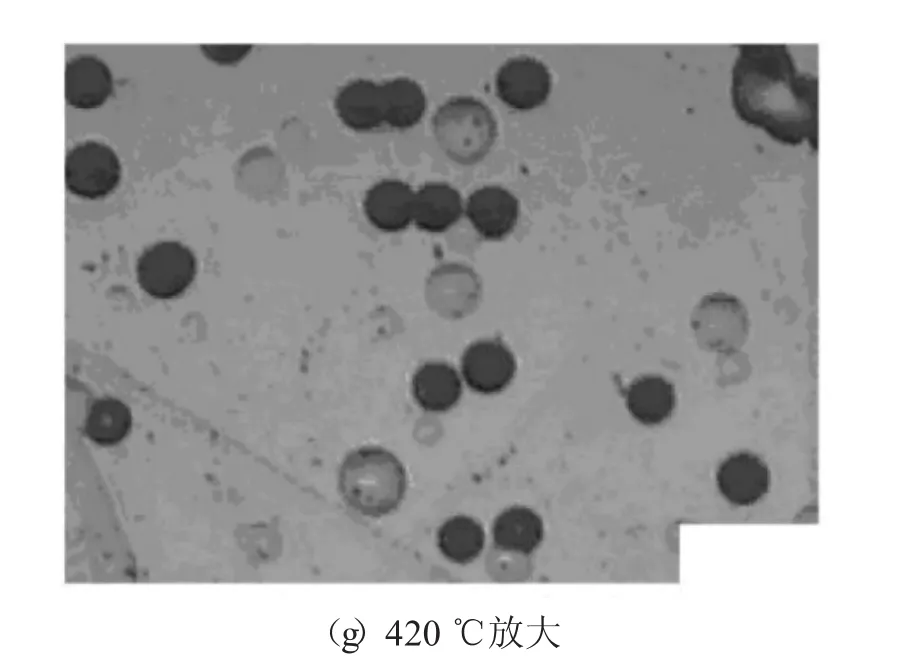
图3 不同温度下未辐照SiC晶片腐蚀的光学显微图像
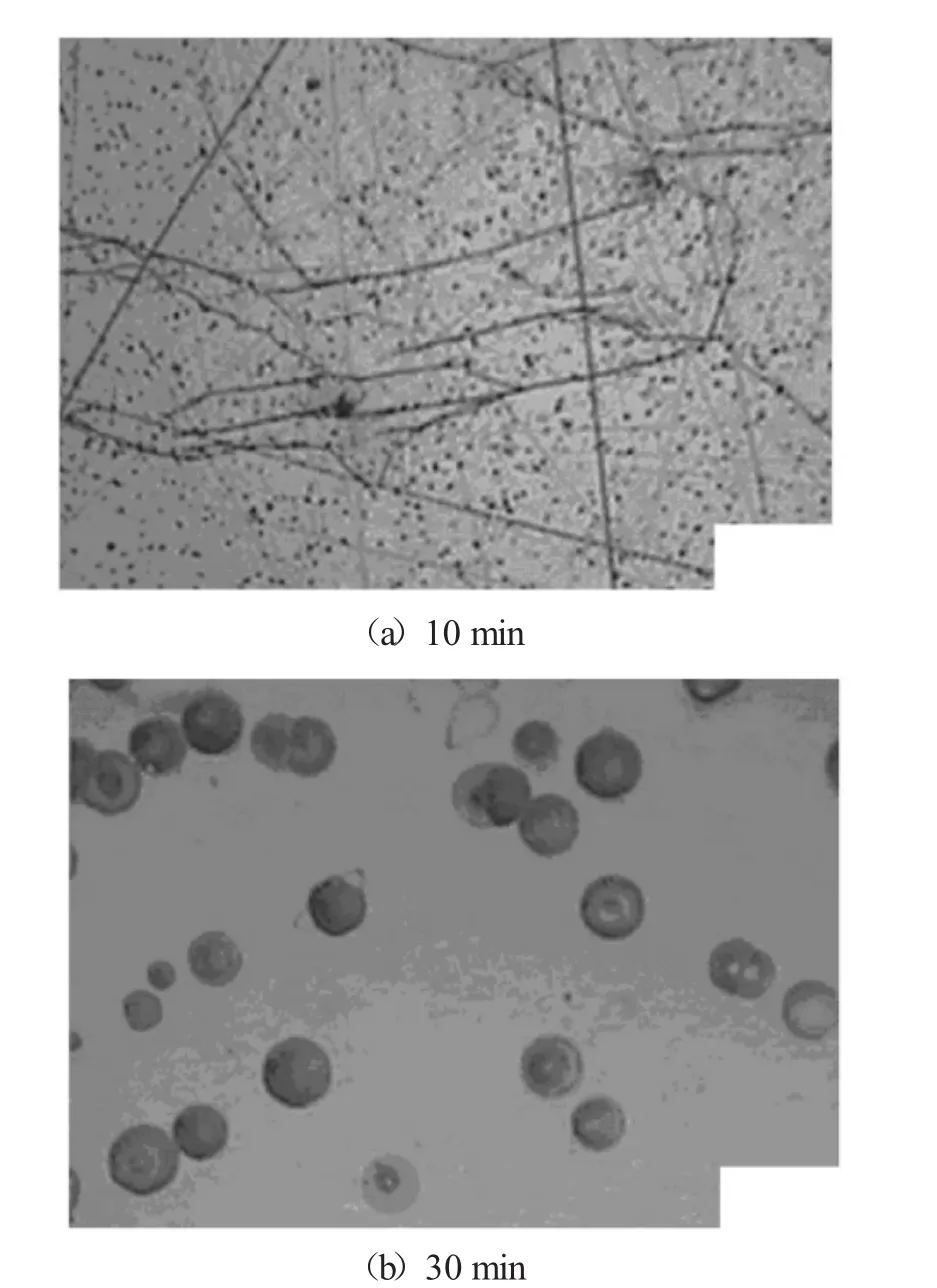
图4 不同腐蚀时间下未辐照SiC晶片腐蚀的光学显微图像
采用30 g KOH+0.75g K2CO3腐蚀剂,腐蚀温度为410℃时,腐蚀时间对未辐照SiC晶片腐蚀的影响如图4所示。从图中可见,当腐蚀时间为10 min时,Si面只出现轻微的腐蚀坑(图4(a)),说明腐蚀时间过短导致腐蚀不充分,腐蚀坑太小不利于位错密度的计算。图4(b)是腐蚀30 min后的放大图,从图中可见,此时腐蚀坑已经失去六边形轮廓,而呈现圆形,说明腐蚀时间过长导致腐蚀过度。只有腐蚀时间为20 min的样品(图2(b)),腐蚀效果最佳,腐蚀坑尺寸适中,形状清晰。可见较佳的腐蚀时间取20 min为宜。
因此,SiC单晶的较佳腐蚀工艺参数是:腐蚀剂配比为30 g KOH+0.75 g K2CO3,腐蚀温度为410℃,腐蚀时间为20 min。
4.2 晶片位错蚀坑变化
对于晶片辐照前、后及退火的位错蚀坑变化,首先对未辐照的SiC样品进行1000℃的退火,退火时间为20 min,然后用以上较佳腐蚀工艺对其进行腐蚀,腐蚀结果如图5所示,并将其与未经退火的原始样品在此腐蚀方法下(图2(b))进行比较,观察其位错蚀坑的变化情况。

图5 经1000℃退火的未辐照的SiC样品的腐蚀形貌
经过比较可见,未辐照的原始样品位错分布较密,且不均匀,说明样品本身就存在一定的缺陷(图2 (b))。经1000℃退火后,位错蚀坑数目与原始样品相比有所减少,但不明显,说明通过退火可适当消除SiC中的固有缺陷(图5)。
采用较佳腐蚀工艺对辐照后的SiC样品进行腐蚀后的位错蚀坑如图6所示。与未辐照原始样品的腐蚀(图2(b))相比,辐照后样品的位错蚀坑的密度明显增加,说明辐照对样品造成严重的损伤,在其中产生了大量缺陷,导致位错蚀坑的数目明显增加。

图6 辐照后的SiC晶片的腐蚀形貌
对辐照后的SiC样品分别在700、1000、1200℃时退火20 min,然后采用较佳腐蚀工艺对其进行腐蚀,腐蚀后位错蚀坑的分布如图7所示。因700℃退火的样品只有其他2块样品的一半,为能在显微镜中有同样大的视场而便于观察,将其放大倍数提高到其他样品放大倍数的2倍。对图6、7对比可知,经700℃退火的样品(图7(a))比辐照未退火的样品(图6)蚀坑数目有所减少。进一步提高退火温度,蚀坑数目减少更加明显。当退火到1200℃时(图7(c)),样品中的蚀坑密度与未辐照的原始样品的蚀坑密度几乎相等。这说明辐照后产生的大量缺陷,经退火后能得到有效地消除,且在高温退火阶段,其消除更加明显。
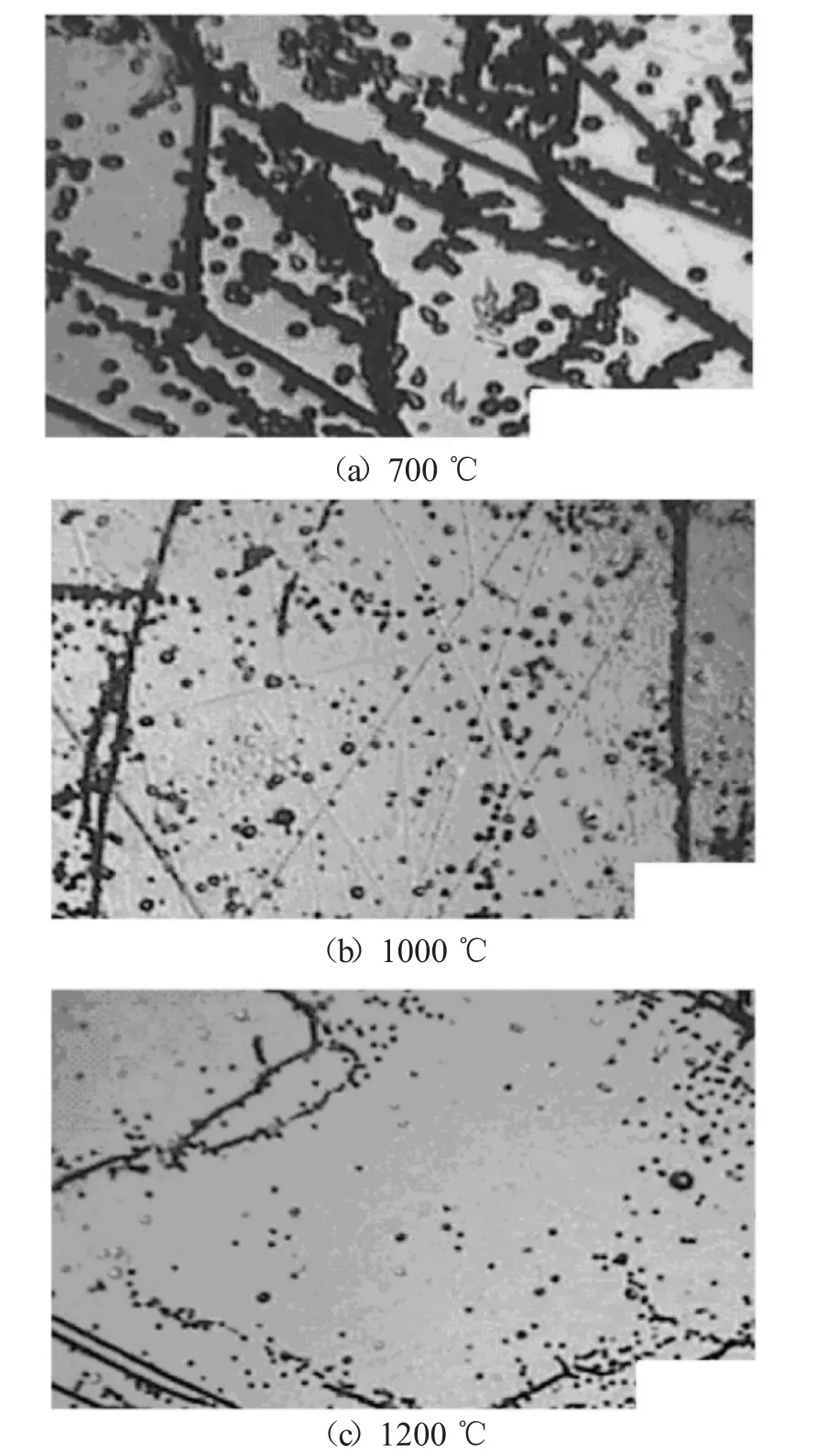
图7 经不同温度退火后的辐照SiC晶片的腐蚀形貌
5 F-θ曲线与位错密度的关系
为了能数值化给出位错密度的变化情况,用Image-Proplus图像处理软件进行定量分析。分析中采用了文献[7]给出的1个适合于计算机图像分析的软件计算位错密度的公式,即

式中:ρ为位错密度;Ad为位错面积;A为总测量面积;a为位错衍射像的宽度;t为样品厚度。
对于试验,a和t可视为常量,且相等,因此,ρ的变化取决于位错面积比(Ad/A)。对图2(b)、5、6、7的分析结果见表1,将未辐照原始样品与辐照样品的位错面积比随退火温度的变化绘制成曲线图,如图8所示。

表1 SiC晶片在不同条件下的Ad/A
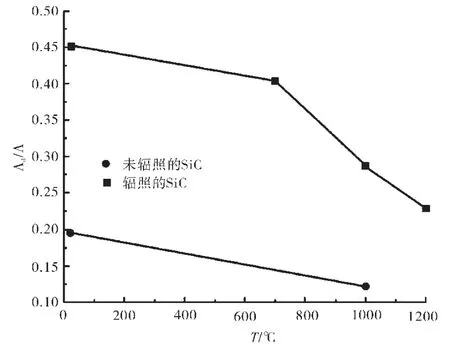
图8 SiC晶片的Ad/A随退火温度的变化曲线
从图8中可见,辐照后样品的位错面积比比原始样品的明显变大,说明辐照导致样品产生了大量的位错[8]垛层错、位错等,即导致晶体中的固有缺陷增多,晶体的固有缺陷在辐照的过程中可起到“钉扎”作用,使晶体易于产生长程缺陷(如位错)。而经退火以后,未辐照样品的位错面积比变化较小,而辐照样品的位错面积比变化很明显,且呈现2个阶段(20~700℃和700~1200℃),说明辐照样品经退火消除的缺陷主要是由辐照引起的位错。可见,经辐照产生的位错开始消除的温度点在700℃左右。在退火温度低于700℃时的位错面积比变化很小,表明此时可能只是一些辐照引起的Frenkel缺陷对 (近距离的间隙原子和空位对)的复合[9],而位错无明显恢复。在退火温度高于700℃时,点缺陷获得更高的动能,扩散更加剧烈,从而不断地被作为点缺陷尾闾的位错所俘获,使位错开始攀移[10],当正、负位错(即相向攀移的2列位错)相遇时发生相互作用而消失,因此,这一阶段位错密度的降低表现极为明显。
位错密度的这种变化趋势与经辐照的SiC晶体XRD峰的WFHM随退火温度变化曲线很相似。XRD峰的WFHM反映了晶体晶格的有序度,有序度越高,WFHM越小。而在不同的退火阶段伴随着不同的缺陷恢复,在退火温度低于700℃时,由于位错密度基本保持不变,只是简单点缺陷的恢复,其恢复并不能引起晶格结构弛豫明显变化,从而不能提高晶格有序度,因此XRD峰的WFHM基本保持不变,高于700℃以后,作为长程缺陷的位错开始相互作用,并大量减少,其恢复导致晶格结构弛豫明显减小,从而提高了样品晶格排列的有序度,XRD峰的WFHM逐渐变小。因此,WFHM所表现的恢复规律的微观机理就是辐照产生的位错在高温退火阶段的消除(图1)。然而,辐照后位错密度的变化趋势与XRD峰的WFHM的变化趋势并不完全一致,说明位错变化只是XRD峰的WFHM变化的一个重要因素,而其他可能因素(如点缺陷,空洞等)的作用,还需要进一步研究。
6 结论
通过对辐照前、辐照后及辐照后退火的样品的腐蚀和位错蚀坑的观测,以及位错面积比的定量分析,揭示了XRD峰的WFHM随退火温度的规律性恢复,说明经辐照的SiC晶体中所产生的位错可能是导致XRD峰的WFHM变化的1个重要因素。
通过对辐照的SiC晶体退火特性研究得出:辐照SiC晶体后,其XRD峰的WFHM增大,经不同温度退火后,半高宽随退火温度的升高呈线性下降的趋势。本项目研究通过试验验证,证明了该晶体测温方法可行,具有广阔应用前景。
[1]林宏军.喷嘴匹配方案及火焰筒开孔对燃烧室性能影响的试验研究[J].航空发动机,2012,38(5):13-17. LIN Hongjun.Effect of nozzle matching and flame tube holes on combustion performance[J].Aeroengine,2012,38(5):13-17. (in Chinese)
[2]郭常霖.α-SiC晶体中的位错 [J].物理学报,1982,31(11): 1511-1525. GUO Changlin.Dislocatios in α-SiC single crystal[J].Acta Physica Sinica 1982,31(11):1511-1525.(in Chinese)
[3]郭常霖.β-SiC外延层中晶体缺陷的观察 [J].物理学报, 1982,31(11):1526-1533. GUO Changlin.Observation of defects in β-SiC epitaxial film [J].Acta Physica Sinica,1982,31(11):1526-1533.(in Chinese)
[4]Siche D,Klimm D,Hölzel T,et al.Reproducible defect etching of SiC single crystals[J].Journal of Crystal Growth,2004,270: 1-6.
[5]杨莺,陈治明.湿法腐蚀工艺研究碳化硅晶体缺陷表面形貌[J].人工晶体学报,2008,37(3):634-638. YANG Ying,CHEN Zhiming.Defect characterization of SiC by wet etching process[J].Journal of Synthetic Crystals,2008,37 (3):634-638.(in Chinese)
[6]刘忠良,康朝阳,唐军,等.衬底温度对Al2O3(0001)表面外延6H-SiC薄膜的影响[J].硅酸盐学报,2011,39(2):306-311. LIU Zhongliang,KANG Zhaoyang,TANG Jun,et al.Effect of substrate temperature on the growth of 6H-SiC thin films on Al2O3(0001)surface[J].Journal of the Chinese Ceramic Society, 2011,39(2):306-311.(in Chinese)
[7]赵敬世.自动图像分析中计算位错密度的一个公式[J].物理测试,1992(3):55-57. ZHAO Jingshi.A formula for calculating dislocation density in automatic image analysis[J].Physics Examination and Testing, 1992(3):55-57.(in Chinese)
[8]Sakwe S A,Stochmeier M,Hens P,et al.Bulk growth of SiC-review on advances of SiC vapor growth for improved doping and systematic study on dislocation evolution[J]. Physica Status Solidi,2008,245(7):1239-1256.
[9]Sawabe T,Akiyyoshi M,Ichikawa K,et al.Microstructure of heavily neutron-irradiated SiC after annealing up to 1500℃[J].Journal of Nuclear MaterialsJ Nucl Mater,2009(1):333-337,386-388.
[10]Heera V,Prokert F,Schell N,et al.Density and structural changesin SiC afteramorphization and annealing[J]. Application Physica Lett,1997,70(26):3531-3533.
Research on Crystals Annealing Characteristic for Areoengine Temperature Measurement
ZHANG Xing,ZHANG Zhi-xue,XUE Xiu-sheng,ZHANG Yu-peng,ZHAO Ying-song
(AVIC Shenyang Engine Design and Research Institute,Shenyang 110015,China)
Aiming at the technology difficulty of high temperature measurement of areoengine key component,a new thermometry using crystals as sensors was studied.The crystal annealing characteristic and the method of observing defects were described.The annealing characteristic of SiC crystals was analyzed by X-Ray Diffraction (XRD).It was found that post-irradiation the Full Width at Half Maximum (FWHM)of the XRD peaks was increased and with increasing of the annealing temperature a linear law recovery was shown at the range of 700-1230℃.A novel temperature measurement technique for the measuring of high temperature and complicated temperature field were developed based on the law.Moreover,the dislocation erosion for the irradiation,post-irradiation SiC crystals anneal were investigated using KOH added K2CO3as a chemical etchant.The results show that the change trends of dislocation area ratio in neutron irradiated with the annealing temperature is agreed with that of FWHM.The dislocations induced by neutron irradiation could be one of important factors for the changes of FWHM of XRD peaks.
temperature measurement;crystal;annealing;defect;FWHM;aeroengine

张兴(1955年),男,高级工程师,从事航空发动机测试研究工作。
2013-03-20

