0.8 μm多晶栅等离子刻蚀研究
王春栋,李幸和,顾爱军,赵金茹,刘国柱
(无锡中微晶园电子有限公司,江苏 无锡 214035)
1 引言
随着CMOS集成电路的发展,特征尺寸已从微米级发展到现在的90nm,而决定特征尺寸的是多晶栅,所以在半导体器件的制造中,多晶栅刻蚀是最关键工序之一。在当今流行的MOS器件中,作为介电材料的多晶栅是由LPCVD掺杂生长的。但多晶硅是较难刻蚀的结构,它必须对下层的栅氧化层有高的选择比并有非常好的均匀性,同时多晶栅的侧面倾斜角度必须控制在合理范围内。首先过刻蚀会导致栅氧化层击穿,需要刻蚀的高度各向异性;其次多晶硅栅的宽度决定着器件有效沟道的长度,所以要将倾斜的角度严格控制在合理的范围内。本文主要采用DOE正交实验来研究多晶栅刻蚀的最优化条件,研究多晶栅刻蚀中各种因素对刻蚀效果的影响。
2 实验
本文采用Precision 5000设备刻蚀多晶,主刻蚀步骤(ME)采用终点检测系统来控制,当SiO2刚好露出来,多晶便停止刻蚀。理想情况下,要腐蚀的薄膜厚度和腐蚀速率均是完全均匀的,并不需要过刻蚀步骤(OE),所以相对于衬底的选择比也就不用考虑了。实际工艺中这种理想状态是不存在的,由于电路中的暴露面积不一样很容易出现负载效应,过腐蚀步骤总是需要的,所以刻蚀过程中多晶相对于SiO2的选择比必须足够大,以避免底层的氧化物被完全刻蚀,避免Si衬底受到刻蚀。
实验片为干净的光硅片,首先氧化生长17.5nm SiO2,然后用LPCVD设备生长350nm多晶,再对多晶进行掺杂,控制方块电阻为23Ω·□-1±3Ω·□-1,最后再对多晶进行光刻、曝光、显影形成电路图形。
刻蚀过程分四步:第一步(STB),稳定,时间10s,压力为13.33Pa,气体CF4为25scc,磁场为0Gass;第二步(BT),击穿,时间60s,压力为13.33Pa,气体CF4为25scc,磁场为0Gass,功率为300W;第三步(ME),主刻蚀,刻蚀时间需要终点系统自动找终点,磁场为30Gass,压力、HBr 流量、Cl2流量、功率为采用DOE实验进行设计(见表1);第四步(OE),过刻蚀,时间25s,压力为13.33Pa,气体HBr为 30scc,Cl2为 20scc,He+O2为 10scc,功率为150W,由于刻蚀过程主要在主刻蚀完成,所以本文主要考察主刻蚀中功率、压力、HBr流量、Cl2流量对多晶刻蚀效果的影响,本文运用Mintab软件进行实验设计,这里采用4因子2水平的正交实验。

3 结果与讨论
实验主要考察等离子体刻蚀中的功率、压力、HBr流量、Cl2流量对多晶条刻蚀效果的影响。本文中主要考察多晶条倾斜角度(需要同时考虑孤立条跟密集条,如图1)及刻蚀后的表面形貌,是否“打毛”(即是否把栅氧层完全刻蚀掉)。图2中展示的是DOE实验采用Precision 5000等离子刻蚀后的剖面角度,从图2中我们可以明显地看到当DOE实验中的各参数组合不一样时,剖面倾斜角度剧烈的变化,从70.2°变化到92.2°。但是CMOS器件中多晶条的侧壁倾斜角度既不能太大也不能太小,倾斜角度太小时多晶条的实际宽度将比设计值偏大,即有效沟道长度变宽,IDS比理论值偏小。侧壁倾斜角度太大(角度超过90°),即负角效应,此时与栅氧化接触的多晶栅长度将比理论值小,即有效沟道长度变短,导致IDS比实际设计值大。如果负角比较大,浅注入的离子扩散之后可能没法达到多晶栅的边缘,就将导致沟道电流IDS显著变小,甚至电流无法导通,导致器件完全失效。图2中同时给出了芯片中间孤立多晶条两侧的侧壁倾斜角度,可以发现左右两边侧壁并没有理想的那样对称,还是存在一定的偏差。为了更方便比较实验数据,图3中展示了DOE实验中间跟边缘孤立多晶条及密集多晶条左侧倾斜角度,从图3中可以看出同样条件下密集条的倾斜角度要比孤立条的倾斜角度大些,这与刻蚀的负载效应有关。

图4为DOE正交实验多晶刻蚀速率图,图中可以明显看到由于等离子刻蚀过程中功率、压力、HBr流量、Cl2流量的不同,刻蚀速率变化剧烈。从3.888nm/s(功率200W,压力19.99Pa,HBr流量20Sccm,Cl2流量40Sccm)变化到8.75nm/s(功率400W,压力19.99Pa,HBr流量40Sccm,Cl2流量40Sccm)。刻蚀速率变化幅度将近两倍多。

图5为DOE正交实验各因子效应的pareto图,Pareto图中列出了软件拟合的各因子及因子的交叉作用对刻蚀效果的影响。在采用Mintab软件分析时,本文中Alpha采用0.4。从图中可以明显看到只有B因子超过临界线(即图中的虚线),此即表明等离子刻蚀中压力对多晶条刻蚀效果影响最大。
图6为DOE实验四个因子对多晶条倾斜角度影响的主效应图,其中纵坐标为输出力矩,横坐标为所设计实验的各因子水平,主效应图中的倾斜度越大则表明符合水准的效果越大,即对刻蚀效果的影响最大。从图中可以明显看出,当压力从6.665Pa上升到19.99Pa时多晶条的Angle值从81°迅速增加到89.5°,而RF、Cl2流量、HBr流量变化时曲线的斜率相对较平缓些,其中HBr流量的变化最为平缓,这也从另外一个方面说明四个因子中压力对多晶条的Angle影响最大,而HBr对多晶条Angle的影响最小。

图7为DOE正交实验各因子的影响效果正态分布图,图中的点可认为信号因子,从图中可以看出B因子刻蚀时(压力)对多晶体的倾斜角度的影响最显著,对其效果的影响达到90%以上,而其他因子对倾斜角度的影响均不明显(在分界线以下)。
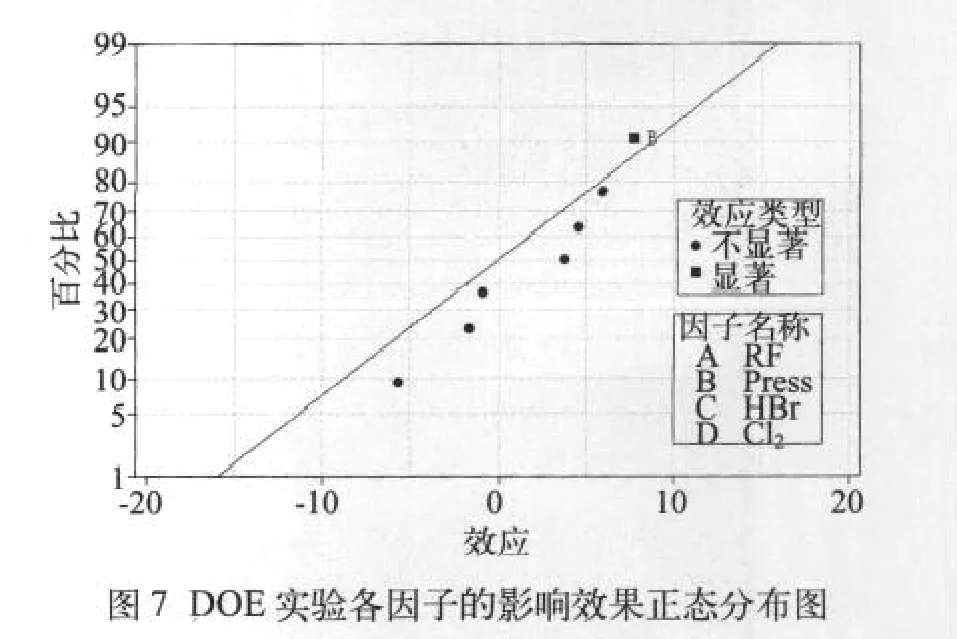
图8为DOE正交实验多晶刻蚀Mintab软件分析给出的最优条件筛选图,其多晶条剖面倾斜角度最优条件为:功率396W,压力9.464Pa,HBr流量20Sccm,Cl2流量40Sccm。这里的最优条件主要以多晶条Angle=84°作为目标值。以图8 Mintab软件给出的最优条件作为实验条件。获得实验结果为:最优化条件下的多晶刻蚀速率为437.6nm;中间孤立多晶条侧壁倾斜角度为84.8°。
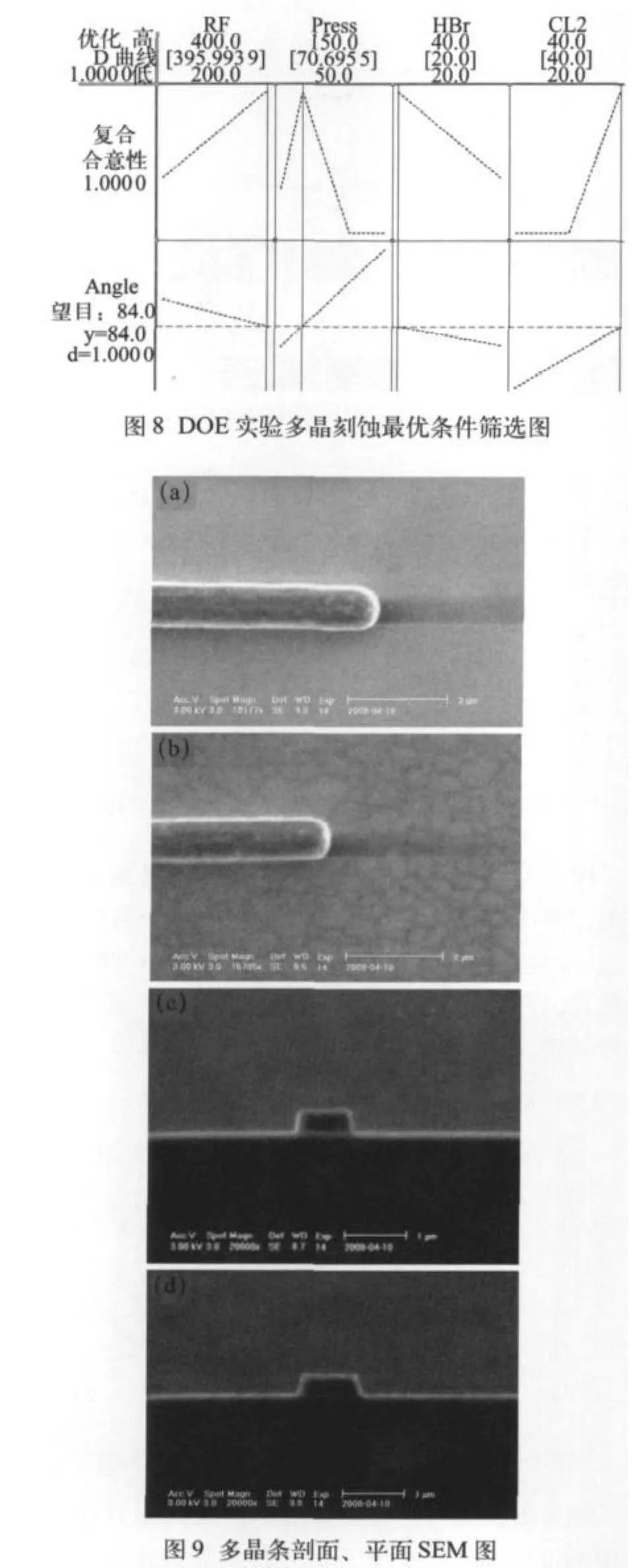
图9展示了采用Mintab 软件获得的DOE实验最优化条件做出的结果。图9(a)、(c)为根据最优化条件等离子刻蚀后的多晶条的表面及剖面SEM形貌图。为了与随机的条件进行比较,我们也给出了DOE第六组实验(功率400W,压力6665Pa,HBr流量40Sccm,Cl2流量20Sccm)中多晶条剖面及表面SEM图。从图9(a)中我们可以明显看出采用最优化条件获得的多晶条表面形貌规则,并且多晶条下面的栅氧层正常,而采用DOE第六组实验参数刻蚀之后,表面有明显的打毛现象,如图9(b)。这说明多晶条下面的栅氧层已经被刻蚀掉,并且硅衬底也有一定程度的刻蚀,这将严重影响器件的性能。图9(c)给出了最优化条件下的剖面SEM图,测试结果为多晶条的倾斜角度为84.8°,而图9(d)给出的多晶条的角度只有70°,这将导致有效沟道长度明显比理论值大,同时从图9(d)中可以看到一些表面小坑,这也验证了图9(b)中的打毛现象。
4 结论
本文基于Mintab软件运用DOE实验研究了等离子体刻蚀的不同条件对多晶栅刻蚀效果的影响。通过实验比较及Mintab软件分析发现等离子刻蚀中压力对多晶条的刻蚀影响最大,其次按顺序分别是功率、Cl2流量、HBr。同时运用Mintab软件对实验数据分析还获得了多晶条等离子刻蚀的最优化条件,运用该优化条件刻蚀的多晶条倾斜角度、表面形貌均能达到CMOS制造的要求。本文对半导体器件中多晶刻蚀工艺开发具有一定的参考价值。
[1]Wang Chundong, Teng Baohua, Zhang Xianjun, et al.Phase transition properties of ferroelectric thin film with one distinct inserting-layer [J].Mod Phys.Lett.B, 2008, 22(31):3 099-3 111.
[2]Anderson B L, Anderson R L.Fundamentals of Semiconductor Devices [M].New York : MC Graw-Hill, 2005.
[3]Tsividis Y.Operation and Modeling of the MOS Transistor[M].New York: MC Graw-Hill, 1999.
[4]崔铮.微纳米加工技术及其应用[M].北京:高等教育出版社,2005.

