In0.52Al0.48As/InP 的正向和反向异质结在带隙附近的不同光谱现象*
吴洋 胡晓 刘博文 顾溢† 查访星‡
1)(上海大学物理系,上海 200444)
2)(中国科学院上海技术物理研究所,上海 200083)
1 引言
In1–xAlxAs/InP 是应用人工半导体生长技术构建电子和光电子器件的重要结构之一.尤其是晶格匹配的In0.52Al0.48As/InP 异质结被广泛应用于构建红外和太赫兹器件、量子级联激光器、单电子雪崩二极管以及高电子迁移率晶体管(HEMTs)等[1–5].众所周知,异质结界面结构及其电子性质对器件性能有着至关重要的影响.InAlAs/InP 异质结界面性质一直是长期受到关注且比较复杂的材料生长和器件物理问题[6].例如异质结的外延生长中常常伴随着界面处As/P 原子的交换和In,As原子的自聚团簇效应,这导致其界面光谱现象具有复杂性而其产生机制也有不同的观点[7–17].
在InAlAs/InP 的界面研究中,一个引起较多关注的现象是InP 衬底或缓冲层上生长InAlAs形成的所谓正向生长异质结构和在InAlAs 外延层上生长InP 形成的反向异质结构的差异性问题.InAlAs/InP 理论上被认为属于II 型异质结,不过其界面发光现象并不具备典型的II 型异质结发光特征[9–11].对于典型II 型异质结而言,由于其电子和空穴分别束缚在界面两侧,光生载流子注入会诱导较强界面电场效应,从而引起界面势阱能级明显抬升,导致随着激发增强发光峰位出现明显蓝移的现象,但InAlAs/InP 的界面发光现象则未呈现上述特征[9–11].有关于In0.52Al0.48As/InP 光致发光研究的文献观察到,生长条件的调控会导致界面处形成几个原子层厚的InAs 势阱或InAlP 势垒层[9–11].近年来关于InAlAs/InP 的界面研究揭示反向生长界面实际是In/As/P 组分渐变的势阱结构模型[14–17].
迄今关于InAlAs/InP 异质结的界面性质的认识大多来自光致发光(PL)实验.很多实验都表明,界面二维电子气对其光学性质有着不可忽视的影响.众所周知,具有高载流子浓度、高迁移率的界面二维电子气(2DEG)对半导体电学性质有着极其敏感的影响.光电导谱(PC)是将光激发和载流子输运特性紧密结合的表征手段[18],将不同方法结合起来有助于对界面光谱特征的起源获得更明确的认识.我们注意到迄今PC 关于InAlAs/InP异质结界面电子性质的研究工作尚不多见.本工作应用PC 研究了InAlAs/InP 正向和反向异质结,发现二者呈现很大不同,其差异反映了二者明显不同的界面电子结构性质.通过结合PL 谱测量并与PC 数据比较分析,阐明反向异质结所呈现的近InP 带边的916 nm 发光峰起源于界面电子与价带空穴的复合发光.
2 实验
实验使用的两组InAlAs/InP 异质结样品均是采用分子束外延法(MBE)技术在InP(100)衬底上生长的.第一组样品(样品A)是在InP 衬底上直接生长了2 μm 厚的In0.52Al0.48As 层,它与衬底形成单一的正向生长异质结,记为In0.52Al0.48As/InP.另一组样品(样品B)是在上面样品的基础上进而生长2 μm 厚InP 覆盖层形成的InP/In0.52Al0.48As/InP 双异质结样品,其中上异质结相对于前一种结构被称为反向异质结.由于样品B 外延层较厚,从本工作的测量结果可看到,样品B 界面光学性质主要由反向异质结主导.
对于进行光电导实验的样品,采用电子束蒸发Ge/Ni/Au 在样品表面形成欧姆接触的金属电极.PC 和PL 实验时将样品置于液氮温度的低温杜瓦内.光谱测量使用的是Zolix-λ3017 光栅光谱仪.图1 给出了光电导谱测量光路示意图.实验使用的白光光源是150 W 溴钨灯.经光栅光谱仪分光后的单色光通过平行光管准直和凸透镜调节形成在样品表面覆盖于两电极区域的光斑.如图1 的内插图所示,样品与一固定电阻R0(10 kΩ)和一3 V 直流电源串联形成闭合回路.样品受到光照其电阻RX发生改变,对应的样品电导率的变化是通过测量样品端电压的变化直接来反映的.该电压测量是通过引出电极将电压信号输出到锁相放大器(Stanford SR830)并配合入射光路上的斩波器实现的.PL 使用852 nm 半导体激光器作为激发光源.该激发光只对InP 激发带带跃迁而不激发InAlAs 层,故激发光对于样品A 能有效穿透表层而对界面和下面的InP 进行有效激发.PL 采用低温制冷InGaAs 探测器.PL 光谱实验同样使用了SR830 锁相放大器并配合斩波器进行发光信号的采集.

图1 光电导谱实验光路图.内插图示意性给出光电导信号取样电路Fig.1.The setup of photoconductive (PC) spectroscopy experiment.The inset is the schematic plot of electric circuit of sampling the PC signal.
3 结果与讨论
图2(a)和图2(b)分别给出的是正向异质结(样品A)和反向异质结(样品B)在液氮温度下的光电谱实验测量结果.实验采用光从样品上表面入射的构型,如图2(c)所示.对于图2(b)所呈现的表层为InP 覆盖层(样品B)的光电导谱主要特征,很容易从通常的半导体带带跃迁物理图像来解释,即光子能量大于表层InP 的带隙时激发光被InP层所吸收,因此激发的光生载流子会使InP 层电导骤增,而出现光电导谱在InP 带边(约1.41 eV)附近阶跃式变化[18,19].

图2 InAlAs/InP 的正向结构(Sample A)(a)和双异质结构(Sample B)(b)的PC 实验结果; (c) 测量构型Fig.2.The PC measurement results of the normal heterostructure (Sample A) (a) and double heterostructure(Sample B)(b) of InAlAs/InP; (c) the schematic of measurement configuration.
图2(b)呈现的样品B 在InP 带边附近的光电导现象同样在样品A 的PC 谱测量中得以呈现.如图2(a)所示,当激发光子能量小于表层InAlAs带隙而大于InP 带隙时,激发光则主要引起InP层光生载流子增加,而在InP 带边附近观察到与图2(b) PC 谱呈现的阶跃变化.然而,图2(a)和图2(b)展示的阶跃变化的光谱范围有所差异.两谱中阶跃起始点拐点能量均对应于InP 的带隙(1.41 eV),而结束拐点能量分别在1.373 eV (样品A)和1.360 eV (样品B).样品B 的能量展宽机制将在后文做进一步讨论.容易注意到的是,图2(a)中在表层InAlAs 带边(约1.52 eV[18])附近,在光子能量小于InAlAs 带隙时有一电导率的骤然上升过程,该现象看起来和前面关于InP 附近光电导阶跃变化的产生机制似乎是矛盾的.因为样品A 表层是InAlAs,当光子能量从大到小(波长从小到大)扫过其能带带边时应观察到与类似图2(b)的随波长变小(能量变大)电导信号阶跃式下降的结果; 然而实际情况却是如图2(a)所展示的相反的情形.
要解释上述看似反常的光电导谱现象,应考虑到所测量的样品为半导体多层异质结构.尽管光电导采用的是图2(c)所示的电极与样品表层接触的测量构型,光电导响应不仅来自表层,还有界面层和下层体材料的电导贡献.图2(a)和图2(b)虽然都在InP 带边附近具有相同的光电导变化规律,但注意到图2(a)中的样品InP 并不处于表层,这说明表层之下的其他外延层的光电导响应对测量结果的贡献是不可忽视的.已有文献研究表明,半导体多层异质结构的光电导还要计入界面二维电子气(2DEG)等多层结构因素对电导的贡献[20].因此对于图2(c)所示结构,样品A 光电导信号可以写为
基于上述多层结构的光电导机制,则对于前述样品A 在InAlAs 带边附近的反常光电导谱现象可给出如下解释.由于原生态外延生长的InAlAs一般存在着较多缺陷[21,22],它们成为光生载流子的俘获或散射中心,使得InAlAs 层的光电导贡献明显被抑制,即(1)式中第一项对光电导的贡献相就远不如后面两项来得重要.另一方面,当光子能量由低到高变化扫过InAlAs 带边时,却因InAlAs层对大于其带隙光子的吸收使得对InP 层光激发产生突然的阻断效应,导致(1)式其他两项光电导贡献骤降.所以,表层InAlAs 尽管会因带带跃迁光吸收而能使该层电导有所增强,但相对于InAlAs 层光吸收引起的下层界面和InP 层光电导的下降却为小量,这样总的电导率在InAlAs 带边附近就产生如图1(b)所示的阶跃式下降现象.
另外如图2(a)所示,样品A 在低于InP 带边能量为900—1000 nm 的区间有一肩峰结构.同样的光谱范围,样品B 的光电导信号则很不明显,尤其是样品A 在916 nm 出现明显的小峰结构并未在图2(b)给出的样品B 的PC 谱中呈现.关于此小峰的起源,或有人认为它来自外延层中的缺陷能级.但是如果它起源于InP 的体缺陷,却未在样品B 中探测到,况且样品B 中InP 是样品表层.如果它起源于InAlAs 层缺陷,由于916 nm 光子能量小于InP 带隙,即 InP 覆盖层对于该光子能量是透明的,因此它对InAlAs 层的电导影响应被探测到.事实上该信号仅发生在样品A 的PC 谱中,说明其起源应从样品A 与样品B 结构差异来分析.而这个差异性存在于两样品界面结构的不同.迄今关于InAlAs/InP 异质结认为确实存在着正向界面和反向界面结构的不同[8–11],它是由两类界面生长时发生的In-As-P 原子的不同扩散机制所导致.结合现有文献关于InAlAs/InP 正向界面和反向界面电子结构的描述[7–14,16],在图3 中示意性地绘出样品A 和样品B 的能带图,分别如图3(a)和图3(b)所示.其中图3(b)反映出界面处As/P原子互扩散形成了As-P 组分阶梯型渐变的界面过渡层.

图3 (a) InAlAs/InP 正向界面结构和(b) InP/InAlAs/InP双异质界面结构能带图Fig.3.The energy band diagrams of (a) InAlAs/InP heterostructure with the normal interface and (b) InP/InAlAs/InP double heterostructure.
基于上述界面电子结构,对于InAlAs/InP 在InP 带边附近的发光过程,可以总结为如图3(a)和图3(b)所示的几类情形: ①带带跃迁; ②导带-带间受主态复合; ③ 2DEG 与价带空穴复合;④ 2DEG 与界面束缚空穴以及2DEG 界面缺陷态的复合.为了对前面给出的PC 光谱结果进行进一步的理解和分析,对样品A 和B 还分别进行了77 K 温度下的PL 光谱测量.PL 采用852 nm 波长激光激发.由于该波长能量介于InAlAs 和InP带隙之间,故它只激发InP 层而不激发InAlAs 层.参考关于In0.52Al0.48As/InP 已有的PL 研究文献报道,上述情形④所描述的发光现象的光谱范围一般处于1000—1500 nm 范围,而且发光强度比上述过程①—③要弱近2 个数量级,也未在PC 谱上观察到对应光跃迁过程.关于此发光过程相关的PL 谱特征和详细分析,将另文专门报道阐述.本文主要关注850—1000 nm 范围的与PC 谱具有直接对应关系的发光现象.
图4 分别给出了样品A (蓝色谱线)和样品B(红色谱线)在850—1000 nm 范围的PL 测量结果.激光激发功率为7 mW.可以看到,样品A 和B 均有对应于InP 带带跃迁(880 nm)的发光峰,不过样品B 的发光强度要远大于样品A,其机制我们稍后具体阐述.首先注意到,样品A 在916 nm 处出现了很强的发光峰,其发光强度要明显大于同一样品880 nm 处发光峰; 其次,比较样品A 与样品B 的880 nm 发光峰,我们看到样品A 的发光峰强度要明显弱很多.另外,样品B 则在904 nm 处还出现一小的肩峰结构.关于带边附近的904 nm 发光峰,文献中认为来源于InP 材料中导带电子与价带边阳离子受主的复合[9].该结构在样品A 的PL 谱并未呈现,可能是如下原因: 因904 nm 发光来自InP 层的体缺陷,对A 样品而言,表面下的InP 发光需透过界面被探测.因A 样品存在能量较低的界面能级(如916 nm 发光能级),则较短波长光子透过界面时会被吸收; 又因904 nm 发光强度本来很弱,还有界面反射损耗因素的影响,所以该发光在样品A 的PL 谱中难以呈现.
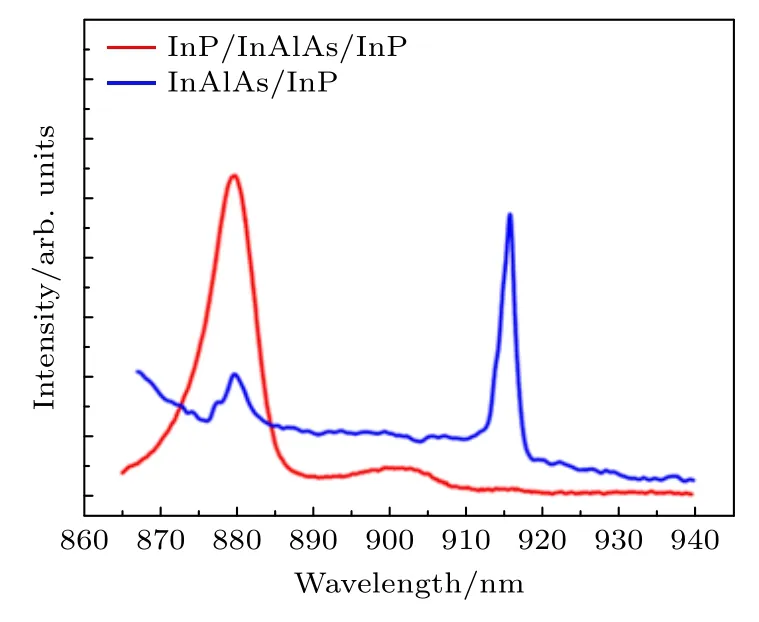
图4 正向异质结样品和双异质结样品的77 K 光致发光谱Fig.4.The PL spectra of normal heterostructure and double heterostructure samples measured at 77 K.
在半导体异质结界面2DEG 参与的发光中,除了上文指出的它与界面束缚空穴以及2DEG 界面缺陷态的复合发光之外,还存在着界面2DEG与同侧半导体(此处为InP)价带空穴的复合发光过程,即图3 所示的过程③,类似发光过程在其他半导体异质结如GaN/AlGaN 结构的研究中同样存在[23].该发光能量一般低于导带-价带跃迁复合能量,在图4 中对于正向异质结样品A 所观察到的916 nm 发光可归因于这一机制.
对于样品A 所观察到的上述能量发光,为何在样品B 的PL 谱上未呈现呢? 这个问题可作如下解释: 对于InP 带边附近来自界面2DEG 和界面处价带空穴的复合发光,发光能量受到界面能带弯曲产生的束缚势阱深度的影响.样品B 的反向界面通常被认为具有In-As-P 组分渐变的结构特征[7,14–16],该组分变化不仅可引入能量分布较宽的带尾态,而且较之正向界面,它对界面电子形成较弱的势阱束缚,其激发态束缚能级更接近体材料导带底,导致界面电子与价带空穴的复合能量趋近带带跃迁.二者叠加会使得880 nm 波长发光明显增强.另外,较浅的束缚势阱使得2DEG 电子波函数向体内更加扩展,可使与价带空穴复合发光的振子强度显著增大.综合这上述因素,可以说明图4 中样品B 比样品A 的880 nm 发光峰的明显增强以及同时展现较大的半峰宽.此外,上述物理图像对于前面提到的图2(a)和图2(b) InP 带边附近光电导下降沿的不同展宽也给出了自洽的解释.后者显示能量展宽有13 meV 的增幅,可认为来自带尾态及能量与之接近的2DEG 的混合产生的.对于正向结构,2DEG 势阱能级与较窄的InP 带尾态有明显的能量分离,而由前者导致的带边下降沿就比反向异质结情形变窄了.
4 结论
综上所述,本工作应用PC 和PL 谱对In0.52Al0.48As/InP 和InP/In0.52Al0.48As/InP 两种异质结构在低温下进行了表征.观察到In0.52Al0.48As/InP 反向异质结样品在光子能量大于In0.52Al0.48As带隙时电导率下降的反常现象,需从光照对多层结构光电导影响的角度对上述现象进行解释.另外,正向结构的PC 谱测量观察到的916 nm 电导峰,且对应此波长在PL 谱也产生很强的发光峰.该光谱归因于界面势阱能级与InP 价带空穴的复合发光.该光谱结构却未在出现于反向异质结样品,暗示了后者不同的界面特性; 可基于反向界面的In-As-P 组分渐变的结构模型来理解.该界面特点是很大程度上降低了界面能带弯曲效应,使得界面2DEG 界面约束效应减弱而能量上也更接近体的带带跃迁复合能.本工作PC 和PL 相互参照的表征分析也为界面光谱结构的澄清提供了有效的研究方法.
感谢韩超同学对部分实验测量工作给予的帮助.

