非晶铟镓锌氧化物薄膜晶体管制备工艺及性能研究
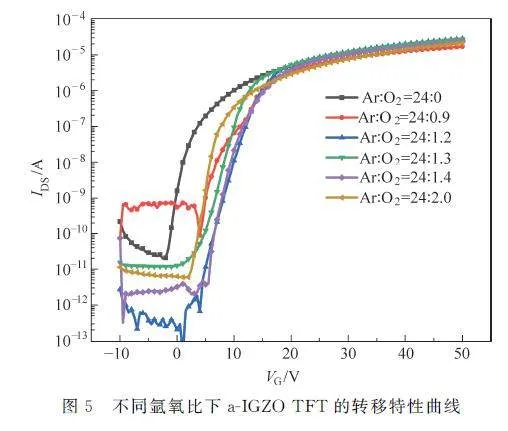
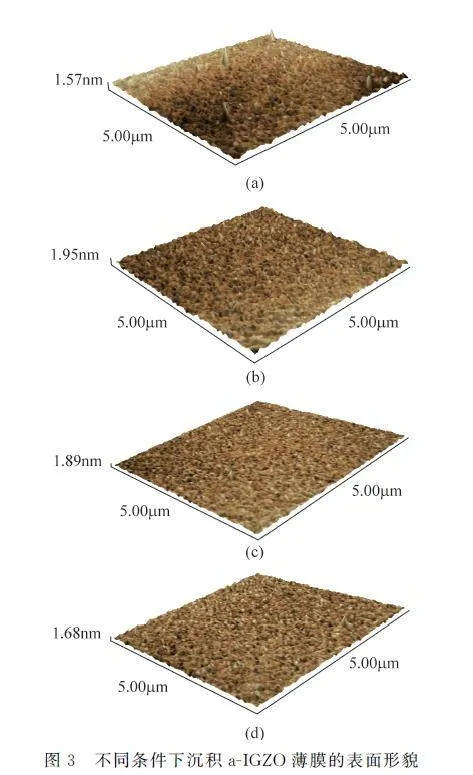
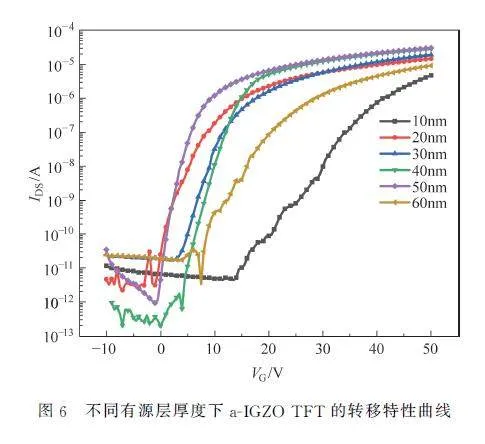


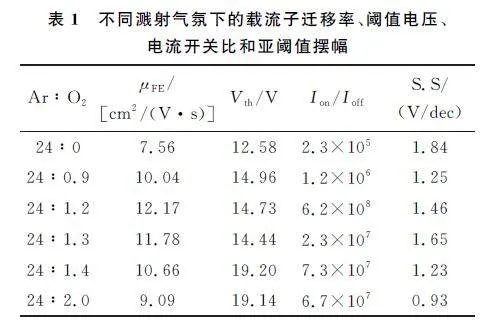

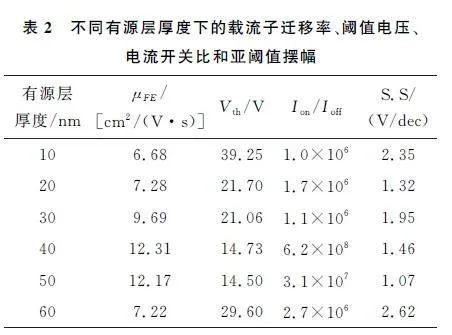

摘 要 本文介绍了利用射频磁控溅射技术在氧化硅衬底上制备非晶氧化铟镓锌(a-IGZO)薄膜,对溅射的薄膜进行了不同条件下的特性分析,制备成a-IGZO 薄膜晶体管(a-IGZOTFT),并分别研究了溅射气氛、有源层厚度和退火工艺对器件电学性能的影响。实验表明,当使用50W 的溅射功率时,溅射过程中补充氧气,可以填补材料的深能级氧空位缺陷,提高了器件性能。但氧气浓度过大也会造成吸附氧等受主缺陷增多,更易发生载流子的散射,实验中采用氩氧比为Ar∶O2=24∶1.2的条件器件性能较好。其次,当有源层厚度控制在40~50nm 时,器件性能较好,且40nm 的薄膜性质更佳。最后,高温退火工艺可以改善薄膜的缺陷,消除薄膜内部原有应力。相比氮气退火条件,将薄膜在空气下退火可以实现更好的电学特性,将40nm 的薄膜在空气下400℃退火30min,a-IGZO TFT 的性能达到最佳,其迁移率为15.43cm2/(V·s),阈值电压为13.09V,电流开关比为7.3×108,为将来制备晶圆级的高迁移a-IGZO TFT奠定了基础。
关键词 铟镓锌氧化物;薄膜晶体管;磁控溅射;有源层厚度;退火
薄膜晶体管(TFT)是广泛应用于液晶显示器等电子设备的半导体器件,最早可以追溯到1962年,由美国RCA 实验室的Weimer提出[1]。随着液晶显示器的广泛应用,TFT 得到进一步发展和完善。目前,主流的TFT结构通常采用多晶硅或非晶硅作为半导体材料,氧化铟锡或氧化锌等作为透明导电层,同时采用光刻技术精确控制器件的尺寸和性能。虽然工艺相对简单,具有低成本、高制备效率、可控制备等优点,但存在迁移率低、漏电严重、稳定性差等诸多问题[3-6]。
近年来,基于非晶氧化物半导体(AOS)的TFT由于制备温度低、迁移率高、均匀性好等优势受到了学术界和工业界的广泛关注。目前,在各类AOS TFT 中,非晶的铟镓锌氧化物薄膜晶体管(a-IGZO TFT)的研究最为成熟,a-IGZO 是一种新型的n型半导体材料,由氧化铟、氧化镓、氧化锌三种化合物组成,被广泛应用于液晶显示器等领域[7-10]。相比于传统的非晶硅薄膜晶体管,a-IGZO TFT具有更高的电子迁移率、更低的漏电流和良好的透光率,可以提高TFT的开关速度、降低功耗、提高显示器的分辨率和色彩饱和度[11,12]。研究表明,a-IGZO TFT 不仅可以应用于显示领域,而且基于其对光、压力、pH 及气体等参数具有可区分敏感性的优势,在神经形态电子学[13-15]、光学[16-18]、生物[19-21]、气敏[22,23]及压力[24,25]等在内的传感器领域也具有重要的研究和应用意义。
a-IGZO TFT器件的电学性能很大程度上取决于有源层,而薄膜质量与其沉积工艺密切相关,因为不同生长机制的薄膜在结构、化学及电学特性上会存在差异。为了获得具有优异电学性能的a-IGZO TFT,科研人员着手研究a-IGZO 薄膜的沉积工艺对器件电学性能的影响。当前,有源层a-IGZO 薄膜的沉积主要采用溅射沉积[26-28]和溶胶凝胶法[29-31]制备,Choi等人[26]在Si/SiO2 衬底上采用溶胶凝胶法制备了a-IGZO TFT,研究了不同烧结时间下器件电学性能差异,发现器件迁移率会随烧结时间的增加从0.825cm2/(V·s)增加至2.06cm2/(V·s)。Yabuta等人[29]采用射频磁控溅射在室温条件下制备了a-IGZO TFT,研究了溅射气体氛围对器件性能的影响,发现氧分压会影响a-IGZO 的薄膜电导率,实现迁移率为12cm2/(V·s)电流开关比为108 的器件电学性能。由于直接制备出的薄膜质量较差,存在高密度陷阱态,例如空位缺陷、悬挂键等,会导致器件性能较差,所以通常需要300℃以上的热处理以降低陷阱态密度并提升器件电学特性[32-34]。
本文采用射频磁控溅射沉积的方法制备了a-IGZO 薄膜,并在高温下退火后制备成TFT,首先研究了不同的气体氛围、有源层厚度对a-IGZOTFT载流子迁移率、开关比、阈值电压的影响,进一步通过研究不同退火气氛和时间对器件性能的影响,探索出高性能的a-IGZO TFT的制备工艺。
1 a-IGZO TFT制备流程
为了简化制备工艺,a-IGZO TFT 的制造采用背栅顶接触结构,实验具体流程如下:选用硅上氧化硅晶圆片,p型重掺杂硅作为衬底和栅电极,硅上300nm厚的SiO2 作为器件的栅介质层。首先对衬底进行标准清洗,利用光刻机(SUSS MJB)和射频磁控溅射(MSP-300B)沉积IGZO 薄膜,所用的IGZO靶材购自北京晶迈中科材料技术有限公司,成分比为In2O3∶Ga2O3∶ZnO= 1∶1∶1 at%。为了保证薄膜优异的半导体性质,需要在溅射过程中控制氧气比例,沉积气压设置为0.8Pa,沉积功率设置为50W。在a-IGZO 沉积之后,进行热退火处理,最后利用电子束蒸发(Cello Ohmiker50BR),在表面选择性沉积了10nm 厚的钛(Ti)和100nm 厚的金(Au)作为源漏电极,其中器件沟道宽长比为W/L=100/40μm,a-IGZO TFT的结构如图1所示。
2 结果与分析
2.1 a-IGZO 薄膜特性
首先要对磁控溅射出的IGZO 薄膜进行特性分析,制备了50nm 厚的a-IGZO 薄膜,采用X 射线衍射(XRD,Bruker D8 ADVANCE)分析验证其是否为非晶态,结果如图2所示。可以看出,薄膜未表现出尖锐的晶态峰,只有散射峰存在,说明薄膜的形态和内部结构一致,利用磁控溅射制备的IGZO 薄膜呈现非晶态,这是因为在室温状态下,O 原子不足以与In、Ga、Zn原子形成晶体结构,但重金属阳离子仍可以进行能带导电,这与之前的研究相一致[35,36]。
TFT有源层表面的质量对器件性能有着很大的影响,在硅片上利用磁控溅射沉积了不同厚度的a-IGZO 薄膜,对未退火、空气下400℃退火10min和退火30min 进行原子显微镜(AFM,SPM-9700HT)测试,表面形貌如图3所示,选定的区域为5μm×5μm。由测试结果得到,随着溅射时间的增大,其表面的粗糙度逐渐增大,不退火条件下,溅射10min的表面粗糙度Rq 为0.265nm,溅射25min的Rq 为0.398nm。比较图3(b)和图3(c)(d),可以看到,未经退火的薄膜有较大的晶粒尺寸,且表面粗糙度较大,说明其薄膜质量相对较差。而经过退火处理后,其表面粗糙度大幅度降低,且随着时间的增加,粗糙度也会降低,其中退火10min的Rq 为0.353nm,退火30min的Rq 为0.332nm。说明退火会提高薄膜的结晶度,晶格缺陷减少,薄膜材料表面的粗糙度降低,但并不会转变为多晶态。
由于a-IGZO 是一种n型半导体材料,主要依靠浅能级氧空位提供自由电子,薄膜中氧空位含量会影响其导电性,进而影响器件的性能。使用X 射线光电子谱(XPS,Thermo Fisher ESCALABXi+)对薄膜的性质进行探究,图4 (a)为未退火条件下的a-IGZO 薄膜的XPS能谱图。从图中可以看出,In,Ga,Zn,O 的特征峰明显,基本无其他杂质,其中的C元素为XPS图谱定标时所用,结合能用C1s=284.8eV 为基准校正。为了衡量退火对a-IGZO 薄膜内部氧空位含量的影响,在硅片上直接溅射25min的a-IGZO,使用XPS对未退火和空气下400℃退火10min和30min的O1s能谱进行测量,测量完成后将每个O1s能谱分为晶格氧OⅠ和空位氧OⅡ能谱,结果如图4(b)~(d)所示。将空位氧OⅡ 峰的峰下面积计算可得,未退火时氧空位含量为44.54%,经过N2 400℃@30min条件的退火,氧空位含量降至39.18%,Air 400℃@30min的氧空位含量降至35.97%。与未退火的情况进行比较,发现退火处理后薄膜内部的氧空位含量大幅度降低,说明退火能够有效消除薄膜的内部缺陷,提高薄膜质量。氧空位含量的减少说明在退火过程中断裂的金属氧化学键与弱金属氧化学键转变为稳定的金属氧化学键,薄膜内部的空位氧向晶格氧发生转变。这说明了空气下退火有利于获得质量更为优异的a-IGZO薄膜[33]。
2.2 不同溅射气氛下的TFT电学性能
对于a-IGZO TFT 来讲,其有源层的质量好坏直接决定是否有好的器件特性,因此需要对a-IGZO 溅射工艺进行优化,如溅射气氛和溅射厚度。我们首先考虑在射频磁控溅射过程中不同的溅射气氛对TFT电学性能的影响。如上所述,a-IGZO中主要依靠氧空位导电,因此需要在溅射过程中控制氧气的比例以获得具有优异半导体性质的薄膜。通过气体流量计控制溅射腔室内氩气和氧气的气体流量比例(简称氩氧比),分别在功率50 W 的条件下溅射了Ar∶O2=24∶0、24∶0.9、24∶1.2、24∶1.3、24∶1.4、24∶2.0(单位:sccm/min)的a-IGZO TFT,溅射时长为20min,磁控溅射完薄膜后统一在氮气(N2)下400℃退火10min,再利用电子束蒸发制备金属电极,最后用半导体分析仪对器件的转移特性进行测量,即源漏电流IDS 与栅电压VG 之间的曲线,其中源漏电压固定为VDS=2.0V,栅电压VG 范围为-10~50V,转移特性曲线如图5所示。通过转移特性曲线分别提取载流子迁移率(μFE)、阈值电压(Vth)、电流开关比(Ion/Ioff)和亚阈值摆幅(S.S)对不同氩氧比下的器件特性进行对比,如表1所示。
结合图5和表1可以看出,Ar∶O2=24∶1.2时,器件的载流子迁移率最大,为12.17cm2/(V·s),同时关态电流最小,拥有最大的开关比。在溅射过程中通入氧气会提高器件的迁移率,这是因为a-IGZO 薄膜中的氧空位含量受到溅射过程中腔室内O2 含量的影响,O2 含量的增加填补了材料的深能级氧空位缺陷,提高了器件的性能。但随着氧占比的持续增大,吸附氧等受主缺陷增多,载流子受到的散射作用更明显,沟道内自由载流子数目减少,我们可以看到,当氩氧比从24∶1.2升至24∶2.0时,器件特性出现持续退化,场效应迁移率从12.17cm2/(V·s)下降到9.09cm2/(V·s),并且阈值电压增大至19V,严重制约了器件的性能。
2.3 不同有源层厚度的TFT电学性能
为了进一步提高器件的性能,需要进一步优化工艺,探究有源层厚度对TFT性能的影响。实验中保持溅射气氛Ar∶O2=24∶1.2,通过控制薄膜溅射时长为5min,10min,15min,20min,25min,30min制备了六种不同有源层厚度的器件,通过AFM 对溅射10min和25min的薄膜厚度进行表征,计算得到薄膜生长速率,可得知不同溅射时长的薄膜厚度分别为10nm,20nm,30nm,40nm,50nm,60nm。图6所示为不同有源层厚度的a-IGZO TFT的转移特性曲线。
结合图6和表2中器件的性能参数可以看到,当溅射时间为25min 时,即有源层厚度为50nm,器件的性能相对较好,载流子迁移率最大,为12.31cm2/(V·s),阈值电压最小,同时拥有较大的开关比。随着有源层厚度的增加,器件的载流子迁移率逐渐增大,这是由于随着a-IGZO 薄膜厚度的增加,沉积的原子数目增加使得原子间成键机会增加,悬挂键和缺陷会不断得到补偿并趋于稳定,陷阱捕获载流子数目减小,开态电流持续增大,同时迁移率也会随着悬挂键等缺陷的减少而增大。但当有源层厚度超过50nm 之后,器件的场效应迁移率陡然下降,同时伴随着阈值电压的增大。分析可知,由于器件为背栅结构,栅电压加在了栅介质层和有源层上,器件结构相当于两个电容的串联,由于有源层的电容对栅电压起到了分压效果[27]。不仅如此,载流子传输还会收到有源层中多余电荷和带电离子的散射,导致载流子从源极到漏极的距离增加,降低器件性能[34]。因此,当器件有源层薄膜的厚度大于最佳厚度50nm 时,在相同的栅压下,有源层厚度的增大会导致绝缘层的电场减小,从而导致沟道载流子浓度也会随之降低,器件性能有所下降。对于薄膜相对薄的器件,由于沟道表面直接裸露于空气中,临近背沟道表面的膜层将受到空气中氧和水分子的影响,在载流子传输过程中更易发生散射,导致迁移率降低[29],对于厚度较大的有源层,如40~50nm 的器件,受影响相对较小。从实验结果上也可以印证,对于有源层厚度低于30nm 以下的TFT,厚度越小,载流子迁移率越低。
2.4 不同退火工艺下的TFT电学性能
在射频磁控溅射薄膜时,薄膜的生长过程中会出现原子的不完整排列,从而极易产生缺陷、空位[32]。由于薄膜中的缺陷会俘获自由移动的电子而造成内建电场,影响载流子的传输。因此,可以通过退火等多种处理方式对薄膜进行处理,改善薄膜的缺陷,进而可以提高器件的性能。在研究中,我们均采用的是磁控溅射完后在N2 下400℃退火10min,为了探究退火工艺的最优条件,使用Ar∶O2=24∶1.2,50W 的条件下溅射20min的参数,分别采用如下条件的退火工艺参数:N2 300℃ @ 30min,N2 400℃ @ 10min,N2 400℃@30min,Air 300℃@10min,Air 300℃@30min,Air 400℃@30min。分别测量不同退火条件下a-IGZO 的转移特性曲线,结果如图7所示。
结合图7和表3中器件的性能参数可以看到,所有的退火工艺中,Air 400℃@30min下具有最优的性能,载流子迁移率高达15.43cm2/(V·s),从图7中看到,关态电流低至10-14A,是所有工艺中最低的,开关比达到108 量级。在相同的退火时间下,温度越高迁移率越高。这是因为随着温度的升高,氧空位会电离出电子,发生了从深缺陷态向浅施主态的转变。从前文中形貌分析来看,退火时间越长,其表面粗糙度也会随之降低,薄膜更加平整,这有利于提高器件的整体性能。由于N2 为惰性气体,a-IGZO 薄膜并不会与之发生反应,相比较在空气中的退火,由于含有氧气,所以空气退火条件能够补充氧、解吸附OH 基团或化学吸附氧来去除氧缺陷,提高了对氧空位缺陷形成的抑制,改善薄膜的表面状况,提高了界面质量。退火可以消除薄膜内部原先的应力,使薄膜中的原子间距变得更短,缺陷数量降低,密度降低。亚阈值摆幅也可以说明问题,通常亚阈值摆幅越低,说明半导体薄膜的陷阱缺陷态密度越低[29,32]。整体来看,器件在Air 400℃@30min的退火工艺下可以使得器件性能达到最佳。
3 结论
本文采用射频磁控溅射的方法,制备了a-IGZOTFT,并从溅射气氛、有源层厚度和退火工艺三个方面对薄膜性质和器件的电学特性做了系统研究。结果表明,当溅射功率为50W 时,最优溅射气氛为Ar∶O2=24∶1.2,溅射过程中补充氧气,可以填补材料的深能级氧空位缺陷,提高了器件的性能,但氧气浓度过大也会造成吸附氧等受主缺陷增多,载流子受到的散射作用更明显,导致迁移率降低,阈值电压增大。当有源层厚度在30nm 以下时,由于膜层较薄,器件性能较差;有源层厚度为40~50nm 时,迁移率均在10cm2/(V·s)以上,且开关比均在107 量级以上。通过探究退火温度,得到最佳条件为40nm 的薄膜在空气下400℃退火30min,高温退火使器件的性能得到了大幅度提高,器件的电学性能达到最佳:μFE =15.43cm2/(V·s),Ion/Ioff=7.3×108,S.S=0.71V/dec。本文实验结果加深了对AOS TFT的理解,为制备晶圆级的高迁移a-IGZO TFT 奠定了技术应用基础。
参 考 文 献
[1] WEIMER P K. CITATION CLASSIC-THE TFT-A NEWTHIN-FILM TRANSISTOR[J]. Current Contents/EngineeringTechnology amp; Applied Sciences, 1983(3): 16-16.
[2] CHIANG T H, YEH B S, WAGER J F. Amorphous IGZOthin-film transistors with ultrathin channel layers[J]. IEEETransactions on Electron Devices, 2015, 62(11): 3692-3696.
[3] KIM H, MOON J Y, HEO Y W, et al. Effect of thermalannealing on Ni/Au contact to a-InGaZnO films deposited bydc sputtering[J]. Thin solid films, 2010, 518(22): 6348-6351.
[4] Le COMBER P G, SPEAR W E, GHAITH A. Amorphous-silicon field-effect device and possible application[J].Electronics Letters, 1979, 6(15): 179-181.
[5] KLASENS H A, KOELMANS H. A tin oxide field-effecttransistor[J]. Solid State Electronics, 1964, 7(9): 701-702.
[6] GLUECK J. A simplified a-Si: H TFT process for large-areaAMLCDs[J]. Journal of the Society for Information Display,1997, 5(3): 189-195.
[7] MA Q, WANG H, ZHOU L, et al. Robust gate driver onarray based on amorphous IGZO thin-film transistor forlarge size high-resolution liquid crystal displays[J]. IEEEJournal of the Electron Devices Society, 2019, 7: 717-721.
[8] IWASE Y, TAGAWA A, TAKEUCHI Y, et al. A novellow-power gate driver architecture for large 8 K 120 Hz liquidcrystal display employing IGZO technology[J]. Journalof the Society for Information Display, 2018, 26(5): 304-313.
[9] HSIEH H H, LU H H, TING H C, et al. Development ofIGZO TFTs and their applications to next-generation flatpaneldisplays[J]. Journal of Information Display, 2010, 11(4):160-164.
[10] WU G M, LIU C Y, SAHOO A K. RF sputtering depositeda-IGZO films for LCD alignment layer application[J].Applied Surface Science, 2015, 354: 48-54.
[11] Physics and Technology of Crystalline Oxide Semiconduc-tor CAAC-IGZO: Application to Displays[M]. John Wiley amp;Sons, 2017.
[12] Amorphous oxide semiconductors: Igzo and related materialsfor display and memory[M]. John Wiley amp; Sons,2022.
[13] HE Y, LIU R, JIANG S, et al. IGZO-based floating-gatesynaptic transistors for neuromorphic computing[J]. Journalof Physics D: Applied Physics, 2020, 53(21): 215106.
[14] HE Y, NIE S, LIU R, et al. Dual-functional long-termplasticity emulated in IGZO-based photoelectric neuromorphictransistors[J]. IEEE Electron Device Letters, 2019,40(5): 818-821.
[15] ZHU L, HE Y, CHEN C, et al. Synergistic modulation ofsynaptic plasticity in IGZO-based photoelectric neuromorphicTFTs[J]. IEEE Transactions on Electron Devices,2021, 68(4): 1659-1663.
[16] GENG D, CHEN Y F, MATIVENGA M, et al. Touchsensor array with integrated drivers and comparator usinga-IGZO TFTs[J]. IEEE Electron Device Letters, 2017,38(3): 391-394.
[17] CHEN T, WANG C, YANG G, et al. Monolithic Integrationof Perovskite Photoabsorbers with IGZO Thin-FilmTransistor Backplane for Phototransistor-Based Image Sensor[J]. Advanced Materials Technologies, 2023, 8(1):2200679.
[18] SEN A, PARK H, PUJAR P, et al. Probing the Efficacyof Large-Scale Nonporous IGZO for Visible-to-NIR DetectionCapability: An Approach toward High-PerformanceImage Sensor Circuitry[J]. ACS nano, 2022, 16(6):9267-9277.
[19] YANG T H, CHEN T Y, WU N T, et al. IGZO-TFTbiosensors for Epstein-Barr virus protein detection[J].IEEE Transactions on Electron Devices, 2017, 64(3):1294-1299.
[20] SHEN Y C, YANG C H, CHEN S W, et al. IGZO thinfilm transistor biosensors functionalized with ZnO nanorodsand antibodies[J]. Biosensors and Bioelectronics, 2014,54: 306-310.
[21] LI Y, ZENG B, YANG Y, et al. Design of high stabilitythin-film transistor biosensor for the diagnosis of bladdercancer[J]. Chinese Chemical Letters, 2020, 31(6): 1387-1391.
[22] SHIN W, KWON D, RYU M, et al. Effects of IGZO filmthickness on H2S gas sensing performance: response, excessiverecovery, low-frequency noise, and signal-to-noiseratio[J]. Sensors and Actuators B: Chemical, 2021, 344:130148.
[23] TANG H, LI Y, SOKOLOVSKIJ R, et al. Ultra-highsensitive NO2 gas sensor based on tunable polarity transportin CVD-WS2/IGZO pN heterojunction[J]. ACS appliedmaterials amp; interfaces, 2019, 11(43): 40850-40859.
[24] XIN C, CHEN L, LI T, et al. Highly sensitive flexiblepressure sensor by the integration of microstructuredPDMS film with a-IGZO TFTs[J]. IEEE Electron DeviceLetters, 2018, 39(7): 1073-1076.
[25] GENG D, HAN S, SEO H, et al. Piezoelectric pressuresensing device using top-gate effect of dual-gate a-IGZOTFT[J]. IEEE Sensors Journal, 2016, 17(3): 585-586.
[26] CHOI J H, SHIM J H, HWANG S M, et al. Effect ofsintering time at low temperature on the properties of IGZOTFTs fabricated by using the sol-gel process[J]. J.Korean Phys. Soc, 2010, 57: 1836-1841.
[27] KANG J, JANG Y W, MOON S H, et al. SymmetricallyIon-Gated In-Plane Metal-Oxide Transistors for HighlySensitive and Low-Voltage Driven Bioelectronics[J]. AdvancedScience, 2022, 9(13): 2103275.
[28] SON H W, PARK J H, CHAE M S, et al. Bilayer indiumgallium zinc oxide electrolyte-gated field-effect transistorfor biosensor platform with high reliability[J]. Sensors andActuators B: Chemical, 2020, 312: 127955.
[29] YABUTA H, SANO M, ABE K, et al. High-mobilitythin-film transistor with amorphous In Ga Zn O 4 channelfabricated by room temperature rf-magnetron sputtering[J]. Applied physics letters, 2006, 89(11): 112123.
[30] PARK S, KIM K H, JO J W, et al. In-depth studies onrapid photochemical activation of various sol– gel metaloxide films for flexible transparent electronics[J]. AdvancedFunctional Materials, 2015, 25(19): 2807-2815.
[31] KIM K T, KANG S H, KIM J, et al. An Ultra-FlexibleSolution-Processed Metal-Oxide/Carbon Nanotube ComplementaryCircuit Amplifier with Highly Reliable Electricaland Mechanical Stability[J]. Advanced Electronic Materials,2020, 6(1): 1900845.
[32] ANN Y D, YEON J H, OH T. Comparison between theElectrical Properties and Structures after Atmosphere Annealingand Vacuum Annealing of IGZO Thin Films[J].Industry Promotion Research, 2016, 1(1): 7-11.
[33] MUDGAL T, WALSH N, MANLEY R G, et al. Impactof annealing on contact formation and stability of IGZOTFTs[J]. ECS Transactions, 2014, 61(4): 405.
[34] PENG C, YANG S, PAN C, et al. Effect of two-step annealingon high stability of a-IGZO thin-film transistor[J].IEEE Transactions on Electron Devices, 2020, 67(10):4262-4268.
[35] WAGER J F. 15.1: Invited Paper: Amorphous OxideSemiconductor Thin-Film Transistors: Performance amp;Manufacturability for Display Applications[C]//SID SymposiumDigest of Technical Papers. Oxford, UK: BlackwellPublishing Ltd, 2009, 40(1): 181-183.
[36] WANG W, LI L, LU C, et al. Analysis of the contact resistancein amorphous InGaZnO thin film transistors[J].Applied Physics Letters, 2015, 107(6).
基金项目: 陕西省重点研发计划项目(2023-YBSF-407)。

