六方氮化硼的热中子辐照损伤
阳永富 ,王 柱 ,陈万平 ,邹武生 ,赵江滨 ,何高魁
(1.武汉大学 物理科学与技术学院,湖北 武汉 430072;2.中国原子能科学研究院,北京 102413)
第三代宽禁带半导体中的六方氮化硼(hBN)具有非常优异的物理、化学性能[1],主要表现在[2-6]:热中子俘获截面高达3.84×10-21cm2、宽带隙、极高的电阻率、低介电常数、大的位移阈能、低原子序数等。这些正是高性能热中子探测器需要的特性,因而hBN在热中子(能量约为0.025 eV)探测器领域具有广泛的应用前景[2,7-10]。
但是,在探测中子的过程中,10B 原子会逐渐转变为Li 原子和He 原子,成为杂质;中子和10B 反应生成的Li 离子和α 粒子具有很高的能量,能够造成hBN的级联位移损伤,产生大量缺陷。这些杂质和缺陷通常可能作为载流子的产生/散射/复合中心,影响其迁移率及载流子输运,是影响探测器的电荷收集的重要因素,因而缺陷研究引起了不少学者的关注。
Kotakoski 等[11]通过第一性原理计算hBN 完整晶格中和缺陷存在时B 和N 的位移能,用高分辨率透射电子显微镜(HRTEM)观察到电子辐照产生的三角形多空位,并解释了其形成机理。Pham 等[12]进一步研究了hBN 电子辐照缺陷的温度依赖性和稳定性。相比低温下常见的三角形缺陷,高温下四边形和六边形缺陷占主导;而在缺陷边缘原子数低于10 时,六边形缺陷占主导。Lehtinen 等[13]通过分子动力学模拟研究离子辐照下hBN 产生不同缺陷的概率,给出了单空位、双空位及复杂空位缺陷产生概率最大的辐照能量区间。Simos 等[14]则研究了质子辐照对hBN 稳定性和微观结构的影响,将石墨烯作为对比,说明了hBN具有良好的抗辐照性。中子辐照相对于其他辐照有着更深的作用深度,与中子探测器材料的应用环境所受到的核辐射条件非常类似,对中子探测器研究具有直接的指导意义。Cataldo 等[15]通过电子自旋共振(ESR)等技术手段研究了中子辐照单层hBN 缺陷结构,发现中子辐照后存在以一硼中心和三硼中心为主的空位型缺陷。Toledo 等[16]研究了中子辐照粉末、体态和单晶hBN 材料中的缺陷,认为色心的产生可能与VNNB和VBCN缺陷有关。对于氮化硼中子探测器来说,辐照缺陷浓度、尺寸和种类对载流子产生、吸收和输运的影响是探测器研究中迫切需要解决的科学问题,目前,还没有发现相关的研究报道。因而,本文首次使用对原子缺陷十分敏感的正电子谱学方法研究了不同中子剂量辐照的hBN 材料中缺陷结构的演绎,并利用静电计测量了中子辐照前后载流子输运的变化,进而讨论并解释了电流密度变化的微观机理。
1 实验
1.1 样品准备
1.1.1 制备方法
本文选择了热解氮化硼(PBN)和热压氮化硼(HBN)两种工艺成熟且具有广泛应用的六方氮化硼材料进行研究。PBN 的制备是以三氯化硼(BCl3)和氨气(NH3)为前驱体,通过高温化学气相沉积法生长的[17],可以生长成各种各样的形状和尺寸。据报道,以化学气相沉积法生长的BN 很少能成为单相,一般都是伴随着六方相、涡轮静压相(t-BN)和非晶相,并且六方相的浓度与生长温度相关[18]。H-BN 是通过热压烧结[19](Hot Pressed Sinteriong,HP)的方法制备的。将干燥的hBN粉末填入模具(石墨)内,对模具进行加压、加热。加压及加热同时进行有利于颗粒的塑性扩散和致密化,从而得到高密度、性能优良的氮化硼材料。
1.1.2 SRIM 仿真
10B 原子对热中子的捕获截面高达3.84×10-21cm2[3]。在hBN 材料中,一个10B 原子捕获一个中子伴随着如下核反应:
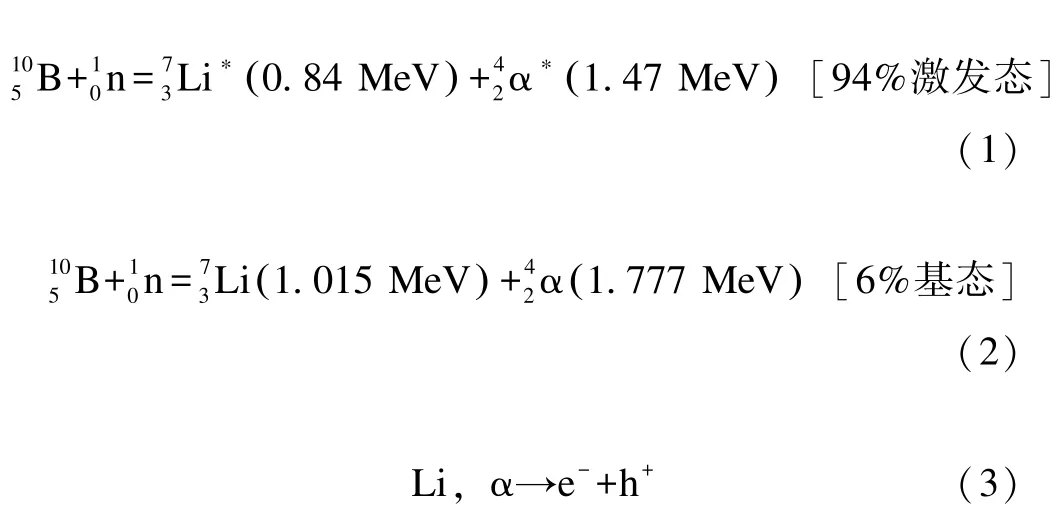
式(1)和式(2)描述了hBN 材料的中子吸收过程,其中中子捕获可产生具有大动能的Li 离子和α 粒子。式(3)则描述了Li 离子和α 粒子在hBN 材料中因辐射而产生的电子(e-)和空穴(h+)的后续过程。这是因为中子辐照hBN 时,生成的高能Li 离子和α 粒子会与hBN 内的电子发生碰撞,通过电离能量损失产生大量的电子和空穴;也会与原子核碰撞,通过核阻止引起原子位移从而产生弗兰克尔对缺陷,即引起辐照损伤。
因此,可以利用Li 离子和He 离子(α 粒子)注入的方法模拟中子辐照造成的辐照损伤,从而指导中子辐照实验剂量的设计,同时提供缺陷浓度信息。SRIM(Stopping and Range of the Ions in Matter)软件[20]基于蒙特卡罗方法,可以模拟出离子注入靶材料的辐照过程以及离子注入对靶材料造成的空位浓度分布和辐照损伤程度(DPA,Displacement per Atom)。基于离子辐照损伤程度计算方法,中子辐照损伤程度可以近似表示为:

式中:Nd为单位体积(1 cm3)样品中位移原子总数;Ф为入射中子剂量(cm-2);n(x)为一个中子在单位路径上造成的原子位移数量;∫n(x)dx为每个中子引入的空位总数;N为靶材料的原子数密度,对于hBN 材料,N=1.06×1023(atoms/cm3);d为样品厚度,取0.1 cm。这里假设中子从各个方向均匀入射,并且中子被1 mm 厚的hBN 全部吸收。
1.1.3 中子辐照实验
为了方便描述,热解氮化硼PBN 样品用样品A 表示,热压氮化硼H-BN 样品用样品B 表示。中子辐照样品的尺寸均为40 mm×14 mm×1 mm。根据不同的后续测试需求,再进一步切割成需要的尺寸,并抛光、清洗和干燥处理。
将样品放入核反应堆里,以5×1011cm-2·s-1的通量率进行三种不同时间的辐照,PBN 样品随总剂量大小依次编号为A2、A3、A4,原生样品编号为A1,HBN 样品编号类似,具体辐照的相关参数如表1 所示。因为中子辐照有轻微的活化效应,辐照结束后,所有样品均需放置一段时间,检测没有辐射后再进行实验。
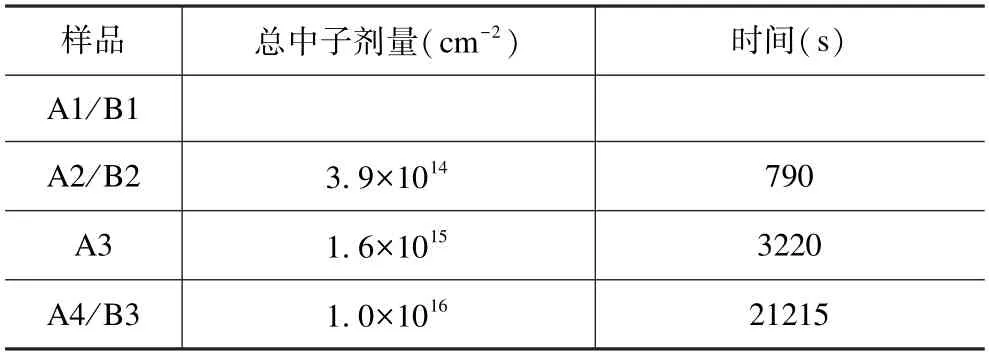
表1 中子辐照实验样品编号及参数Tab.1 Neutron irradiation experimental sample number and parameters
1.2 暗电流测量
将两种中子辐照前后的样品进一步切割成5 mm×5 mm×1 mm 尺寸。制备器件结构如图1 所示,使用磁控溅射镀膜机在两种样品的正反两面均镀上20 nm 的Ti 和100 nm 的Au 作为电极。制备电极过程中要注意防止膜边缘的金属化,以免导致漏电。用Keithley 6517A 静电计搭建出暗电流测量装置。测量在氮气保护条件下进行。

图1 hBN 的电流测量结构。两面先镀上20 nm 的Ti,然后再镀100 nm 的Au 作为电极Fig.1 Current measurement structure of hBN.Both sides were first plated with 20 nm Ti and then 100 nm Au as electrodes
1.3 样品表征
使用高分辨X 射线衍射仪Bede D1 进行X 射线衍射分析,以Cu 作为阳极靶,产生的Kα 特征X 射线波长为λ=0.154 nm,以8(°)/min 的速度进行扫描,扫描范围为5°~95°。使用Hitachi S4300SE 场发射扫描电子显微镜观察样品的形貌。
将两种中子辐照前后的样品切割成14 mm×14 mm×1 mm 的尺寸进行正电子测试。正电子湮没寿命谱是研究材料空位型缺陷的非破坏性的强有力方法[21]。以22Na 作为正电子源,使用分辨率约为260 ps 的快-快符合型正电子寿命谱仪进行测量。正电子源置于两片相同样品之中,形成三明治结构。寿命谱测量总计数达106以上,每个样品重复测量4~6 次,取平均值作为实验结果。本文测量正电子寿命的实验过程均处于真空恒温状态,可以减小湿度、氧气和温度对结果的影响。使用PATFIT 程序对实验数据进行拟合、分析,并且将单晶Si 作为标样以进行源修正。
2 结果与讨论
2.1 SRIM 仿真结果
根据公式(1)、公式(2)及hBN 中N 原子和B 原子的阈值位移能(=19.4 eV)[11],仿真可以得到每个中子产生的空位数约为505 个。
根据表1 的剂量可以计算出不同剂量中子辐照产生的空位浓度,再按照方程(3)计算中子辐照损伤程度值列于表2 中。显然,损伤程度和空位浓度随辐照剂量的增大而增加。考虑到中子辐照引入的空位大部分会很快复合[22],稳定后存留下的缺陷浓度会明显小于表中的空位型缺陷浓度(约小两个数量级),数量级为1016~1017cm-3,该缺陷浓度是在正电子测量敏感范围内,说明实验使用的中子辐照剂量是合理的。值得注意的是,稳定后的缺陷浓度也是随辐照剂量的增大而增加,这可以和后面的正电子寿命测量结果相对照。

表2 SRIM 仿真中子辐照结果Tab.2 Results of SRIM simulation of neutron irradiation
2.2 暗电流特性
图2 显示了在500 V/cm 场强下不同中子辐照剂量下的PBN 和H-BN 的暗电流密度变化曲线。从图中可以明显看出辐照前后两种材料的暗电流密度具有以下特征:(1)两种样品的电流密度均随中子辐照总剂量的增大而增大;(2)辐照前,PBN 和H-BN 样品的暗电流密度分别为5.64,21.11 pA/cm2。在1×1016cm-2剂量的热中子辐照后,PBN 和H-BN 的电流密度都增大了3 倍左右;(3)辐照前后H-BN 的电流密度都比PBN 的大,但是无论是H-BN 还是PBN,电流密度的值都在62 pA 以下。这些结果说明中子辐照引入了载流子,从而使电流密度增大。本征载流子浓度ni可以通过公式计算,其中,NC=表示导带(价带)中的有效态密度,为hBN 的电子/空穴的有效质量,Eg为hBN 的禁带宽度[23]。可以得到hBN的热平衡载流子浓度为10-29cm-3,这会导致电流密度小于当前测量仪器的下限。测量结果说明辐照前的电流可能来自于材料中的残余杂质或缺陷的贡献,并且H-BN 的杂质或缺陷的浓度是高于PBN 的。

图2 在电场强度为500 V/cm 下两种样品的电流密度随中子剂量的变化规律Fig.2 Variation of current densities with neutron doses for the two samples at an electric field strength of 500 V/cm
根据方程(1),一个中子与10B 反应会生成一个Li离子,所以1×1016cm-2剂量的热中子辐照产生的Li 离子浓度应该接近1016cm-2。Li 离子在半导体中的电离能很小,通常会成为施主杂质,提供载流子。如果仅仅考虑Li 离子对导电性的影响,由于外加电场引起的电流密度J=σE=qnμE,辐照后的电流密度应该比辐照前的电流密度大很多,但是实验测量结果仅仅大了2.5~3 倍。根据SRIM 的仿真结果,在1×1016cm-2剂量时,对于1 mm 厚的样品,稳定的缺陷浓度可达5×1017cm-3,由此可以推断辐照引入的缺陷可能会成为:(1)载流子散射中心,降低了载流子迁移率;(2)载流子复合中心,减小了载流子浓度。从而,电流密度的变化并没有预期的明显。下文XRD 和正电子寿命测量结果证实了辐照引入了大量的缺陷,并展示了这些缺陷的演化特征。
2.3 XRD 分析
未辐照的PBN 和H-BN 的X 射线衍射测量结果如图3 所示。在图3 中,两种材料都展现了典型的(002)峰。可以看出热压氮化硼的晶体结构属于标准的hBN 结构,而且(002)晶面方向强度明显大于其他晶面的强度,说明H-BN 具有(002)晶面的择优取向[24]。PBN 在沉积过程中沿c轴方向生长,在c轴方向也表现出了高度的晶面取向[25],这与H-BN 是一致的。但是,相对于标准的hBN,PBN 的(002)面的衍射峰明显更宽,并且峰位往小角度方向偏移,对应面间距为0.344 nm(略大于标准六方氮化硼的0.333 nm)[26]。衍射图中也有一些很弱且不对称的(100),(101),(004)的峰,而这些峰是若干条交叠线的叠加,可以归因于PBN 中不可避免的t-BN 相[27]。t-BN 相是一种高度无序的半结晶结构,其正常层呈现出随机旋转的结构,因此,PBN 就会呈现出堆叠层错的结构,从而导致其平均层间距大于理论的层间距,并不是标准的hBN 结构。图3 插图SEM 观察结果也反映出相同的特点,即热解氮化硼样品表现出层状织构特征,而热压氮化硼样品呈现出片状晶粒堆积的特征[28]。

图3 PBN 和H-BN 的XRD 图谱(插图为SEM)Fig.3 XRD profiles of PBN and H-BN(The inset is the SEM images of PBN and H-BN)
中子辐照后的XRD 分析如图4,5 所示。其中图4(a)展示了中子辐照后PBN 的XRD 谱图,图4(b)为(a)图(002)峰放大的结果。从图中可以发现(002)峰的强度随中子辐照剂量的增加而明显减小,说明中子辐照引入了大量的缺陷,同时X 射线衍射峰展宽并往大角度方向移动,不对称性更加明显。峰的加宽和不对称说明中子辐照引入缺陷;往大角度方向移动意味着晶面间距在逐渐变小。在图4(c)中,(101)峰更加明显,说明中子辐照使PBN 材料结构发生变化[29],h-BN 相越来越多,t-BN 相越来越少,即部分t 相向h 相转变。

图4 (a)中子辐照前后PBN 的XRD 图谱;(b)中子辐照前后PBN 的(002)衍射峰;(c)中子辐照前后PBN 的次级峰Fig.4 (a) XRD patterns,(b) enlarged X-ray bands(002) and (c) enlarged other diffraction peaks of PBN before and after neutron irradiation
从图5 可以看出,在中子辐照后,H-BN 的(002)峰强度也是随辐照剂量增大而下降,表明中子辐照引入了大量的缺陷。但是衍射峰并没有明显的移动。(100)和(101)峰强度只有轻微的增大,说明中子辐照虽然引入了缺陷,但对H-BN 结构的影响并不大。这些结果表明了H-BN 整体抗辐照性能强于PBN。

图5 (a)中子辐照前后H-BN 的XRD 图谱;(b)中子辐照前后H-BN 的(002)衍射峰;(c)中子辐照前后H-BN 的次级峰Fig.5 (a) XRD patterns,(b)enlarged X-ray bands(002) and (c) enlarged other diffraction peaks of H-BN before and after neutron irradiation
2.4 正电子湮没寿命谱分析
为了研究中子辐照诱导缺陷的结构,测量了样品的正电子湮没寿命谱。图6 是PBN 和H-BN 两种样品正电子湮没寿命谱的对比。从图中看出,未辐照时,PBN(A1)具有长寿命分量,明显提示有正电子偶素形成,而H-BN(B1)中没有正电子偶素形成。辐照后的PBN 样品(A4)中,正电子湮没寿命谱发生了明显的变化。其正电子寿命值通过多指数模型拟合正电子寿命谱得到。PBN 正电子寿命谱采用四分量模型拟合方能得到最佳的拟合优度,相应地,H-BN 只能采用三分量模型拟合以得到最优效果。样品的正电子寿命分析结果列入表3,其中平均寿命为。其中τi表示正电子湮没寿命第i分量,Ii表示正电子寿命第i分量对应的强度。

图6 样品PBN 和H-BN 的正电子湮没寿命谱Fig.6 Positron annihilation lifetime spectra of PBN and H-BN
从表3 中可以看出未进行中子辐照的A1 样品的τ1=258 ps,这明显高于计算出的hBN 中正电子体寿命180.6 ps[31]。通常hBN 中会存在各种不同的空位型缺陷,包括单空位VB,VN,双空位VBN及空位团等一些本征缺陷[32-33]。因为VN属于正电荷空位,并不捕获正电子,因此τ1应该归因于正电子在本征缺陷VB、VBN和小空位团中湮没的贡献(这里把这些空位型缺陷定义为组合空位)。τ2的值在500~700 ps 之间。Puska等关于空位团正电子寿命与空位团尺寸关系的计算结果表明[34],随着空位团尺寸的增大,空位团的正电子寿命将趋于其饱和值,大约500 ps。这里作者认为,τ2对应于正电子在大空位团或孔洞的湮没。τ3和τ4的寿命值分别为3 ns 和14 ns 左右,这对应于正电子偶素在大的空位团和孔洞中的拾取湮没。正电子在绝缘体中的大空位团和孔洞内会形成正电子偶素。正电子偶素在真空中的湮没寿命为142 ns,在介质中可以通过拾取周围电子而湮没,其寿命与孔洞大小成正相关,通常大于1 ns。根据电子偶素拾取湮没寿命τ的球形模型,R=R0-ΔR,ΔR=0.1656 nm[30]。计算出PBN 的3 ns 的缺陷半径约为0.3629 nm 的大空位团,14 ns 的缺陷半径约为0.7569 nm 的孔洞。

表3 不同中子剂量辐照下两种样品的寿命及强度Tab.3 Positron annihilation lifetime(τ) and intensity(I) in two samples after different neutron dose irradiation
为了分析不同剂量中子辐照后的PBN 正电子寿命的变化规律,将寿命分量及其强度绘制成图7。在图7(a)可以看出,在中子辐照剂量处于1014cm-2数量级时,τ1值有轻微的减少,说明在辐照过程中,产生了大量的单空位,组合空位中单空位的比例增高,使得整个组合空位中正电子寿命的平均值降低。在图7(b)也可以看出在中子辐照剂量为1014cm-2数量级时,强度并没有明显的增加,说明单空位密度的增加并没有明显改变组合空位的正电子捕获率,辐照损伤并不严重。当中子辐照剂量进一步增加,寿命τ1和强度I1开始增加。到1016cm-2数量级时,其强度变化明显,说明中子辐照引入了更多的单空位,使单空位浓度达到饱和,并且有聚集为双空位、多空位和小空位团的现象。双空位、多空位和小空位团的总数增加,使得组合空位寿命τ1增加,也使捕获率增加,导致I1增加。虽然辐照可能会导致反位缺陷的生成[32],但是,反位缺陷通常与体态寿命接近,在常温下也很难捕获正电子,因而本实验并不能观察到反位缺陷的贡献。
在图7 中可以看出,在中子辐照剂量处于1014cm-2数量级时,τ2值只是略微的减少,I2略微增大,在误差范围内可以忽略这个变化。中子辐照剂量为1016cm-2数量级时,τ2值有较为明显的增大,I2明显减小。这是随着辐照剂量的增加,各种大小不同的缺陷都通过吸收空位而增大,导致大的空位团尺寸也相应增大。由于相对较小的组合空位的数量大幅增加,增加了组合空位的正电子捕获率,使得大空位团以及孔洞捕获正电子的竞争力相对减弱,从而导致强度I2、I3和I4的减小。这与I1的变化是互补的。

图7 (a)样品PBN 的正电子寿命及(b)相应强度随中子辐照剂量的变化Fig.7 (a)Variation of PBN positron lifetime and (b)corresponding intensity as a function of neutron irradiation dose
第三分量的寿命τ3与第四分量的寿命τ4几乎不随辐照剂量变化。强度I3和I4均随着中子剂量的增加而下降。如前所述,τ3与τ4对应于大空位团和孔洞中正电子湮没的寿命。因为孔洞足够大,少量吸收空位对其体积造成的影响很小,因而长寿命几乎不随辐照剂量变化。辐照引入了单空位缺陷和一些组合空位缺陷,降低了大空位团和孔洞对正电子的捕获竞争力,其强度就会有一定的下降。当中子辐照剂量进一步增加时,这种效应变得更加明显。
在H-BN 中τ3为4 ns 左右,但与PBN 不同,I3的强度小于0.2,τ3应归因于在样品表面形成的正电子偶素的拾取湮没寿命,不存在能够形成正电子偶素的大孔洞。根据先前对PBN 寿命谱类似的分析,在表3 以及图8 中可以发现H-BN 中缺陷演绎规律与PBN 完全相似,即:τ1来自于多种小的空位型缺陷的贡献,τ2是正电子在大空位团中的寿命。与PBN 中的缺陷引入规律类似,中子辐照引入了大量单空位,导致单空位浓度增加。中子剂量的提高以及单空位浓度的增加、单空位的扩散、聚集,逐渐引起更大的空位型缺陷的浓度增加(即引起相应的寿命增加),导致相对较小的空位型缺陷具有更强的捕获竞争力(即强度增加),而大空位团的强度减小。与PBN 不同的是,H-BN 中正电子不能在其中的空位团和孔洞中形成正电子偶数,因而没有对应正电子偶素的拾取湮没分量。由此可见,正电子测量的总浓度随中子辐照剂量增加而增加,这与SRIM 仿真结果是一致的。

图8 (a)样品H-BN 的正电子寿命及(b)相应强度随中子辐照剂量的变化Fig.8 (a) Variation of H-BN positron lifetime and (b)corresponding intensity as a function of neutron irradiation dose
3 结论
通过热中子辐照PBN 和H-BN 两种六方氮化硼材料获得不同缺陷结构的样品。利用静电计测量、XRD和正电子湮没寿命谱分析,研究了热中子辐照损伤和缺陷结构,以及辐照缺陷对载流子输运的影响。研究结果表明中子辐照引入了大量的缺陷和杂质。主要表现为单空位、双空位、小空位团缺陷浓度随着热中子辐照剂量的增加而增加。辐照增加了材料中的载流子浓度,主要为中子辐照产生的杂质Li 离子贡献。由于辐照引入的缺陷主要成为了载流子的散射和复合中心,降低了载流子迁移率和浓度,使得辐照后的载流子浓度远远低于预期的浓度。解释了暗电流密度随着热中子辐照剂量的增加而逐渐增加的微观机制。研究结果有利于进一步理解载流子输运的特性,为解决hBN 中子探测器研究中的关键技术问题提供了科学依据。

