1 MeV Xe离子辐照对4H-SiC肖特基二极管的性能影响研究
茆邦耀,刘建德,汤金金,尹晋超,刘贵鹏 ,赵桂娟
(1.兰州大学 物理科学与技术学院,兰州 730000;2.中国科学院近代物理研究所,兰州 730000)
0 引言
以碳化硅(SiC)和氮化镓(GaN)为代表的第三代半导体材料由于具有更宽的禁带宽度而表现出了高击穿场强、高饱和电子漂移速率及高热导率等一系列优点,这类半导体可以工作在高温、高压、高辐射等极端条件下[1]。4H-SiC的禁带宽度为3.26 eV,离位能为21.8 eV,熔点为2 380 K[2],这使得它有很好的抗辐射能力[3],在航空航天、核能开发以及雷达探测方面具有广泛的应用前景[4]。
4H-SiC肖特基势垒二极管(SBD)作为最基本的功率器件因其工艺相对简单而得到了广泛的应用[5]。4H-SiC SBD的整流特性主要取决于金属-半导体界面的肖特基接触[2,6],在肖特基接触下4HSiC SBD能提供近乎理想的动态特性[7-8]。半导体器件在宇宙空间工作时会受到各种各样粒子,如电子、质子、中子、快中子以及离子等的辐照。辐照对SBD中金属-半导体接触界面的影响十分严重,常常导致器件无法正常工作[9]。近年来国内外对4H-SiC SBD离子辐照后的性能退化多有研究[10-12],但很少有人关注性能退化的本质原因。本文选取Xe离子作为辐照离子,重点研究辐照对金属-半导体界面的影响,分析4H-SiC SBD整流特性失效的机制。
1 实验过程
1.1 实验器件
器件为具有场限环结构的4H-SiC SBD[13],如图1所示。图2给出了器件的扫描电子显微镜(SEM)和能谱图(EDAX),图2(a)为器件的顶面SEM图,图2(b)为底面SEM图。从EDAX图中可以看出,SBD器件的阳极为Al/Ti(图2(c)),阴极为Ni/Ag(图2(d))。图2(e)和(f)分别给出了器件的截面图。所选用的4H-SiC SBD的额定正向开启电压为0.6 V,额定反向击穿电压为650 V。
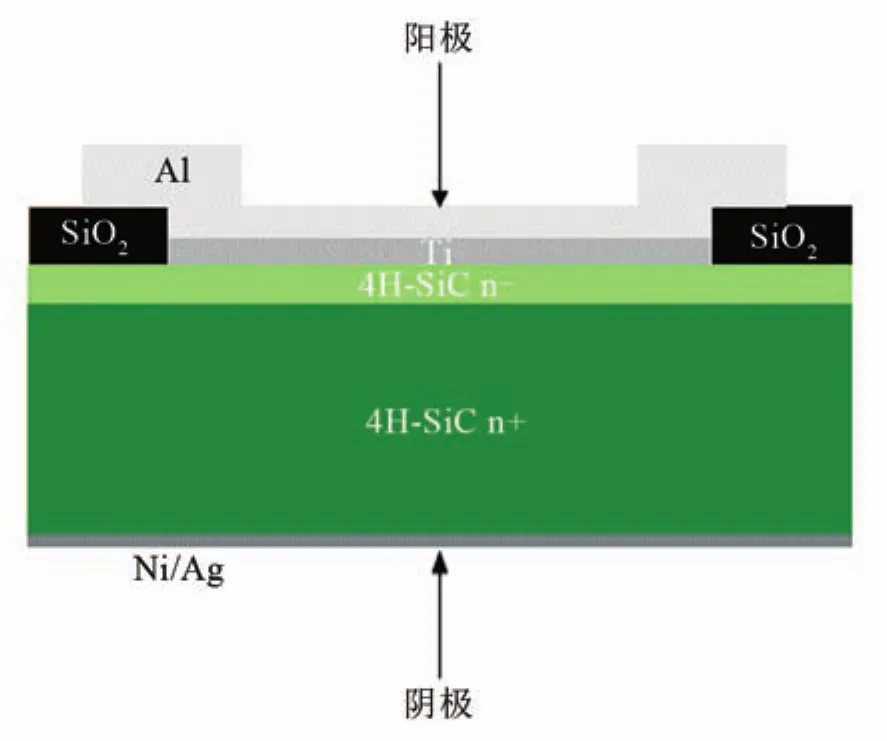
图1 4H-SiC肖特基二极管器件结构图Fig.1 The structure of 4H-SiC Schottky diode device

图2 4H-SiC SBD SEM和EDAX图Fig.2 The SEM and EDAX images of 4H-SiC SBD
1.2 SRIM仿真
辐照实验之前,用SRIM软件仿真了不同能量Xe离子对4H-SiC SBD器件的影响。SRIM(the stop⁃ping and range of the ions in the matter)软件可以通过蒙特卡罗方法模拟离子辐照的损伤和位置,该方法与实际的辐照过程比较接近。当离子通过4H-SiC SBD时,会与冲程内的原子发生碰撞,并将能量以非电离能量损失(NIEL)的形式传递给晶格原子;获得能量的晶格原子发生位移并产生空位,在材料中形成缺陷,进而改变器件的电学性能。
模拟用能量为0.5~6 MeV的Xe离子对4H-SiC SBD进行辐照,模拟器件的结构尺寸如图3所示,与实际器件结构(如图2所示)相近。器件的软件模拟部分尺寸为±2.50µm×5.01µm,从左至右共四层:1 µm 厚的Al,10 nm 厚的Ti,3 µm厚的 SiC n-,1 µm厚的SiC n+。Xe离子从器件的阳极垂直照射在器件表面,模拟结果如图4所示。结果表明,不同能量Xe离子的平均渗透深度不同,0.5 MeV的Xe离子平均深度小于Al电极的厚度,如图4(a)所示;1 MeV的Xe离子大部分渗透到Al和Ti的交界面,平均深度为0.8 µm,如图4(b)所示;3 MeV Xe离子进入了4H-SiC外延层,如图4(c)所示;6 MeV的Xe离子对外延层造成了大量的损伤,如图4(d)所示。为了研究辐照对4H-SiC SBD的金属-半导体界面的影响,须保证辐照过程中只有少量的Xe离子直接打入到4H-SiC外延层中,损坏4H-SiC的晶格完整性,大部分Xe离子作用在金属-半导体界面附近。因此,选用1 MeV的Xe离子进行辐照实验。
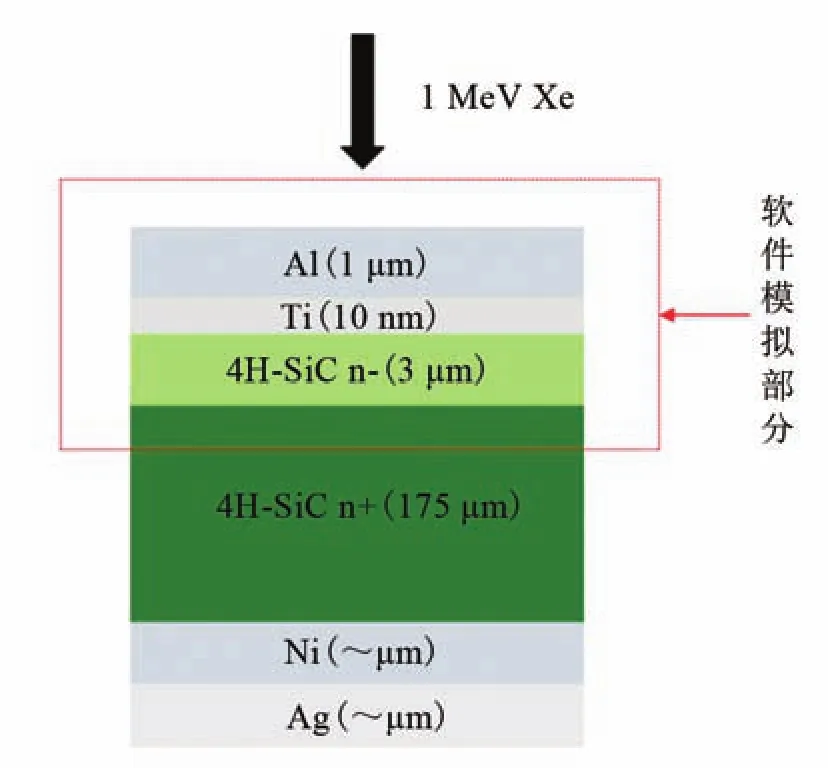
图3 模拟器件结构图Fig.3 The schematic of Al/Ti/4H-SiC Schottky barrier diode and experimental conditions of Xe ion irradiation

图4 模拟不同能量Xe离子辐照4H-SiC SBD的损伤图Fig.4 SIMS depth of 4H-SiC SBD after 1MeV Xe ion irradiation
1.3 辐照实验
在中国科学院近代物理研究所的兰州重离子加速器(HIRFL,Heavy Ion Research Facility in Lan⁃zhou)上进行了辐照实验。Xe离子能量为1 MeV,通量为2×1015ion/cm2,从阳极垂直照射在4H-SiC SBD器件上。
2 实验结果与讨论
正常工作时4H-SiC SBD的正向和反向I-V特性曲线如图5所示,小于0.8 V的正向开启电压(Von)被认为是稳定的I-V特性曲线[14]。根据热电子发射理论,理想因子(n)和肖特基势垒(SBH,Φb)决定了一个SBD的电学性能。

图5 实验测得的4H-SiC SBD的I-V特性曲线Fig.5 The I-V characteristics of 4H-SiC SBD
SBD的理想电流方程为[6]:



式中:V为外加电压;IS为从零偏置电压下ln(n)轴直线截距得出的饱和电流;n为理想因子;Rs为串联电阻阻值;q为元电荷量;K为玻耳兹曼常数;T为温度;A为肖特基结有效结面积(本文所用器件A=0.5 mm2);A*为理查德森常数,4H-SiC的理查德森常数为 146 A/cm2·K2[14-15]。
图5(a)和(b)分别是辐照前的正向和反向I-V特性曲线,图5(c)和(d)分别是Xe离子辐照后的正向和反向I-V特性曲线。Xe离子辐照明显地改变了4H-SiC SBD的I-V特性,辐照后的正向开启电压接近于0 V,正向电流增大了近10倍;反向击穿电压降至-100 V,反向电流大小变化不大,反向漏电明显增加。
1 MeV的Xe离子辐照会在4H-SiC SBD器件的金属-半导体接触界面附近引入损伤和缺陷,一方面辐照产生的缺陷造成了许多表面态,在界面处产生了费米能级钉扎[12];另一方面,表面缺陷和近表面的体缺陷使得肖特基界面处的隧穿概率增大,导致隧穿电流随之增大。正向开启电压的减小说明SBD金属-半导体接触界面的肖特基势垒降低,使更多的载流子通过势垒。根据热电子发射理论[6],SBD的正向电流主要由越过势垒的载流子提供。这可以很好地解释辐照后4H-SiC SBD正向I-V特性的变化。根据式(1)~(4),肖特基势垒的降低会使得电流变大,与实验结果相符。为了研究辐照产生的缺陷对器件性能的影响[10,16-17],将辐照后的器件在温度873 K下退火30 min[18-19]再测试,得到了图5(e)和(f)。从I-V特性曲线中可以看出,4H-SiC SBD的肖特基接触特性曲线变成了欧姆接触特性曲线。
为了研究界面的微观变化[9,11,20],对器件进行了高清晰透射电子显微镜(XTEM)成像。将用TES⁃CAN LYRA3 FIB-SEM聚焦离子束从器件中心部分5µm深处切取的90 nm宽的截面切片置于FEI Tecnai F30透射电子显微镜和配置的Bruker XFlash Detector能谱下进行扫描观测。从图6(a)可以看出,金属-半导体间有明显的分界面,各层分布均匀,说明退火对金属-半导体界面有一定的修复作用;在图6(b)中,金属一侧原子排列均匀致密,4HSiC外延层中无明显缺陷,进一步证明退火对金属-半导体界面的损伤修复有较大的作用。但是退火不能完全修复此类损伤,从图6(c)可以看到明显的原子排列的断区,这可能是辐照离子轰击留下的空位损伤或者是反冲粒子占位形成的损伤,这种损伤对肖特基势垒的影响是永久性的,即便退火也不能改变。

图6 辐照后873 K退火30 min的金属-半导体界面XTEM图像Fig.6 XTEM images of metal-semiconductor interface annealed at 873 K for 30 min after irradiation
为了研究原子的分布,对界面进行了元素分析,如图7所示。图7(a)为肖特基接触界面处电镜扫描区域,(b)~(f)为各元素面扫描图。从图中可以看出,Si原子主要在SiC区域,C原子也集中在SiC区域,上部的C零星分布可能与设备腔内的碳纤维有关,部分Al和Ti原子是被Xe离子打入到SiC外延层中的。值得注意的是,大部分Ti原子被反冲到Al电极中,这表明Ti电极和4H-SiC外延层的界面处有大量的Ti原子空位,造成了大量的界面态,使得肖特基势垒降低,从而导致金属-半导体呈欧姆接触。

图7 肖特基接触界面处XTEM EDX元素分布图Fig.7 XTEM EDX images of the Schottky contact interface
从SRIM和X结果可知,辐照引入的局部晶格错位和损伤深度取决于辐照离子的能量,且错位和损伤集中分布在一个平均薄层中。在空间环境中,可以根据辐照环境来调整器件的结构使其按照预期 目标正常工作。
2 结论
本文研究了经1 MeV Xe离子辐照后4H-SiC SBD器件电学性能的退化。SRIM软件仿真表明,1 MeV Xe离子辐照对本器件的金属-半导体界面影响最大。辐照离子向金属-半导体界面区域引入了缺陷,导致了肖特基势垒的降低,进而使得4H-SiC SBD的整流特性失效。实验结果表明,由辐照引入的缺陷可以通过873 K下30 min退火处理得到部分修复。用XTEM和EDX观察并分析了界面处微观结构的变化,给出了辐照和退火改变4H-SiC SBD电学性能的微观解释。
本实验的研究方法适用于研究在空间环境中工作的电子电力器件。通过仿真来调节实验条件,再分析实验结果,讨论实验现象,得出结论。空间环境是一个复杂且多变的环境,多种多样的辐照对电子电力器件的影响有待深入研究。

