溅射功率对氧化镓薄膜特性的影响
付宏远,张 猛,张宝萍,赵 洋,王 辉
(河南科技大学 a.物理工程学院;b.河南省光电储能材料与应用重点实验室,河南 洛阳 471023)
0 引言
由于透明导电氧化物(transparent conductive oxide,TCO)具有优异的电学和光学性质,被广泛应用于平板显示器、光学窗口和高温化学气体传感器等领域[1-3]。然而,现有的大多数TCO材料的带隙为3.0~4.3 eV,如In2O3(带隙为3.75 eV)、SnO2(带隙为3.5~4.0 eV)、ZnO(带隙为3.3 eV)和氧化铟锡(indium tin oxide,ITO)导电玻璃(带隙为3.5~4.3 eV)等,这意味着其在深紫外(deep ultraviolet,DUV)短波区域的应用受到局限[3]。因此,有必要研究适应于紫外光区域的新型TCO材料。氧化镓(Ga2O3)是一种宽禁带半导体材料,常温下为绝缘体,高温下为n型半导体。Ga2O3具有多种结构,其中以单斜结构的β型Ga2O3最为稳定。室温下Ga2O3的禁带宽度为4.2~4.9 eV,在紫外波段透射率高,具有良好的导电性和光学性能,可作为紫外TCO材料应用于光电器件,有望改进常见TCO材料在深紫外区域光学透射率较差的缺点[4-5]。此外,Ga2O3在高功率器件领域也具有广阔的发展前景[6-9]。文献[10]采用分子束外延(molecular beam epitaxy, MBE)方法,在蓝宝石衬底引入100 nm Ga2O3同质缓冲层,制备了β-Ga2O3薄膜紫外探测器。文献[11]采用金属有机化学气相沉积(metal-organic chemical vapour deposition, MOCVD)方法制备了Ga2O3薄膜,并对薄膜进行退火处理,制备了Ga2O3日盲紫外探测器,对器件的性能进行了测试和分析。文献[12]利用射频磁控溅射方法,通过调整溅射时间控制薄膜厚度,采用Au/Ti叉指电极在β-Ga2O3薄膜上制成金属-半导体-金属光电器件。目前,Ga2O3薄膜的制备方法主要有脉冲激光沉积法、分子束外延法、金属有机化学气相沉积法和磁控溅射法等。其中,磁控溅射法由于工艺简单、成本低廉成为许多科研工作者的首选方法[13]。磁控溅射法制备Ga2O3薄膜的试验中,温度、氧氩气体流量比和溅射功率对Ga2O3的材料特性有很大影响[14-15]。本文采用射频磁控溅射方法,在蓝宝石和硅片衬底上制备了一系列Ga2O3薄膜,研究了溅射功率对Ga2O3薄膜晶体结构、表面形貌以及光学特性的影响。
1 试验
本试验采用JGP300型超高真空磁控溅射镀膜设备,选用蓝宝石和硅片作为衬底,高纯Ga作为靶材,溅射气体为高纯氧气和氩气。首先,将衬底依次在丙酮(CH3COCH3)、乙醇(C2H5OH)和去离子水中各超声清洗5 min,然后用去离子水冲洗,氮气吹干,有效去除衬底表面的灰尘、杂质粒子和氧化层。在正式溅射之前,先进行5 min预溅射,有效去除Ga靶材表面杂质。制备过程的参数如下:采用涡轮分子泵和机械泵,使反应室本底真空小于1×10-3Pa;衬底与靶材间距为7 cm;溅射温度为450 ℃;溅射压强为0.5 Pa;氧氩气体流量比为4∶50;溅射时间为2 h;溅射功率分别为80 W、100 W、120 W和140 W。其中,溅射温度450 ℃是从以前数据中优化确定的。
分别采用X射线衍射仪(X-ray diffraction, XRD)、原子力显微镜(atomic force microscope, AFM)和紫外分光光度计(UV-2700)等测试手段分析所制备样品的晶体结构、表面形貌及光学特性。
2 结果与讨论
2.1 XRD物相分析

图1 不同溅射功率制备Ga2O3薄膜的XRD谱图
图1为不同溅射功率制备Ga2O3薄膜的XRD谱图。从图1中可以看出:除了位于41.7°附近来自衬底蓝宝石的衍射峰(006)外,共有3个来自Ga2O3薄膜的衍射峰,分别对应Ga2O3薄膜的(-201)、(401)和(-603)衍射峰。除了这3个衍射峰以外,没有出现其他Ga2O3晶面的衍射峰,说明随着溅射功率的增加,Ga2O3薄膜的晶体结构几乎没有改变。从图1中还可以看出:溅射功率从80 W升至100 W时,Ga2O3薄膜的(-201)、(401)和(-603)衍射峰强度均逐渐增强,(401)衍射峰对比于其他Ga2O3衍射峰占据明显优势,此时Ga2O3薄膜沿(401)晶面择优生长。随着溅射功率继续增加,达到120 W时,3个衍射峰强度均呈现出减弱的趋势,继续增加溅射功率至140 W,衍射峰强度继续减弱。可见,随着溅射功率的增加,Ga2O3衍射峰的强度呈现出先增强后减弱的趋势。这是因为,在一定范围内适当增大溅射功率,溅射电流密度和自偏压增大,在电场作用下被电离形成的氩离子携带能量增大,受氩离子轰击产生的溅射离子动能增大,溅射效率提高,使得结晶质量提高[3,16]。但溅射功率过高时,腔体内粒子能量和基片温度过高[17],导致粒子间互相碰撞,Ga2O3薄膜表面的组织结构受到损害,容易形成多孔洞,反而不利于提高Ga2O3薄膜的结晶质量。
Ga2O3薄膜的平均晶粒尺寸可用德拜-谢勒(Debye-Scherrer)公式进行计算,表达式[18]为:
(1)

表1 Ga2O3(401)衍射峰的半高宽(β)、晶面间距(d)以及平均晶粒尺寸(D)
其中:D为平均晶粒尺寸,nm;λ为X射线波长,为0.154 056 nm;β为相应衍射峰的半高宽(full width half maximum,FWHM),(°);θ为对应衍射峰的布拉格角,(°);K为谢勒常数,Ga2O3(401)衍射峰的半高宽对应的K为0.89。根据布拉格(Bragg)公式[3],可求出晶面间距d,表达式为:
2dsinθ=nλ,
(2)
其中:d为晶面间距,nm;λ为X射线波长,为0.154 056 nm;θ为对应该衍射峰的布拉格角,(°);n为任何正整数。Ga2O3(401)衍射峰对应的计算结果见表1。
由表1可知:样品在不同溅射功率下的半高宽分别为0.550°、0.521°、0.582°和0.610°,其结果相近于文献[19]中采用MOCVD方法制备的Ga2O3(401)衍射峰的半高宽(0.575 0°),原因在于溅射温度同为450 ℃,晶相趋于稳定。从表1中还可以看出:在溅射功率为100 W的条件下,平均晶粒尺寸最大,为16.4 nm,呈现出良好的结晶质量。当溅射功率达到140 W时,平均晶粒尺寸减小到14.0 nm,结晶质量相对较差,这是由于Ga2O3薄膜沉积速率过快,组织结构受到损害、存在孔洞所致。
2.2 表面形貌分析
溅射功率升高,原子的扩散会更加充分,薄膜内部组织会发生很大变化,同时其表面形貌也会受到很大影响。图2为不同溅射功率制备Ga2O3薄膜的三维AFM图。由图2可以看出:随着溅射功率从80 W升高到120 W,Ga2O3薄膜更加致密、均匀,表面缺陷较少,但溅射功率增加到140 W时,Ga2O3薄膜的致密性和均匀性降低。这可能是因为溅射功率过高导致晶体质量下降。在AFM测试中,表面粗糙度先增大后减小,从1.48 nm增加到2.49 nm,再逐渐减小到1.88 nm。可见,在溅射功率增加的过程中,表面粗糙度的变化趋势与表1中平均晶粒尺寸的变化趋势是一致的[20]。
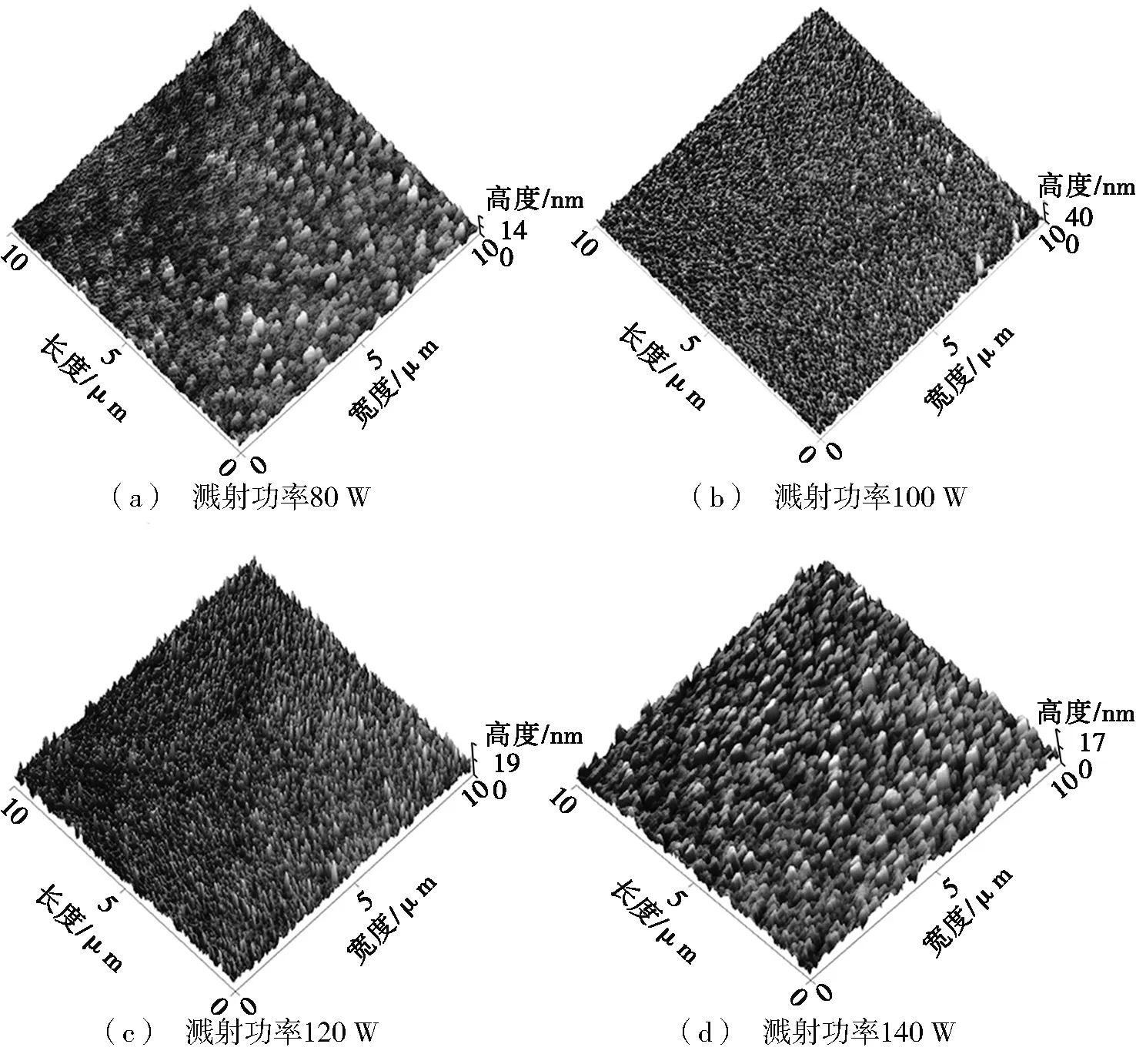
图2 不同溅射功率制备Ga2O3薄膜的三维AFM图
2.3 透射与吸收分析
入射光照射到半导体薄膜上时,会在表面发生反射和透射,透射率计算公式[18]为:
T=I0/I=(1-R)e-αd,
(3)
其中:I0为入射光强,cd;I为出射光强,cd;d为样品厚度,nm;R为样品表面的反射率,%;α为吸收系数,L/(g·cm-1);T为透射因数;R、α和T都是波长的函数。从透射因数T和波长的关系谱线中可以直观地反映出薄膜从紫外到红外各个波段的透射情况。图3为不同溅射功率下Ga2O3薄膜的透射曲线。采用以蓝宝石为衬底的Ga2O3薄膜进行测试,并且在测试过程中以蓝宝石作为参考以获得更加精准的数据。从图3中可以看出:制备的Ga2O3薄膜在可见光区域的平均透射率达到80%以上,最低透射率为79.83%。随着溅射功率从100 W增加到140 W,Ga2O3薄膜的透射率呈现先增大后减小的趋势,溅射功率为120 W时透射率最高,表明溅射功率为120 W时,Ga2O3薄膜的光学质量和表面平整度较好。当溅射功率进一步提高到140 W时,腔体内粒子间发生剧烈碰撞,Ga2O3薄膜表面的组织结构受到损害,表面不平整,加强了光的散射,导致透射率降低。另外,Ga2O3薄膜吸收波边为240~280 nm,随着溅射功率的增加,吸收边逐渐红移,一方面是因为晶粒尺寸增大,厚度增加;另一方面,高功率生长的薄膜表面晶粒分布更不均匀,从而导致吸收边缘向低能量转移[3]。
Ga2O3是一种直接带隙的半导体材料,在直接带隙半导体中,光子的吸收主要为导带与价带之间的本征吸收,所以Ga2O3薄膜的光学禁带宽度可由Tauc方程[18]得出,关系式为:
(αhν)2=A(hν-Eg),
(4)
其中:A为常数;α为吸收系数,L/(g·cm-1);hν为光子能量,eV;Eg为Ga2O3的光学带隙,eV。通过光子能量hν和(αhν)2的曲线关系图,作出线性部分延长线交X轴的截点,可估算光学带隙Eg。图4为不同溅射功率下Ga2O3薄膜的吸收曲线。由图4可得:溅射功率分别为80 W、100 W、120 W和140 W时,Ga2O3薄膜的光学带隙分别为5.20 eV、 5.08 eV、5.00 eV和4.90 eV,即随着溅射功率升高,光学带隙Eg逐渐变小。其原因可归结为:随着溅射功率增加,溅射出的靶材粒子增多,Ga2O3薄膜厚度增加,晶格应变减少,从而使带隙宽度Eg减小[3]。本文制备Ga2O3薄膜的光学带隙略大于文献[3]中采用磁控溅射法制得的Ga2O3薄膜的光学带隙(约为4.63 eV),其原因在于文献[3]中的溅射功率较大,为160~200 W,晶格应变较小,从而使得带隙较小。
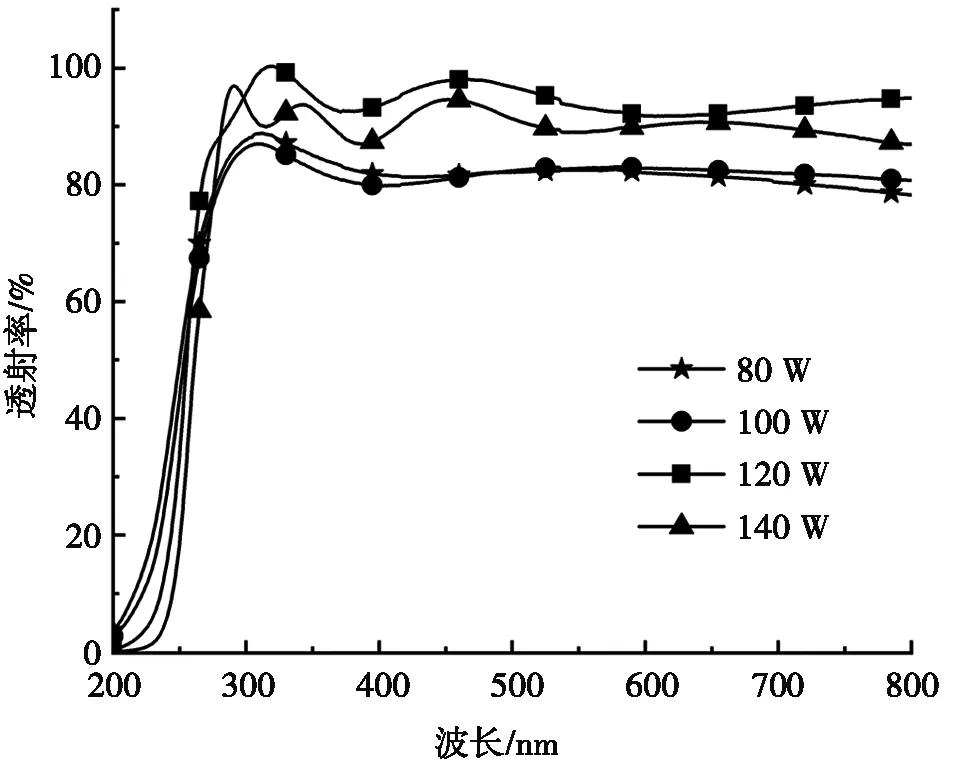
图3 不同溅射功率下Ga2O3薄膜的透射曲线
3 结论
(1)随着溅射功率的提高,Ga2O3衍射峰先增强再减弱,在溅射功率为100 W时达到最强,其中,(401)衍射峰占据明显优势。
(2)随着溅射功率的提高,平均晶粒尺寸与薄膜粗糙度均呈现出先增大后减小的趋势,结晶质量先提升后下降,与XRD谱图符合较好。
(3)随着溅射功率的提高,制备的Ga2O3薄膜在紫外波段的透射率呈现出先增大后减小的趋势。当溅射功率为120 W时,透射率达到最高,此时Ga2O3薄膜的光学质量和表面平整度较好。

