电荷耦合效应对高耐压沟槽栅极超势垒整流器击穿电压的影响*
徐大林 王玉琦 李新化 史同飞
1) (中国科学院合肥物质科学研究院固体物理研究所, 合肥 230031)
2) (中国科学技术大学, 合肥 230026)
3) (安徽建筑大学数理学院, 合肥 230022)
1 引 言
功率整流器件综合性能的提升一直是当今电力电子技术的核心问题.传统的功率整流器虽然得到了广泛应用, 却难以满足系统开关速度以及功率容量大幅提升后的性能需求.P-i-N 整流器利用电导调制效应来降低基区的导通电阻, 但在关断过程中需要抽取基区中大量的存储电荷, 较长的反向恢复时间限制了其在高频方面的应用.肖特基势垒整流器作为多子输运器件, 拥有极快的开关频率, 得益于内建电势远低于PN 结势垒, 热电子发射机制会形成较大的导通电流密度与较低的导通压降; 但是由于存在着金属-半导体界面, 镜像电荷效应会导致有效势垒高度的降低, 导致反向漏电流呈指数增长, 较低的击穿电压限制了其在高压电路中的应用.为了满足高频电力电子电路中对兼具高反向击穿电压、小反向漏电流、低导通压降、高开关速度的器件设计要求, 超势垒整流器(super barrier rectifier, SBR)应运而生[1-17].该类器件利用金属-氧化物-半导体(metal-oxide-semiconductor, MOS)结构形成的可调节的电子势垒来实现器件的开合, 其开关速度和正向导通压降可以媲美肖特基整流器,又因为摒除了信赖性较差的肖特基接触而提高了反向漏电流和击穿电压等方面的表现.相比于平面栅极结构的SBR, 沟槽栅极超势垒整流器(trenchgate-type SBR, TSBR)借助沟槽结构消除了JFET区内阻, 而且元胞节距可以制造得更小, 因此可以获得更低的导通压降.国内外已经发表的专利与论文主要聚焦于SBR 的特性分析与结构优化[1-12],专利[13-15]提出了TSBR 的新型结构及制造方法,文献[16]将肖特基势垒整合入TSBR 中, 并分析了基区掺杂浓度、台面宽度以及温度等因素对复合结构电学特性的影响.但是针对TSBR 反向阻断电压的相关研究, 特别关键结构参数对击穿电压的影响, 几乎处于空白.
本文利用器件仿真软件Sentaurus TCAD 来构造TSBR 的二维结构并进行器件模拟, 结合理论模型分析器件内部二维电场的分布规律, 揭示了电荷耦合作用[17]对器件反向承压能力的重要影响,并完成了关键参数的优化.最后提出了阶梯栅氧TSBR (stepped oxide TSBR, SO-TSBR)结 构,在保证反向承压能力的前提下, 大幅度降低器件的正向导通压降.
2 TSBR 的结构与理论模型
TSBR 的元胞结构截面示意图和原理图如图1所示, 可视为一个金属氧化物半导体场效应管(metal-oxide-semiconductor field-effect transistor, MOSFET)与一个PN 二极管的并联结构,MOSFET 的栅极/源级/衬底短接并作为阳极, 漏极作为阴极.MOS 结构使硅表面的能带发生弯曲,P 型基区表面的反型层构成导电沟道, 同时N—漂移区表面形成了积累区, 两个区域之间的能带差构成了正向导通势垒.当TSBR 在较低的正向偏压条件下导通时, 由于正向导通势垒远低于基区与漂移区形成的P+N 结势垒, 几乎所有的电流都经沟道由电子进行传输, 同时可以忽略注入漂移区的少数载流子, 提高了器件的开关速度.器件反向偏置时主要依靠低掺杂的漂移区来承担电压, 导电沟道与N+区域之间的势垒也影响着反向漏电流的大小.无论是正向还是反向的势垒高度, 都可以利用栅氧厚度和基区掺杂浓度来调整[16].得益于这种特性, 超级势垒器件因此得名, 器件优化时也会更有效地实现通态压降和反向漏电流之间的良好折衷.

图1 TSBR 结构及原理图(G, 栅极; S, 源极; D, 漏极)Fig.1.Structure and schematic diagram of TSBR (G, gate electrode; S, source electrode; D, drain electrode).
当TSBR 反向偏置时, 不仅P+N 结势垒会使漂移区中的耗尽层沿纵向扩展, MOS 结构也会促使耗尽层沿栅氧外壁的法线向外延伸, 两者作用下产生的二维电荷耦合改变了电场的分布.这种电荷耦合效应[17]可以用电荷平衡耐压原理[18]来解释:漂移区内电离施主正电荷产生的电力线大部分终止于MOS 结构的栅极金属, 只有很少一部分终止于基区的电离受主负电荷, 这将有效减小P+N 界面的纵向电场强度, 使耦合影响区内的导通电阻随着击穿电压准线性增大, 而不像一维结构以更快的二次方增长.图2 中用虚线标示出了电荷耦合区的范围, 并将基区与漂移区形成的P+N 结界面设定为x 轴, 台面的中轴线定义为y 轴.沟槽栅氧厚度τox、台面宽度Wms、栅极深度L 和沟槽深度Dt也在图中标示, 其中L = Dt— τox.本文中将L 和Dt定义为栅极及沟槽栅氧伸出基区的长度.

图2 耗尽区和关键点示意图Fig.2.Schematic diagram of the depletion and key points.
电荷耦合区的二维电场强度由横向电场Ex与纵向电场Ey共同决定.当横向电场Ex变为零时,电荷耦合效应消失, 电场重新变为了一维分布.在非耦合区, 电场的一维分布使相同纵坐标的电场及电势重合, 电场沿y 方向呈线性分布, 衰减斜率为qND/εs, 其中εs为硅的介电常数, q 为电子电荷的绝对值, ND是漂移区掺杂浓度.非耦合区的承压由非耦合区最大场强和非耦合区厚度D 决定.图2中的D 点与E 点位于耦合影响区和非耦合区的分界线上, 横向电场EDx= EEx= 0 且纵向电场EDy=EEy, 因此可以用D 点的总场强|ED|表示非耦合区的最大场强.
考虑到沟槽栅氧的尖锐边角处会有电场增强而导致雪崩击穿, 可通过使槽型结构更加圆滑来解决该问题[19].对沟槽栅氧进行圆角化处理后, 发生雪崩击穿的位置转移到了圆角与栅氧侧壁或底面的交界点, 在图2 标记为B 点与C 点.A 点、D 点与F 点位于台面的中轴线上, 其中F 点位于P+N结界面; E 点与C 点的横坐标相同.由于D 点与E 点的电势相同, 因此F 点到D 点之间耦合影响区承受的反向偏压, 与底部氧化层和C 点到E 点之间耦合影响区共同承受的反向偏压[20]相同.
要判断发生雪崩击穿的具体位置, 需要对B 点与C 点的场强进行估算.将P+N 结界面电势设定为0, 通过求解均匀掺杂漂移区内的Poisson方程, 可以得到耦合影响区内横向电场和纵向电场的表达式[21]:

式中, u(y)为台面中心的电势,

其中台面中心承压Vcc是A 点(0, L)处的电势;λ 为横向衰变长度,

其中εox为氧化层介电常数.
通过(1)式可知, 栅极深度L 不会影响横向电场Ex的分布.由于器件的对称结构, 台面中心的横向电场Ex将始终保持为零.由(2)式推导出A点的纵向电场:

其中, 耦合系数S = εsVcc/(qλ2), 可以用来衡量一定承压条件下的电荷耦合强度, 如果保持中心承压Vcc不变, 横向衰变长度λ 越短, 耦合系数S 越大, A 点的纵向场强|EAy|越大.栅氧厚度τox很大程度上决定了中心承压Vcc的大小.由于在相同纵坐标的位置, C 点到E 点间的纵向场强要高于台面中心的纵向场强, 所以该区域的电势将低于相同纵坐标的台面中心位置的电势.因此在沟槽圆角化半径较小时, 可以假设C 点的电势也为Vcc, Vcc将全部由底部栅氧承担, 则C 点的纵向场强为

对于阻断电压超过200 V 的高耐压TSBR, 由于边缘效应会使击穿电压只能达到平行平面结击穿电压值的80%左右, 因此漂移区掺杂浓度ND≤1.2 × 1015cm—3.同时考虑到实际工艺中沟槽栅氧厚度τox≤ 300 nm, 因此Vcc不会超过28 V.为了形成耦合影响区, 横向衰变长度λ 必须足够小,来保证相邻沟槽的耗尽层重叠, 这将导致耦合系数S ≫ ND, A 点的纵向场强可以简化为

由(4)式可知, |EAy|将随着栅极深度L 的升高而降低.当栅氧厚度τox增大时, 中心承压Vcc以及B 点的场强也会随之增大.为了便于比较与说明, 将沟槽圆角化半径设定为τox, B 点坐标即为(Wms/2, L), 由(1)式与(2)式可以推导出B 点的横向和纵向电场表达式:

可以看到, 通过增大栅氧厚度τox来增大中心承压Vcc, 或者通过减小Wms的方式, 都可以增大耦合系数S, 使B 点的横向场强、纵向场强以及总场强|EB|增大.当|EB| > |EC| 时, 雪崩击穿将会出现在栅氧侧壁SiO2/Si 界面处的B 点.
3 关键参数的优化
当漂移区的掺杂浓度及厚度固定时, 通过第2 节理论模型的分析可以确定栅氧厚度τox、台面宽度Wms和沟槽深度Dt是影响器件承压能力的关键参数.将结合器件仿真来对这些关键参数做进一步的讨论.为了便于比较非耦合区的电场分布,模拟时将底部栅氧与漂移区的SiO2/Si 界面设定为x 轴, 这与第2 节理论模型中使用的坐标系不同.器件模拟中维持不变的参数包括: 采用N 型重掺杂多晶硅作为栅极材料, 掺杂浓度为5 × 1020cm—3; 沟槽栅极宽度为1.1 μm, P+与N+掺杂浓度均为1 × 1018cm—3, 漂移区厚度与掺杂浓度分别为16 μm 与9 × 1014cm—3, 基区厚度与掺杂浓度分别为0.8 μm 与5 × 1016cm—3, 沟槽栅氧圆角化半径为0.5 μm.
图3 为栅氧厚度τox从25 nm 增长到250 nm时, 沟槽深度Dt对击穿电压的影响, 模拟时保持台面宽度Wms为2 μm.当τox= 200 nm, Dt=1.36 μm 时, 击穿电压到达最高值272.3 V.下面针对三种栅氧厚度, 讨论沟槽深度Dt对击穿电压的影响.

图3 不同τox 条件下击穿电压随Dt 的变化趋势Fig.3.The Dt dependence of the breakdown voltage with various τox.
1) 当栅氧较薄时, 击穿电压随Dt的增大而单调下降.图4 所示是τox= 50 nm 条件下发生雪崩击穿时, Dt对台面中心电场分布的影响.由(3)式可知, 较薄的底部栅氧厚度决定了台面中心承压Vcc较低, 雪崩击穿出现在底部栅氧的C 点.较低的Vcc导致了耦合系数S 的不足, 并通过(4)式影响着A 点的纵向场强|EAy|.当Dt增大时, 不仅会降低|EAy|, A 点与D 点之间耦合影响区的纵向场强和电势都会随之整体降低, 非耦合区最大场强|ED|的降低也减小了非耦合区的承压, 最终造成了击穿电压的下降.
2) 当栅氧厚度增大到可以保证耦合影响区的承压能力时, 存在着最优沟槽深度使器件获得最大阻断电压.图5(a)所示是τox= 200 nm 条件下发生雪崩击穿时Dt对台面中心电场分布的影响,图5(b)中B 点总场强|EB|总是大于C 点总场强|EC|的现象则表明, 无论如何调节Dt, 雪崩击穿只会出现在侧壁栅氧界面处的B 点.进一步对比图3 与图5(b)可以发现, 非耦合区最大场强|ED|的变化趋势与击穿电压保持一致, |ED|的最大值也出现在Dt= 1.36 μm 的最优沟槽深度条件下.由(6)式可知, 纵向场强|EBy|随着沟槽深度Dt的增大而降低, 与|EAy|保持相同的变化趋势.在B 点总场强|EB|保持为击穿临界电场Em的前提下, |EBy|的降低会导致横向场强|EBx|和中心承压Vcc的增大, C 点的纵向场强|ECy|也随之增大.非耦合区最大场强|ED|主要由|EAy|与|ECy|来决定, 在沟槽深度Dt较小时, |ECy|的影响占据主导, |ED|随着Dt的增大而增大, 在超过最优沟槽深度的窗口后,|ED|开始随着|EAy|的降低而降低, 器件的承压能力也随之下降.

图4 薄栅氧条件下Dt 对台面中心电场分布的影响Fig.4.Effect of Dt on the electric field distribution at the medial axis of the mesa with the thinner oxide.

图5 τox = 200 nm 时Dt 对台面中心电场分布(a)以及关键点场强(b)的影响Fig.5.Effects of Dt on the electric field distribution at the medial axis of the mesa (a) and the magnitude of the total electric field at key points (b) when τox = 200 nm.
3) 当栅氧厚度继续增大时, 通过(3)式可知,在相同Vcc的条件下会造成|ECy|的下降, 进而降低了非耦合区的最大场强|ED|和反向承压.因此需要更深的沟槽来提高Vcc与|ECy|, 来获得该栅氧厚度条件下的最高阻断电压.这与图3 中最优沟槽深度随着τox的增大而增大的事实相符.
台面宽度Wms也是影响耦合强度S 的重要参数, 在τox= 200 nm, Dt= 1.36 μm 的条件下发生雪崩击穿时, Wms对台面中心电场分布的影响如图6 所示.当Wms较小时, 较大的耦合系数S 使击穿临界电场出现在侧壁栅氧的B 点.根据(5)式和(6)式可以得到B 点纵向与横向场强之比:

Wms的增大会导致比值T 的减小, 在B 点总场强|EB|保持为击穿临界电场Em的前提下, 意味着B 点的横向场强|EBx|随着Wms的增大而增大.由(5)式可知, 这会造成Vcc的上升, 并伴随着C点纵向场强|ECy|的增大, 这些变化补偿了A 点纵向场强|EAy|下降对非耦合区最大场强|ED|的影响,这也在图6 中得到了印证, Wms等于0.4 μm 和2 μm 两种条件下, 非耦合区的电场分布出现重合.当Wms= 2 μm 时, 器件的承压能力最优.当Wms继续增大时, 耦合系数S 以及|EAy|会迅速降低, 电荷耦合效应逐渐减弱直至失效, 导致非耦合区最大场强|ED|和器件承压能力的下降.

图6 Wms 对台面中心电场分布的影响Fig.6.Effect of Wms on the electric field distribution at the medial axis of the mesa.
4 阶梯栅氧TSBR 的提出与优化
虽然增大栅氧厚度可以提高TSBR 的击穿电压, 但是会带来正向导通压降的增加.基于以上矛盾, 设计了SO-TSBR 结构, 其栅氧结构类似于双沟槽MOSFET 的阶梯栅氧结构[22], 但作用机理与效果全然不同.SO-TSBR 在保证底部栅氧承压能力的同时, 降低了正向导通时的沟道电阻.
器件仿真构建的SO-TSBR 结构如图7 所示,保持底部栅氧厚度τox= 200 nm、台面宽度Wms=2 μm.与常规结构不同的是, SO-TSBR 的横向衰变长度λ 变为

其中Tso为侧壁栅氧厚度.随着Tso的降低, 使横向衰变长度λ 变小.由(2)式可以推导出F 点纵向场强表达式:


图7 SO-TSBR 结构图Fig.7.Structure of SO-TSBR.
|EFy|随着λ 的变小而降低, F 点及A 点之间耦合影响区的纵向场强和电势都会随之整体下降, 台面中心承压Vcc的下降又导致|EFy|进一步地降低.虽然变小的横向衰变长度, 在一定程度上减缓A 点纵向场强|EAy|的下降幅度, 但依然无法阻止台面中心承压Vcc的下降趋势, 导致C 点纵向场强|ECy|以及器件的整体承压随Tso的降低而小幅下降.与Tso降低的效果类似, 阶梯深度Dso的增大也会降低F 点的纵向场强和器件的阻断电压, 出于工艺裕量的考虑, 无法使Dso为零, 因此在模拟中将Dso设定为0.3 μm.图8 分别给出了Tso从25 nm 增长到200 nm 时, 击穿电压随Dt的变化趋势, 其中Tso= 200 nm 作为常规结构进行对比.可以看到, 无论如何变化Tso, 最优沟槽深度依然为1.36 μm, 这是由相同厚度的底部栅氧所决定的.不同Tso条件的击穿电压峰值差距不超过1 V, 证明阶梯栅氧结构达到了提高击穿电压的预期效果.对比图3 与图8 可以发现, 当Tso= 25 nm 时击穿电压峰值为271.5 V, 与常规结构(243.5 V)相比增长了11.55%.

图8 不同Tso 条件下SO-TSBR 击穿电压随Dt 的变化Fig.8.The Dt dependence of the breakdown voltage with various Tso.
通过减小Tso可以增大基区反型层能带的弯曲幅度, 从而降低了超势垒的高度, 在降低正向导通压降的同时, 也会带来反向漏电流的增大, 因此需要考虑工作周期占空比等因素进行折衷选择.图9 给出了不同Tso条件下器件的正向导通特性,当Tso≥ 60 nm 时, 正向导通电压不会有明显的降低, 说明正向导通势垒高度趋于稳定.当通态电流密度为2.5 A/cm2时, Tso= 25 nm 条件下的导通压降为0.303 V, 与常规结构(0.585 V)相比降低了51.49%.观察图10 所示的漏电流, 虽然Tso=25 nm 条件下的漏电流远大于常规结构的数值, 但由于漏电流小于正向导通电流约5 个量级, 其较大的漏电流仍然是可以接受的.根据实际的应用需求, 也可以选择Tso= 40 nm 作为最佳器件参数,在漏电流略有增大的情况下, 正向导通压降降低了25.77%.
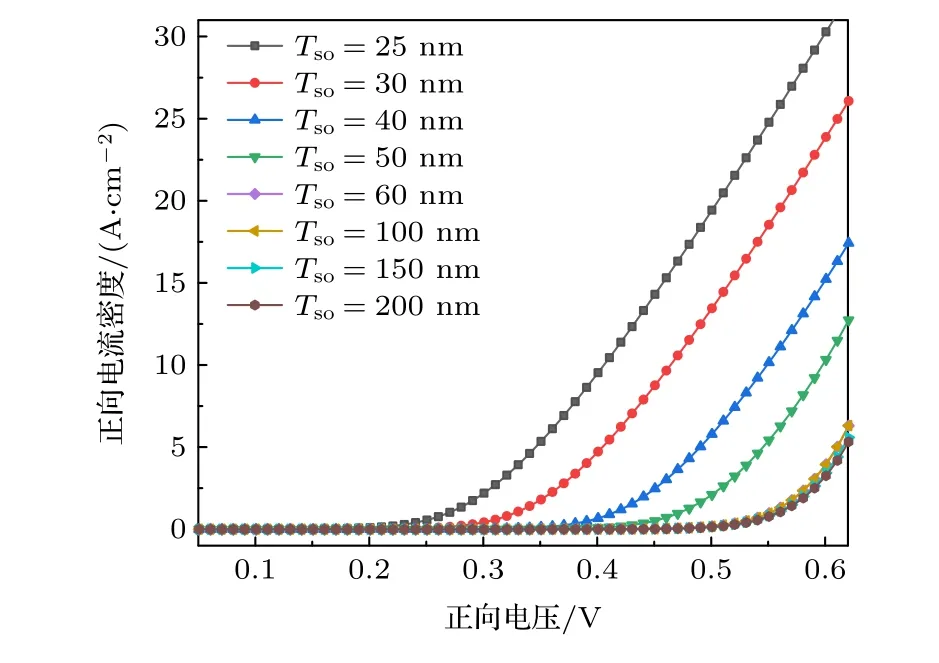
图9 Tso 对正向导通特性的影响Fig.9.Effect of Tso on forward characteristics.
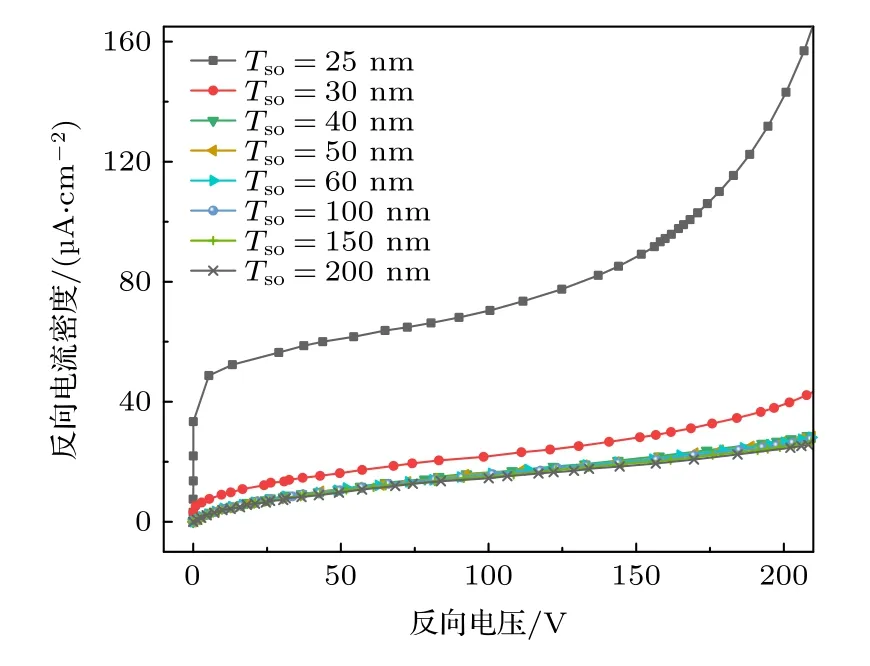
图10 Tso 对反向漏电流的影响Fig.10.Effect of Tso on the reverse leakage currents.
5 结 论
本文利用数值理论模型与器件仿真软件Sentaurus TCAD, 系统地分析了栅氧厚度、台面宽度和沟槽深度对TSBR 电荷耦合区电场分布的影响,进而完成了对影响击穿电压关键参数的优化.最后提出了阶梯栅氧结构(SO-TSBR), 在保证反向承压能力的同时, 正向导通压降可以降低51.49%.

