退火温度对AZTO薄膜晶体管电学特性的影响
左欢欢,王 超,杨 帆
吉林建筑大学 电气与计算机学院,长春 130118
0 引言
由于金属氧化物薄膜晶体管(Thin film transistor,英文缩写为TFT)相比于传统的非晶硅(Amorphous silicon,英文缩写为A-Si)薄膜晶体管具有高载流子迁移率、良好的光学透过率而受到越来越多的关注[1].目前,广泛研究的金属氧化物半导体材料有铟镓锌氧化物(Indiumgalliumzincoxide,英文缩写为IGZO),IGZO-TFT具有很多优点,比如迁移率较高、栅绝缘层选择广泛(SiO2,SiNx,Y2O3,HfO2),均匀性好等,这些优势使其在有源矩阵液晶显示器(Active matrix liquid crystal display,英文缩写为AMLCD)和有源矩阵有机发光二极管显示器(Active matrix organic light emitting diode display,英文缩写为AMOLEDD)等平板及柔性显示领域倍受人们的青睐[2].尽管IGZO-TFT具有良好的器件性能,但其组成元素铟(In)、镓(Ga)均为稀有元素,经济成本很高[3],不利于广泛制备,因此研究不含In,Ga类金属氧化物逐渐成为热点[4],其中铝锌锡氧化物(Aluminium zinc tin oxide,英文缩写为AZTO)所含元素储量大,价格便宜,并且AZTO-TFT也具有很高的载流子迁移率和良好的器件性能,因而成为无铟类金属氧化物材料的代表[5].
本文拟通过射频磁控溅射方法,沉积AZTO薄膜,在高温下退火后制备成TFT,并利用半导体参数仪测试不同退火温度下器件的性能.
1 实验
本实验采用美国Kurt J.Lesker磁控溅射设备沉积AZTO薄膜,Si(004)衬底上具有285 nm SiO2介电层,靶材由ZnO,AI2O3,SnO2粉末混合烧结而成,掺杂的质量百分比为ZnO∶Al2O3∶SnO2=58∶2∶40,氩氧比为99∶1,溅射气压为8 m Torr,溅射功率为100 W,衬底温度为常温.然后在空气气氛下对薄膜进行30 min的退火,退火温度分别为400 ℃,450 ℃,500 ℃,600 ℃.将退火处理后的薄膜通过与金属掩膜板贴合,再次通过磁控溅射设备沉积电极银,制备成TFT器件.
本实验没有采用传统的湿法光刻技术蒸镀电极,而是直接在薄膜上贴合金属掩膜板沉积电极,薄膜晶体管的结构如图1所示.
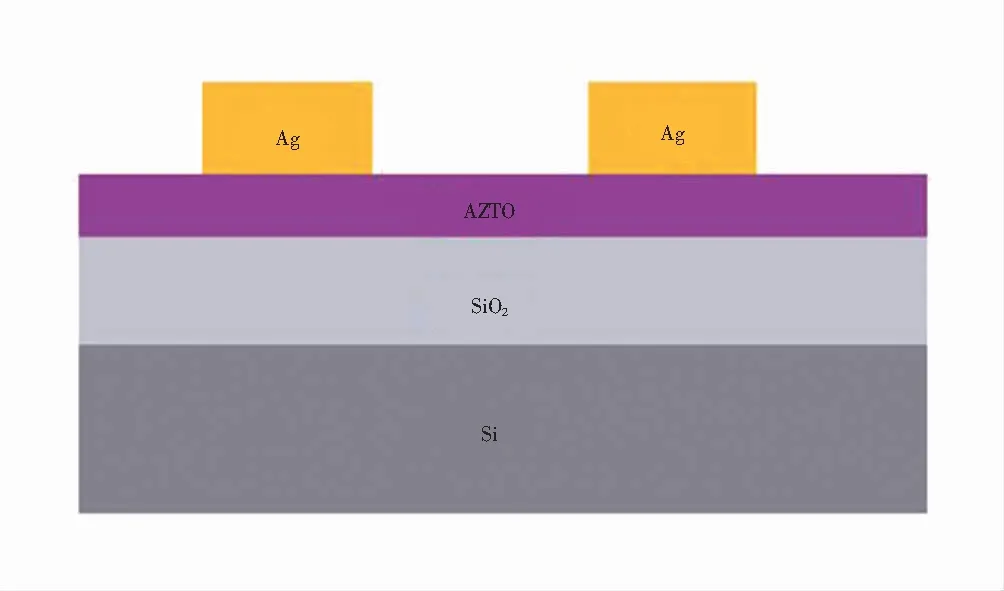
图1 AZTO薄膜晶体管结构Fig.1 Structure of AZTO thin film transistor
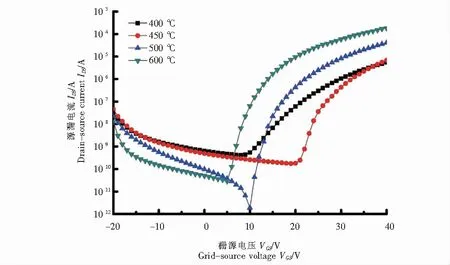
图2 不同退火温度下AZTO-TFT的转移特性曲线Fig.2 Transfer characteristics of AZTO-TFT at different annealing temperatures
2 结果与讨论
图2为不同退火温度下TFT的转移特性曲线即源漏电流IDS-栅源电压VGS曲线, 源漏电压VDS为20 V,栅源电压VGS范围为-20 V~+40 V.由图2可知,所有器件都存在转移特性,具有明显的关态区和开态区[6],当退火温度由400 ℃升至500 ℃时,AZTO-TFT器件的电流开关比由1.24×104增至2.16×107,当温度升至600 ℃时,器件的电流开关比则又由2.16×107降至6.29×106,整体呈现先增大后降低的趋势,当退火温度为500 ℃时,器件的电流开关比达到最大,其值为2.16×107.
图3~图6为源漏电压VDS为20 V时的IDS1/2-VGS曲线,作曲线的斜率延长线,其与横坐标的交点为器件的阈值电压[7],经拟合得到每个器件IDS1/2-VGS曲线中直线段的斜率分别为1×10-4,2×10-4,3×10-4,5.5×10-4.器件在饱和区工作时的场效应迁移率由下式计算:

(1)
Ci=εrε0/dinsulator
(2)
式中,K为IDS1/2-VGS曲线中拟合出的斜率;L/W为沟道的长宽比[8],其中长度L和宽度W分别为200 μm和1 000 μm;Ci为绝缘层单位面积的栅电容, nF/cm2,本文中的Ci为12.1 nF/cm2;εr为绝缘层材料的相对介电常数(即绝缘层材料介电常数与真空介电常数之比);ε0为真空介电常数,nF/cm,其值为8.85×10-5nF/cm;dinsulator为绝缘层的厚度,cm.
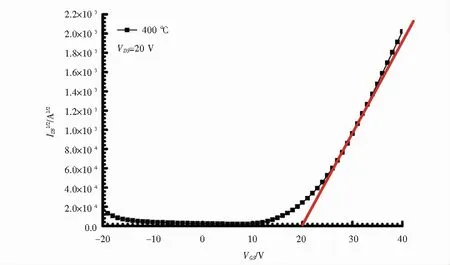
图3 400 ℃退火的AZTO-TFT的IDS1/2-VGS曲线Fig.3 IDS1/2-VGS curve of AZTO-TFT annealed at 400 ℃
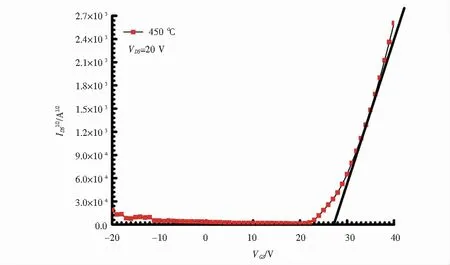
图4 450 ℃退火的AZTO-TFT的IDS1/2-VGS曲线Fig.4 IDS1/2-VGS curve of AZTO-TFT annealed at 450 ℃
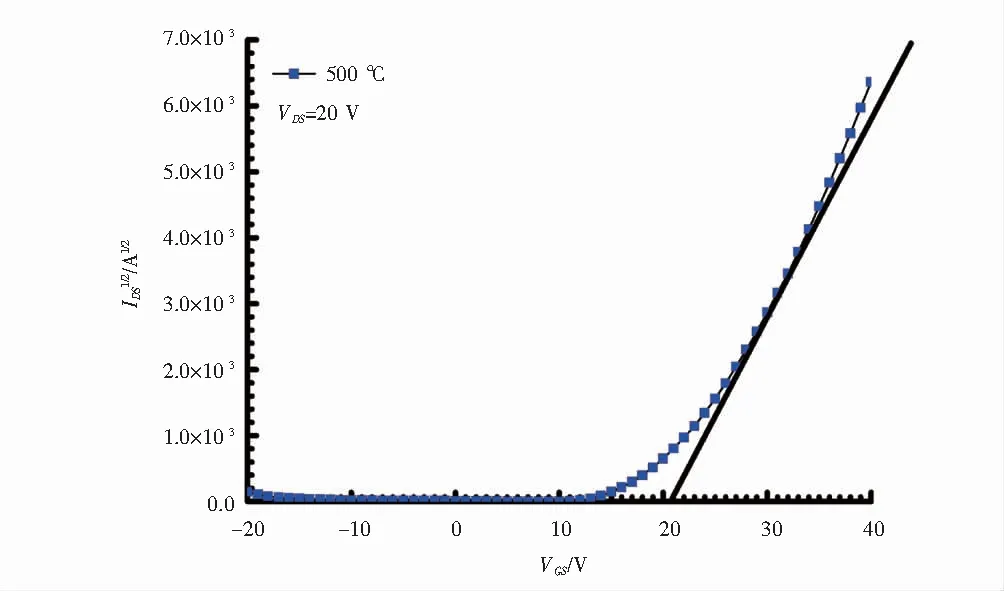
图5 500 ℃退火的AZTO-TFT的IDS1/2-VGS曲线Fig.5 IDS1/2-VGS curve of AZTO-TFT annealed at 500 ℃
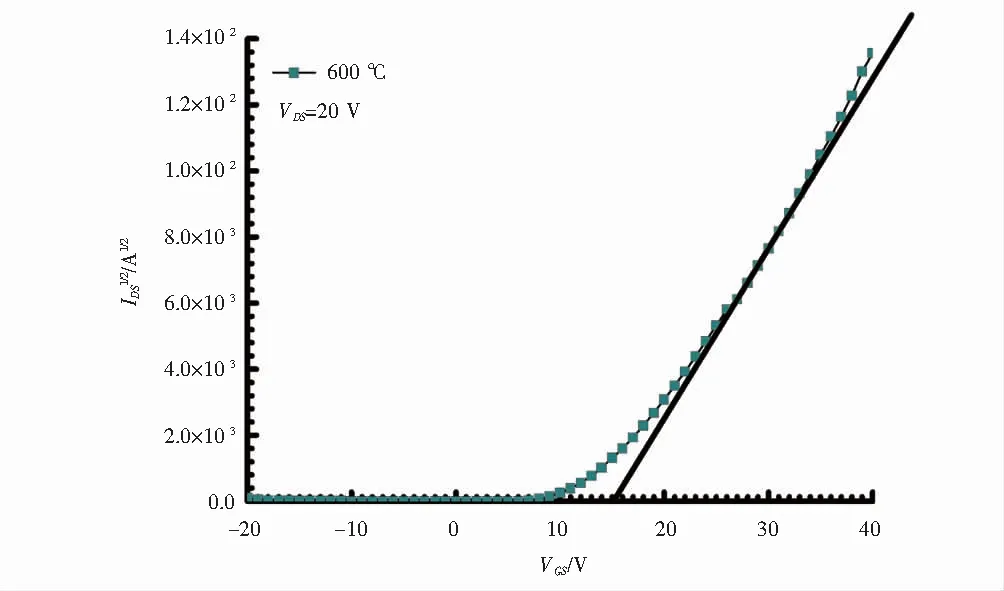
图6 600 ℃退火的AZTO-TFT的IDS1/2-VGS曲线Fig.6 IDS1/2-VGS curve of AZTO-TFT annealed at 600 ℃
表1给出了不同退火温度下器件的电学性能参数.
由表1可知,随着退火温度的升高,器件的阈值电压先增大后降低,在退火温度为600 ℃时,阈值电压达到最低为13 V,所需驱动电压最小,器件的能耗也最小[9].器件的迁移率从0.33 cm2/(V·s)增至10.00 cm2/(V·s),显著增大,本文推测可能是由于温度的升高,薄膜中的氧空位降低有利于提高迁移率,其中一种完全电离的氧空位以浅施主形式在导带底附近存在,另外一种非电离的中性氧空位以深缺陷的形式存在,随着退火温度的不断升高,更多的氧空位就会电离出电子,从深缺陷状态转移成为浅施主状态[10],因此自由电子会大量增多,迁移率也随之增大.2019年上海大学杨祥等[10]人的研究结果与本文得到的规律相同.综合考虑,器件在600 ℃高温退火的状态下性能最佳,阈值电压最低,迁移率最高,开关比为6.29×106.

表1 不同退火温度下AZTO-TFT的电学性能Table 1 Electrical properties of AZTO-TFT at different annealing temperatures
3 结语
本文通过磁控溅射方法,制备了AZTO-TFT,并对不同退火温度下器件的电学特性做了研究,随着退火温度的升高,可能是由于氧空位的减少,器件的迁移率得到了较大的提高,相反阈值电压得到降低.总而言之,通过高温退火,得到了迁移率和开关比高、阈值电压小的器件,说明高温退火对提高器件的性能具有很大的帮助,由此加深了对TFTs器件性能的理解,为将来制备高迁移率的AZTO-TFT奠定一定的基础.

