类金字塔状GaN微米锥的形貌及发光性能
仝广运, 贾 伟*, 樊 腾, 董海亮,李天保, 贾志刚, 许并社
(1. 太原理工大学 新材料工程技术研究中心, 山西 太原 030024;2. 太原理工大学 界面科学与工程教育部重点实验室, 山西 太原 030024)
1 引 言
GaN材料具有优异的物理、化学性能,常常被应用在各种光电子器件中,例如:发光二极管(LED)、激光器、探测器和晶体管[1-3]。近年来,基于GaN材料的蓝光LED更是得到了长足的发展,发光效率已经超过了300 lm/W[4]。但是,商用GaN基LED仍然有许多问题需要解决,这些问题限制了LED的进一步发展和应用。第一,GaN材料的晶体结构是六方纤锌矿,N原子和Ga原子的电负性不同,在GaN中存在自发极化效应。InGaN/GaN多量子阱外延后,由于InGaN和GaN之间较大的晶格失配和热失配又会产生一个很强的压电极化,极化效应会使InGaN/GaN多量子阱能带倾斜,电子空穴波函数在K空间发生分离,产生量子限制斯塔克效应,导致发光波长红移,发光效率下降[5-6]。第二,商用二维GaN基LED薄膜由于各功能层间存在全反射,光抽取率较低,进一步降低了发光效率[7]。第三,在商用二维GaN基LED薄膜中,发光波长比较单一,难以直接实现白光及多彩发光[8]。第四,商用二维GaN基LED薄膜难以实现柔性发光[9]。
近年来,研究者们发现GaN微纳阵列结构可以很好地解决以上问题,其主要原因是GaN微纳阵列结构的InGaN/GaN多量子阱是生长在半极性或非极性面上的,具有较低的内建电场和较大的发光面积及光抽取率[10-11]。类金字塔状GaN微米锥作为GaN微纳阵列的典型代表,更是吸引了科学家们的注意,例如,Wang等的研究结果表明,类金字塔状GaN微米锥的半极性面具有很低的极化场和较高的In并入效率[12];Cho等发现,在同一个类金字塔状GaN微米锥上可以同时存在量子点、量子线、量子阱3种结构,实现宽光谱发射[13];CHOI等通过制备高密度的类金字塔状GaN微米锥得到了很高的光抽取率[7];Tian等通过类金字塔状GaN微米锥实现了高光效的柔性LED[14]。但到目前为止,类金字塔状GaN微米锥的发光机理与结构之间的关系尚不完全明确,仍需进一步的研究。
本文通过MOCVD原位沉积SiNx掩模层后,首先制备了类金字塔状GaN微米锥,随后外延生长了3个周期的InGaN/GaN多量子阱,并分析了InGaN/GaN多量子阱沉积前后类金字塔状GaN微米锥顶端形貌变化的原因。结合阴极荧光光谱、微区光致发光光谱和透射电子显微镜详细阐释了其微观结构与发光性能之间的关系,并通过原子迁移模型解释了其多波长发射机理。
2 实 验
2.1 类金字塔状GaN微米锥的生长
本实验采用Aixtron公司的TS300型MOCVD,首先在非掺杂的GaN薄膜上原位生长SiNx掩模层,随后生长出了类金字塔状GaN微米锥,具体生长工艺已在我们之前的工作中详细介绍[15]。本实验是在类金字塔状GaN微米锥上继续生长了3个周期的InGaN/GaN多量子阱,生长过程中所用载气是N2,反应源分别为三甲基镓(TMGa)、三乙基镓(TEGa)、三甲基铟(TMIn)和NH3。GaN垒层的生长温度是850 ℃,NH3和TMGa的流量分别是4 500 cm3·min-1和55 cm3·min-1,生长时间1 000 s;InGaN阱层的生长温度是730 ℃,NH3、TEGa和TMIn流量分别是4 500,50,20 cm3·min-1,生长时间600 s。整个外延生长过程中,反应腔压力始终保持在40 kPa。
2.2 透射样品的制备
本实验利用TASCAN公司的LYRA3聚焦离子束双束系统(FIB)制备透射样品,InGaN/GaN多量子阱是生长在类金字塔状GaN微米锥的半极性面上的,其切割流程如图1所示。为了保证类金字塔状GaN微米锥待测部分不被破坏,首先在其表面沉积一层SiO2作为保护层, 如图1中黑色矩形区域所示。利用铂离子束沿着矩形的两条长边垂直向下切割,得到了厚度只有1 μm左右的透射样品。随后用Ga离子轰击的办法对透射样品进行减薄处理,将被观测区域厚度减少至100 nm以内,最后使用FIB的机械手将其转移到铜网上。

图1 FIB制备透射样品示意图
Fig.1 Schematic diagram of preparation of TEM samples by FIB
2.3 测试方法
本实验通过日本电子株式会社JSM6700F型扫描电子显微镜(SEM)表征InGaN/GaN多量子阱生长前后类金字塔状GaN微米锥的形貌;利用MonoCL3+阴极荧光光谱(CL)和LabRAM HR Evolution微区光致发光光谱(μ-PL)对半极性面的发光性能进行了详细的研究。通过株式会社JEOL-2010透射电子显微镜(TEM)表征了半极性面上生长的InGaN/GaN多量子阱形貌并分析了其发光机理。
3 结果与讨论
图2是单个类金字塔状GaN微米锥的SEM图,其中图2(a)为侧视图,可以看到类金字塔状GaN微米锥的高度约为7.5 μm,底边长8 μm左右,从图中得知其侧面与底面夹角为62°,利用公式1可以计算出六方晶系的晶面夹角,公式如下:



图2 单个类金字塔状GaN微米锥的SEM图。 (a)侧视图;(b)InGaN/GaN多量子阱沉积之前的俯视图;(c)InGaN/GaN多量子阱沉积之后的俯视图。
Fig.2 SEM images of a single GaN micro-pyramid. (a) Lateral view. (b) GaN micro-pyramid before MQWs deposition. (c) GaN micro-pyramid after MQWs deposition.
图3是单个类金字塔状GaN微米锥上InGaN/GaN多量子阱的CL图。从图3(a)中可以发现类金字塔状GaN微米锥底部一圈六边形区域以及顶端处颜色差别较大,可能是In原子的含量不同导致。为此,在类金字塔状GaN微米锥半极性面上自下而上依次选取了7个点做了CL谱分析,结果如图3(b)所示,每条曲线都有两个发射峰,370 nm左右的峰是GaN的本征发光峰,420 nm左右是InGaN/GaN多量子阱的峰。沿着类金字塔状GaN微米锥的半极性面自下而上,InGaN/GaN多量子阱的发光峰先蓝移后红移。InGaN材料中,随着In元素含量的增加,其禁带宽度减小,发光波长红移。可见在类金字塔状GaN微米锥上,随着位置自下而上,In含量分布先减少后增加,在其底部和顶端是In含量较高的地方。

图3 (a)单个类金字塔状GaN微米锥的CL图;(b)不同位置InGaN/GaN多量子阱的CL发射谱。
图4是InGaN/GaN多量子阱在不同激发功率密度下的室温μ-PL光谱图,其激发源是325 nm的激光器,光斑直径大小约为6 μm。图中黑色的发光峰是原始数据,对其高斯拟合之后得到了波长分别在406 nm(峰一)、424 nm(峰二)和442 nm(峰三)附近的3个峰,图5(a)是不同功率下3个峰的峰位变化图。可以看到,随着激发功率密度的增加,3个峰的峰位均有小幅度的蓝移,蓝移量分别是1.54,2.70,3.11 nm。对于InGaN/GaN多量子阱来说, PL激发功率密度的增加导致波长发生蓝移由两种机制共同影响。其一是载流子屏蔽极化场效应,当激发功率密度增加时,光生载流子的数目也随之增加,部分光生载流子会在极化场的作用下迁移,从而达到屏蔽极化场的效果,这使得能带变平整,同时发光波长蓝移,半高宽减小[19]。其二是能带填充效应,由于InGaN层的厚度很薄,载流子只能做准二维运动,当激发功率密度增加时,光生载流子填满较低的能级后会去填充更高的能级,这也会导致发光波长蓝移,同时半高宽增加[20]。因此,可以通过半高宽的变化来判断究竟何种因素占据主导地位。此外,由于3个发光峰的蓝移量很小,可以证明类金字塔状GaN微米锥的半极性面上的InGaN/GaN多量子阱极化场很小[12]。
图5(b)是μ-PL中不同发光峰的半髙宽,可以看出,峰一的半高宽随激发功率密度的增加而减小,峰二则先减小后增加,而峰三则一直增加,结合CL结果,峰一波长最短,对应于半极性面中心区域,峰三波长最长,对应于类金字塔状GaN微米锥顶端及底面处,因此,峰一的蓝移可以归因于载流子屏蔽极化场效应,而峰三的蓝移却不能简单归因于能带填充效应。这是因为随着位置越来越靠近类金字塔状GaN微米锥的底部和顶端,In原子的积累也越来越多,这会带来更多的态密度,从而削弱了相同激发功率密度下的InGaN/GaN多量子阱能带填充效应。所以,峰三半高宽随激发功率密度的增加与量子点在顶端形成有关。顶端量子点具有分立的能级,当激发功率密度增加时,载流子会被激发到更高的局域态[21]。
功率密度增加虽不会导致单个载流子获得更高能量,仅仅使激发出来的载流子数量增加,但是对于InGaN/GaN多量子阱结构来说,载流子吸收一个完整的激发光子能量会跃迁至较高的能级,之后很快掉到基态后再去发生辐射复合,而量子图6是InGaN/GaN多量子阱的TEM图,图6(a)中蓝色虚线标记部分是类金字塔状GaN微米锥的半极性面,较为明亮的区域则是经过离子减薄后的部分。图6(b)是图6(a)中红色方框区域的放大图,在类金字塔状GaN微米锥的半极性面上可以较为明显地看到3个周期的InGaN/GaN多量子阱,且越靠近类金字塔状GaN微米锥顶端越厚,对比CL结果,这与In原子和Ga原子在半极性面上的不同迁移速率有关,其迁移模型如图7所示。

图4 InGaN/GaN多量子阱在不同激发功率密度下的室温μ-PL光谱(黑色曲线是原始数据,红色、蓝色、绿色3条曲线分别是原始数据高斯拟合之后的峰一、峰二、峰三)
Fig.4 Room-temperature μ-PL spectra obtained at different excitation power densities of MQWs (The black curve represents the original spectrum, Gaussian fitting of each spectrum yielded three deconvolved emission peaks named peak one (shown in red), peak two (shown in blue), and peak three (shown in green))
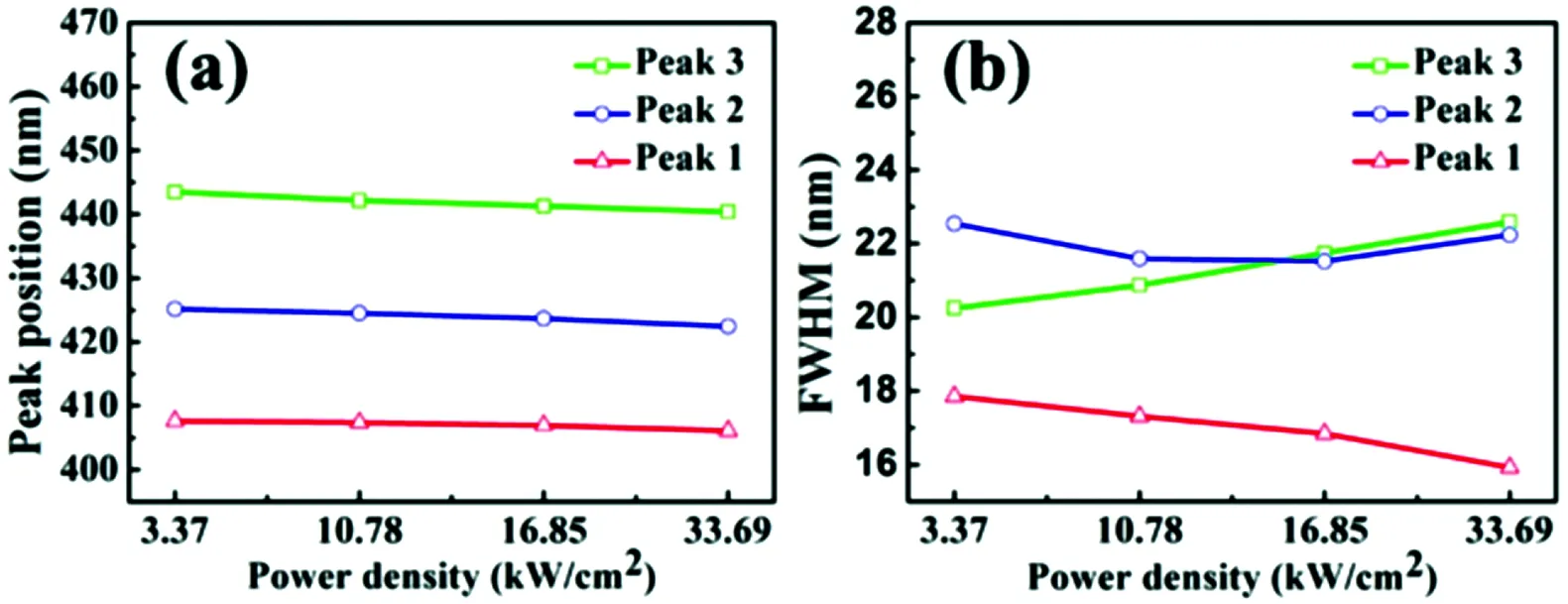
图5 (a)μ-PL中3个发光峰的峰位;(b)μ-PL中3个发光峰的半高宽。
点在束缚到一个载流子后则不会轻易使其掉落到更低的能级,因此激发功率密度的增加带来了大量的光生载流子,也使得载流子在不同的量子点能级中分布,使发光峰的半高宽增加。峰二的波长介于峰一与峰三之间,对应于类金字塔状GaN微米锥上In含量较高且比较靠近顶点及底部区域,该区域可能包含了量子阱和量子点两种结构,随着激发功率密度的增加,开始是载流子屏蔽极化场起主要作用,后来量子点局域态占主导因素,因此半高宽先减小后增加。
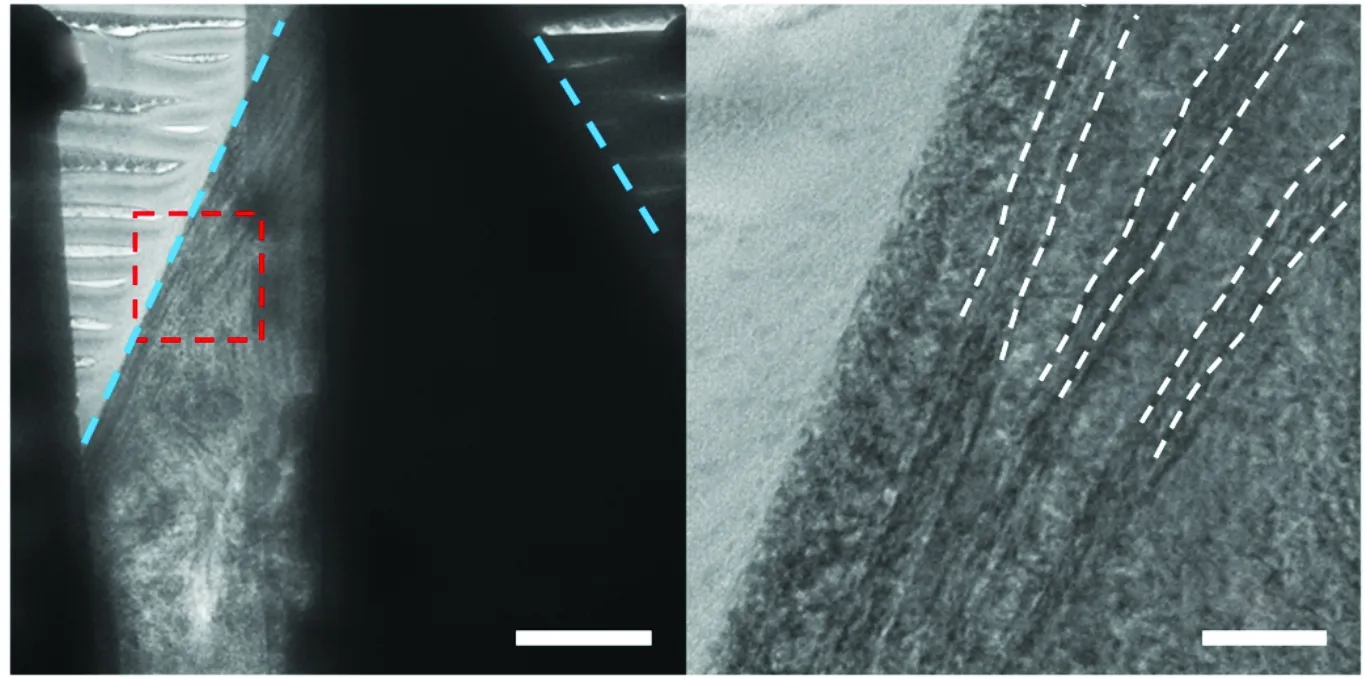
图6 (a)InGaN/GaN多量子阱的TEM图;(b)图(a)红色方框区域的放大图。
Fig.6 (a) TEM image of the InGaN/GaN MQWs. (b) Enlarge image in Fig.6(a).
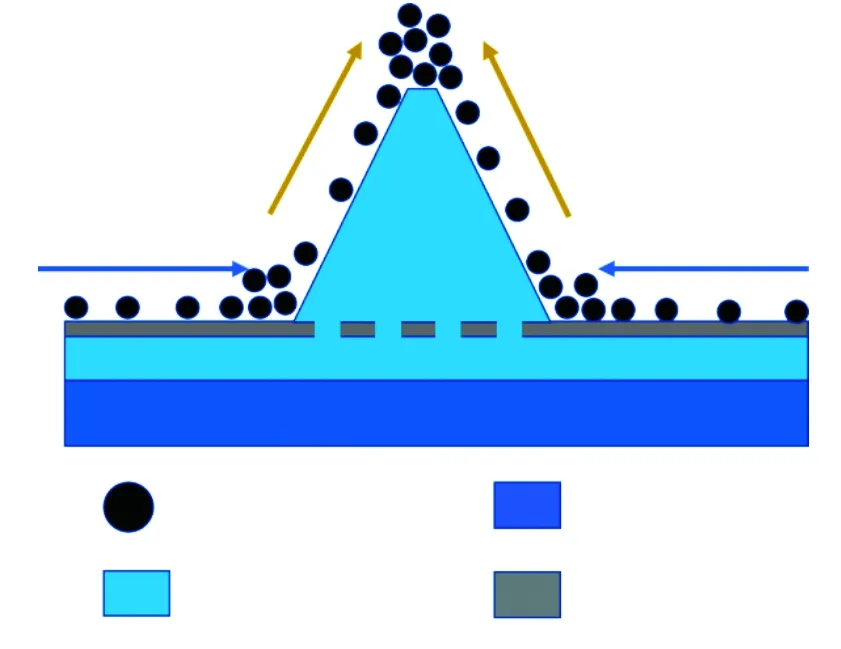
图7 In原子在类金字塔状GaN微米锥半极性面上的迁移模型图
Fig.7 Model diagram of the migration of In atoms on the semi-polar facet of the GaN micro-pyramid
In原子的迁移率比Ga原子高,同时c面作为极性面生长速率更快,吸附在类金字塔状GaN微米锥r面上的In原子更容易向顶端c面移动[17],因此,随着位置越接近顶端,In的含量越高,InGa/GaN多量子阱的生长速率也会随之增加,导致其厚度增加。与此同时,较多的In原子积累在顶端,使得顶端c面的生长速率远大于r面,c面InGaN/GaN多量子阱的厚度也会随之增加,当其厚度超过临界厚度时,c面较强的应力会使InGaN/GaN多量子阱层弛豫,生长模式转变为Stranski-Krastanov模式[18],导致量子点在顶端形成。此外,c面由二维层状生长转变为岛状生长模式,其不完整的顶端也会被填平[22],导致最终InGaN/GaN多量子阱沉积之后的类金字塔状GaN微米锥有一个完整的顶端,这也与之前分析结果相吻合。另外,类金字塔状GaN微米锥是生长在多孔SiNx掩模层上的,在生长过程中,In原子也会吸附在SiNx掩模层的孔隙附近,由于In原子对GaN和SiNx的粘附系数不同,因此,其不容易在SiNx掩模层上生长,更容易迁移到类金字塔状GaN微米锥底部区域,导致底部In含量也相对较高[23]。
4 结 论
本文利用MOCVD原位沉积SiNx掩模层后,首先制备了类金字塔状GaN微米锥,并在其半极性面上外延生长了3个周期的InGaN/GaN多量子阱。形貌表征结果表明,类金字塔状GaN微米锥在InGaN/GaN多量子阱沉积前顶端出现明显的c面,而当InGaN/GaN多量子阱沉积之后,顶端长成尖状,c面消失,这是由于量子点在类金字塔状GaN微米锥的顶部合成导致的。μ-PL测试结果表明,InGaN/GaN多量子阱的发光峰是由3个不同波长的峰叠加而成,且随着激发功率密度的增加峰位蓝移量很小,说明类金字塔状GaN微米锥半极性面的极化场很小,这有利于发光效率的提高。结合CL和TEM结果,类金字塔状GaN微米锥的半极性面不同位置In含量不同,量子阱厚度也不同,这为制备多波长发射的LED提供了理论基础。

