微F-P腔可调谐滤波器关键工艺研究*
李元元, 蒙庆华, 陈四海, 曾毅波, 郭 航
(1.中国科学院 深圳先进技术研究院,广东 深圳 518055;2.西安电子科技大学 微电子学院,陕西 西安 710071;3.厦门大学 萨本栋微米纳米科学技术研究院,福建 厦门 361005)
微F-P腔可调谐滤波器关键工艺研究*
李元元1,2, 蒙庆华1, 陈四海1, 曾毅波3, 郭 航3
(1.中国科学院 深圳先进技术研究院,广东 深圳 518055;2.西安电子科技大学 微电子学院,陕西 西安 710071;3.厦门大学 萨本栋微米纳米科学技术研究院,福建 厦门 361005)
采用表面加工工艺,AZ5214E光刻胶进行光刻并反转,磁控溅射NiCr合金,剥离出高度为2.3 μm的金属桥墩,填充聚酰亚胺作为牺牲层,再在牺牲层上光刻、沉积金属形成金属桥面,在金属桥面的中心嵌入第二布拉格反射镜。采用O2等离子体刻蚀去除聚酰亚胺膜,制作成微法布里—珀罗(F-P)腔,不需要硅片键合,克服了传统F-P腔高度不够高、调谐范围有限、腔平整度不好以及对设备要求高的缺点,并且可以做出大阵列结构,易于探测器集成。着重对腔体关键工艺,即金属桥墩的NiCr剥离工艺进行研究,针对现有技术缺陷,提出解决办法。
微法布里—珀罗(F-P)腔; 光刻反转; 磁控溅射; 剥离
Study on key fabrication process of micro F-P
0 引 言
基于MEMS技术的法布里—珀罗(Fabry-Perot,F-P)可调谐滤波器在超光谱成像、密集波分复用(dense wavelength division multiplexing,DWDM)的光通信系统中有广泛的应用前景[1],与其他可调谐滤波器相比,具有体积微小、易与激光器、探测器集成、可调谐光谱范围大、光谱分辨率高、采用批量制造可大幅降低成本等优点[2~4]。金属桥墩的剥离[5]是微F-P腔长可调谐滤波器制作的关键工艺,也是工艺制作的难点。金属桥墩的高度关系到微F-P腔长可调谐滤波器调谐性能,腔体的平整度决定了微F-P腔长可调谐滤波器的滤波效果。
本文主要研究金属桥墩的搭建和平整度良好的腔体的制作,并着重讨论了金属桥墩的剥离工艺。依据设计要求,金属桥墩高度要达到2.3 μm才能获得良好的滤波效果。
1 微F-P腔长可调谐滤波器的结构与工作原理
图1所示,悬臂梁与金属桥面在同一水平面上,采用NiCr薄膜制成。悬臂梁的一端与金属桥面成“L”型,另一端架金属桥墩上,其他的悬臂梁以此类推,四端的悬臂梁将金属桥面吊起。金属桥面通过悬臂梁的4个端点架在4个桥墩上,悬浮在衬底之上,桥面与衬底之间形成空腔。当电极1,2上施加电压后,在静电力的作用下,悬臂梁会牵引金属桥面上(下)运动,从而改变F-P滤波器的腔长,实现波长或频率的调谐。其中,金属桥墩决定悬臂梁的变化范围,进而影响器件的调谐范围。
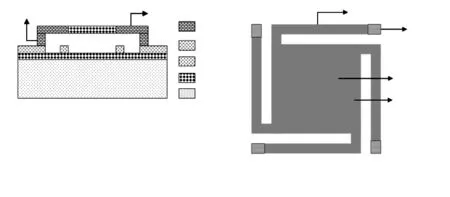
图1 微F-P腔长可调谐滤波器结构图Fig 1 Structure diagram of micro F-P cavity length tunable filter
2 实验与讨论
微腔结构的实现需要采用微加工工艺。设计的器件是128×128的阵列结构,每个单元结构都很小,适合用表面MEMS工艺来制备。制备微F-P腔具体工艺流程如图2所示:a.清洗硅衬底,进行表面活化处理;b.制备反射镜膜层;c.在反射镜膜层上制作电极1,2;d.在电极1上制作金属桥墩(桥墩兼顾电互连和机械支撑作用);e.填充牺牲层,并固化处理;f.在牺牲层上光刻,制作金属桥面;g.制备反射镜膜层;h.释放牺牲层,形成F-P腔。其中金属桥墩的搭建是工艺难点。

图2 微F-P腔制备工艺流程Fig 2 Fabrication process of micro F-P cavity
2.1 金属桥墩的搭建
在光刻形成有反射镜和电极的衬底上涂覆光刻胶并光刻出金属桥墩的图案,淀积金属,剥离掉和光刻胶直接接触的金属,完成金属桥墩的制备。
2.1.1 光刻反转
AZ5214E光刻胶的反转如图3所示。经过第一次曝光仍旧作为正胶使用,而后经过反转烘和泛曝光两道工序并最终显影可作为负胶使用。使用AZ5214E光刻胶反转具有如下优点:可以使用正版或负版;与负性光刻胶相比膨胀小,光刻后的图形失真小;经过图像反转后的光刻胶抗干法刻蚀能力强;可形成“倒八字形”侧壁,即光刻胶侧壁图形上宽下窄,易于使沉积的金属在光刻胶掩模区域断开,有利于剥离[6~7]。
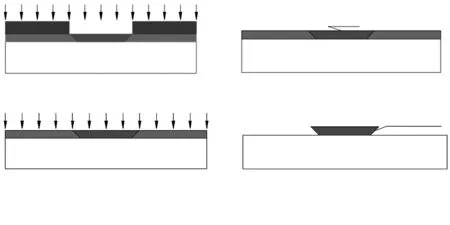
图3 AZ5214E光刻胶反转步骤Fig 3 AZ5214E photoresist inversion step
形成金属桥墩的掩模版和光刻胶反转后的表面形貌如图4所示。光刻胶反转之后,具有正胶性质的AZ5214E光刻胶转换为负胶,原有掩模版不透光区域在基底上保留了光刻胶。AZ5214E光刻反转工艺参数如下:旋涂2 000 rpm/30 s;前烘4 mins/96 ℃;曝光11.5 s;反转烘4 min/96 ℃;泛曝光12.5 s显影82 s。

图4 金属桥墩的掩模板和光刻后的形貌Fig 4 Mask of metal bridge pier and profile after photo lithography
2.1.2 溅 射
实验用溅射的靶材为NiCr合金,其中,Ni的含量为80 %,Cr的含量为20 %。
如图5,采用一次性溅射厚度超过1.2 μm的NiCr金属层或者厚度约为2.3 μm的Cr+NiCr合金金属层(每一层包括Cr的厚度为10 nm和NiCr厚度约为380 nm,逐层叠加,一次性溅射),容易产生应力集中,拉应力直接破坏底部电极,因此,一次性完成溅射2.3 μm NiCr金属层的方案是不可行的。
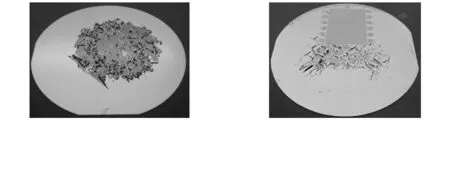
图5 一次性溅射金属层Fig 5 Once completed sputtered metal layer
采用分次溅射,减少NiCr合金每次溅射的厚度,有望减小溅射金属层的内应力,避免内应力的过度集中和累加。如图6(a)所示,在底电极上溅射厚度为900 nm的NiCr,可获得高度约为900 nm的NiCr桥墩。相比与大面积相连的NiCr金属层,桥墩为彼此不相连,隔断式的凸点阵列,有利于NiCr 金属层的应力分散,避免过大应力对于基底的破坏。但是,如果在高度900 nm的NiCr桥墩基础上再溅射900 nm厚度的NiCr,再次溅射的NiCr与原有的NiCr桥墩未能完全粘合,如图6(b)所示。

图6 桥墩结构Fig 6 Structure of bridge pier
分次溅射中,需要先溅射厚度为10 nm的Cr作为籽晶层,作为已有的NiCr基底与欲再次溅射的NiCr之间的过度缓冲层。Cr作为过度缓冲层可缓解膜基界面间的不整合所产生的应力,微纳米颗粒的Cr纳米薄膜为NiCr薄膜局域应力释放提供了条件,从而极大降低NiCr薄膜再次沉积过程中所产生的本征残余应力,显著提高NiCr薄膜之间的粘附性能。基于分层溅射和增加过度缓冲层,确定制备桥墩的工艺路线如下:光刻反转→溅射(10 nm Cr+400 nm NiCr+10 nm Cr+400 nm NiCr)→剥离→光刻反转→溅射(10 nm Cr+400 nm NiCr+10 nm Cr+400 nm NiCr)→剥离→光刻反转→溅射(10 nm Cr+400 nm NiCr+10 nm Cr+400 nm NiCr)剥离。表1是溅射10 nm Cr膜和溅射400 nm NiCr薄膜的工艺参数。采用上述工艺所制备的桥墩,大部分的桥墩与底电极粘附良好,高度在2.2~2.35 μm。
通过实验论证,采用分层溅射和增加过度缓冲层,结合多步光刻反转和剥离的技术方案可以制备出高度约为2.3 μm的NiCr桥墩,但是桥墩完好率只有约95 %。

表1 10 nm Cr 和400 nm NiCr的溅射工艺参数
结合以上讨论,对工艺进行改进:
1)降低分层溅射NiCr的厚度,减小到每层厚度为:10 nm Cr+300 nm NiCr+10 nm Cr+300 nm NiCr,进一步减低应力集中和累积。
2)适当降低溅射功率:随着溅射功率的提高,薄膜内应力会随之增加,但薄膜的致密程度和溅射速率也随之降低。本方案所采用的NiCr溅射功率为250 W,溅射功率处于适中并略低的范围。如果一味降低溅射功率,不仅会影响到薄膜的质量,同时必然会延长溅射时间,加大溅射速率的不均匀性。从膜的质量,溅射时间和薄膜所产生的内应力等方面考虑,可适当降低溅射功率,范围在150~200 W之间。
3)剥离之后低温退火:考虑到有源器件,退火的温度不能超过450 ℃。由于采用多次溅射的方法,NiCr之间的接触内阻必然增加。通过低温退火,一方面使得NiCr薄膜中的细小晶粒合并为更大的晶粒,晶粒间界面积减小,从而降低彼此的电阻率;另一方面,可消除NiCr的内应力,随着温度的升高,已溅射的NiCr基底和后溅射的NiCr界面间的分子互相扩散,界面的结合由物理结合变为冶金结合,从而提高NiCr之间的粘附性能。
改进工艺后,搭建2.3 μm的金属桥墩完全可以实现,并且完好率达100 %,如图7所示。

图7 NiCr桥墩Fig 7 NiCr bridge pier
2.1.3 剥 离
首先通过涂覆光刻胶并经紫外线曝光形成图案,然后采用蒸发或溅射技术淀积一层金属。接下来将基片浸入能溶解光刻胶的溶液里,淀积在光刻胶上的金属将随着光刻胶的溶解而从基片脱落,直接淀积在基片上的金属图形将被保留[8~10]。
AZ5214E光刻胶可以溶解于丙酮溶液,通过溶解,去除原先附着于光刻胶表面的金属,保留附着于基底上的金属。剥离时,可借助高频超声来辅助光刻胶的溶解,原先附着于光刻胶金属层脱落后,用丙酮浸泡的无尘棉棒轻轻擦拭衬底表面,除去金属碎屑及残胶,可获得完整的剥离后的金属图形。
2.2 腔体制作
在形成有金属桥墩和2个电极的衬底表面填充牺牲层,对牺牲层进行固化处理,采用化学机械抛光将金属桥墩顶部的牺牲层去除并露出金属桥墩的顶部,然后在其上涂覆一层光刻胶,光刻形成金属桥面图形,淀积金属,采用剥离工艺对桥面图形填充有金属的光刻胶薄膜进行剥离并形成金属桥面,在金属桥面的中心嵌入第二布拉格反射镜。然后释放牺牲层形成腔体。其中光刻反转、溅射和剥离工艺均与金属桥墩的制备方法相同,牺牲层制作工艺和腔体释放工艺讨论如下。
2.2.1 牺牲层制作工艺
为了获得平整性良好的F-P腔,制作表面质量良好、性能优异的牺牲层也至关重要。工艺选用的牺牲层材料是聚酰亚胺PI—5。在制备牺牲层时,聚酰亚胺需要采用梯度升热处理进行亚胺化,以抵御后续工艺的影响。其工艺是:1)旋涂聚酰亚胺,转速2 550 r/min,时间25 s;2)氮气环境下平放流平;3)预亚胺化:30 min/70 ℃,1 h/110 ℃;4)亚胺化:N2环境下5 min/150 ℃,5 min/170 ℃,5 min/200 ℃,4 h/240 ℃;5)自然冷却。
由于金属桥面的平整度对滤波性能至关重要,所以,必须通过涂胶反刻工艺对牺牲层进行平坦化处理并将金属桥墩顶部的牺牲层去除并露出金属桥墩的顶部。
2.2.2 腔体释放工艺
对于牺牲层的释放,考虑到聚酰亚胺是一种高分子材料,耐腐蚀性强,一般采用等离子去胶法,去胶气体为氧气。特定条件下氧气电离形成氧离子、活化的氧原子、氧分子和电子等混合物的等离子体的辉光柱。活化氧(活泼的原子态氧)可以迅速地将聚酰亚胺膜氧化成为可挥发性气体,被机械泵抽走,这样就将硅片上的聚酰亚胺膜去除了。聚酰亚胺等离子体刻蚀工艺条件为:刻蚀功率为150 W,氧气的流量为5 cm3/s,去胶时间90 min。图8为牺牲层释放后形成的腔体结构SEM图和结构高度图。
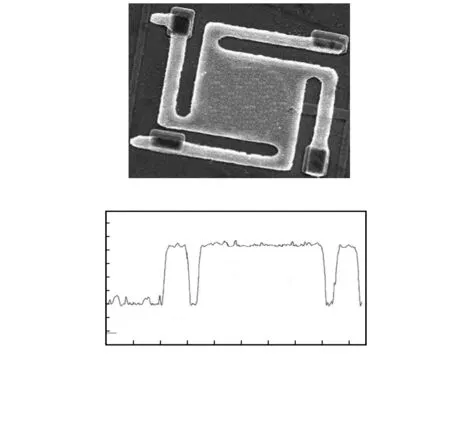
图8 腔体结构SEM图和结构高度图Fig 8 SEM image of cavity structure and height of structure
3 结 论
本文通过剥离工艺进行金属桥墩的搭建,牺牲层释放工艺进行腔体的制备,解决了微型F-P腔可调谐范围小和腔平行度不好的问题。先制备金属桥墩再制作牺牲层,可以使金属桥墩达到所需的高度,与现有工艺方法比较,比较简单,对设备要求不高。
[1] 李旭辉.MEMS发展应用现状[J].传感器与微系统,2006,25(5):7-9.
[2] Meng Qinghua,Chen Sihai.Multi-physics simulation and fabrication of a compact 128×128 micro-electro-mechanical system Fabry-Perot cavity tunable filter array for infrared hyperspectral imager[J].Applied Optics,2015,54(22):6850-6856.
[3] Shen Zhenqiang,Zhao Jianlin,Zhang Xiaojuan.Frequency-division multiplexing technique of fiber grating Fabry-Perot sensors[J].Acta Optica,2007,27(7): 1173-1177.
[4] Meng Qinghua,Luo Huan,Bao Shiwei,et al.Study on the structure of bridge surface of the micro Fabry-Perot cavity tunable filter[J].Phys Conf Ser,2011,276:75-79.
[5] 吴清鑫,陈光红,于 映,等.悬臂梁接触式RF MEMS开关的关键工艺研究[J].传感器与微系统,2009,28(9):118-120.
[6] 姜国光,段成丽,张洪泉.一种基于MEMS技术的冗余Pt温度传感器研究[J].传感器与微系统,2012,31(7):23-25,29.
[7] 史锡婷,陈四海,何少伟.剥离技术制作金属互连柱及其在MEMS中的应用[J].半导体技术,2005,20(12):16-18.
[8] 赵文杰,杨守杰,于 洋,等.AlN陶瓷微热板MEMS传感器阵列设计与工艺实现[J].传感器与微系统,2015,34(8):87-90.
[9] 杨文茂,刘艳文,徐禄祥,等.溅射沉积技术的发展及其现状[J].真空科学与技术学报,2005,25(3):204-210.
[10] Widmann D W.Metallization for integrated circuits using a lift-off technique[J].IEEE Journal of Solid-State Circuits,1976,11(4):466-471.
陈四海,通讯作者,E—mail:cshai99@163.com。
cavity tunable filter*
LI Yuan-yuan1,2, MENG Qing-hua1, CHEN Si-hai1, ZENG Yi-bo3, GUO Hang3
(1.Shenzhen Institute of Advanced Technology,Chinese Academy of Sciences,Shenzhen 518055,China;2.School of Microelectronic,Xidian University,Xi’an 710071,China;3.Pen-Tung Sah Institute of Micro-Nano Science and Technology,Xiamen University,Xiamen 361005,China)
Using surface processing technology,AZ5214E photoresist lithography and inverted,magnetron sputtering NiCr alloy,stripping out metal pier with height of 2.3 μm,fill polyimide as sacrificial layer,and then on sacrificial layer photolithography,depositing metal to form metal bridge,in the center of metal bridge surface,embed the second Bragg reflector.Using O2plasma etch and remove polyimide film,form cavity structure,without silicon bonding,overcome shortcoming that height is not high enough and the limited tuning range of traditional F-P cavity,bad flatness of cavity and low demand of equipment,and it can make a large array structure,easy to integrate with the detector.Focus on key fabrication process that is NiCr metal stripping process,propose solutions based on existing technical defects.
micro Fabry-Perot(F-P) cavity; photolithography reverse; magnetron sputtering; lift-off
2016—08—02
深圳市科技研发资金资助项目(JCYJ20140529163538765)
10.13873/J.1000—9787(2016)10—0008—04
TN 713
A
1000—9787(2016)10—0008—04
李元元(1990-),女,河南周口人,硕士研究生,主要研究方向为微机电系统的设计与制作。

