两种H形管的抗总剂量性能仿真研究
裴国旭,邓玉良,邱恒功,李晓辉,邹 黎
(深圳市国微电子股份有限公司,广东 深圳 518057)
两种H形管的抗总剂量性能仿真研究
裴国旭*,邓玉良,邱恒功,李晓辉,邹 黎
(深圳市国微电子股份有限公司,广东 深圳 518057)
为了研究0.13 μm体硅工艺的抗总剂量效应加固,分别对两种结构的H形管的性能做了仿真研究。仿真结果表明,两种结构的H形管有基本相同的转移特性曲线,但有一种结构的H形管有较大的饱和电流;同时,此结构的H形管还有较强的抗总剂量性能,可考虑在抗辐照要求的集成电路中使用。
抗辐照;总剂量效应;H形管
随着现代科学技术的发展,具有强抗辐射能力的计算机及控制芯片已成为卫星用、核电站用等电子系统的核心部分[1]。在空间轨道运行的卫星,会暴露在空间辐射的影响下,空间辐射环境主要来自宇宙射线、范艾伦辐射带(Van Allen Belt)、太阳耀斑、太阳电磁辐射和极光辐射等。不同的轨道辐射环境有所不同,但在外层空间运行的卫星所受到的辐射是相当严重的,一个地球卫星中的电子系统每年所受到的累积辐射总剂量可达102Gy(Si)以上,对于直接暴露在空间中的芯片则会更高[2-4]。因此对集成电路进行抗辐照加固技术的研究很有必要。
CMOS的总剂量效应主要在SiO2中产生电子-空穴对,在Si/SiO2界面产生界面缺陷电荷等[5-6]。由于空穴的迁移率比电子要小,同时SiO2不可能是理想的绝缘体,内部存在着缺陷能级,使得电子-空穴对在SiO2内不能有效复合,造成空穴在SiO2内及Si/SiO2界面处的积累,产生净有效电荷,从而对MOS器件的阈值电压、亚阈值漏电流等电学性能产生影响[7]。
目前CMOS工艺的抗总剂量效应加固多采用特殊形状的晶体管,如H形管、环形管,以消除源漏区边缘的漏电等[8]。为研究0.13 μm工艺中两种不同结构的H形管的基本性能和抗总剂量性能,我们对两种结构的H形管的转移特性曲线和抗总剂量性能做了仿真研究。综合仿真结果,对两种结构的H形管在抗总剂量性能方面表现出的差异进行了分析和讨论。
1 建模仿真
首先,参考0.13 μm CMOS工艺,使用ISE-TCAD系统中的3D建模工具SDE建立两种结构的H形管的3D模型;然后,使用格点和掺杂工具MESH定义模型中的掺杂分布和格点细化;最后使用器件仿真工具SDEVICE仿真两种管子的转移特性曲线和抗总剂量性能曲线。仿真过程中,场氧和栅氧分别被处理为理想绝缘体或宽禁带的半导体材料。这样处理可以对抗总剂量性能进行更精确的仿真。
目前的研究表明,对深亚微米器件,SiO2中的陷阱电荷包括氧化层陷阱电荷和界面陷阱的影响变得很小,可以忽略;而场氧化层中的陷阱电荷特别是浅能级陷阱电荷在辐照效应中起了主要作用。因此在仿真过程中,考虑了场氧化层中的陷阱电荷,在物理模型中加入了由辐照引起的场氧化层中浅能级的陷阱电荷[9]。
仿真用到的物理模型包括载流子的流体力学输运模型、辐射模型、SiO2中的陷阱(Traps)模型、Si中与掺杂浓度、散射等相关的载流子迁移率模型、俄歇复合模型(SRH)等。构建的两种H形管的俯视图和剖面图如图1所示。上面这种结构我们称之为常规结构,编号为C-H;下面这种结构我们称之为特殊结构,编号为S-H。由图1可以看出,S-H结构较C-H结构要占用更大的面积。
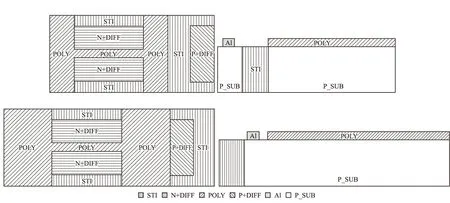
图1 模型俯视图和剖面图
如图1所示,模型中不同阴影部分分别代表器件中的STI(Shallow Trench Isolation)场氧区域、N型扩散区(N+DIFF)、P型扩散区(P+DIFF)、POLY、P_SUB、Al电极等部分。
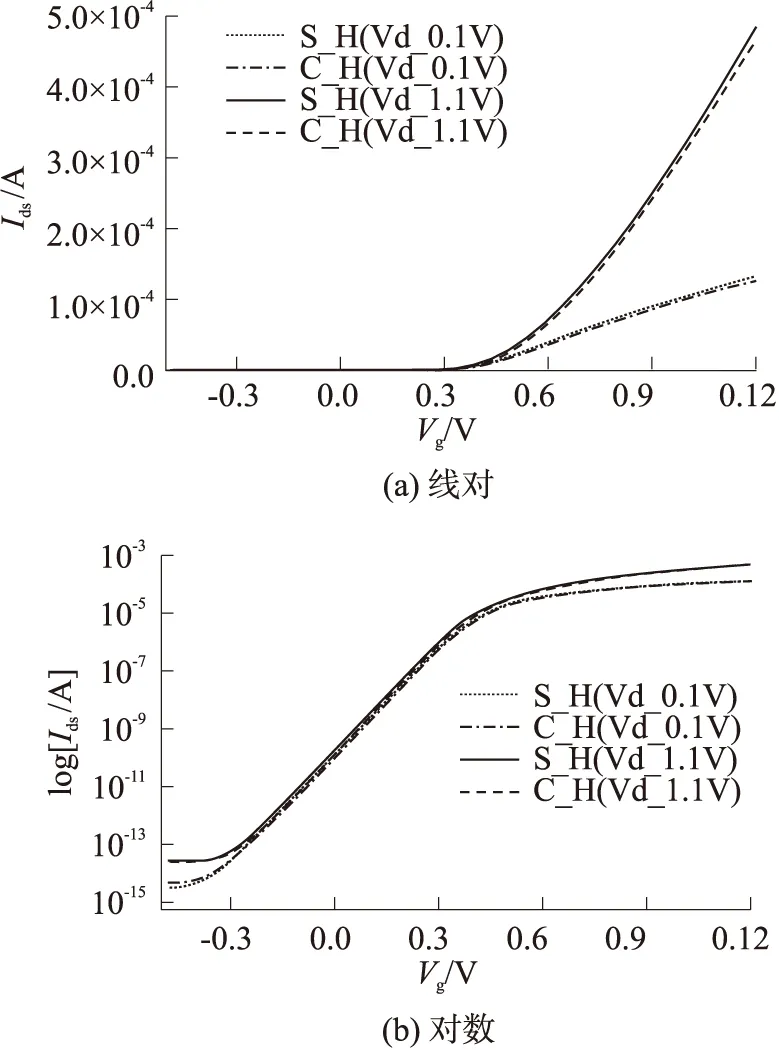
图2 线性(a)和对数(b)坐标下两种管子的转移特性曲线
2 仿真结果及分析
2.1 输出特性仿真
为研究两种H形管的结构对其基本电学性能的影响,构建了两种管子的3D模型,对它们的转移特性曲线进行了仿真。在模型构建和仿真过程中,栅氧和STI处理为理想绝缘体。
仿真得出了两种结构的H形管分别在漏极电压Vd分别为0.1 V和1.1 V下的转移特性曲线,如图2所示。仿真结果显示,两种管子的阈值电压基本相同;对数坐标下显示两种管子在亚阈值区有基本相同的漏电流和亚阈值摆幅。但S-H结构的管子饱和电流Ids略大于C-H结构,这是由于同源/漏区宽度的两种管子,S-H结构的两端存在更大的寄生宽度ΔWeff(如图1所示),使其实际的沟道宽度更大,这可在实际应用中根据仿真结果进行修正。总之,根据仿真结果,这两种不同的结构对相同工艺下晶体管的基本电学性能影响不大,一定条件下,在电路中可以互相替换使用。
2.2 总剂量特性仿真
为进一步研究两种结构的H形管抗总剂量性能,仿真了两种管子受总剂量辐射的过程。辐射时间从T=100 s开始到T=2 100 s结束;漏极电压Vds及栅极电压Vgs随时间T的变化在仿真结果中给出;辐射剂量率分别为1 Gy(Si)/s、2.5 Gy(Si)/s[10]。为了验证是栅氧还是STI造成的漏电,同时仿真了去掉STI结构的晶体管,编号为NO-STI。仿真过程中,栅氧和STI根据需要处理为宽禁带的半导体材料。
如图3所示,显示了两种H形管及没有STI结构的晶体管的抗总剂量仿真结果。仿真结果显示,没有STI结构的管子不存在辐照造成的栅氧漏电,说明0.13 μm工艺下,辐照主要影响STI,对栅氧的影响已经小到可以忽略;C-H结构的H形管在剂量率为1 Gy(Si)/s辐照下,在T=1 500 s时开始出现漏电,在剂量率为2.5 Gy(Si)/s辐照下,在T=600 s时就出现漏电,其抗总剂量能力在1 250 Gy/Si~1 500 Gy/Si之间;S-H结构的H形管在剂量率为1 Gy(Si)/s辐照下,在T=17s之后开始出现漏电,在剂量率为2.5 Gy(Si)/s辐照下,在T=7 s之后开始出现漏电,同时其漏电大小较C-H结构的要低,其抗总剂量能力为1 500 Gy/Si~1 600 Gy/Si之间。
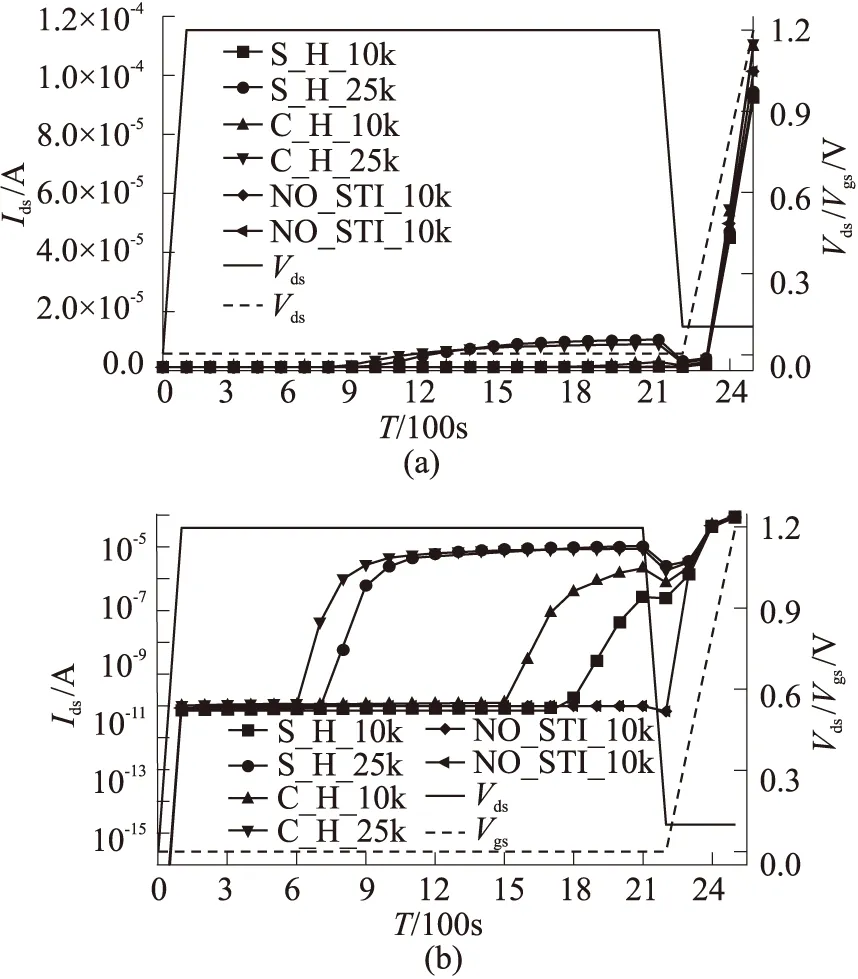
图3 线性(a)和对数(b)坐标下抗总剂量仿真曲线
根据仿真结果,S-H结构的H形管抗总剂量能力较C-H结构有所提高。这是因为,辐射使正电荷在STI中积累,当STI中的正电荷积累到一定量,会导致与STI接触的体区表面反型,造成晶体管中的漏电。而S-H结构中造成漏电的STI中,有一段是包围着衬底接触区,此处的掺杂浓度比体区高,使这一段STI需要积累更多的正电荷才能使漏电通道开启;同时,S-H有更长的STI漏电通道,漏电通道开启后有较大的电阻,使漏电流下降。
S-H结构相当于增大了体区掺杂浓度,增大了漏电通道的电阻,使其较C-H结构具有更大的抗总剂量性能,及更小的漏电流。
3 结论
仿真结果显示,两种0.13 μm尺寸的H形管,理想状态下有基本相同的转移特性曲线,但S-H结构由于有效沟道宽度Weff较大,所以有较大的饱和电流。在抗总剂量方面,S-H结构变相增大了体区掺杂浓度和漏电通道的电阻,所以其抗总剂量能力较C-H结构有所提高,但这是以增大面积为代价的。
总之,在抗辐照要求的芯片中,可以考虑采用S-H结构的H形管来做抗总剂量效应的加固,但要兼顾对芯片面积的要求。
[1]Katz R,LaBel K,Wang J J,et al. Radiation Effects on Current Field Programmable Technologies[J]. Nuclear Science,IEEE Transactions on,1997,44(6):1945-1956.
[2]Russell C T. The Solar Wind Interaction with the Earth’s Magnetosphere:A Tutorial[J]. Plasma Science,IEEE Transactions on,2000,28(6):1818-1830.
[3]Mullen E G,Ginet G,Gussenhoven M S,et al. SEE Relative Probability Maps for Space Operations[J]. Nuclear Science,IEEE Transactions on,1998,45(6):2954-2963.
[4]冯彦君,华更新,刘淑芬. 航天电子抗辐射研究综述[J]. 宇航学报,2007,28(5):1071-1080.
[5]冯彦君,华更新,刘淑芬. 航天电子抗辐射研究综述[J]. 宇航学报,2007,28(5):1071-1080.
[6]Devine R A B. The Structure of SiO2,Its Defects and Radiation Hardness[J]. Nuclear Science,IEEE Transactions on,1994,41(3):452-459.
[7]赵力,杨晓花. 辐射效应对半导体器件的影响及加固技术[J]. 电子与封装,2010,10(8):31-36.
[8]Liu S T,Jenkins W C,Hughes H L. Total Dose Radiation Hard 0. 35 μm SOI CMOS Technology[J]. Nuclear Science,IEEE Transactions on,1998,45(6):2442-2449.
[9]孟志琴,郝跃,唐瑜,等. 深亚微米nMOSFET器件的总剂量电离辐射效应[J]. 半导体学报,2007,28(2):241-245.
[10]何定平,王桂珍. 空间低剂量率辐射诱导电荷效应评估技术研究[J]. 强激光与粒子束,2003,15(3):275-278.

裴国旭(1972-),男,吉林省梅河口市人,工学学士,工程师,研究方向为集成电路抗辐照加固设计与研究、集成电路失效分析等,gxpei@ssmec.com;

邓玉良(1969-),男,辽宁省沈阳市,博士,高级工程师,研究方向为高性能微处理器、存储器和可编程逻辑器件,yldeng@ssmec.com。
SimulationoftheTotalIonizingDoseEffectofTwoKindsofDifferentH-GateMOSFETs
PEIGuoxu*,DENGYuling,QIUHenggong,LIXiaohui,ZOULi
(Shenzhen StateMicro Electronics Co.,Ltd,Shengzhen Guangdong 518057,China)
Two different structures of H-gate MOSFETs’ performances are simulated,which are used to study total dose radiation hardness of commercial 0.13 μm CMOS process. Simulation results show that two kinds of different H-gate MOSFETs have basically same transfer characteristics curves. But one of two structures H-gate MOSFETs has bigger saturation current and radiation-hardened for radiation applications. This kind of H-gate MOSFETs could be considered to be used in the radiation hardened ICs.
radiation hardened;total ionizing dose effect;H-gate transistor
2013-10-23修改日期:2013-12-05
O472.8
:A
:1005-9490(2014)06-1054-03
10.3969/j.issn.1005-9490.2014.06.009

