低Al组分In1-xAlxSb薄膜的MBE生长和优化
尚林涛,刘 铭,邢伟荣,周 朋,沈宝玉
低Al组分In1-xAlxSb薄膜的MBE生长和优化
尚林涛,刘 铭,邢伟荣,周 朋,沈宝玉
(华北光电技术研究所,北京100015)
采用分子束外延的方法进行了低Al组分In1-xAlxSb薄膜的生长和优化。通过在InSb(100)衬底上外延生长一系列不同条件的In1-xAlxSb薄膜,分析总结了衬底的热脱氧特征以及InAlSb薄膜低Al组分(2%左右)的控制,探讨了退火和InSb缓冲层的优化等参数对In1-xAlxSb外延薄膜表面形貌和质量的影响。测试结果表明薄膜质量得到极大改进。
InSb(100);铝;InAlSb;薄膜生长;优化
1 引 言
InSb基材料由于其高电子迁移率和低有效质量在高速和光电器件应用中很有技术意义[1]。Sb基化合物半导体由于其在光学、电子学及结构方面的属性而吸引了诸多兴趣。锑化物具有III-V族化合物中的最小带隙,基于Sb基化合物半导体的器件已经显示了高的性能[2]。以色列的SCD公司在InSb基InAlSb红外探测器的研究方面处于领先地位[3],于2004年报道了InSb基InAlSb中波红外320×256焦平面探测器,可工作于77~100 K,像元可操作性>99.5%,95 K残余非均匀性较准<0.03%。
InAlSb的外延生长可以采用磁控溅射外延(Magnetron Sputtering Epitaxy,MSE)、分子束外延(Molecular Beam Epitaxy,MBE)和金属有机化学气相沉积(Metalorganic Chemical Vapour Deposition, MOCVD)等方法进行。MBE方法具有精确的单原子层控制生长能力以及原位的实时在线监测工具—反射式高能电子衍射(Reflection High Energy Electronic Diffraction,RHEED),可以生长具有突变异质界面的高质量半导体外延薄膜材料,广泛用于科研和生产中。InAlSb的带隙大,阻抗高,晶格常数与InSb相近,因而可以实现晶格匹配的外延生长。
本文论述了InSb(001)衬底上低Al组分(2%左右)InAlSb/InSb外延薄膜的MBE生长和优化。通过生长一系列样品,确定了InSb(100)衬底的脱氧特征,探索了低Al组分的控制。通过退火、缓冲层的处理等参数优化了外延膜的缺陷。测试结果表明材料薄膜晶体质量得到极大改进。
2 实 验
实验在超高真空DCA-MBE P600实验设备上进行。腔室周围配备的各种泵可使整个系统维持较高的真空,可达10-11Torr。MBE生长室腔体上配有RHEED,可用于实时在线观测生长室中样品的表面形貌、衍射类型和生长速率等特征。衬底加热器采用旋转加热的方法可以保证加热温度的均匀性。实验所用的衬底是由本所制备的InSb(100)衬底,晶向偏向(111)角2°。InSb体晶经切割、机械抛光和化学抛光、改良的CP4处理后得到了厚度(500± 25)μm、表面平整、氧化层薄的InSb(100)外延型衬底。衬底首先在180℃下MBE快速进样室中加热1 h除汽;然后移送入缓冲室中,在加热台上300℃下加热除气1 h以去除表面残余有机物。然后,通过磁力传送杆送入MBE生长室中进行外延生长。样品在脱氧之后,先在InSb(100)衬底上生长InSb缓冲层,生长温度430℃,然后接着在相同温度异质外延生长一定厚度的低Al组分InAlSb层。样品生长完成后,降温至室温,由生长室经由缓冲室送至快速进样室取出。采用OLYMPUSMX61光学显微镜对样品表面的形貌和缺陷进行100倍(视场面积1.45 cm2)和200倍(视场面积3.62 cm2)观测;采用BRUKER公司的DeKtakXT台阶仪用探针法对样品边缘的厚度进行测试;采用X’Pert PRO MRD型XRD来测试样品的特征峰和计算Al组分,其采用Cu靶,发射波长λKα=1.54056Å。
3 结果与讨论
3.1 InSb(100)衬底的脱氧
衬底的脱氧是外延薄膜质量的基础决定性因素。在生长之前对编号为T01-T09的样品均进行了Sb2束流保护下的热脱氧,脱氧温度大致为575℃,视具体情况为半个到一个小时不等。图1列出了一些样品脱氧完成后的RHEED图像。
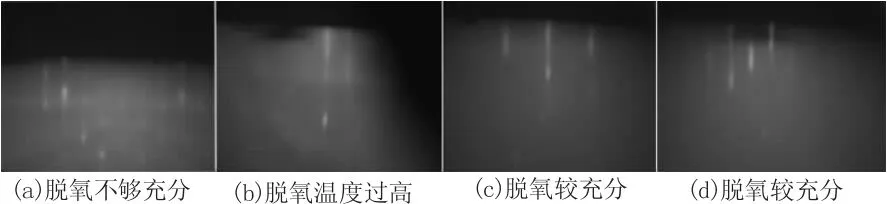
图1 一些样品脱氧后的RHEED图像
逐渐将衬底从室温加热到热脱氧温度,320℃时逐渐开Sb2束流保护,RHEED斑点由无序散乱分布的斑点逐渐转变为拉成明亮平行等间隔排列的条纹,背景杂散衍射点消失,指示出脱氧基本完成。由于实际样品衬底氧化层的厚度不一致,脱氧温度及脱氧时间有一定的偏差。若脱氧温度不够或时间较短,则不能有效地完成热脱氧,图1(a)所示样品的衍射条纹中仍存在斑点且背景比较模糊,说明脱氧不够充分;若脱氧温度过高,可能会造成样品边缘部分熔化、卷边而粘在钼托上,图1(b)所示样品衍射图像边角较暗,暗示了有物体挡住了电子枪发射电子的入射,实际上已经发生了卷边粘托的情况。图1(c)和图1(d)指示出比较好的完成了脱氧,衍射条纹及背景清晰、衍射级数较多。
3.2 In1-xAlxSb薄膜Al组分的调控
为了得到低Al组分In1-xAlxSb外延薄膜,需要对III族和V族束流进行调控。V族Sb源顶部裂解器温度为900℃,产生Sb2。源的束流大小与源温有一定的对应关系,一般温度越高,束流强度值也越大,但两者并不一定成线性关系。In源的温度在920~930℃之间调制;Al源的束流大小在980~1100℃之间调制,控制Sb源的束流强度是In与Al的III族源束流之和的7倍,即V/III≈7。
根据晶格衍射的布拉格方程:

及维戈定律:

通过XRD测得样品的InSb和InAlSb特征峰角度,由式(1)和式(2)可以大致推算出Al组分。
图2列出了通过XRD测出的不同Al源和In源温度对应的In1-xAlxSb样品中Al组分的分布情况。可以看出,在In源温度保持在930℃时,Al组分会随Al源温度的升高而增大,图中当Al源温度从980~1050℃变化时,Al组分会从1.69%到5%近似线性的增大;在Al源温度保持在1010℃时,Al组分也会随In源温度的降低而迅速升高,图中当In由930℃降低到924℃时,Al组分由2.718%迅速增大到5.12%。图中有一个重复点对应的两个样品(Al:980℃,In:930℃)的Al组分稍有偏差(1.69%和1.709%)可能是实验或测量误差造成,但误差较小,影响不大。总体趋势是In1-xAlxSb外延薄膜中的Al组分随Al源温度的升高而近似线性增大,随In源温度的降低而迅速增大。图中Al组分基本都在5%以内,所需要的低Al组分目标在2%左右,即可在保持In源在930℃时Al源在990℃以下。

图2 InAlSb薄膜Al组分随In、Al温度的分布图
3.3 退火对薄膜缺陷的影响
退火处理对优化薄膜晶体表面缺陷很有意义。退火可以提高材料表面能量,增强外延膜表面原子的迁移率,使粗糙表面得到改善。图3(a)样品未经过退火处理,表面缺陷较多,存在明显的网格线、较多小坑和突起缺陷;图3(b)图样品采用对InAlSb外延层退火的方法分别在生长InAlSb 1个小时和生长完成后各在480℃退火15分钟。表面有略微的网格线和较小的凹坑。可见,退火可以降低样品表面缺陷和减少表面网格线。

图3 样品表面的光学显微图像(200倍)
3.4 缓冲层优化处理对外延薄膜的影响
网格线的存在可能源于衬底在表面处理加工时形成的一些缺陷状况,若在后续的缓冲层生长时缓冲层覆盖的不够厚或处理的不好,缺陷很可能进一步迁移至顶层。因此优化缓冲层的优化处理可以覆盖掉衬底中表面缺陷[4]。
对缓冲的优化处理如下:在430℃生长InSb缓冲层30 min,然后在480℃下退火10 min;然后在较高的温度450℃下生长InSb缓冲层30 min,接着在480℃下退火10 min。即先低温成核生长并退火,然后再高温生长并退火以达到优化缓冲层的目的。最后样品表面的RHEED图像如图4所示,样品表面三个主要衍射方向条纹清晰,分别是2×,1×和4×结构,整体呈2×4重构。清晰的RHEED条纹反映出样品表面平整,质量较好。样品表面的光学显微结果如图5所示,样品表面除少许微小的凹点外,整体光亮如镜,没有网格状条纹或In液滴。台阶仪测试样品的平均总厚度为4.495μm。随后进行的XRD测试显示如图6所示,InAlSb和InSb层的特征峰明显,非常尖锐,InAlSb层的FWHM为18.6 arcsec,InSb层的FWHM为18.1 arcsec。In-AlSb薄膜和InSb衬底的晶格失配度为0.2%。反映出薄膜晶体质量较好,经计算得出Al组分大致为1.69%,与期望值符合。

图4 生长完成后的样品表面RHEED图像

图5 样品表面100×和200×光学显微图像
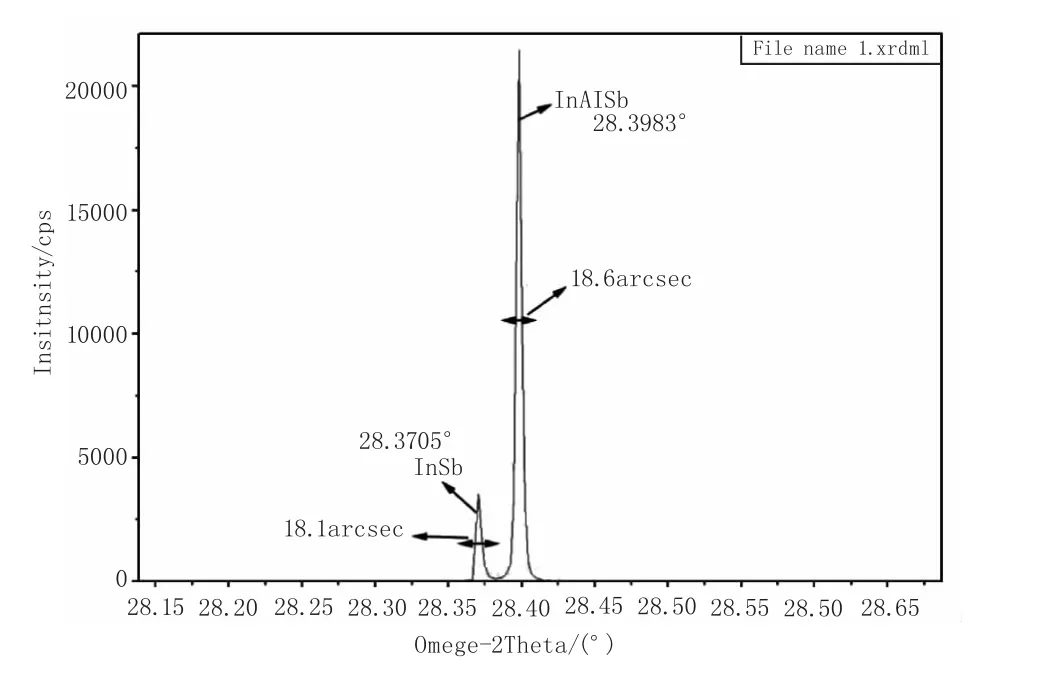
图6 InAlSb/InSb样品的XRD特征峰
4 结 论
本文论述了InSb(001)衬底上低Al组分In-AlSb/InSb外延薄膜的MBE生长和优化。生长了一系列In1-xAlxSb外延薄膜,通过对比分析确定了InSb(100)衬底的脱氧特征,通过控制In和Al源温度探索了低Al组分(2%左右)InAlSb薄膜的生长控制。发现退火可以改善薄膜表面缺陷,缓冲层的处理可以改善衬底缺陷使整体薄膜缺陷大幅降低,晶体质量得到提高。后期在工艺中还需要更进一步的优化薄膜材料的质量以符合红外探测器件生产制造的要求。
致 谢:对华北光电技术研究所焦平面专业部的折伟林、王经纬、王丛、高达、强宇和王彬等所做的相关工作表示感谢!
[1] M D Robertson,J M Corbett.Transmission electron microscopy characterization of InAlSb/InSb bilayers and superlattices[J].Micron,1997,28(2):175-183.
[2] Y H Kim,J Y Lee,Y G Noh,et al.Observation of V-shaped defects in the growth of In0.8Al0.2Sb/InSb layers:Temperature and V/III flux ratio dependences[J]. Journal of Crystal Growth,2006,296:75-80.
[3] LIU Ming,CHENG Peng,XIAO Yu,et al.Research of InSb film growth bymolecular beam epitaxy[J].Laser&Infrared,2013,43(11):1256-1259.(in Chinese)
刘铭,程鹏,肖钰,等.InSb薄膜分子束外延技术研究[J].激光与红外,2013,43(11):1256-1259.
[4] LUO Zijiang,ZHIOU Xun,YANG Zairong,et al.The research on growth of GaAs under themonitoring of RHEED[J].Journal of Functional Materials,2010,4(41):704-708.(in Chinese)
罗子江,周勋,杨再荣,等.在RHEED实时监控下GaAs晶体生长研究[J].功能材料,2010,4(41):704-708.
MBE grow th and optim ization of low Al component In1-xAlxSb film
SHANG Lin-tao,LIU Ming,XINGWei-rong,ZHOU Peng,SHEN Bao-yu
(North China Research Institute of Electro-optics,Beijing 100015,China)
Low-aluminium In1-xAlxSb film is growth and optimized bymolecular beam epitaxialmethod.After a series of In1-xAlxSb films were grown on InSb(100)substrate under different conditions,the thermal deoxidation characterization of the substrate and the low-aluminium component control(approximate 2%)were analyzed,and the effect of process parameters such as annealing and InSb buffer layer optimization etc onmorphology and quality of the film was discussed.The test results show the quality of the film has a great improvement.
InSb(100);Aluminium;InAlSb;film growth;optimization
TN213
A
10.3969/j.issn.1001-5078.2014.10.010
1001-5078(2014)10-1115-04
尚林涛(1985-),男,硕士,助理工程师,主要从事红外探测器材料分子束外延技术研究。E-mail:peacefulslt@163.com
2014-03-26

