65nm n沟MOSFET的重离子辐照径迹效应研究*
高婷婷,王 玲,苏 凯,马 瑶,袁 菁,龚 敏,
(1.四川大学物理科学与技术学院,成都 610064;2.微电子技术四川省重点实验室,成都 610064)
1 引言
航天器在飞行中,遇到的离子环境是十分复杂的,其中重离子约占粒子总数的1.3%。对重离子辐照效应,过去十几年人们主要关心由电离辐射引起的“单粒子翻转”,并已经发展了有效的抗辐射加固技术。径迹是高能粒子和电子相互作用,能量转移产生的热效应导致的沿粒子径迹的晶体局域相变[1]。许多研究已经观测到高能重离子辐照能够在聚合物、半导体、绝缘体和金属材料中产生直径为几到几十纳米、贯穿深度很大(几十微米)的纳米管状径迹[2,3]。特别的,D.Fink等人利用TEAMS结构(类似于MOS管结构)模拟出低注量的高能粒子束能够在500 nm厚的SiO2层中明显诱生漏电流,但是其数量级是皮安(pA)级[4]。因此面对航天器中应用最为广泛的器件,纳米级的MOS器件长期暴露在空间环境中可能会经过宇宙射线中重离子的辐照诱生出粒子径迹线,若此径迹线形成电离沟道跨过MOS器件的某一界面势垒层,就会产生明显的电流电压变化;且“径迹沟道效应”会随着器件尺寸的进一步减小,集成度的不断增加,电参数要求的不断提高和空间应用可靠性要求的提高而变得重要,此影响不可忽视。
本文利用Geant4软件对两种高能重离子在65 nm n沟MOSFET中径迹沉积能量进行模拟研究分析。基于中国科学院近代物理研究所重离子加速器HIRFLCSR的条件,对设计的65nm n沟MOSFET器件进行Sn离子辐照实验,将辐照前后的各电学参数作一分析讨论。
2 Geant4模拟过程及结果分析
重离子入射到靶物质中时,通过入射带电粒子和靶原子中的电子连续多次地碰撞发生能量转移,重离子的能量会发生损失,同时速度也会减慢。当靶物质足够厚,最终会使它的能量全部耗尽,停留在靶物质当中。对于高能重离子来说,它和靶物质的相互作用主要是与核外电子发生非弹性碰撞时的能量损失,通过能量沉积产生热效应,瞬时的高温导致粒子径迹晶体局域相变。
有相关报道中指出绝缘体的电子能损阈值为1~10 KeV/nm[5]。Olli H.Pakarinen等人用经典分子动力学模拟得出用27~185 MeV的高能Au单粒子辐照2 µm厚的无定形SiO2,当在无定形SiO2中电子能损为3.6 KeV/nm时,即会形成半径为2 nm的管状径迹[6],能量沉积越大,径迹长度和半径都会增加;当电子能损达到18 KeV/nm时,会产生完全中空结构半径为5 nm的圆柱形径迹[7]。我们模拟的65 nm n沟MOSFET氧化层厚度是2.35 nm,相比于Olli H Pakarinen等人用分子动力学模拟的SiO2厚度非常薄,因此在此结构中产生径迹的总能量沉积值会小于18 KeV/nm。
我们用10~30 KeV的小能量Au和Sn单粒子垂直入射1 nm厚SiO2层,得到Au和Sn在SiO2中产生径迹的的能量沉积分别为23 KeV/nm和16 KeV/nm,这与分子动力学模拟结果接近。因此Geant4可以很好地进行重离子径迹模拟。
2.1 Geant4中NMOS结构模型的实现
为了给实验提供参考性数据而专门设计了65 nm的MOSFET结构,采用的是中芯国际65 nm工艺数据库标准。实际工艺中,多晶硅上层有金属层、介质隔离层及钝化层,因此我们模拟中将填埋的8层金属用Cu替代,隔离层用SiO2替代,模拟中所用NMOS工艺参数如下:隔离层厚度8.43 μm,金属层厚度1.72 μm,多晶硅层厚度100 nm,栅氧化层厚度2.35 nm,沟道宽为130 nm,长度65 nm,W/L=2。由此数据在Geant4中构建的NMOS模型如图1所示。

图1 NMOS模型图
本文采用的两种重离子分别是Sn和Au,每次只从正上方垂直入射一个重离子,入射能量250~700 MeV,步长50 MeV。
2.2 模拟结果及分析
Sn和Au离子在不同入射能量下经过钝化层、隔离层、金属层及多晶硅层射入SiO2层的剩余能量A如表1所示。

表1 两种粒子入射能量及A点能量
图2是不同入射能量的两种离子在65 nm n沟MOSFET的SiO2层中的能量沉积图。
Sn离子当入射能量是350 MeV时,A点能量为173 MeV,在SiO2中的能量沉积值为8 KeV/nm,说明选取的能量足以在SiO2中产生径迹。 对于不同种类的重离子,都遵从电子能损超过阈值越多,越会在一个圆柱形区域内形成径迹,且径迹越趋近于直线。径迹的形貌与能量沉积、入射离子种类、入射能量、靶材料的厚度及工艺等因素有关。
由图2得出,不同离子在SiO2层的能量沉积不同,Au离子相较于Sn离子沉积能量大。根据量子理论,推导出的重带电粒子在靶材料中的电子阻止能力的表达式为[8]:

其中,β=v/c,c是光速,I是靶原子的平均激发电离能,I的值近似为I=I0Z,I0≈10 eV。对于原子序数Z≥13的靶物质,I0较小;而对于原子序数Z<13的靶物质,I0稍大些,I0≈13Z eV。因此,靶物质对重离子的阻止本领只与它的N和Z有关,即原子序数和密度越高,这种材料对重离子的阻止能力越强,重离子在此靶物质中的总能量沉积越大。

图2 不同离子在氧化层中沉积能量值
各离子在SiO2层的能量沉积起初是随着能量的升高而升高,Au在大约650 MeV,Sn在大约350 MeV处表现出极大值,而后随能量的增大反而减小,这与俘获截面有关,俘获截面强烈地依赖于它所处的能量位置。Sn在除了能量200~400 MeV区间之外,俘获截面都随能量增加而衰减。
3 辐照实验结果及分析
实验样品为65 nm工艺n沟MOSFET阵列,栅氧化层厚度2.35 nm,电源电压为1.2 V,采用共栅结构设计,源端和衬底接地,ESD静电保护。辐照实验用中国科学院近代物理研究所重离子加速器HIRFL-CSR,采用Sn同位素,相对原子质量为112,单核能3.7 MeV/u,单个离子能量为414 MeV,注量率为109ions/cm2·s,辐照实验无外加电源。由于样品面积较小,且重离子入射存在概率问题,因此我们研究的仍是单个离子的行为。对65 nm器件分别采用1010ions/cm2、1011ions/cm2两种注量,保证栅面积上至少入射一个重离子。由于重离子入射能量较大,因此入射的准直性很好。
3.1 阈值电压
下面提取出辐照前后MOSFET的阈值电压,如图3所示。
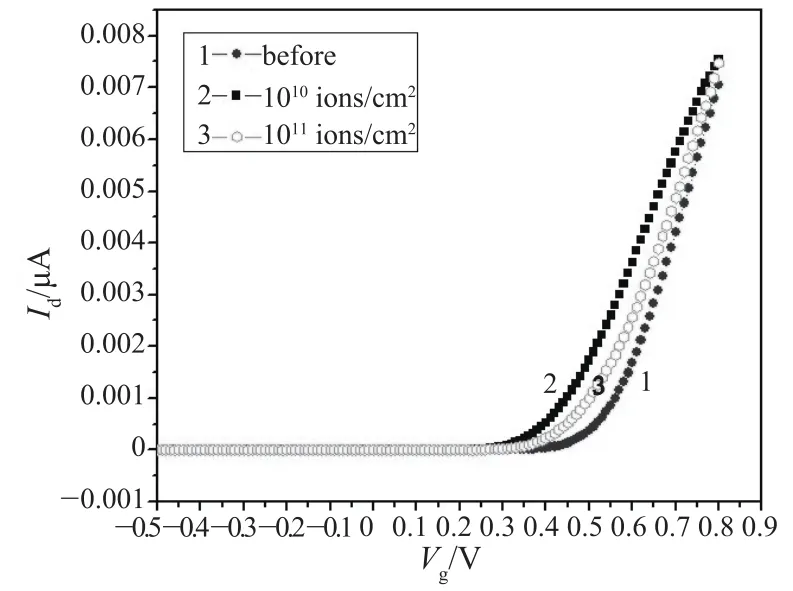
图3 辐照前后器件的转移特性曲线
从图3中可以看出,当Sn离子注量在1010ions/cm2及1011ions/cm2时,器件的阈值电压相对于辐照前负向漂移。

其中,ΔVt是氧化物俘获的空穴电荷引起的阈值电压变化,fy(E,Eox)是空穴产额(即未被复合的空穴部分),D是辐射注量,tox是氧化层厚度。当栅上加正偏压时,空穴向SiO2-Si界面附近移动,产生的空穴由于迁移率较小,相对于电子来说是不动的,在氧化层被陷阱俘获的空穴电荷就会引起阈值电压向负方向偏移,但是总体辐照前后阈值电压变化不大。单粒子辐照所产生的径迹在栅面积所占的比例很小,因此对Vt影响不大。
从图3中提取出辐照前、辐照注量为1010ions/cm2、1011ions/cm2下MOSFET的跨导gm值分别是3.06×10-5S、3.03×10-5S、2.88×10-5S,辐照之后,跨导没有发生明显的变化,说明迁移率变化不大,辐照过程中没有产生明显的界面态电荷。因此,阈值电压及跨导的变化主要都是径迹效应产生的。
3.2 电流变化
图4为n沟MOSFET在不同注量下电流电压特性曲线图,其中Ids为MOSFET漏极至源极电流,Vgs为栅极扫描电压。从图中可以看出,漏电流随着注量增加而不断增大。在注量为1011ions/cm2时,器件的漏电流达到10-5A,比辐照前的漏电流10-8A高出三个数量级。在该注量下,器件不能正常关断,将导致功能失效,静态功耗增加。
在同一注量下,随着栅压的增大,漏电流在不断增大。电路在实际的运用中,栅电压也会不断变化,因此,恶劣的辐照偏置条件将会在一定程度上降低器件的抗辐照能力。
图5是n沟MOSFET栅漏电流随注量变化曲线图。从图中可以看出,随着辐照注量的增加,栅漏电流明显增大。且在注量达到1011ions/cm2时,器件的栅漏电流达到10-5A,比辐照前的栅漏电流10-10A高出五个数量级,因此该注量下,器件的栅氧化层破坏较为严重,预估计在栅氧化层中产生了较大尺寸的径迹,径迹效应产生了电流变化。
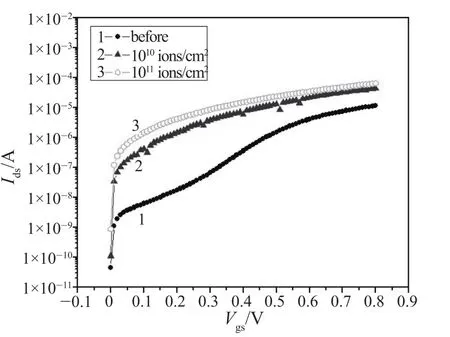
图4 MOSFET辐照前后电流电压特性曲线
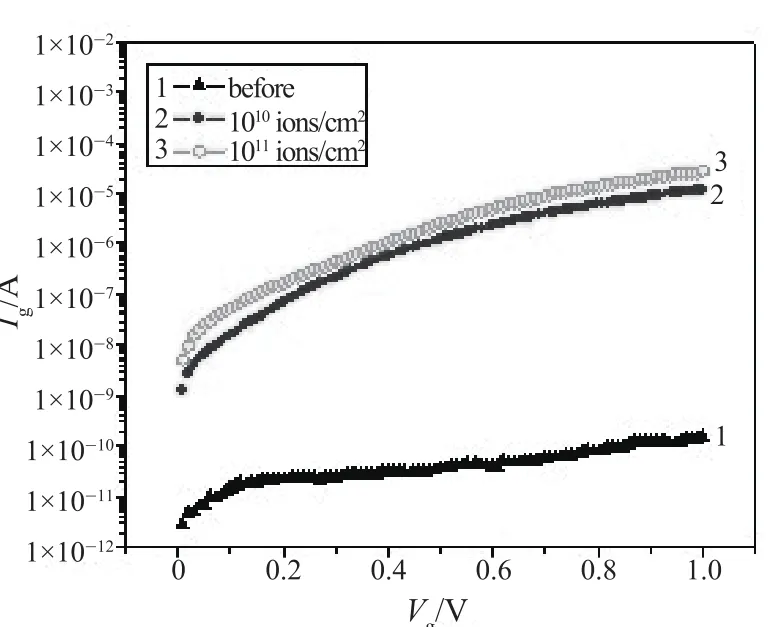
图5 MOSFET辐照前后栅极漏电流随栅压变化曲线
4 结论
通过65nm n沟MOSFET器件的模拟及辐照实验表明,我们的入射能量足以在MOSFET的栅氧化层引入“径迹沟道”,产生的电荷能够引起电流/电压变化,Ids和Ig明显增大,器件性能退化严重。
航天器在宇宙环境中飞行时遭遇到的重离子能量通常很高,尤其随着微电子芯片集成度越来越高,灵敏单元尺寸和间距越来越小,这种重离子径迹效应对小尺寸MOS器件造成的影响更是值得关注的。
但是,重离子辐照对MOSFET电学特性影响的微观细节机理尚不清楚,还需要进一步地进行实验和分析验证。
[1] J Jensen, A Razpet. Ion track formation below 1MeV/u in thin films of amorphous SiO2[J]. Nuclear Instruments and Methods in Physics Research B 243(2006)∶119-126.
[2] P Kluth, C S Schnohr. Measurements of latent tracks in amorphous SiO2using small angle X-ray scattering[J].Nuclear Instruments and Methods in Physics Research B266(2008)∶2994-2997.
[3] P Kluth, C S Schnohr. Fine structure in swift heavy ion tracks in amorphous SiO2[J]. PHYSICAL REVIEW LETTERS, 2008∶1-4.
[4] D Fink, A Chandra. Resistance of ion track based electronic structures to high voltage and radiation[J]. Journal of Physics D∶ Applied Physics,40(2007)∶ 3212-3218.
[5] 侯明东,刘杰,等. 快重离子电子能损引起的缺陷产生及其后续效应[J]. 原子能科学技术,2008, 42(7)∶ 622-627.
[6] Olli H Pakarinen, Flyura Djurabekova, et al. Molecular dynamics simulations of the structure of latent tracks in quartz and amorphous SiO2[J]. Nuclear Instruments and Methods in Physics Research B 267(2009)∶ 1456-1459.
[7] Olli H Pakarinen. Density evolution in formation of swift heavy ion tracks in insulators. Nuclear Instruments and Methods in Physics Research B.268(2010)∶3163-3166.
[8] Larry Franks. Nuclear Radiation Detection Materials[A].MRS, 2011, 12(4)∶ 26-28.

