气相掺杂区熔硅单晶的掺杂剂量计算方法研究
史继祥,索开南
(中国电子科技集团公司第四十六研究所,天津 300220)
气相掺杂区熔硅单晶的掺杂剂量计算方法研究
史继祥,索开南
(中国电子科技集团公司第四十六研究所,天津 300220)
随着电力电子技术的发展,对高品质低阻高寿气相掺杂区熔硅单晶的需求越来越紧迫,欧美主要国家的气相掺杂区熔硅单晶生长技术已经趋于成熟,而我国还处于起步阶段。主要从理论方面分析气相掺杂过程PH3进入晶体中的方式和过程,并对掺入量的计算过程进行了详细说明。
气相掺杂;电阻率;区熔;原子浓度
电力电子器件是电力电子技术的重要基础,也是电力电子技术发展的“龙头”,其基本组成包括功率二极管、晶闸管及绝缘栅双极型晶体管(IGBT)、栅极可关断晶闸管(GTO)等。电力电子技术的发展又使对高纯度、高均匀性、无位错、低缺陷的大直径区熔硅单晶材料的需求变得更加紧迫,通过区熔的方法在氩气气氛保护下生长的硅单晶,电阻率一般在1 000 Ω·cm以上,而用于电力电子器件的区熔硅单晶,对电阻率的要求为几十殴姆·厘米到几百殴姆·厘米,因此需要对其进行N型掺杂。
目前国内电阻率较低,电阻率均匀性较好的电力电子器件用N型区熔硅单晶材料主要是通过中子嬗变掺杂(NTD)制成,对于电阻率几十殴姆·厘米的单晶需要长时间、大剂量的中子辐照,会导致硅单晶中产生大量辐照缺陷,从而使少子寿命大大降低,即使经过良好的退火工艺,少子寿命一般只能恢复到(800~1000)μs,很难达到更高,要想获得高少子寿命的低阻区熔硅单晶,就需要采用掺杂法生长单晶。除去NTD法外,区熔硅单晶的掺杂生长工艺有三种,即固体掺杂法(母合金法)、液相掺杂法和气相掺杂法。对于直径较大的区熔硅单晶,气相掺杂方法是目前国外采用的主要掺杂手段,这种掺杂方法既可以有效避免单晶生长和掺杂准备过程中与器皿接触造成的沾污问题,又不会出现NTD单晶的辐照缺陷,是获取高少子寿命低阻区熔硅单晶的最佳方式。
气相掺杂区熔硅单晶材料制备难度大,掺杂剂量的控制是生产研制初期面临的最大问题。要想实现电阻率的掺杂目标,必须对掺杂剂量进行缜密计算,才能有效提高生产研制进度,节约试验成本。
1 掺杂机理
区熔气相掺杂工艺是与区熔单晶生长同时进行的,掺杂过程是在高纯封闭系统内进行,可以保证掺杂过程中不受外来有害杂质的沾污,从而提高了晶体的内在质量。气相掺杂的常用杂质源是PH3(磷烷)和 B2H6(硼烷)。PH3是 N 型杂质源,B2H6是P型杂质源,本项目要求导电类型为N型,所以掺杂剂为PH3。磷烷气体受热易分解,反应方程式为:

通过气相扩散和表面附着作用,熔硅吸收杂质原子,从而达到掺杂的目的[1]。
气相掺杂的核心是通过高精度控制的配气系统在晶体生长过程中向熔体中掺入高纯度的磷原子,要想生长的单晶一次达到目标电阻率,掺杂剂量的控制非常关键。根据理论分析,电阻率几十殴姆·厘米的目标单晶掺杂剂浓度为1×1014个/cm3数量级,而硅的原子密度为5.0×1022个/cm3,目标单晶需要掺入的溶质与溶剂的原子比为1×10-8,掺杂剂量非常小,越是小剂量掺杂控制起来难度越大。作为掺杂剂,磷在硅晶体结构中处于替位态,如图1所示。作为第Ⅴ族元素,有5个价电子,磷原子共享了4个价电子给它周围的4个硅原子,还有1个未共享的电子被磷原子贡献出来,成为载流子,所以在计算的时候,磷的掺入量可视为载流子的掺入量。

图1 掺磷硅简化晶格结构图
熔体表面对掺杂气体有吸附功能,在表面吸附的气体饱和之前,吸附作用会一直持续进行,直至达到饱和。磷在硅中的固溶度上限为1.3×1021个/cm3,而我们要掺入的剂量为1014个/cm3数量级,所以离饱和状态还有较大距离。
掺杂实现过程如图2所示。
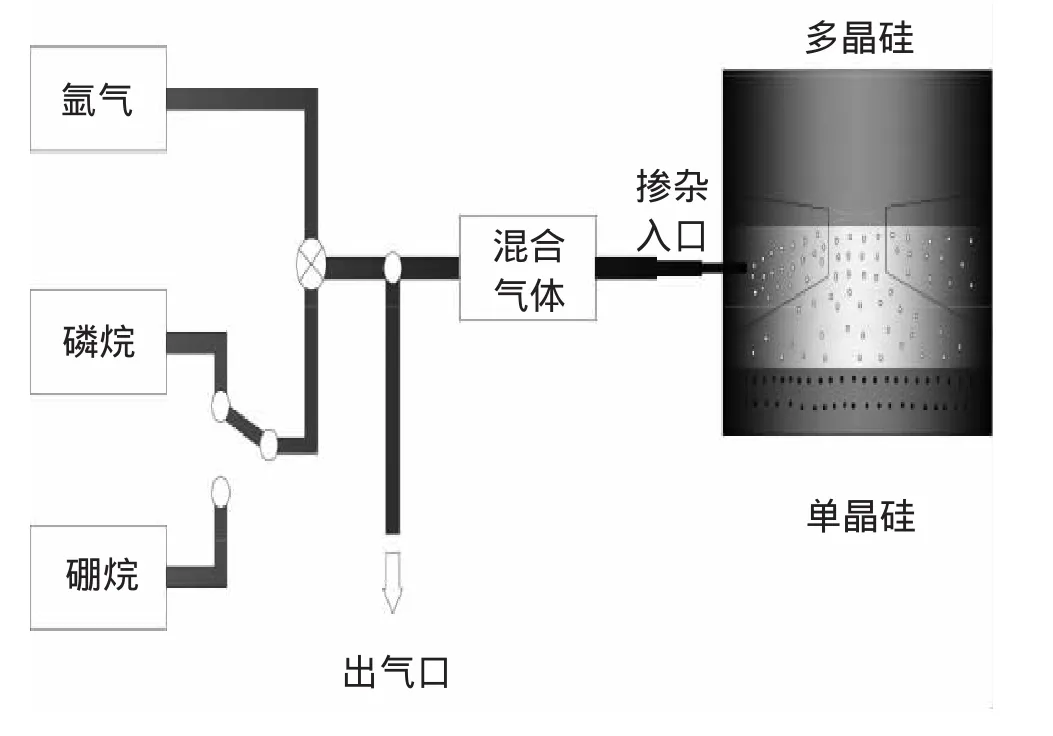
图2 区熔硅单晶气相掺杂原理图
2 掺杂剂量的计算过程
2.1 熔体表面对杂质原子的吸附过程计算
当杂质气流吹至熔区表面时,发生分解反应,磷原子一部分被硅熔体吸附,然后靠扩散和搅拌作用进入熔体内;另一部分返回气流中[2,3]。
假设掺杂气流方向垂直于熔体表面,CG表示掺杂剂原子浓度,CS为熔体表面上吸附的杂质原子浓度,J1表示从气流到熔体表面的杂质迁移的粒子流密度,J2为被熔体吸附住的杂质原子流密度,单位:个/cm2·s,于是,可用线性方程组近似表示出 J1、J2:

其中:nG为杂质原子的迁移个数(个 /cm2·s)
此时,熔体表面和附近空间一薄层两边浓度差为(CG-CS),其浓度梯度为(CG-CS)/δc,于是根据Fick扩散第一定律,通过薄层δc的原子流密度J1为:



根据上述推导结果,可以求出,杂质吸附到表面的吸附速率G为:

N为硅原子密度 5.0×1022个 /cm3,PH3的摩尔浓度为x,则:

掺杂速率随温度的升高呈指数上升。

从式(8)中可以看到,掺杂原子被吸附的速率与温度T没有关系。
2.2 扩散进入熔体内杂质总量的计算
晶体生长过程中,掺杂源以一定速度进入炉膛内,其掺杂状态可视为是恒定源掺杂过程[4]。
恒定源掺杂过程可以假设在整个扩散过程中,熔区表面始终暴露在具有恒定而均一的杂质源气氛中。在该状态下,杂质原子被熔体吸附的吸附几率=(杂质输入量-尾气排出量)/时间。
杂质原子被吸附后,假设是仅靠扩散机制进入单晶体内,可用扩散方程表示:

此时的边界条件:在整个扩散过程熔区表面的浓度保持恒定,即在x=0处,在任何时刻都有:
N(0,t)=Ns,N(∞,t)=0,NS为熔区表面杂质浓度;

初始条件为:t=0,N(x,0)=0,x>0;
令 N(x,t)=NS+u(x,t),边界条件齐次化后有

可求出:

原方程解:


材料内部的杂质浓度随时间增加而增加,随距离增加而减少。
选定杂质元素和浓度后,NS和D被确定,再根据t求出扩入体内的杂质总量Q:

换算成升为0.2 mol/l,再根据PH3在混合气体中的浓度和阿伏加德罗常数NH,即可求得表面杂质浓度N1。
生长单晶的实际P掺入量根据下式计算得出:


测量出电阻率值后,NT根据GB/T13389掺硼掺磷硅单晶电阻率与掺杂剂浓度换算规程查出。
2.3 修正系数的计算
杂质气体通入炉膛后不可能全部被硅熔体吸附进入熔体内,会有很大一部分返回气流中,随着循环氩气被排出炉腔,另外熔入溶体中的杂质原子还要进行蒸发和分凝。这样实际掺入晶体中的杂质数量与工艺过程中通入炉腔内的杂质数量就会有一个比值ξ,这个比值我们要通过试验结果进行计算求出,作为掺杂量计算的修正系数。
要想获得较为准确的修正系数ξ,需要采用多次实验结果,进行叠代计算,计算方法如下:

可计算出第一个修正系数ε1,再根据第一次实验的ε1值反推计算第二次生长工艺的混合气体流量,生长完成后测量电阻率值,按照第一次的计算方法,计算得到第二个修正系数ε2值,依次类推,求得εi,随着I的增大,εi应该向着真实的掺杂系数ε收敛。
3 总 结
本文通过熔体表面对杂质原子的吸附过程推导,扩散进入熔体内杂质总量的推导,和修正系数的叠代计算,从理论上验证了气相掺杂电阻率高命中率实现的可行性。

:出掺入磷杂质的理论原子数。这里扩散系数D取硅熔点的扩散系数,即5.05×10-10cm2/s,t为掺杂时间,取某段单晶生长时间,NS的计算。
因为混合气体直接吹向固液界面处,所以可近似认为NS=N1I,I为通入混合气体的流量为已知量,N1为混合气体的原子浓度,在温度固定的情况下,该量取决于掺杂混合气体浓度和气压,计算主要依据理想状态气体方程:

假设混合气体中PH3的浓度为1×10-6,配好混合气的起始压力P为5.0×105Pa;气体温度取300 K,R=8.314 Pa·m3/(mol·K),由于流量很小,
[1]樊铭德,葛涛.硅区熔气相掺杂工艺的研究[J].上海金属(有色分册),1987,8(6):31-34.
[2]闵乃本.晶体生长的物理基础[M].上海:上海科学技术出版社,1982.301-307.
[3]郭丽华.硅单晶气相掺杂技术的研究[D].天津:河北工业大学.29-31.

史继祥,(1978.2-),男,天津人河西人,助理工程师,目前主要从事半导体材料的测试及其性能研究。
The Calculation Method Research of Gas-doped FZ Silicon
SHI Jixiang,SUO Kainan
(The 46th Research Institute of CETC,Tianjin 300220,China)
Abstract:With the development of power electronics technology,high-quality gas-doped silicon with low-resistivity and high-lifetime has a large demand more and more urgent.Gas doped FZ silicon growth technology has become mature in Europe and America,while China is still in its infancy.In this article,we analyzed the process of PH3 going into the crystal and the doping amount with calculation.
Keywords:Gas doping,Resistivity,Float zone,Atomic concentration
TN305.3
A
1004-4507(2013)10-0050-04
2013-08-12

