Mg注入非极性a面GaN退火温度的研究
杨 扬,李培咸,周小伟,贾文博,赵晓云
(西安电子科技大学 宽禁带半导体材料与器件教育部重点实验室,陕西 西安710071)
GaN材料具有较大的直接带隙、优良的化学稳定性、高热导系数、高熔点及较高的电子饱和速度,是制造短波长高亮度发光器件、耐高温器件的理想材料。但是,GaN薄膜通常是沿着其极性轴生长的,由自发极化和压电效应而产生的强大内建电场大幅地降低了发光效率,内建电场的存在使能带弯曲、倾斜,能级位置发生变化,发光波长发生蓝移。同时由界面电荷产生的电场还会使正负载流子在空间上分离,电子与空穴波函数的交迭变小,使材料的发光效率大幅地降低。避开极化效应的根本方法是生长非极性面的GaN基材料,从而彻底消除极化效应的影响。目前普遍采用的用于制备非极性GaN基材料的途径有两种:(1)在LiAlO2的衬底上利用MBE技术生长()m面GaN。(2)在r面()蓝宝石衬底用MBE,MOCVD和HVPE技术生长a面()GaN材料。r面蓝宝石因其在高温下稳定,且在其上生长的GaN材料背底掺杂浓度低,是一种更理想的衬底材料,因此在r面蓝宝石上生长a面GaN成为这一领域的研究热点[1]。
关于r面蓝宝石上生长的a面GaN的掺杂问题,有过n型掺杂的报道,而对Mg注入a面GaN的p型掺杂以及退火温度的研究较少。文中通过AFM、PL、拉曼等测试手段对Mg注入a面GaN的退火温度进行研究,实验选取650℃、750℃、850℃这3个温度进行对比研究,研究发现选取750℃时退火效果较好。
1 材料生长实验
在r面蓝宝石上生长的a面GaN材料是在立式MOCVD反应室中进行的,将衬底放入反应室后,先经过高温退火处理,然后以H2作为载气进行GaN材料的生长,TMAl,TEGa,NH2和CP2Mg分别作为Al源,Ga源,N源和Mg源。首先生长一层25 nm厚的低温AlN成核层,温度为620℃;然后在其上生长一层100 nm厚高温AlN缓冲层,温度为1 060℃;接着生长一层200 nm厚的AlGaN/AlN超晶格层,温度为1 040℃;在缓冲层生长结束后,生长一层1.5μm厚的非极性GaN薄膜,温度为1 000℃,最后在上面生长一层掺Mg的p型a面GaN,生长温度为880℃。
GaN材料生长结束后,为激活p-GaN中的Mg,需要进行退火处理,退火在N2气氛中进行,在400~500 torr(1 torr=133 Pa)压力下退火10 min,由于c面GaN的退火温度约为750℃最佳,所以本次试验为获得理想的退火温度,选取试验的退火温度分别为650℃,750℃和850℃,另外还有一片未做退火处理的GaN材料用作对比。
所有测试均在室温下进行,采用型号为Agilent 5500 AFM,PL谱和拉曼测量采用325 nm的氦镉激光器。
2 结果与讨论
不同退火温度的非极性a面p型GaN 5μm×5μm AFM 3d形貌,如图1所示,不同的退火温度,3个样品的表面粗糙度有不同的变化,从样品图1(a)与样品图1(b),图1(c),图1(d)的比较可以看出,Mg的掺入使材料质量出现了一定的退化,同时在退火样品图1(b),图1(c),图1(d)的比较中可以看出样品图1(c)的表面相对于样品图1(b),图1(d)的表面形貌变得更加平缓,这是由于在氮气气氛退火时,表面存在着两种运动,分解和吸附,在高温下,两种运动的平衡会造成表面原子的重新分布,在合适的退火温度下,表面会变得平缓[2]。上述图1(a),图1(b),图1(c),图1(d)4个样品的RMS分别为37.2 nm,99.7 nm,47.9 nm,61.1 nm,从均方根粗糙度可以看出,退火样品中图1(c)最小,即退火温度选在约750℃最合适。
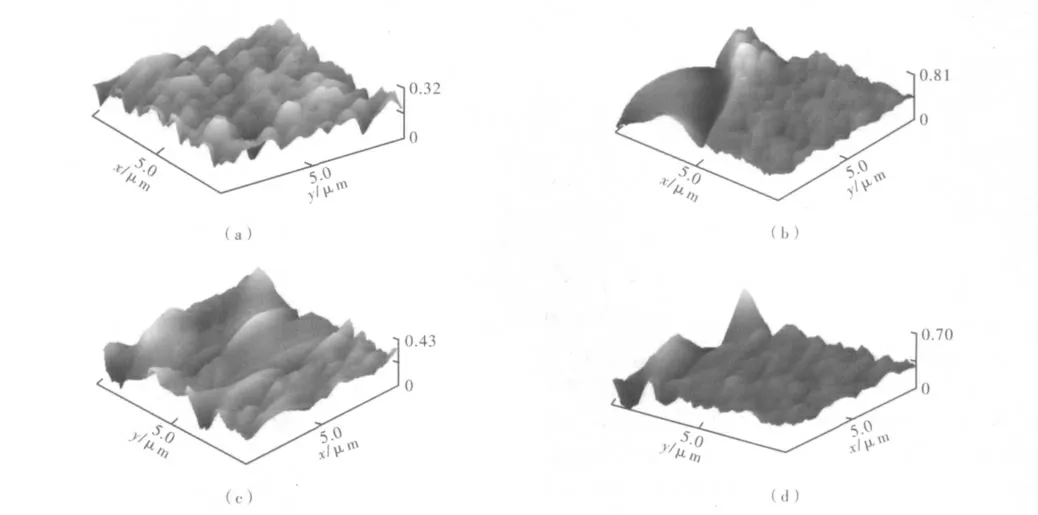
图1 4个样品5μm×5μm AFM 3d形貌图
图1中4个样品5μm×5μm AFM 3d形貌图,图1(a)~图1(d)样品的退火温度分别为0℃,650℃,750℃,850℃。图2是3个样品的光致发光谱,图2(a)为650℃退火时的光致发光谱,从图中可以看到3个发光峰,图中1,2,3的3个发光峰位分别为363 nm,411 nm,550 nm,对应着3.415 eV,3.02 eV,2.25 eV。其中发光峰位1对应着带边峰,对于发光峰位2文献[3]报导为导带自由电子和掺杂引入深受主能级复合引起,有人认为是深施主与浅受主对发光[4],文中观点趋向于认为是独立的受主MgGa和位于导带底170 meV处的间位Mg杂质Mgi复合所产生的,发光峰位3则为黄带。图2(b)为750℃退火似的光致发光谱,图中出现了5个发光峰,发光峰位为367 nm,382 nm,550 nm,733 nm,751 nm,对应着3.378 eV,3.25 eV,2.26 eV,1.69 eV,1.65 eV;发光峰位1为带边峰,相对于650℃时峰位红移了0.037 eV,这是由于750℃退火时GaN外延层的应力更好的得到了释放,对于发光峰位2有报道为浅施主与Mg浅受主对复合发光[4](DA对发光),也有报道为导带自由电子与Mg浅受主能级复合发光[5](e,A发光),文中认为是e,A发光,在KaufmannU等人试验中[6],掺Mg的GaN中出现3.24 eV谱线,他们把这个峰归结于(Mg0,e),也印证了文中的观点。发光峰位3为黄带,峰位4为带边峰的二倍频峰,峰位5为红带。图2(c)为850℃退火时的光致发光谱,出现了4个发光峰,发光峰位分别为364 nm,419 nm,550 nm,730 nm,分别对应3.406 ev,2.96 eV,2.26eV,1.69 eV;发光峰位1为带边峰,相对于650℃,峰位蓝移了0.009 eV应力释放效果也比650℃退火时效果好,峰位2的位置与650℃时峰位2的位置相当,文中认为两者产生的机理相同,即为独立的受主MgGa和位于导带底170 meV处的间位Mg杂质Mgi复合所产生的,发光峰位3为黄带,发光峰位4为带边峰的2倍频峰。

图2 不同温度下的PL谱图及对比
从图2(d)中可以看出不同退火温度下,750℃退火时PL谱的带边峰最强,不考虑非辐射复合的影响,样品带边峰发光跃迁几率与载流子浓度成正比,退火后,Mg杂质被激活,样品载流子浓度增加,带边峰强度也将增加,所以3个温度比较,750℃退火时PL谱退火激活的载流子最多,相对退火温度最好。黄带(实线)的产生机理目前仍在争论中。目前普遍接受的观点是黄带是本征缺陷产生的施主和受主之间的辐射复合引起的,峰位约在2.2~2.3 eV。如果材料中的施主或受主杂质增多,则施主和受主杂质之间的距离减小,电子和空穴的波函数交叠增加,施主和受主复合的可能性大幅增加,从而提高了材料的黄带[7]。从图2(d)中可以看出,750℃退火时的黄带强度最大,也就是750℃时掺入的Mg最多,从这一点上也能说明750℃退火效果相对较好。红带(虚线)是由退火引起的位于禁带中心的深能级缺陷[8],有报道认为对黄带发射负责的点缺陷同样对红带负责,由于其被不同扩散缺陷所影响从而使发光带的峰位产生变化,由于只有750℃退火时出现了红带,这也从侧面印证了750℃时退火较好。
不同退火温度下的a面非极性GaN的拉曼光谱如图3所示,实验选取的背散射方向为y(x z)y,由拉曼散射的选择定则可知此时的A1(TO),E1(TO),E2(H),E1(LO)的4种声子模式是允许的。其中E2(H)声子模式对应力非常敏感,通常用E2(H)声子模式的频移来计算面内应力的大小,也可以通过E2(H)声子模式半高宽的大小来判断晶体质量的好坏[9]。实验中未退火样品、650℃退火、750℃退火、850℃退火的E2(H)声子模式频率分别为570.79 cm-1,570.79 cm-1,570.79 cm-1,570.79 cm-1;可以看出未退火与不同温度退火条件下,面内的应力没有变化,分析认为是非极性GaN材料生长质量较低,以及Mg的掺入量有限导致退火对面内应力的影响基本可以忽略。在T=300 K条件下,GaN在无应力条件下的E2(H)频率为567.6 cm-1,实验样品中的E2(H)频率向高能方向频移了3.19 cm-1,此时样品中还存在压应力,这与衬底和外延层之间的晶格失配以及热失配有关,需要在后续试验中进一步研究降低应力的方法。
3 结束语
通过AFM,PL谱,Raman谱对不同退火温度下Mg注入非极性a面GaN进行了研究,在选取650℃,750℃,850℃这3个退火温度中,750℃退火时表面更加平整,在光致发光谱中750℃退火时带边峰的强度最大,更能有效激活掺入的Mg,获得更高的载流子浓度。750℃退火时效果相对较好,为后续试验奠定了基础。
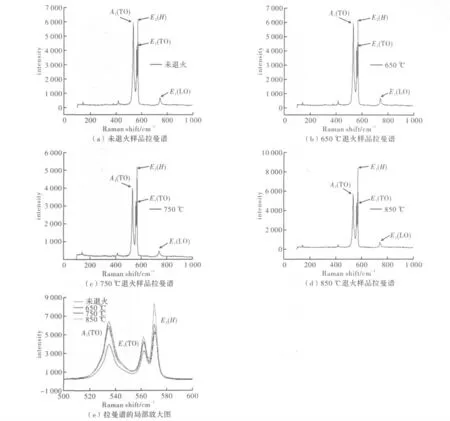
图3 不同温度下的拉曼谱以及对比
[1] 许晟瑞,段焕涛,郝跃,等.r面蓝宝石生长的a面氮化镓研究[J].西安电子科技大学学报:自然科学版,2009,36(10):1049-1052.
[2] 蔡茂世.Mg掺杂AlGaN的MOCVD生长及表征[M].西安:西安电子科技大学出版社,2011.
[3]EUNSOON O H,HYEONGSOO P,YONGJO P.Excitation density dependence of photoluminesceace in GaN:Mg[J].Apply Physics Letter,1998,72(1):70-72.
[4]KAUFMANN U,KUNZER M,MAIER M,et al.Origin of defect-related photoluminescence bands in doped and nominally undoped GaN[J].Apply Physics Letter,1998,72(11):1326-1333.
[5]ISHER S F,ETZEL C W,HALLER E E,et al.On p-type doping in GaN—acceptor binding energies[J].Apply Physics Letter,1995,67(9):1298-1302.
[6]KAUFMANN U,KUNZER M,MAIER M,et al.Nature of the 2.8 eV photoluminescence band in Mg doped GaN[J].Apply Physics Letter,1998,72(11):1326-1332.
[7] 许晟瑞,周小伟,郝跃,等.在r面蓝宝石上生长的a面掺硅GaN的光学和电学性质研究[J].中国科学:技术科学,2011,41(2):234-238.
[8] 尤伟.离子注入GaN的光学和电学特性研究[D].兰州:兰州大学,2008.
[9]XU Chengrui,HAO Yue.Stress and morphology of a nonpolar a-plane GaN layer on r-plane sapphire substrate[J].China Physics B,2011,20(10):107-112.

