脉冲激光背照射单粒子效应实验研究
王德坤,曹 洲,刘海南,杨 献
(1.兰州空间技术物理研究所 真空低温技术与物理国家级重点实验室,甘肃 兰州 730000;2.中国科学院 微电子研究所,北京 100029)
静态随机存储器已在空间大量应用,在空间辐射环境中,静态存储器易受高能粒子的影响而发生单粒子事件。近年来,静态存储器的加固技术和抗辐射能力测试技术快速发展。大量研究证明,脉冲激光是模拟单粒子效应(SEE)的有效工具。随着IC器件集成度的提高,器件正面的金属层数越来越多。脉冲激光从正面辐照穿透更多的金属层到达器件敏感结更困难,故有必要开展激光背照射单粒子效应的研究。本文通过两种SRAM样品的单粒子效应实验,对背照射单粒子效应实验的可行性及样品加固措施的有效性进行验证。
1 背照射实验的相关问题
1.1 激光波长的选择
背面照射实验要求脉冲激光能在穿透衬底到达敏感区域后还有足够能量产生单粒子效应。本实验所采用的1 079和1 064nm波长激光在硅中的射程分别达1 000和700μm左右,对于现代电子器件已具足够穿透深度。若采用一些波长相对较小的激光,在进行背照射实验时需通过一些特殊方法来减薄衬底。
1.2 衬底减薄技术
高强度激光能产生足够大的电场来电离半导体表面的原子。在热量进入半导体内部前产生烧蚀,由此可减薄衬底。应用一定功率密度的飞秒脉冲激光系统可对衬底进行烧蚀处理[1]。这种技术便于使用且能开启微电子工业领域中所有的封装形式,存在的问题是烧蚀过后硅表面会出现厚约3μm的不平整残留物。需对其进行机械抛光处理以使表面达到好的光学效果。
由于本实验所用的是深穿透波长激光及本着对器件加固验证的目的,未对衬底进行烧蚀和抛光处理。但一般器件的衬底表面均是不平滑的,衬底的薄厚不均可能导致不同位置的阈值能量略有差异;表面的粗糙可能导致部分激光不能垂直入射,进而导致落在敏感区的激光在能量上并非严格的高斯分布。
1.3 激光在衬底中的传播
1.3.1 聚焦定位 激光束在衬底中传播会沿着其路径扩散,到达敏感区域后束斑尺寸会覆盖多个敏感结,导致多位翻转以至过高地估计翻转截面,低估阈值能量。但激光在硅中的发散较在空气中的小。由激光束传播的收敛理论可推断,沿着z轴移动器件可使背面入射的激光传播到正面敏感区域时束斑最小化[2],如图1所示。z0为最小束斑聚焦到背面表面时背面的垂直坐标,z1为最小束斑聚焦到敏感区域时背面的垂直坐标,有:

其中:d为芯片厚度;n为半导体材料折射率。
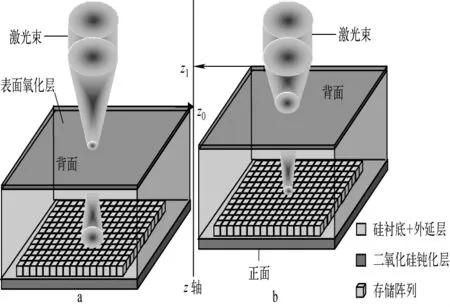
图1 背面入射激光的传播Fig.1 Spread of laser irradiation from backside
对两种器件的加固验证无需测量其绝对阈值和翻转截面,只需测量二者产生SEE的有效激光能量的相对比率。故本实验采用图1a的方法。若对单个晶体管的敏感性进行诊断测试,建议采用图1b的方法。
1.3.2 激光能量校正 考虑到样品开盖后裸露在空气中,经一段时间后会形成1层3~5nm厚的二氧化硅。假设衬底表面具有良好的光滑度,并考虑氧化层的二次反射,可得到透射率Г是氧化层厚度d的周期函数[3]。入射激光经二氧化硅透射后进入衬底能量遵循Beer定律指数衰减。待激光传播到正面表面时会反射回一部分能量,这部分能量也产生SEE。未考虑二氧化硅层的二次反射,是因金属层均是网状的,与二氧化硅是交错层叠的,激光很难形成有效的二次反射,如图2所示。
由于激光束覆盖多个敏感区(图1a),产生单个位翻转的敏感区只是1个激光束斑所覆盖的面积的一部分。设比例系数γ表示激光束中心位置覆盖1个敏感区域面积的能量占整个脉冲能量的比率,假设硅吸收的激光能量产生的载流子均能被有效收集,则对于入射到背面表面的激光能量E0,产生SEE的有效激光能量Eeff校正为:
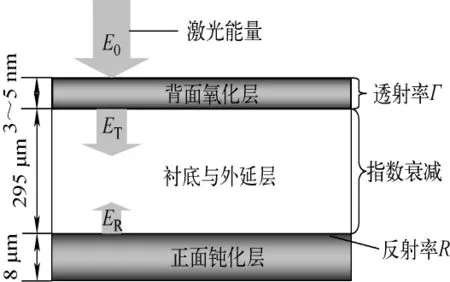
图2 产生SEE的有效激光能量Fig.2 Efficient laser energy

其中:α为吸收系数;z为穿透深度;Г为背面氧化层的透射率;R为正面钝化层的反射率。
本实验目的是对样品的加固措施进行验证,无需精确计算Eeff,而需得到器件2(SRAM 1020-2)和器件1(SRAM IL-2)产生SEE的有效激光能量阈值Eeff2th与Eeff1th的比例系数C:

其中:Г、R、z均决定于集成电路的制造工艺;γ决定于激光束的能量分布。C越大,越能说明器件2较器件1具有更好的抗SEE能力。若两种器件的制造工艺相同,又采用同一波长高斯激光束进行实验,γ1=γ2,Г1=Г2,R1=R2,z1=z2,α1=α2,则:

2 实验方法
实验样品采用非加固SRAM IL-2和加固SRAM 1020-2。1K 容量,CMOS工艺。两种器件除存储单元内部设计不同外,在制造工艺上完全相同。加固器件增大了晶体管尺寸和节点电容以提高临界电荷量。实验前将器件背面开盖,开盖后电测器件性能正常。
实验用激光波长为1 079nm(脉宽9~12ns)和1 064nm(脉宽20~30ps)。
测试系统主要分3个部分:上位计算机、测试板、辐照板。测试板和辐照板分别加电,实时监测被测器件的电流。测试板完成测试激励的生成、响应信号比较、故障统计和部分控制功能,上位计算机完成测试中的控制和测试结果存储,需要时完成数据的适时处理。
3 结果与讨论
3.1 单个位翻转
实验中观察到了单个位翻转,其激光阈值能量如图3所示。

图3 两种样品的激光阈值能量比较Fig.3 Comparison of energy threshold of both devices

这说明1020-2器件具有比IL-2器件更好的抗SEU能力,对1020-2器件的加固措施效果是明显的。
同一器件不同位的阈值能量出现差异可能是由以下原因造成的:1)器件不同敏感点所对应背面表面的平滑度不同,导致光学效果不同,进而使得到的阈值有差异;2)衬底薄厚不均导致激光在传播路径上的衰减稍有差异;3)实验误差。
3.2 单粒子多位翻转
入射到背面表面的激光束斑尺寸约3μm,经295μm的衬底传播后,激光束斑发生了扩散。束斑尺寸可由下式计算[5]:
尽管两种样品的不同位的SEU阈值能量略有差异。但由图3可看到,IL-2的阈值变化范围 (18.5nJ)和 1020-2 的 阈 值 变 化 范 围(50.5nJ)还是远小于两种器件阈值均值之间的差异 (183.2nJ)。由于两种器件制造工艺相同,同一器件的各存储单元设计也相同,所以,两种器件阈值均值之间的差异主要取决于器件电路设计上的差异,而同一器件各个位之间的阈值差异主要取决于实验条件的差异。
由式(4)可得:

其中:ω(z)为在衬底中传播后的束斑半径;ω0为入射激光束斑半径,1.5μm;z为传播距离,295μm;n为Si的折射率,约为3.51;z0为共焦长度;λ为激光波长,1.079μm。
经计算知,激光束斑在Si中传播295μm后,束斑直径约为38.6μm,束斑面积可覆盖横向数个地址线,纵向数个位线。当能量足够大时,即可诱发单粒子多位翻转。这由实验中的单粒子多位翻转最多纵跨4个字线(4×3.6μm=14.4μm),横跨3个位线(3×5μm=15μm)可验证(图4)。图4中,黑色实心点为发生翻转的位,激光束斑由深到浅表示理想束斑能量的高斯分布。但实际上硅片表面是粗糙的,亚微米级的不平滑度导致激光束中的部分激光不能垂直入射,而是与硅片表面成一定角度,这样透过硅片表面的激光以及到达敏感区域的激光也不是标准的高斯分布。这也是图4中发生翻转的位置并不处在束斑中心的原因。
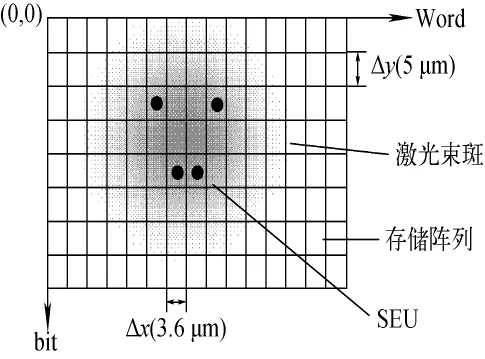
图4 激光束斑覆盖存储阵列示意图Fig.4 Memory cells covered by laser beam
激光测试和重离子测试存在的差异之一是激光的电荷径迹比重离子的电荷径迹大。激光束斑覆盖多于1个存储单元时可能会导致多位翻转。因此,注意在计算翻转截面时要对此进行校正,以免过高估计翻转截面[4]。
3.3 同一位置两种波长激光辐照结果
对IL-2测试中遇到的最敏感点分别用1 079nm和 1 064nm 波长激光辐照,得到1 079nm和1 064nm波长激光产生SEU的能量阈值分别为52.6nJ和42.6nJ。这是因为1 079nm激光器的脉宽约为10ns,1 064nm激光器的脉宽约为30ps,前者脉宽较大,能量密度略低,产生的载流子密度也略低,在有效的电荷收集时间里载流子的收集效率稍低,因而,同样产生SEU所需的能量较后者略大。
4 结论
对两种SRAM样品的存储阵列进行了脉冲激光背面照射单粒子效应实验,得到加固SRAM 1020-2产生SEU的有效激光阈值能量是非加固SRAM IL-2产生SEU的有效激光阈值能量的3.96倍,说明增大管子尺寸和增大节点电容的加固措施是有效的。对IL-2的脉冲激光能量辐照达260nJ,对1020-2的脉冲激光能量辐照达500nJ,仍未发现锁定现象,说明两种器件有较好的抗单粒子锁定能力。
[1]DEAN L,VINCENT P,FELIX B,et al.Backside laser testing of ICs for SET sensitivity evaluation[J].IEEE Transactions on Nuclear Science,2001,48(6):2 193-2 201.
[2]DARRACQ F,LAPUYADE H,BUARD N,et al.Backside SEU laser testing for commercial off-the-shelf SRAMs[J].IEEE Transactions on Nuclear Science,2002,49(6):2 977-2 983.
[3]田恺,曹洲,薛玉雄,等.器件表面钝化层对脉冲激光等效重离子LET值的影响[J].真空与低温,2006,13(2):102-106.TIAN Kai,CAO Zhou,XUE Yuxiong,et al.Impact of device surface coverd by apassivation layer on plused laser-equivalent heavy ion LET value[J].Vacuum and Cryogenics,2006,13(2):102-106(in Chinese).
[4]MELINGER J S,BUCHNER S,McMORROW D,et al.Critical evaluation of the pulsed laser method for single event effects testing and fundamental studies[J].IEEE Transactions on Nuclear Science,1994,41(6):2 574-2 584.
[5]DARRACQ F,LAPUYADE H,POUGET V,et al.A non-linear model to express laser-induced SRAM cross-sections versus an effective laser LET[C]∥Proceedings of R4DECS 2003:Radiation and Its Effects on Components and Systems.Noordwijk:[s.n.],2003:107-112.

