基于强流离子源的离子束溅射镀膜设备均匀性优化*
李桑丫 张艾霖 徐欣 吕涛 王世康 罗箐‡
1) (中国科学技术大学,国家同步辐射实验室,合肥 230029)
2) (中国科学技术大学,核探测与核电子学国家重点实验室,合肥 230031)
3) (中国科学技术大学核科学技术学院,合肥 230026)
随着高端光学器件镀膜的发展,其多样性溅射镀膜需求对离子束流流强、均匀度和可调性提出了更高的要求.对于新一代离子束溅射镀膜机来说,如何在不同离子比、不同流强的束流下保持足够的均匀度,成为了溅射镀膜设备的一大难题.本文提出了一种基于三电极引出系统的优化模拟方法,模拟和优化了离子源的引出系统,研究了等离子体电极、抑制电极、引出电极的形状、角度、距离对离子束引出性能的影响.同时,重点研究了离子比对束流引出的影响.该模型可以指导科研工作者根据离子源的状态和应用需求,对三电极引出系统的角度、距离和形状进行系统优化并找出最优解.最后,本文还给出了一种方法对混合离子束的溅射深度进行了估算.
1 引言
近年来,离子束溅射镀膜技术作为一种广泛应用于各类基底上形成薄膜的关键技术,受到了广泛关注[1-5].随着对薄膜均匀性的需求不断提高,研究离子源流强、引出方式和镀膜效率之间的关系显得尤为重要.离子源流强直接影响薄膜的质量和效率,国内外已有很多提高传统潘宁源流强的研究,比如Nouri等[6]设计出了一种由潘宁离子源组成的流强可达50 mA 以上溅射离子源;Mamedov等[7]利用强流脉冲可以获得放电电流10—100 mA 的潘宁离子源.本文所参考的潘宁源为一种小型潘宁离子源[8]的增强版,在高功率下直流流强最高估计可到100 mA.为确保稳定受控的离子束以获得均匀高质量的涂层,优化引出系统是不可或缺的关键步骤[9].为了获得高能量和大束流密度的离子束,常采用多电极系统.这种系统具有两个主要优势:一是可以通过调整加速间隙的电场与引出间隙的比值改善束流的光学特性;二是获得的束流密度高且可以将其加速至较高能量[10].对于潘宁源,常用的两种引出方法是边(径向)引出和轴向引出.边引出通常用于需要精确束流控制的情况,而轴向引出则具有更高的流强和更好的束流发射度,容易获得大面积的引出束流,但如何控制离子束发散并保证束流的均匀性仍然是一大挑战.此外,轴向引出通常获得的离子束流分子态的粒子更多且电荷态较低,边引出获得的分子态粒子则相对较少[11].潘宁离子源面临的另一个挑战是其电离强度相对于其他强流离子源较弱,例如0.5 mA 引出流强的潘宁源的电离效率仅有10%[12].离子源的电离强度对离子比的影响巨大,这意味着引出束是一种混合产物,存在大量的分子离子.在设计引出系统时,需考虑不同应用需求和参数设置条件下的电离产物比例,因为这将显著影响引出过程和镀膜效率.为了满足大面积引出需求,本文采用能获得更高流强的轴向引出,由于流强的提高,原离子源为探井设计的引出系统将不再适用.为了满足大面积均匀镀膜的需求,束流的引出面积和均匀度都需要进一步优化,为此,本文发展了专用的模拟算法,考虑了不同电离产物比例、电磁场分布、等离子体特性等参数对引出效率的影响,通过优化设计引出系统,致力于提升潘宁离子源在溅射镀膜应用中的离子束均匀性、能量分布和整体镀膜效率.
2 引出系统模拟
2.1 流强、均匀度和单能性对镀膜效率影响的估算模型
沉积效率和均匀性的实际方程和函数将特定于离子源、镀膜工艺和材料特性.可以使用沉积速率(单位时间内沉积的材料量)、涂层厚度的均匀性来度量镀膜效率.
基于模拟条件,本文只考虑引出束流质量对镀膜效率的影响,假定后续沉积效率一致的情况下,使用溅射速率、引出束流的均匀性来等效估算镀膜效率.在实际实验中可以直接通过测量样品各个位置的涂层厚度来衡量镀膜的一致性以及镀膜效率.
定义束流均匀度为流强均方差的倒数,并以单位时间溅射出靶材上的粒子数作为溅射速率D:
分别在常见的不同靶材材料下对比S,评估引出入射离子束质量的核心参数,对比优化的提升效果.在一定范围内,更高的离子电流密度(流动强度)可以导致更快的沉积,而更高的均匀性可以导致更均匀的涂层.
多数金属的溅射阈值位于10—40 eV,该值的大小与靶材的升华热有关.入射离子能量达到该阈值后,溅射率与离子能量成正比.但入射离子能量增至10 keV 左右时,溅射率的增长速度逐渐变缓,从撞击能范围进入级联碰撞溅射.但由于高能注入的出现,溅射产额在离子能量高于50 keV 左右后出现下降.
下面介绍3 种产额估算经验公式,Bohdansky,Matusnami,以及Yamamura.Bohdansky 经验公式为[13]
式中,α是修正因子,α=0.15+0.13M2/M1,Rp/R为平均射程Rp与投影射程R的比值,Rp/R=(0.4M2/M1+1)-1,US为每个 原子的表面结合能,Eth是溅射阈值能量,Sn(E) 是核阻止截面.
Matusnami 经验公式[14]为
式中,ke为电子阻止本领的修正系数,Γ为描述轻离子溅射靶材对总的溅射产额的贡献参数,Γ=W[1+(1+M1/7)3]-1.对于Cu 靶,经验参数Q=1.0,W=0.73,s=2.5,对于Ni 靶,Q=0.94,W=1.33,s=2.5.
从上文可以看出,不管哪种模型,溅射效率主要与离子束能量和束流强有关,所以束流的能量也是一个至关重要的因素,能散和不同离子比的优化将作为本文的重点研究内容之一.
2.2 模拟优化方法简介
本文优化的潘宁源参数如表1 所示.大面积均匀镀膜需要的离子束流为低能强流束,本文使用离子源常用的三电极系统作为引出电极系统.三电极分别为等离子体电极、抑制电极,以及引出电极,一般用于强流离子源加速器系统[16].

表1 潘宁源参数Table 1.Parameters of penning source.
选择优化的引出系统为如图1 所示孔径3 mm的三电极系统,通过改变优化参数,试图获得束流能量为15 keV,束流面积能达到引出500 mm 并拥有更高的均匀度的大面积溅射镀膜的束流.

图1 初始引出电极设计Fig.1.Initial extraction electrode design.
本文设计了优化算法,调用IBSimu(ion beam SIMUlator)[17],进行引出系统的优化.通过自编译代码,实现了对电极几何形状、电极间位置距离以及电极电压的调控,并通过收集出口处的粒子信息,进行对束流均匀度、流强等束流品质参数的二次分析,从而实现对引出系统的自动优化算法.
基于2.1 节溅射效率经验公式分析,这里设置3 个统计量用于评估引出束流质量,分别是束流平均流强密度、单粒子平均能量,以及各宏粒子位置的方差的倒数衡量的束流均匀度.通过归一化函数进行去量纲化来实现各电极参数组合的模拟之间综合加权的比较.由于统计时某些粒子的状态为丢失,选用传统的线性映射方法如Min-Max 归一化会由于最大值与最小值的不稳定而导致评估的不准确.我们选择Sigmoid 函数作为后文使用的非线性归一化函数[18]:
如(5)式所示,Sigmoid 函数拥有类S 的曲线,允许数据趋向正无穷和负无穷且具有良好的阈值切分性,可以规避极端粒子对评估数据带来的不稳定性.改变的参数如表2 所示.

表2 优化参数Table 2.Optimized parameters.
通过收集粒子信息计算得到3 个评估值的变化来评估各优化参数对束流质量的影响,粒子信息收集为距等离子体开口12 cm 处.
3 模拟优化结果及分析
3.1 离子体电极的优化
等离子体电极作为离子源第一电极,对束流的引出至关重要.根据本文开发的优化程序,对强流潘宁源等离子体电极形状进行了深度优化,通过对电场位形的分析,优化出新的等离子体电极形状,其结果如图2 所示.

图2 优化前后的等离子体极形状 (a)两种初始等离子体电极设计;(b)优化后的等离子体电极设计(等离子体电极为15 keV,抑制电极为-5 keV)Fig.2.Optimized plasma pole shape:(a) Two initial plasma electrode designs; (b) optimized plasma electrode design(Plasma electrode is 15 keV,suppression electrode is-5 keV).
新的等离子体电极拥有带沟槽与弧度过渡的底部,通过调整引出系统前部分的电场分布改变束流的初始引出状态,在保证扩大束流引出度的同时也限制了更多的非均匀束流.
3.2 电极角度的系统优化
电极角度的优化工作量巨大,为了提升优化效率,利用旋转矩阵在IBSIMU 代码中添加了对电极角度自动旋转改变优化功能模块实现对不同引出电极角度改变量对均匀度的影响的探究.
依次对使各电极角度一起旋转改变和单独旋转改变做了优化,旋转角度为顺时针.从图3 可以看出,(b)组对整体束流品质变化的贡献最大,而(c)组并不直接影响整体束流品质的走向.即各电极角度变化量对束流品质的影响主要由等离子电极的角度变化主导并与引出电极的角度变化共同影响.图4 为使用Sigmoid 函数归一化三评估量后,侧重均匀度以(3∶1∶6)分别对流强、能量、束流均匀度加权得到的随等离子电极与引出电极的变化角度幅度的变化.图中颜色约深代表该点处的束流品质越好,图中的空白是由于剔除某些组合会出现的束流偏航后导致的.

图3 各电极角度变化量对束流品质的影响 (a)三电极同步角度调整;(b)等离子体电极角度调整;(c)抑制电极角度调整;(d)引出电极角度调整Fig.3.Influence of angle variation of each electrode on beam quality:(a) Three-electrode synchronization angle adjustment;(b) plasma electrode angle adjustment;(c) inhibit electrode angle adjustment;(d) extraction electrode angle adjustment.
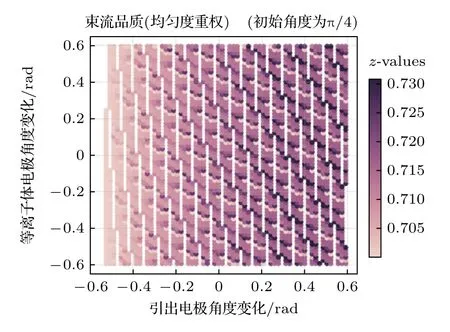
图4 等离子电极与引出电极的角度共同作用对束流质量的影响Fig.4.The influence of the angles of plasma electrode and extraction electrode on beam quality.
从图4 的热图颜色变化可以看出,束流品质在两个电极角度变化下存在明显的周期性,并且因为边缘效应的减小有随着引出电极的抬升渐强的趋势.选取评估值大于0.73003(前4%)的4 组进行对不同抑制电极对均匀度的影响的探究,各组别对应角度变化如表3.只考虑角度的优化最佳结果为第5 组,后续将在这5 组角度的基础上进行电极距离的优化.

表3 优化电极的角度选择Table 3.Optimize electrode angle selection.
3.3 抑制电极系统优化选择
抑制电极除了可以抑制回流吸引等离子体中的电子,对束流品质也有很大的影响.
如图5 所示,在没有抑制电极的情况下,束流的均匀很难得到控制(图5(a)).同时,不合适的抑制电极位置会导致束流的损失(图5(b)).为了探究抑制电极的位置对束流品质的影响,对进行角度优化后的5 组电极系统进行位置参数的优化扫描.

图5 有无抑制电极时的束流对比图 (a) 无抑制电极;(b) 有抑制电极Fig.5.Comparison diagram of the beam with and without the suppression electrode:(a) Without the suppression electrode;(b) with the suppression electrode.
从图6 可以发现,组2,4,5 的表现都较为接近,尤其是组2 与组4 的表现,这也印证了3.2 节中发现的等离子体电极与引出电极的互补周期关系.其中第5 组在抑制电极距离增大后的流强表现上更好,但均匀度表现最差.第1 组与第3 组的表现接近,更陡峭的等离子体电极的束流均匀度有所提高但也为此损失了流强.通过综合考虑,得到如表4 所示的3 组最优结果.

图6 各组别抑制电极距离对束流品质的影响Fig.6.The influence of electrode distance on beam quality in each group.

表4 优化抑制电极的选择Table 4.The selection of optimized inhibition electrode.
3.4 引出电极距离优化
模拟研究表明,在束流不轰击引出电极水平部分的情况下,引出电极的长度并不会直接改变束流品质,因此将着重研究引出电极距离对束流品质的影响.
引出电极优化结果如图7 所示,可以发现3 组情况各有优缺点,其中组1 作为引出电极更为平缓的组别牺牲了部分束流换取了较高的流强,其他两组牺牲了更低电荷量的离子获得了更高的束流能量与均匀度.同时对比组2 和组3 可以发现,离等离子体电极更近的抑制电极对分子态的离子限制更大.总体上,引出电极距离在正常范围内对能量影较小,而对流强和均匀度的影响成反比,因此很难通过更改引出电极距离来提升束流均匀度,所以对于本文的引出系统,引出电极距离并不需要特地做优化.
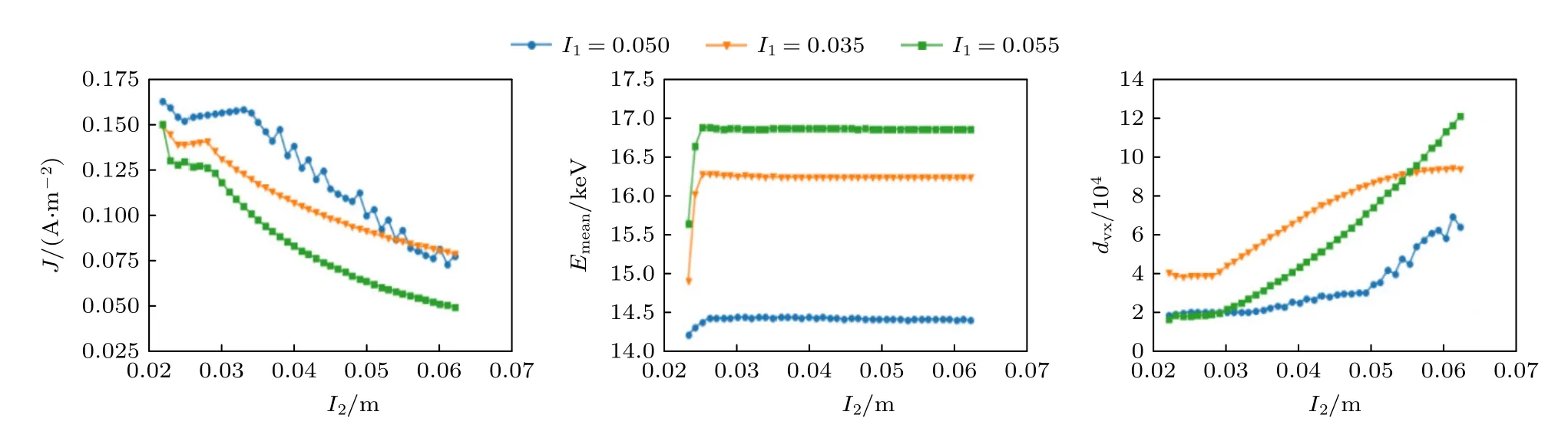
图7 各组别引出电极距离对束流品质的影响Fig.7.The influence of the distance of the leading electrode on the beam quality.
3.5 混合离子束引出优化
由于等离子体内部复杂的相互作用、重组反应和其他相互竞争的电离和解离过程,这些离子的确切比例会发生变化.H2的电离效率和生成的物质比取决于多种因素,包括电子能量分布、气体压力和磁场强度.通过优化这些参数获得更高的电离强度,可以产生更丰富的离子,包括H+,图8 是不同离子比对引出束流质量的模拟结果,可见离子比对束流的引出有极大的影响,而在以往的引出系统研究中往往被忽略.

图8 不同离子比对引出束流质量的模拟Fig.8.Simulation of extracted beam mass by different ion ratios.
根据模拟结构可知,随着分子态的离子占比的提高,以抑制电极牺牲流强的提高均匀度的方式导致的流强损失将不可忽视,而较为陡峭的引出电极设置可以在一定程度上补偿抑制电极的效果.因此,对于高质子比的束流,需要关注等离子体电极的角度与抑制电极的距离,着重两者之间的电场优化以获得高均匀度的束流.而对于高分子态离子比的束流,采用与高质子比一样的通过抑制电极获得高均匀度的方法会导致流强不可接受的损失,更适合通过引出电极的形状补偿均匀度.
3.6 多参数下的智能优化
从上文的分析可知,在不同电极形状,电极角度,l1下对应的l2变化影响也会有所不同;同理,在不同l1与l2下改变电极形状与电极角度也会得到不同的电场结构.并且不同的离子比也会对优化方向带来巨大影响.在耦合影响的作用下,需要将多个参数反复迭代直到收敛得到限定条件下的最优解.从流强的角度上,表4 第1 组的流强更能满足大面积均匀镀膜的要求.
通过多参数迭代后,在表4 第1 组的基础上进行更细致的参数智能扫描获得均匀度更高的版本,得到如图9 所示的结果,可以发现程序主要是通过修改等离子体电极形状优化引出电场使不均匀的束流偏航并最大化地进行扩束以满足大面积均匀镀膜需求.
对比优化前的输入版本,优化后的版本在12 cm 处的束流横截面积提高了57.6%,均匀度也有显著提升.在实际应用中,能够通过延长引出系统长度获得满足0.5 m2以上的大面积镀膜需求.图10 为流截面能量分布优化结果,可见有明显的提升.

图10 优化前后束流截面能量分布对比 (a)优化前;(b) 优化后Fig.10.The comparison of energy distribution of the beam before and after optimation:(a) Before optimation;(b) after optimation.
4 溅射镀膜深度估算
以光学镀膜常用的Ni 靶为例,对于Ni 靶,质子的高点在1—5 keV 之间.离子源不可避免地同时产生H+,,和离子,假定其离子比为4∶5∶1,对引出势能为1.5 keV 的引出系统进行优化得到的优化引出结果如图11 所示.

图11 优化后的1.5 keV 引出模拟Fig.11.The optimized 1.5 keV extraction simulation.
一般来说可以通过计算溅射沉积速率、溅射深度、溅射功率密度来评估溅射沉积的效率[19-21].
其中Ps是溅射功率,ρ是材料密度,A是材料摩尔质量.M是离子质量,N是离子通量.其中溅射功率可由实际使用的机器参数决定,估算对于1.5 kV引出的混合氢离子,H+,,和的Ni 靶的溅射深度如图12 所示.

图12 氢离子优化引出Ni 靶的溅射深度估值Fig.12.Estimation of sputtering depth of Ni target induced by hydrogen ion optimization.
溅射深度可以帮助研究者对靶材的损耗进行评估.总体来说,优化后的系统可以满足溅射镀膜所需的入射能量与均匀度.
5 总结与展望
本文深入探讨了影响离子束溅射镀膜设备均匀度的几个因素,特别是针对强流离子源的引出系统的系统优化研究.给出了一种智能优化方法,在众多的可优化参数中,筛选出最优解,给出了等离子体电极的角度和抑制电极的距离精确优化值,以实现低电荷态离子的高均匀性.而对于分子态离子,提出了电极形状的改进方法,以平衡均匀性和流强.此外,还估算了混合引出束流的溅射深度,为靶材消耗评估提供参考.
未来,我们将继续研究其他影响因素,如温度、压力和靶材,根据特定的应用场景,结合软件开发,获得对离子束特性对涂层效率的影响更准确的估计,以完善离子源优化模型.这些研究结果对于提高离子源技术的应用潜力和涂层质量具有重要意义.

