2022年电子电路技术亮点
龚永林
(上海《印制电路信息》杂志社,上海 201108)
0 引言
2022年是新冠疫情暴发后的第3年,全球经济受到严重影响,我国的电子电路产业艰难前行,但因其市场广阔,总体呈增长趋势。为适应市场需要,电子电路技术也在不断完善、提高。本文阐述的2022年“技术亮点”是指电子电路产业比较突出的前沿性的引人关注的事项。
1 提高运营效率
目前在全球经济不景气的环境下,电子制造业总体仍呈现增长趋势。但2022年是紧缩的一年,影响电子制造业的关键业务指标是材料和人工成本增加、产能利用率降低和生产利润率减少。因此,企业应追求技术进步,以提高运营效率。
1.1 优化生产过程,提高生产能力
2022年印制电路板(printed circuit board,PCB)整体市场呈增长趋势,有较多PCB 企业营收实现两位数增长,可满足新兴电子市场的高端PCB需求。
仅有少数企业通过投资数亿甚至数十亿元人民币实现扩产增能。对于大多数中小企业,即使资金短缺但仍应加强投资,通过生产过程控制改进或局部自动化技术水平提高来提升生产能力。如购置激光钻机和激光直接成像(laser direct imaging,LDI)曝光机,来提升PCB 高密度细线化加工能力;湿处理生产线可配置传感器、溶液配置自动分析添加装置等,以提高过程控制效率;单机作业间可增设自动传送装置、自动装料和卸料装置,将其升级为自动化生产;配置工件自动装卸设备,其长期成本低于人工成本,且操作简单,即插即用;对于老旧但运行良好的重型设备,可以增配传感器,使其实现数字化,不必购买全新设备。工业4.0 和自动化过程是渐进式发展过程,可首先以小投入解决当前生产技术的瓶颈,以取得立竿见影的效果。
1.2 设计和制造
PCB 成本的80%由设计控制,20%由制造控制,节约材料需要得到利益相关者的支持[1]。设计可决定或控制的成本因素为:受PCB 尺寸形状影响的基材利用率,受布线方式和密度影响的基板层数、厚度及加工难易程度,基材性能规格的选定,以及对阻焊层和最终表面涂饰层的选定。上述因素决定了PCB 材料类型和材料数量,占PCB 总成本的50%。另外,PCB 的结构复杂程度决定了其加工难易程度,即影响加工工时和成品合格率等,这些因素占PCB总成本的30%。
应考虑减少PCB 的材料数量,一是减小PCB厚度,二是缩小PCB 面积,这样既可以减少板材用量,也符合电子设备小型化要求。基材有多种规格,价格差异较大,应选择性能匹配的基材,而不是选择最高级的。由不同基材混合组成多层PCB 是降低材料成本的方式,如高速数字和电磁频率(radio frequency,RF)电路区域采用高性能的高价基材,不需要信号控制的区域使用普通、便宜的FR-4 基材。多层板混压技术正在得到普及,应注意不同材质的处理方式存在差异,如压合、钻孔、孔金属化等工艺参数的差异。
最终涂饰为PCB 连接盘或区域提供一个适于焊接、键合或接插连接的表面,种类多样。选择最终涂饰时,除了考虑用途目的,还应考虑是否含铅、导体间距、平整度、耐腐蚀性、潜在问题、存储期、成本等因素。另外,可以考虑采用已经成熟的喷墨打印阻焊剂技术,因喷墨打印油墨仅覆盖保护导线部分,故可节省50%的阻焊油墨。
与可制造性设计(design for manufacturability,DFM)相比,PCB 设计师与制造商之前更强调设计与制造(designer with manufacturers,DWM)的关系[2]。在实现项目中,尽早并经常与下游流程中涉及的利益相关者沟通,包括设计者、制造商和装配者的DWM 团队,以确保产品质量,降低成本并缩短交货期。
1.3 数字化技术应用
采用数字化技术可提高工厂生产率,因此得到了较广泛的应用。市场、设计、计划、制造和交货的业务系统均可利用数字化相互连接,形成高质量和高效率的价值链。市场数字化充分利用IT 网络掌握行业信息,联络供应商和用户,进一步完善了供应链。
PCB设计数字自动化包括以下2个方面:
(1)设计过程自动化。使用CAD 工具更快、更好地处理复杂的设计数据,完成产品设计。
(2)设计验证自动化。应用数字化模拟权衡功率、热、可制造性、成本等多项因素。
部分公司建立了数字化设计平台,通过EDA工具将设计项目上传至数字平台,在产品开发生命周期的任何阶段均可传递信息及获取反馈,在设计环节获得报价、交付周期等信息,取得竞争优势。
许多制造商利用数字化和自动化技术将计算机管理系统串联起来,使其发挥更大作用。如将管理前端业务流程的企业资源规划(enterprise resource planning,ERP)系统、管理生产流程的制造执行系统(manufacturing execution system,MES)和自动化生产线连接起来,实现精益生产[3]。厂内物流方案是关键,可与制造执行系统协调,通过计划/调度和执行掌握实时数据,确保原材料完成从仓库—生产工位—制品生产线—成品入库流转程序。
工厂通过数字化信息掌控设备运转和生产情况,由企业资源规划系统(enterprise resource planning,ERP)、产品生命周期管理系统(produ ct lifecycle management,PLM)和MES 这3 个系统构成闭环制造信息协调体系。如对DFM 展开分析,完成材料清单(bill of material,BOM)和工艺清单(bill of process,BOP),使用数字孪生发布到ERP 和MES,再由MES 系统协调柔性制造,最后通过PLM、MES 和ERP 之间的数字线程实现质量闭环管理。
部分供应商向客户提供设备时,同时推出数字化解决方案,构建设备可视化和软件控制平台。通过数字化解决方案,供应商可更紧密地与客户联系,实现更强大的远程服务,避免与客户产生摩擦,减少计划外停机时间,以此提高了工厂运营效率,并引导制造业向智能化转型。
但同时,数字化的应用会带来网络安全问题,如网络骇客入侵企业数字化网络会造成运营中断或信息泄露。因此,企业采用数字化网络时迫切需要安全措施,要考虑网络数据设置加密和运用权限,检测和预防网络入侵,这是数字化转型过程中的必要措施。
2 向超高密度互连发展
2.1 从HDI到UHDI
在PCB 技术发展中,高密度化是永恒的主题[4],PCB 技术的发展是围绕实现高密度化展开的。在20世纪90年代初,PC 出现了高密度互连(high density interconnector,HDI)技术,美国电子电路和电子互连行业协会(IPC)和日本电子封装和电路协会(JPCA)标准对HDI 板的定义是最小导线宽度和间距≤0.10 mm、最小导通孔孔径≤0.15 mm、含有盲孔和埋孔的多层PCB。后续在此基础上,增加了每面、每平方厘米平均不少于20个连接点的要求。
目前,HDI板的应用已进入了计算机、汽车电子等领域,穿戴电子、医疗设备、航空航天、IC封装等需要密度更高、尺寸更小的HDI板,从而推动了超高密度互连(ultra high-density interconnections,UHDI)技术的发展。2022年,IPC 技术委员会提出了UHDI定义:线宽和间距小于50 μm,介质层厚度小于50 μm,微导通孔直径小于75 μm 的HDI 板[5],其基本条件如图1所示。
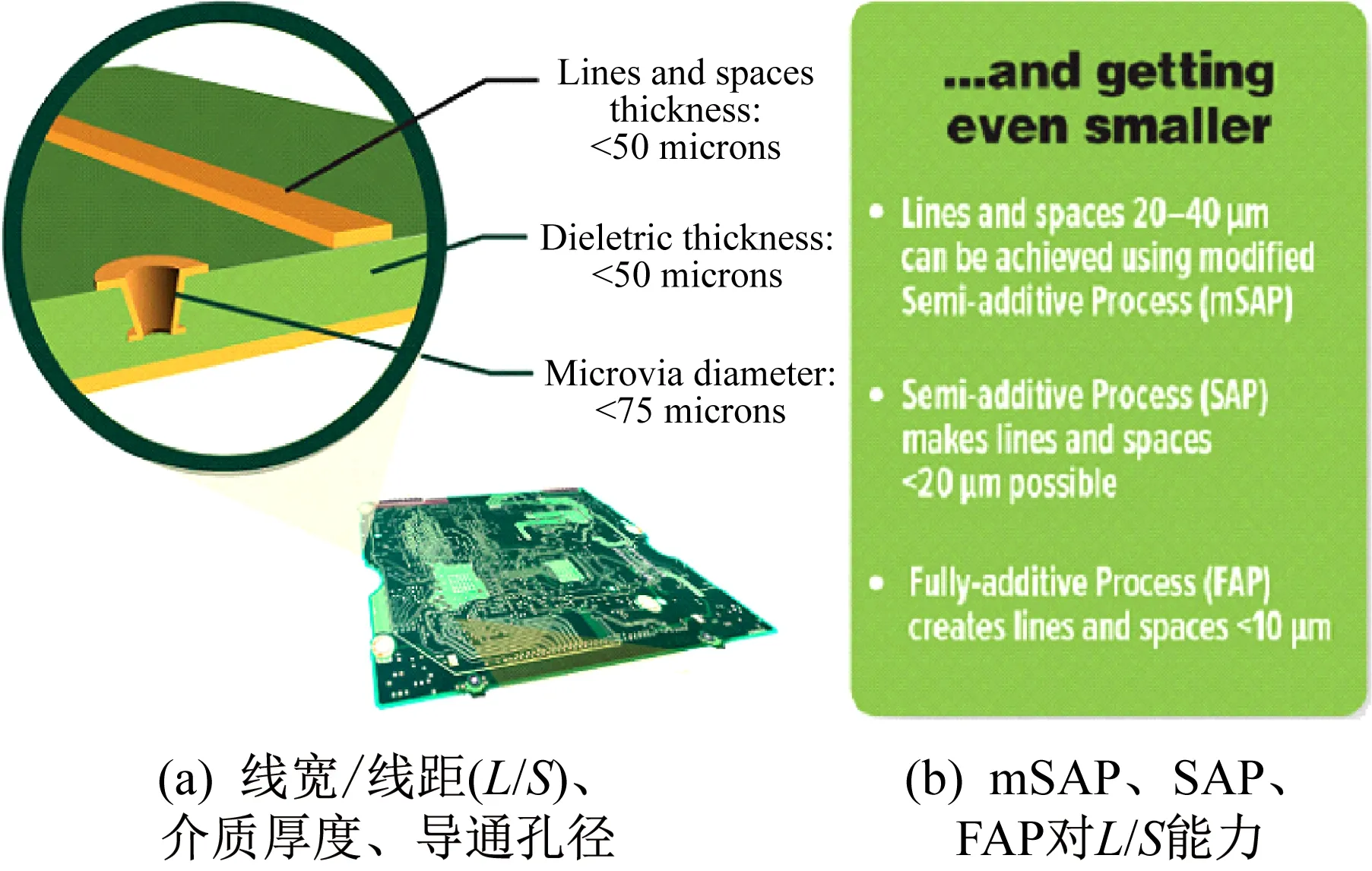
图1 UHDI基本条件 (摘自PCB magazine 2022/10)
2.2 UHDI的必要技术条件
线宽和孔径是HDI 板的基本条件,HDI 板工艺的重点之一是积层(build-up),即芯板积层、任意层全积层及积层层数。前期HDI 板制作是延续了传统PCB 的减成法(铜箔蚀刻法),在厚35 μm 或18 μm 的铜箔上采用感光膜光致成像与化学蚀刻,可制得100 μm 及75 μm 的线宽/线距。积层工艺虽然已有附树脂铜箔(resin coated copperfoil,RCC)和绝缘介质层(如ABF),但为节省成本,可采用半固化布(perperg,PP)加铜箔层压。
减成法是先用金属全面覆盖于基材上,然后去除多余区域形成电路的工艺(蚀刻);加成法是选择性地将金属添加到基材中形成电路,不去除任何金属的工艺(无蚀刻);半加成法是在薄导电层上选择性地加厚金属,从薄层中去除多余金属形成电路的工艺(闪蚀刻)。加成法和半加成法突破了减成法的限制,减少了PCB尺寸和层数。有关工艺能力比较如表1所示[6]。

表1 HDI板不同工艺能力比较 单位:μm
HDI 板可细分为类载板(substratelike-PCB,SLP)和集成电路(integrated circuit,IC)载板,线宽/线距小于30/30 μm,甚至10/10 μm。目前从标准化技术角度提出了UHDI板、HDI板的技术发展路线,开辟了半加成(semi-additive processes,SAP)或改进型半加成(modified semi-additive process,MSAP)工艺路线,这已成为制造HDI板和UHDI板的主流工艺。
为提高生产能力和升级制造UHDI板,HDI板制造工厂需增加设备,主要有高分辨率的直接成像设备(laser direct imaging,LDI)、与成像系统兼容的抗蚀剂、可加工孔径50 μm 及以下的激光钻孔设备、快速差分蚀刻设备、适合薄板的图形和微孔填充电镀设备、处理厚度1~3 μm 的超薄箔设备、自动光学检测 (automated optical inspection,AOI)设备、细节距飞针测试设备等。另外,应确保生产环境洁净,以实现高洁净度的成像、层压等工艺。
mSAP 是一种经过生产验证的方法,可用于生产25 μm 以下线宽/间距的HDI 板,这方法包括激光直接成像、激光打孔、极薄铜箔、填孔电镀和闪蚀等工艺技术;应用这方法生产HDI 板的铜粗糙度小于1 μm,可以得到线路平滑的界面和垂直侧壁,具有显著的信号完整性优势。
3 先进的IC封装载板
以IC 为主体的半导体产业一直是电子工业的重点。2021—2022年上半年,电子设备芯片紧缺,更加显出IC 的重要性,国内外都大力投资IC 产业,同时也看到了PCB的重要性。
半导体芯片是孤立易碎的,需要IC 载板封装保护和建立输出输入通道,使其成为有使用价值的IC。PCB和IC在同一电子产业生态链上,为IC和各种电子元器件实现功能提供了平台。
近年来,硅芯片图形尺寸细微化进展已放缓,芯片含有晶体管数量大约每2年增加1倍的摩尔定律也在改变。国际电子工业联接协会(IPC)调查报告[7]认为,先进封装是未来半导体产业发展的关键和驱动力,可推动IC 超大规模化发展。对于IC 技术发展,由于芯片密度增长已经趋缓,因此未来集成电路高密度多功能会越来越依赖于先进封装。先进封装技术包括倒装芯片(flip chip,FC)、多芯片模块(multi-chip-package,MCP)、系统内封装(system in a package,SiP)、3D IC、2.5D IC、异构集成(heterogeneous integration,HI)、扇出晶圆级封装(fan-out wafer level packaging,FOWLP)等,为进一步提高IC 的集成密度,目前又出现“芯片组”封装。互连技术采用有机树脂、硅、玻璃基材的内插板(interposer)和载板,具有微凸点或铜柱等特征。
PCB(包括IC 载板)是复杂且独特的定制产品,其工艺过程与IC 芯片制造相同,包括光刻胶成像和蚀刻。PCB 有镀覆孔(plated through hole,PTH)电镀,IC 有硅通孔(through silicon via,TSV)电镀,两者的差别只是线路宽度不同,PCB是微米级,IC是纳米级。
随着半导体芯片封装尺寸的缩小,作为IC 载体的PCB 也面临更多的技术挑战。主要采用加成和半加成工艺,这项技术能够制作8 μm 及以下的线宽和线距,实现超精细和超高清晰度。但IC 载板需要具有耐热性、尺寸稳定性和介电特性更佳的基材,包括积层膜(如ABF)。
异构集成是指将具有不同功能的多个裸芯片和微小贴片封装在同一块基板上,有多芯片封装、含内插板封装和基板内埋置硅封装这3 种结构。异构集成采用先进的PCB(HDI 基板),制造HDI基板面临着材料、测试和成本方面的挑战,因此必须得到封装客户支持和设计协同[8]。为此,从芯片到内插板、封装载板布线结构和实现系统PCB,所有设计与制造团队需协同工作。先进封装需要先进的IC 载板和内插板,必须投入先进设备、足够的人力资源以及采用高性能基板材料,需要得到政府财政和政策支持。
4 印制电子和加成制造电子
目前,PCB 制造流程已得到优化,印制电子(printed electronics,PE)和加成制造电子(additively manufactured electronics,AME)技术可简化复杂的制造过程,并已取得进展。
与传统电路板相比,PE 和AME 具有成本低、轻量化、外形灵活及与可数字制造兼容的优势,将会越来越普及。目前PE 主要用于柔性电子产品,已经被广泛应用于传感器、照明、光伏和其他商用组件,正在扩展的应用领域有新兴数字医疗领域、自动驾驶汽车内饰系统等,如数字医疗领域的电子皮肤贴片、汽车车内加热和照明等,工业传感器越来越多地被采用。
PE 最初的用途为薄膜触摸开关,现已被用于电路板。PE 可以制成75 μm、甚至50 μm 的线宽和线距,且不再限于聚酯薄膜(polyethylene terephthalate,PET)基材,也可印制在聚酰亚胺薄膜上;PE 可穿戴产品所用的油墨和织物均得到改进,可提供更多的洗涤效果。
AME 的代表性技术是3D 打印,目前已实现多层次和多材料加成,其中电子电路和元件都可打印在基板上,这是一种100%的数字制造工艺。多材料的加成至少包含2 种材料,通常是一种导电材料和一种介质材料,根据所需的电子功能性逐步沉积形成电子电路,包括直接制造无源元件,如电容器、线圈和电阻器,埋置于电路内[9]。AME 形成的结构与传统PCB 形成的结构大不相同,包括3D 结构,使连接设备只需要导线,没有过孔;AME 设计和制造技术不受垂直设计的限制,不存在任何层依赖关系;AME 可以在最佳距离进行布线和生产,实现更高的封装密度,故称为数字印制电路板(digital printed circuit board,dPCB)。AME 最常见使用的是喷墨打印设备,该设备至少有2 个打印头,1 个用于电介质,1 个用于导电油墨,另外还集成了油墨固化和烧结装置。AME提高了X、Y和Z方向的制造公差,所有运动都在微米级内。
随着材料、制造和加工技术的改进,可穿戴电子产品的范围已经越来越广泛。这些进步主要体现为挠性电路(flexible printed circuit,FPC)技术扩展到挠性混合电子(flexible hybrid electronics,FHE)技术,即是将传统制造技术与3D 电子打印相结合,得到导电线路与元件兼有的聚合物厚膜FPC。随着FPC 技术的不断发展,又有可拉伸电路和电子器件受到了越来越多的关注,进而又创造出更多可穿戴电子设备。
PE 和AME 是加成工艺,没有用干膜成像和电镀、蚀刻工艺,PE 和AME 生产减少了PCB 生产步骤。这种颠覆性加成法技术已逐渐进入电子电路的制造过程中。
5 绿色生产与社会责任
目前,人类活动对环境的破坏日益严重,因此人类社会越来越关注经济发展对自然生态环境的影响。制造企业利益相关方不仅应关心其经济盈利,更应承担社会责任。社会责任是企业自愿将社会和环境问题纳入其生产活动中,以维持企业可持续发展。对此在技术上应采用绿色材料和工艺,减少碳排放,避免对环境和气候方面产生负面影响。电子制造业的的龙头企业在环境、社会和治理(environmental social governance,ESG)方面也应起到带头作用,定期发布ESG 报告(又称“可持续性报告”)。目前许多企业都已开始关注ESG,努力减少温室气体排放,减少能源和水源消耗,注重废物回收利用,以实现“碳中和”目标。采用再生能源也是企业采取的有效措施之一。
PCB 的研发也应为减少碳排放作贡献,主要考虑以下2 方面:① 产品制造加工技术减少碳排放;② 产品结构和材料技术减少碳排放[10]。
在PCB 生产技术方面,应确保技术升级和绿色发展相结合。如喷墨打印标记文字和阻焊剂可节省材料、减少工序、达到高质量图形,喷墨打印还可用于抗蚀图形和电阻图形。PCB 互连孔的金属化工艺由化学镀铜变为直接金属化镀铜,可减少化学品的种类和数量、耗水量和能源,以及碳排放。PCB 最终表面涂饰有多种涂层可选择,从成本和环境影响考虑,有机可焊保护层(organic solderability preservatives,OSP)最适合,OSP进而发展为OSP-HT,以得到更广泛的应用。为了减少工艺步骤和镍对电信号的损耗,将最终表面涂饰的化学镀镍/金(ENIG)、化学镀镍/钯/金(ENEPIG)改为化学镀钯/金(EPIG或EPAG),甚至去除钯,以直接铜浸金(DIG)、还原辅助浸金(RAIG)。在PCB装配方面不断探索低温焊锡,以降低焊接温度、减少能源消耗,确保与Cu-OSP可靠连接。PCB产品结构和材料技术主要体现在设计方面,PCB 设计考虑到产品环保性,采用节省时间、减少浪费和排放的创新方法,在结构上尽量减少材料种类和用量,所用材料绿色环保,确保设计可制造性佳,且产品应具有高质量、高可靠性和可持续性。如挠性电路板的基材聚酰亚胺(polyimide,PI)与聚酯(polyethylene terephthalate,PET)相比,价格昂贵且对环境影响大,因此,一般产品应采用PET基材,甚至采用纸、天然纤维等可生物降解材料。现在,已有公司启动可生物降解PCB的试点项目,包括直接打印导电线路替代湿法蚀刻的加成方法,使用低温连接材料实施低温加工,尽可能采用可回收和可再利用的材料。
传统的投资回报(return on investment,ROI)是按财务数据计算,但目前许多技术升级和绿色发展不能以简单的ROI 估算。实现工厂自动化、工业4.0、绿色化和零排放,除了可提高生产效率、降低劳动力成本,还可改善劳动条件和工厂环境,吸引人才加入,这有利于得到客户认可和促进社会发展,同时也可确保企业持续发展。
6 结语
2023年整体经济形势并不乐观,行业仍面临巨大的不确定性。技术发展是必然趋势,要以新技术开创新产品和新市场。本文所述技术亮点是当前电子电路行业已在进行并成趋势的技术动向,其中部分亮点是延续多年的热点,以供望同行参考借鉴。

