氧空位含量对铝基薄膜忆阻器的影响及稳定性研究
刘 兰,朱 玮,文常保,周荣荣,郭恬恬
(长安大学 电子与控制工程学院,陕西 西安 710064)
自2008 年HP 实验室宣布发现一种交叉结构的TiO2薄膜符合忆阻特性以来,忆阻器在新型电子器件、新型多功能材料、神经网络电路设计等交叉学科涌现丰富的研究成果[1-4]。忆阻器因自身阻值可随流经电荷而变化的特性,使其工作方式与人脑神经突触有相似之处,被视为制备类脑芯片的重要仿生器件之一[5]。在电子器件领域内,已知的符合忆阻特性的材料主要包括高介电材料(SiO2、Al2O3、AlN 等)[6-8]、过渡金属氧化物(TiO2、ZnO2和VO2等)[9-11]和功能型材料(HfO2、In2O3等)[12-13]。其中高介电材料因其造价低廉、性能稳定、与现有CMOS 技术可融合等特点,在阻变材料及其忆阻器件研究中具有特殊意义。铝基材料的忆阻特性已有相关文献发表[7-8],但针对氧空位含量对介电材料阻变特性的影响研究较为缺乏。氧空位指阻变材料中缺失氧原子的活跃金属离子,可以在不同电场方向下做迁移运动[14-16]。本文利用磁控溅射技术制备了不同氧空位含量的铝基薄膜。通过对比发现,氧空位含量对薄膜阻变特性有显著的影响,在制备成忆阻器后会直接影响器件的关键性能参数,如开态电流、关态电流和器件保持时间等。换言之,通过调整阻变材料的氧空位含量,也可实现忆阻器基本参数的有序调整。这对忆阻器件特性优化及其神经网络电路的应用具有一定参考意义。
1 样品制备与表征
首先将200 nm 厚度的Al 沉积在p 型硅衬底上形成忆阻器底电极,之后采用射频磁控溅射的方法在底电极上制备约40 nm 厚度的铝基薄膜。磁控溅射时,靶材选用99.99%纯度的铝靶,通入的氩气、氮气和氧气的气体体积流量分别为45,15,0.5 mL/min(样品1)和45,15,1.5 mL/min(样品2),电源功率固定为150 W,溅射时间约为15 min。
因为铝在氧气中反应较为活跃,因此溅射时的氧气流量不宜过高,避免铝靶材与氧气反应过激而损坏。溅射过程中可以通过调整溅射时的氧气流量,制备不同氧空位浓度的铝基薄膜。溅射完成后的铝基薄膜马上进行400 ℃退火处理可在薄膜内部形成铝纳米颗粒。制备忆阻器通常采用MIM(Metal-Insulator-Metal)结构,还需要活跃金属作为顶电极。采用离子束蒸发法在铝基薄膜表面沉积银材料,形成厚度为200 nm,直径为100 μm 的圆形电极,最终完成忆阻器三明治结构。忆阻器电学特性由Keithly 4200 参数分析仪进行测试,探针台底盘温度最高可达250 ℃。
铝基薄膜的X 射线光电子谱(X-ray Photoelectron Spectrum,XPS)测试结果如图1 所示。当氧气流量较少时,只有小部分铝原子可以和氧原子反应,因此游离的铝原子(即氧空位)含量高,如图1(a)所示Al 离子含量较高为样品1;当氧气流量增加,更多的铝原子会与氧气反应形成Al2O3,这使得游离的氧空位含量变低,如图1(b)所示Al 离子含量低为样品2。通过XPS 结果可知,样品制备过程实现了通过调整磁控溅射时的氧气流量来控制薄膜氧空位含量的目的。

图1 XPS 结果图。(a)样品1;(b)样品2Fig.1 XPS results.(a)Sample1;(b)Sample2
2 实验结果与讨论
2.1 I-V 测试
I-V测试是研究器件电学特性的基本测试。不同氧空位含量的忆阻器I-V测试结果如图2 所示,测试设定最高限制电流为100 mA。
将样品1 和样品2 进行对比发现,氧空位含量高的样品1 具有更低的阻值,具体表现在样品1 具有较高的Ion(开态电流)和Ioff(关态电流)。这是因为氧空位含量高的样品代表具有更多可移动的铝原子,可以形成较粗的导电丝;而样品2 的Ion和Ioff相对较低,意味着在氧空位含量低的样品里形成的导电丝较细,器件的流经电流Ion和Ioff与导电丝的粗细程度直接相关。样品1 和样品2 的结构如图2(a)所示。Vreset和Vset是判断忆阻器性能的另外两个重要参数,较低的Vreset和Vset是制备低功率器件的关键。复位(reset)过程对应了忆阻器从低阻态(Low Resistance State,LRS)到高阻态(High Resistance State,HRS)的转变,意味着导电丝断裂,通常与材料内产生的热量相关;置位(set)过程对应了忆阻器从HRS 到LRS 的转变,意味着导电丝的连接,通常与材料内活跃金属在导电丝上的累积相关。从图2(b)可知,样品1 和样品2 都属于单极性忆阻器,即器件的reset 和set 过程都发生在同一电极的电压扫描测试中。若进行负向电压扫描时器件依旧会在负向电压范围内发生置位和复位过程。对比样品1和样品2 的Ion、Ioff、Vset和Vreset值发现存在一定差异,需要进一步的研究探索。

图2 (a) 样品1 和样品2 的结构图;(b) 样品1 和样品2 的I-V 测试图Fig.2 (a) Structure of Sample 1 and Sample 2;(b) I-V measurements of Sample 1 and Sample 2
本文对样品1 和样品2 分别进行了40 次的I-V测试,得到的Ion和Ioff值、Vset和Vreset值分布分别如图3(a)和(b)所示。通过对比图3(a)中样品1 和样品2 的Ion和Ioff值可以发现,样品1 在LRS 和HRS 状态下的电流都比样品2 高,这说明样品1 比样品2 拥有更低的阻值,这也与图2(a)中设定的样品1 拥有较粗的导电丝这一设定相符。
对比图3(b)中的Vreset和Vset可以发现,样品1 的Vreset值比样品2 要高。这是由于reset 过程是导电丝的断裂,因此较大的Vreset表明样品1 内形成的导电丝较粗,需要更多的能量断裂;而样品1 的Vset值却比样品2 小,这是因为富含铝的样品在HRS 状态下会流经较大的电流(Ioff),可以加速活跃离子的累积,因此只需要较低的电压就可以使导电丝重新连接。通过上述实验发现,氧空位含量对于Ion、Ioff、Vset和Vreset这四个参数值都有重要的影响,器件的阻变特性与材料内氧空位含量直接相关。因此证明了在进行忆阻器件设计时,可以通过调整氧空位含量实现忆阻器关键参数的调整。

图3 (a) 样品1 和样品2 的Ion和Ioff分布图;(b) 样品1 和样品2 的Vreset和Vset分布图Fig.3 (a) Ion and Ioff distribution of Sample1 and Sample2;(b)Vreset and Vset distribution of Sample1 and Sample2
2.2 脉冲电压测试
脉冲电压测试区别于I-V扫描测试,该测试下忆阻器展现的电学特性更贴近人脑神经突触信息处理的方式,这在忆阻器的神经网络电路应用中有重要研究价值。
本文分别对样品1 和样品2 施加连续的脉冲电压如图4(a)所示。第一级阶段脉冲电压幅值为1 V,宽度为50 ms,间隔为20 ms。这一阶段的脉冲电压激励让忆阻器从LRS 转换到HRS,如图4(b)和(c)所示。对比两个样品,样品1 完成这一转换平均需要16 个脉冲,而样品2 需要10 个脉冲。这也说明在脉冲测试中,样品1同样需要较多的能量去实现导电丝的断裂。第二阶段脉冲电压测试施加的脉冲幅度为2.5 V,宽度和间隔不变。这一阶段的脉冲激励使得处于HRS 的忆阻器转换至LRS,激发过程如图4(b)和(c)所示。样品1 和样品2完成这一转换分别需要10 个(约0.7 s)和34 个(约2.38 s)脉冲,说明较粗的导电丝因流经电流较大,因此仅需较少的脉冲数量就可以完成导电丝断裂和再连接过程。这一测试结果也与之前结论相符。
通过对比图2 和图4 可知,无论是扫描电压测试还是脉冲电压测试,忆阻材料内氧空位的含量对于器件参数都有明显的影响。氧空位含量高的忆阻器会比氧空位含量低的忆阻器拥有更小的激发阈值,在神经网络中更易受到外界刺激而激发。同时,可以通过调整材料内氧空位含量浓度,实现在同一材料上制备不同激发阈值的忆阻器,这对于神经网络电路设计和硬件实现具有一定参考价值。
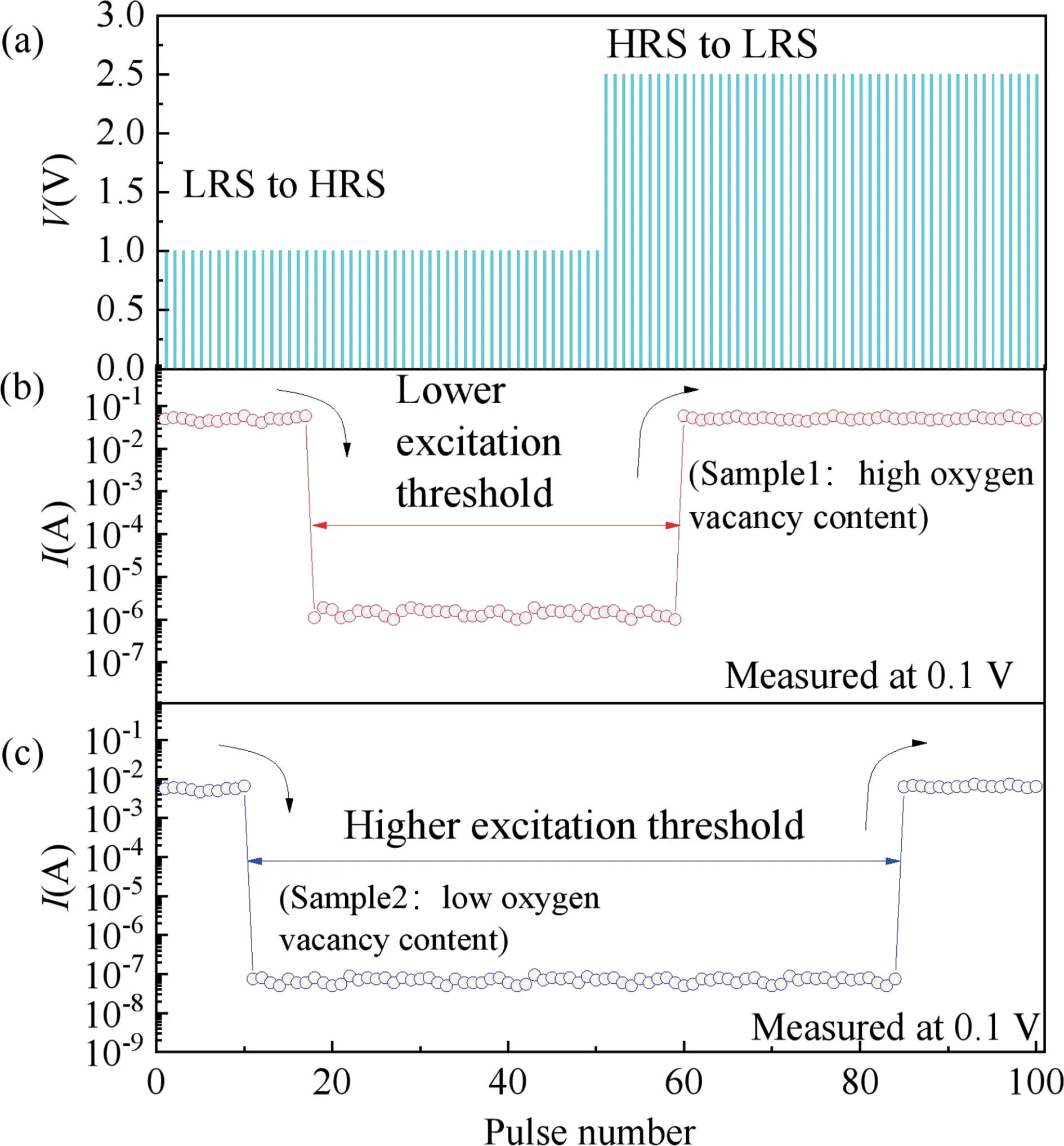
图4 (a) 施加两个阶段的脉冲电压;(b) 样品1 在脉冲电压测试下的电流变化;(c) 样品2 在脉冲电压测试下的电流变化Fig.4 (a) The applied two stages pulse voltages;(b)The current change of Sample1 with applied pulse voltage;(c) The current change of Sample2 with applied pulse voltage
2.3 样品稳定性测试
忆阻器保持各阻态阻值(LRS 和HRS)的稳定性是器件研究的一个重要问题,但与普通电子器件不同的是,在神经网络应用中忆阻器阻值的保持时间应具备可调的特性,就好比神经突触的权值保持时间也应随着接收到的脉冲刺激增强而增加,而人类的记忆保持时间也会从几分钟持续到数十天甚至数年不等。因此不同材料和工艺制备的忆阻器保持时间差异较大。高温测试是考验电子器件稳定性的常用方法之一。本文的稳定性测试首先将样品1 和样品2 分别置于温度为50 ℃的衬底上进行LRS 和HRS 阻态保持时间测试,发现在经历4×104s 后两个样品的HRS 阻值没有明显变化,但LRS 阻值都有一定程度的降低;尤其样品2的LRS 有明显的降低,如图5(a)所示。这一现象考虑是高温条件下器件内的存储电荷加速流失的结果。

图5 (a) 在50 ℃下样品1 和样品2 的状态保持结果;(b)在150,175,200 和225 ℃时样品1 和样品2 的保持时间,样品1 和样品2 分别在85 ℃条件下保持219.9 天和4.2 h;(c)循环测试结果Fig.5 (a) Retention time of Sample1 and Sample2 at 85 ℃;(b) Retention time of Sample1 and Sample2 at 150 ℃,175 ℃,200 ℃and 225 ℃,Sample1 and Sample2 can keep 219.9 days and 4.2 h at 85 ℃respectively;(c) Duration measurement result
默认电荷流失50%的时间为器件阻值的保持时间,将测试温度提高到150,175,200 和225 ℃时,样品1 和样品2 的LRS 阻值保持时间分别进行测试后的结果如图5(b)所示。从图中通过线性拟合可知,若环境温度为85 ℃时,样品1 和样品2 的LRS 阻值保持时间分别为219.9 天和4.2 h。由此可知,在高温条件下,拥有较细导电丝的样品2 忆阻器更易断裂,其电荷保持时间要低于拥有较粗导电丝的样品1,这也与前文图2(a)所述样品2 的导电丝需要较少能量断裂的解释相符。虽然样品1 和样品2 的LRS 阻值保持时间有很大差异,但并不代表样品2 无法应用于神经突触功能的模拟,正如人脑内并非所有的神经元都有长久记忆的属性,还应根据神经网络电路具体要求进行忆阻器设计。器件的抗疲劳测试一般通过置复位循环测试完成,如图5(c)所示,在经过四个置复位交替测试后器件依旧保持较高的开关比,说明该忆阻器内导电丝的形成和断裂状态较为稳定。
3 结论
本文制备了两组结构相同但氧空位含量不同的三明治结构忆阻器,经实验发现氧空位含量会显著影响忆阻器性能,包括重要参数Ion、Ioff、Vset和Vreset等。当氧空位含量增加时,样品具有更高的开态电流(约10-2A)和关态电流(约10-6A)。由于较多的氧空位可形成较粗的导电丝使得流经电流增大,因此具有较低的置位电压(约1.2 V)可让导电丝重连;同时较粗的导电丝需要较高的复位电压(约0.5 V)才能断裂。这一结果与已报道的结论是相似的。另外在进行脉冲电压测试时发现,氧空位含量高的样品1 激发时间(约0.7 s)要明显快于氧空位含量低的样品2(约2.38 s)。同时,样品1 的LRS 状态 保持 时间(约219.9 天)也要明显优于样品2(约4.2 h)。样品1 的LRS 保持时间已基本满足电子器件实际的运行要求,这与样品1 内部形成了较稳定的导电丝有关。氧空位含量对器件阻变特性的影响研究对于忆阻器设计优化具有重要意义,为忆阻器应用于神经网络电路提供了设计参考。

