MRAM 的辐射效应分析及加固方法简述
施 辉,张海良*,宋思德,曹利超,王印权,刘国柱,顾 祥,吴建伟,洪根深,李明华,贺 琪
(1.中国电子科技集团公司第五十八研究所,无锡214072;2.北京科技大学 材料科学与工程学院,北京100083)
0 引言
磁性随机存取存储器(magnetic random access memory,MRAM)的技术发展最早可以追溯到19世纪50年代提出的铁氧体环芯磁随机存储器;1984年Honeywell 公司利用磁性薄膜的磁电阻各向异性设计出磁电阻随机存储器,代表真正现代电子学意义上的磁随机存储器的诞生;80~90年代,巨磁电阻效应(giant magnetoresistance,GMR)、室温高隧穿磁电阻效应(tunneling magnetoresistance,TMR)、自旋转移矩效应(spin transfer torque,STT)的相继发现为MRAM带来了新的应用前景,研究人员提出了GMR-MRAM设计方案并相继研发出Toggle-MRAM和STT-MRAM等芯片产品;当前,基于自旋轨道力矩写入技术的磁随机存储器(spin orbit torque based MRAM,SOT-MRAM)以及电压控制磁随机存储器(MeRAM)也正处于研究阶段。MRAM兼具静态随机存取存储器(SRAM)的高读写速度和动态随机存取存储器(DRAM)的高集成度,并且具有非易失性、可无限擦写和低功耗等优势,被认为是构建下一代非易失性缓存和主存的理想器件。此外,存储单元磁性隧道结(magnetic tunnel junction,MTJ)还具有较好的抗电离辐射和耐高低温性能,因此MRAM 有望成为未来空间飞行任务普遍采用的理想存储器。
大量研究表明,空间辐射效应对MRAM的外围CMOS电路和MRAM存储单元都会产生影响。对外围CMOS电路而言,其存在电离总剂量(TID)损伤、单粒子锁定(SEL)、单粒子翻转(SEU)、单粒子瞬态(SET)和单粒子功能中断(SEFI)等风险。在MRAM 存储单元方面,典型的MRAM存储单元结构为1T-1MTJ(1个MTJ 和1个NMOS晶体管漏端相连,也即1M1T)结构,其中NMOS晶体管受辐射效应影响会产生阈值漂移现象,而认为MTJ 对辐射免疫的论断也被证明并不符合实际。
本文主要总结国际上关于第一代Toggle-MRAM和少量的第二代STT-MRAM的辐照试验研究结果,包括TID效应致MRAM 读错误机制、单粒子效应(SEE)致MRAM 写错误机制以及辐射效应对MTJ 性能的影响。而全面准确地理解MRAM的抗辐射机理有利于更好地利用新材料、新结构来提高MRAM的抗辐射性能。
1 MRAM 的辐射效应研究
1.1 辐射效应导致MRAM读写错误的物理机制
自2006年Freescale公司推出第一款型号为MR2A16A 的商用Toggle-MRAM芯片以来,MRAM技术不断发展。为了确保MRAM能够应用于空间飞行任务,研究人员对这些不断量产面世的MRAM进行了大量总剂量效应和单粒子效应评估试验。
在长期空间飞行任务中,MRAM的读操作概率远远大于写操作;当系统处于休眠模式时,MRAM进入静态模式。研究人员对静态模式、读模式和读写模式进行了TID试验评估,表1为Everspin(Freescale)、Aeroflex 和Honeywell 三家公司的不同型号MRAM器件的TID试验结果(表中以不同颜色作区分,蓝色区域为商用MRAM,粉色区域为抗辐射加固MRAM),“测试条件”列给出了辐照试验过程中MRAM的操作模式、辐照试验采用的辐照源以及剂量率,文献中未给出测试条件的以符号“—”标注;“抗TID能力”列的数值给出的是MRAM未出现读写错误的最高辐照剂量(≥)或出现读写错误的最低剂量(<)。表1中除Honeywell公司的一款抗辐射STT-MRAM和Avalanche公司的一款商用STT-MRAM外,都是Toggle-MRAM。相同型号MRAM抗TID能力的差异可能和芯片工艺偏差、辐照剂量率以及辐照过程中MRAM 的读写模式的不同有关。从表1可以看出,静态模式、读模式以及读写模式下的TID试验结果均表明,几乎所有MRAM产品都可以承受40 krad(Si)以上的总剂量电离辐射,有些甚至可以达到100 krad(Si)以上的抗总剂量辐射水平。考虑到空间真实剂量率更低,总剂量效应产生的电子-空穴对数目更少,对MRAM性能影响较小,MRAM极有可能实现空间应用。2009年,Honeywell 公司研发出第一款1 Mbit 的抗辐射加固MRAM(型号为HXNV0100),其采用SOICMOS电路(称为SOI-MRAM),研究发现该MRAM经1 Mrad(Si)的总剂量辐照(Coγ 射线和X 射线)后,读写参考电压、读写参考电流、读写周期等读写性能没有发生明显的变化,这表明SOI-MRAM 经1 Mrad(Si)的总剂量辐照后硅衬底和隧穿势垒层中的电荷捕获和阈值漂移不明显。Aeroflex公司的抗辐射加固采用0.18μm TSMC CMOS工艺,其抗总剂量辐射能力在100 krad(Si)~1 Mrad(Si)之间,而Honeywell公司采用SOI CMOS电路加固的SOI-MRAM 的抗总剂量辐射能力均可以达到1 Mrad(Si)以上。Katti 等的研究表明,受制于硅器件的阈值漂移效应和MTJ 的AlO绝缘势垒层性能,MRAM的抗TID能力和抗重离子效应能力无法进一步提高。

表1 MRAM抗总剂量效应能力评估Table 1 Data of total ionizing dose resistance of MRAM Chips
大量研究表明,当总剂量超过MRAM所能承受的阈值时,发生读错误的比特单元数目将急剧增加。目前关于TID致MRAM 读错误机制还没有统一定论,Zhang 等提出存储单元晶体管电阻漂移模型(如图1所示)。

图1 存储单元晶体管电阻漂移模型Fig.1 Resistance drift model of transistor in memory cell
由图1可知,存储单元晶体管由1个NMOS晶体管和2个寄生晶体管组成,寄生晶体管的存在是由总剂量电离效应产生的电子-空穴对在浅槽隔离区域(shallow trench isolation,STI)被陷阱捕获从而形成陷阱电荷和界面态导致的,此时STI区域相当于栅氧。进行读操作时,MRAM存储单元依据式(1)进行状态读取:

式中:I为读电流;R为存储单元晶体管的沟道电阻;R为比特信息为“0”的MTJ 的电阻;R为比特信息为“1”的MTJ 的电阻;R=(R+R)/2,为参考电阻。
随着TID剂量增加,更多正电荷被STI 氧化物捕获,导致NMOS有效沟宽增大、寄生晶体管阈值负漂移增大,进而导致存储单元晶体管的沟道电阻R降低。如图2所示,由于TID效应,R降低程度大于参考单元MOS管的沟道电阻降低程度,导致部分I(R+R)值小于I(R+R)值,从而导致一部分状态“1”被读成“0”的读错误;反之,R降低程度小于参考单元MOS管的沟道电阻降低程度,则会导致一部分状态“0”被读成“1”的读错误。

图2 总剂量效应导致Toggle-MRAM 读错误机制示意[18]Fig.2 Physical mechanism of TID-induced Read errors in Toggle-MRAM[18]
表2为三家公司不同型号MRAM器件的SEE试验结果(表中同样以不同颜色区分商用MRAM和抗辐射加固MRAM,且除表1所述的2款STTMRAM外,都是Toggle-MRAM)。表中的SEE 阈值为MRAM未出现读写错误的最高辐照剂量(≥)或出现读写错误的最低剂量(<)。由表2可见,MR2A16A MRAM对SEL 敏感,而MRAM存储单元采用NMOS管与MTJ 集成工艺,物理上不存在PNPN寄生结构,不会产生单粒子锁定效应,因此前端体硅CMOS外围电路是MRAM的SEL辐射敏感区域。关于敏感节点,Elghefari等认为这种敏感性主要是由CMOS中有源区引起的,有研究人员认为晶体管的漏端是最敏感的节点。经设计加固和在CMOS制程中采用外延层后,MR0A08B的单粒子锁定阈值可达84 MeV·cm/mg以上。Honeywell 和Aeroflex 公司的SOI MRAM对SEL免疫,单粒子翻转率≤10(d·bit),这主要是因为SOICMOS电路避免或缓解了体硅CMOS器件中的辐射效应。

表2 MRAM抗单粒子效应能力评估Table 2 Data of singleevent effect resistance of MRAM Chips
在传统的半导体电荷存储器,如静态随机存储器SRAM和动态随机存储器DRAM中,单粒子效应在MOS晶体管的阱区和源漏端引发电子-空穴对,产生的寄生电流会使存储单元比特状态改变,从而导致单粒子翻转错误。Toggle-MRAM数据写入后,其数值取决于MTJ 磁化层的磁化状态,单粒子效应产生的寄生电流(μA 级)不足以改变存储单元状态(改写电流为mA 级),故大量研究认为静态和写入状态下Toggle-MRAM对SEU 免疫。Toggle-MRAM的读电流在10μA 左右,因此理论上Toggle-MRAM在读操作状态下最敏感;但2013年Tsiligiannis等研究发现,在中子和α 射线辐照下MRAM没有产生SEU 软错误。分析SEU产生需要的3个条件:1)辐照产生寄生电流;2)存在敏感区域;3)读取时间窗口足够大。而MRAM读取时间较短(35 ns)且只有8 个灵敏放大器,因此MRAM读操作时产生SEU 的概率也极低。2012年Aeroflex 公司对抗辐射加固UT8MR2M8 MRAM芯片进行SEU 测试,试验采用氖(Ne)、氩(Ar)、氪(Kr)、氙(Xe)4种重离子,LET(linear energy transfer)值范围为5.7~112 MeV·cm/mg,研究发现MRAM 没有发生SEU,分析认为器件在离子辐照过程中读操作时所探测到的错误是由SET 和SEFI 效应引起的,并分别在LET 阈值为18.1和29.5 MeV·cm/mg 时观察到SET和SEFI。
Sakimura 等和Wakimura 等分别对STTMRAM和STT-MRAM的1M1T存储单元进行单粒子翻转仿真,研究表明,随着STT-MTJ 技术节点越来越小,其翻转电流不断变小,发生SEU 的概率也越来越大。2016年,Yang 等研究了重离子辐照下STT-MRAM存储单元的写错误机制,提出在没有重离子入射时,MTJ 的写电流为

式中:V为电源电压;R为MTJ 在写入电流和对应偏压下的结电阻。若重离子轰击存储单元NMOS源端,则在离子入射的通道处产生大量电子-空穴对,从而在源端和衬底之间形成临时沟道。将该临时沟道电阻定义为R,写“1”时位线接地,则R和R并联(如图3(a)所示),根据Kirchhoff电流定律和Kirchhoff 电压定律可知,此时MTJ 的写电流为
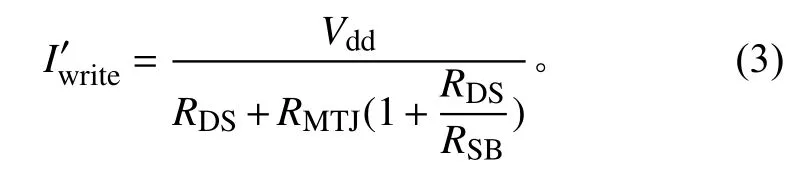
可见,写电流和临时沟道电阻R呈正比。临时沟道电阻R和辐射强度有关:辐射强度越大;R越小,写电流越小;当写电流减小至不足以翻转MTJ磁矩时就会导致MTJ 写“1”错误。相反,写“0”时,由于衬底接地,临时沟道电阻R和R并联(如图3(b)所示),此时MTJ 的写电流为

可见,随辐射强度增大,临时沟道电阻R减小,从而导致MTJ 写电流增大,但这并不会导致MTJ 写“0”错误,因此写“1”错误是STT-MRAM最主要的写错误形式。
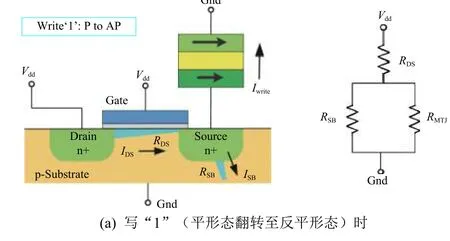

图3 重离子轰击存储单元晶体管形成临时沟道示意和等效电路[31]Fig.3 Physical mechanism of Write errors in STT-MRAM after heavy ion impact on the access transistor and equivalent circuit[31]
1.2 辐射对磁性隧道结性能的影响
一直以来,大多数研究主要是对MRAM芯片进行辐照试验,但是要弄清楚磁性隧道结是否对辐射免疫,需要单独研究辐射对MTJ 性能的影响。
磁性隧道结若在辐射环境下能够正常工作,其核心性能应该至少满足以下条件:1)较高的隧穿磁电阻(TMR)值,使得MRAM 具有足够大的读区间,避免由于低TMR 值导致的读错误;2)较小的磁性隧道结电阻和结面积的积矢(the area resistance,RA);3)足够高的热稳定性系数Δ(>60~70),从而使得数据保持时间可以足够长(10年以上)。热稳定性系数可以表示为

式中:M为饱和磁化强度;H为有效各向异性场;V 为自由层的体积;k为Boltzmann 常数;T 为绝对温度。可以看出,要获得高的Δ值,铁磁电极的饱和磁化强度M和矫顽力H(H和H成正比)需要足够大。
早期的研究集中在离子(如He、Ar、C、O、Ni、Kr、Si、Ag、Ga等)辐射对AlO势垒MTJ 输运性能和磁性能的影响,结果表明TMR 随离子注量增加而降低。其主要原因为:1)铁磁/氧化物界面互扩散增强,铁磁电极的自旋极化率降低,从而降低TMR;2)绝缘层缺陷密度增大,产生额外的电子传输通道,但该通道对电流的极化弱于直接隧穿,因此TMR 降低。RA 随离子注量、能量增加而增大直至饱和,RA饱和平台主要是由势垒缺陷密度增大和势垒变宽两个因素的竞争作用导致的:一方面,随离子注量增加,势垒层中缺陷密度增加,导致势垒电阻降低,从而降低RA;另一方面,辐射导致Al和O原子配位发生局部变化(不影响自旋极化率/TMR),导致势垒变宽,从而增大RA。同时,随离子注量增加,铁磁电极的H降低,而M不发生变化。以上研究表明,在重离子轰击下MTJ 并不完全抗辐射:辐射对MTJ 的影响虽然很小但不可逆,这和MTJ 的结构以及离子的种类、能量和注量有关;辐射导致隧穿势垒层附近的界面效应变化和电子结构变化是辐射效应影响MTJ 性能最主要的因素。
2012年,Hughes等和Ren 等分别对基于MgO势垒的面内磁各向异性MTJ 进行辐射效应研究,结果在质子(约10/cm)、中子(约10/cm)和Coγ 射线(10 Mrad(Si))辐射下,MTJ 薄膜的磁化曲线、电阻和TMR 没有发生变化;同时MTJ 的比特状态和写入性能没有发生变化。这说明Coγ 射线、质子和中子辐射对MTJ的磁性能(M、H)和STT翻转特性影响不大,从而表明这些辐射环境下MRAM 产生的读写错误是由CMOS电路引起的。最近的研究工作表明,MgO势垒的垂直磁各向异性MTJ 也对Coγ 射线和质子辐射免疫,但以上研究均未涉及重离子辐射对MgO势垒MTJ 性能的影响。2014年,日本东北大学的Kobayashi 等研究了不同偏压条件下Si离子(约10/cm)对垂直磁各向异性MTJ 的辐射效应,发现在Si 离子轰击下,辐射前后磁性隧道结比特状态相同,这表明静态下MTJ 有很强的抗SEU 能力;该研究同时表明MTJ 的结电阻和热稳定性系数Δ几乎不变。Katti 等利用高注量重离子辐照Toggle-MRAM芯片(HXNV0100)的研究发现,MRAM 有硬错误并伴随着MTJ 电阻的明显降低,并认为这可能由重离子对隧穿势垒层的破坏和位移损伤导致;2017年,Katti研究重离子对Toggle-MRAM(型号HXNV01600)的截面损伤(Cross-Section)发现,尽管辐照过程中并无SEU 发生,但一些重离子的LET值超过某一阈值后,重离子辐射会对MTJ 的势垒层造成截面损伤,因此相较于粒子注量,LET 值和重离子的原子序数是对MTJ 重离子截面更为重要的影响因素,这表明重离子辐射对MTJ(尤其是隧穿势垒层)的影响是瞬时的而非渐进的——在极高LET值和极高注量下,重离子可能会击穿隧穿势垒层。这些研究表明MTJ 并不完全抗辐射:辐射可能使MTJ 的结构和性能发生变化从而导致错误。2018年,Katti等采用Ne、Ar、Kr和Au等重离子对256 Mbit STT-MRAM进行重离子辐照测试,发现所有辐射条件下STT-MRAM 均无硬错误发生,而Toggle-MRAM 在较强辐射下产生硬错误。这主要是由于STT-MTJ 采用MgO势垒材料以及由于尺寸微缩导致入射至STT-MRAM比特单元的离子数目减少。Wang 等近期研究发现,1907 MeV的Ta离子和2000 MeV 的Kr离子辐射仍未影响双CoFeB/MgO界面STT-MTJ 的电学性能,表明基于MgO势垒的STT-MTJ 具有良好的抗辐射性能。
2 MRAM 加固技术简述
图4为几款MRAM的SEL阈值和抗总剂量能力总结,第一款MRAM 芯片MR2A16A 的抗总剂量能力和抗SEL 能力均较弱;MR0A08B经设计加固和在CMOS工艺中采用外延层后,SEL 阈值得以提高;Honeywell 公司的HXNV 系列MRAM采用SOICMOS电路,抗总剂量能力得到了大幅度提高并对SEL 免疫。
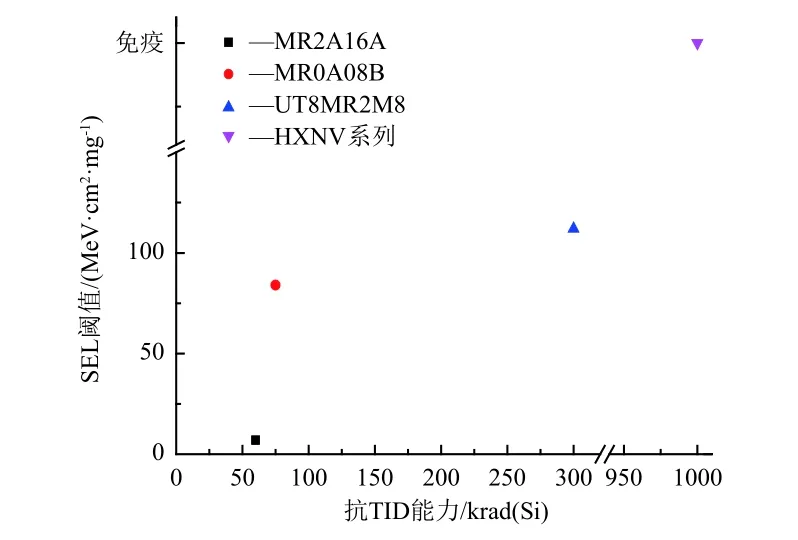
图4 几款MRAM的SEL 阈值和抗总剂量能力Fig.4 SEL threshold and TID resistance for several MRAM chips
MRAM存储区和外围电路的辐射失效类型和辐射失效机理不同,因此MRAM 应在不同的节点针对不同的辐射类型进行相应的加固。此前研究人员已经提出一些MRAM 的电路设计加固方法。目前在工艺方面,外围电路多采用SOICMOS电路以避免SEL 效应,提高抗总剂量能力;MRAM存储单元多采用NMOS管与MTJ 集成工艺,物理上不存在PNPN 寄生结构,不会产生SEL 效应。对于存储单元NMOS而言,可通过提高沟道宽长比、采用环形栅以及场区注入等方法进行加固;对于MTJ 而言,应尽可能提高其TMR 值,以减少辐射后TMR 降低对MRAM 的影响。
3 结束语
商用MRAM采用体硅CMOS外围电路,因此对SEL 效应较为敏感;SOI-MRAM则能消除SEL效应敏感。辐射环境下MRAM读写错误的物理机制还不完全清楚:存储单元晶体管沟道电阻改变可能是MRAM 受总剂量电离辐射产生读错误的物理机制之一;重离子入射轨迹临时沟道的形成则可能是MRAM受重离子辐射产生写错误的物理机制之一。Toggle-MRAM中的AlO势垒磁性隧道结并不完全抗辐射——辐射会影响MTJ 的电输运性能和磁性能,极高LET值重离子辐射可能会击穿MTJ 势垒层从而会导致MRAM芯片发生硬错误。STT-MRAM采用MgO势垒且存储单元尺寸缩小,因此其抗单粒子硬错误能力增强;但由于STTMTJ 尺寸微缩引起的临界翻转电流降低也导致其SEU 风险增大。辐射效应对MTJ 性能的影响与MTJ 的结构以及离子的种类、能量和注量有关;隧穿势垒层附近的界面效应和电子结构变化是辐射效应影响MTJ 性能最主要的原因。
随着基于自旋转移矩写入技术的垂直磁各向异性磁性隧道结的逐步推广应用,辐射效应对垂直磁各向异性的影响,不同种类重离子辐射对MTJ阵列读写性能和数据保持的影响,重离子辐射和磁性隧道结中扩散(铁磁电极和MgO势垒层的互扩散、元素扩散)的关联,以及如何通过调节磁性隧道结材料、结构和尺寸来提高MRAM 抗辐射性能等仍然需要深入研究。

