激光对固态电解质金属氧化物薄膜晶体管性能的影响
杨 倩, 杜世远, 边 锐
(1. 福州大学 至诚学院,福建 福州 350002;2. 福建卫生职业技术学院,福建 福州 350101)
1 引 言
自2003年Nomura报道透明金属氧化物薄膜晶体管(Metal-Oxide Thin Film Transistor, MOTFT)以来,关于材料体系和制备技术得到蓬勃发展[1-3]。MOTFT具有响应时间短、迁移率高、生长温度低、高透光性和可大面积制备等优点,有利于实现较大的开口率,能够满足新一代4K大尺寸显示器的快速、大面积和更高清晰度显示的需求[4-5]。值得注意的是,基于固态电解质的MOTFT具有良好的环境稳定性和优异的电学性能,因而具有巨大的应用潜力[6-7]。
传统的提高固态电解质MOTFT电学性能的方法主要包括材料设计或改变器件结构[8-10]。例如,Beom K.等人采用双栅器件结构从而提高基于TaOx/n-IGZO的器件电导[11];Pillaiet等人则是通过调节固态电解质绝缘层的厚度实现对晶体管性能的调控[12]。然而,上述方法存在制作工艺复杂、制备时间长的问题,同时,难以对晶体管实现精确的调控[13-14]。
利用激光对材料进行处理为上述问题提供了一个简单的解决方案,通过利用激光对材料产生的局部热效应,以及激光优异的加工处理速度,从而实现对材料性能的精确控制[15-18]。本文探究了激光对固态电解质金属氧化物薄膜晶体管电学性能的影响,该晶体管采用高k固态电解质Ta2O5作为栅绝缘层,透明氧化铟锡(ITO)作为有源层以及源漏电极。需要注意的是,在沉积半导体层和电极之前,采用飞秒激光(Femtosecond Laser, fs-laser)对Ta2O5绝缘层薄膜进行照射处理。研究发现,随着激光强度的提高,Ta2O5/ITO TFT的开态电流增加,阈值电压负向漂移。通过对Ta2O5薄膜进行XPS测试,表明激光可以调控薄膜中氧空位的含量。同时,本文进一步探索了激光对固态电解质晶体管突触性能的影响,兴奋性后突触电流(EPSC)随着激光强度的增强而增加。本文提出了一种简单、快速(<1 s)、低温(<45 ℃)地调控晶体管性能的方式,为今后基于固态电解质MOTFT更加广泛的应用奠定了基础。
2 实 验
2.1 固态电解质MOTFT的制备
本文制备的固态电解质MOTFT为底栅顶接触结构,采用纯硅片作为底栅电极。首先,用丙酮、异丙醇和去离子水对硅片依次进行清洗,每次5 min,之后用氮气对其吹干;随后,在硅片上利用射频溅射法溅射150 nm的Ta2O5绝缘体层,溅射功率100 W,气压为0.35 Pa。利用飞秒激光对Ta2O5薄膜进行照射处理,激光脉冲频率为1 MHz、脉冲宽度为283 fs、波长517 nm;为了探究激光强度对Ta2O5薄膜的影响,本文选择了3种不同的激光强度:263,309,358 mJ/cm2,对Ta2O5绝缘层薄膜照射时采用网格型方式扫描薄膜表面,扫描速率为500 mm/s。之后,利用扩散溅射法制备ITO半导体层和源/漏电极,在溅射过程中,ITO源/漏极在纯氩环境下通过射频磁控溅射镍掩模板沉积,掩模板放置在Ta2O5/Si衬底上方,距离衬底50 μm,溅射的ITO纳米团簇会衍射到掩膜版的阴影区,因此,在ITO源极/漏极之间会同时自组装形成一薄ITO沟道层。器件沟道长度和宽度分别为80 μm和400 μm,在扩散溅射过程中压力和功率分别为0.3 Pa和300 W。
2.2 实验仪器
本文制备的固态电解质金属氧化物晶体管电学特性测试使用Agilent 2902半导体器件参数分析仪,Ta2O5薄膜的表面形貌使用原子力显微镜(AFM,Bruker Multimode 8) 测量。利用XPS研究了激光照射对Ta2O5薄膜的化学成分的改变。所有电学特性均在室温环境下测试。
3 结果与讨论
图1(a)为本文制备的底栅顶接触Ta2O5/ITO TFT的结构示意图,其中,绝缘层为固态电解质Ta2O5薄膜,有源层为ITO薄膜。值得注意的是,本文在制备电极和半导体层的过程中,采用了扩散溅射法,即在一个过程中同时形成半导体层和金属层。在溅射100 nm ITO电极时,形成了厚度约20 nm的自组装ITO层,该自组装ITO薄膜显示出半导体性能。利用掩模板自组装方法同时形成电极和半导体层的方法具有制作工艺简单、成本低的优势。由于固态电解质的电双层效应,栅极介质层和半导体层界面之间具有极强的电双层调制效应,因此,基于固态电解质的薄膜晶体管可以在低电压下工作,高k的Ta2O5薄膜(εr=20~35)可以有效降低驱动电压、降低器件功耗。我们采用了扩散溅射法制备半导体层和源漏电极,从而大大简化了工艺步骤,并在电极和有源层之间提供了更好的欧姆接触。需要注意的是,在沉积半导体层和电极之前,本文利用飞秒激光对Ta2O5薄膜进行照射,如图1(b)所示,激光扫描方式为网格型,激光扫描速率为500 mm/s,激光波长为554 nm,激光脉冲宽度为283 fs。

图1 (a) Ta2O5/ITO TFT结构示意图;(b)激光照射Ta2O5薄膜示意图。Fig.1 (a) Structure diagram of Ta2O5/ITO TFT;(b)Schematic diagram of Ta2O5 insulator layer under laser irradiation.
图2(a)为本文制备的Ta2O5/ITO TFT双扫转移曲线。该曲线在Ta2O5薄膜厚度150 nm、源漏电压VDS为5 V情况下测试,器件呈现出典型的n型特性曲线,记忆窗大于3 V,转移曲线中的逆时针迟滞是由于固态电解质绝缘层中移动离子的运动引起的。同时,由于固态电解质中电双层的强静电耦合效应,制备的晶体管的电流开关比大于106,导通电流大于10-4A。Ta2O5/ITO TFT的输出曲线如图2(b)所示,器件在低的源漏电压VDS下IDS呈线性增加,说明TFT具有良好的欧姆接触。
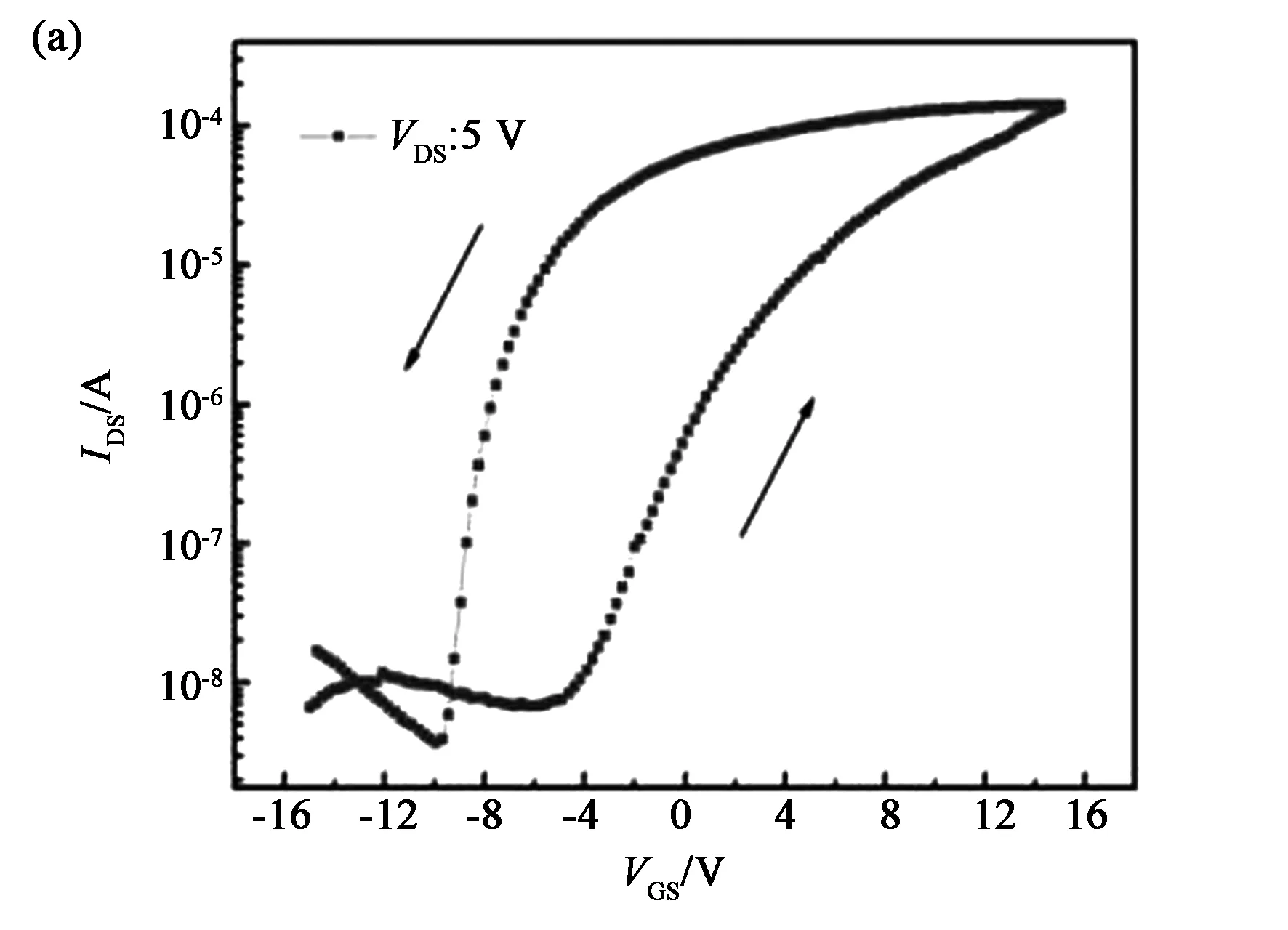

图2 (a)Ta2O5/ITO TFT器件双扫曲线; (b)Ta2O5/ITO TFT 输出曲线。Fig.2 (a) Dual sweep transfer curves of Ta2O5/ITO-based TFT at a constant VDS of 5.0 V; (b)Output curves of the Ta2O5/ITO-based TFT.
3.1 不同激光强度对固态电解质TFT的影响
为了研究激光强度对Ta2O5薄膜表面的影响,本文研究了不同激光强度下的MOTFT特性。图3展示了在激光扫描速率为500 mm/s时,不同激光强度下器件的IDS-VGS特性曲线。从图中可以看到,在激光强度为263 mJ/cm2和358 mJ/cm2时,开态电流有着明显的差异。晶体管在栅压VGS=5 V、激光强度358 mJ/cm2时的开态电流(20.3 μA)是激光强度263 mJ/cm2时的开态电流(3.01 μA)的近7倍,且关态电流也明显增大。这表明在较高的激光强度下有更多的可移动的离子,从而导致在半导体层中产生较高的电子密度。同时,大量移动离子的积累导致阈值电压的负向漂移。我们采用了原子力显微镜(AFM)的tapping模式来表征Ta2O5薄膜的表面形貌,Ta2O5薄膜在无激光照射和激光强度为309 mJ/cm2时的表面粗糙度均方根分别为0.854 nm和0.680 nm,如图4(a)、(b)所示,由此可以得出激光照射对Ta2O5薄膜表面粗糙度没有显著影响。图5 为本文制备的Ta2O5绝缘层的C-V双扫曲线,从该曲线中可以得到,在AC 1 MHz的频率下150 nm厚度的Ta2O5薄膜介电常数(κ)为21。

图3 不同激光强度下Ta2O5/ITO TFT的转移曲线Fig.3 Tansfer curves of Ta2O5/ITO TFT under different laser intensities

图4 (a)无激光照射和(b)激光强度为309 mJ/cm2时Ta2O5薄膜的表面形貌Fig.4 Surface RMS roughness of Ta2O5thin film. (a)With no laser irradiation; (b)With laser intensity of 309 mJ/cm2.
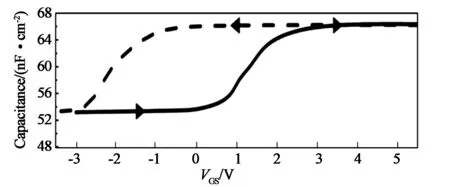
图5 双扫C-V曲线Fig.5 Dual sweep C-V characteristics of the device
3.2 不同激光强度下Ta2O5薄膜的XPS分析

图6 (a~d)不同激光强度下Ta2O5薄膜的O1s峰Fig.6 (a~d)O1s peaks of Ta2O5thin film under different laser intensities


表1 Ta2O5薄膜在不同激光强度时Ta—O、VO2+、CO峰面积百分比
图7所示为本文制备的Ta2O5/ITO TFT的工作机理。当施加正栅压时,如图7(a)所示,带负电的氧离子被吸引到Si/Ta2O5界面,带正电的离子氧空位被排斥到Ta2O5/ITO界面上,因而导致在绝缘层/半导体层界面氧空位的积累。在图7(b)中,激光照射会导致绝缘层/半导体层界面上更多的氧空位积累,导致更多的载流子(电子)积聚在ITO半导体层,并从源极漂移至漏极。有趣的是,绝缘层/半导体层界面上大量氧空位的积累将在固体电解质中形成自上而下的内建电场,从而削弱栅极电场的作用。当施加负栅压时,如图7(c)所示,由于电离氧空位和负氧离子的复合,内建电场消失,晶体管处于OFF态。
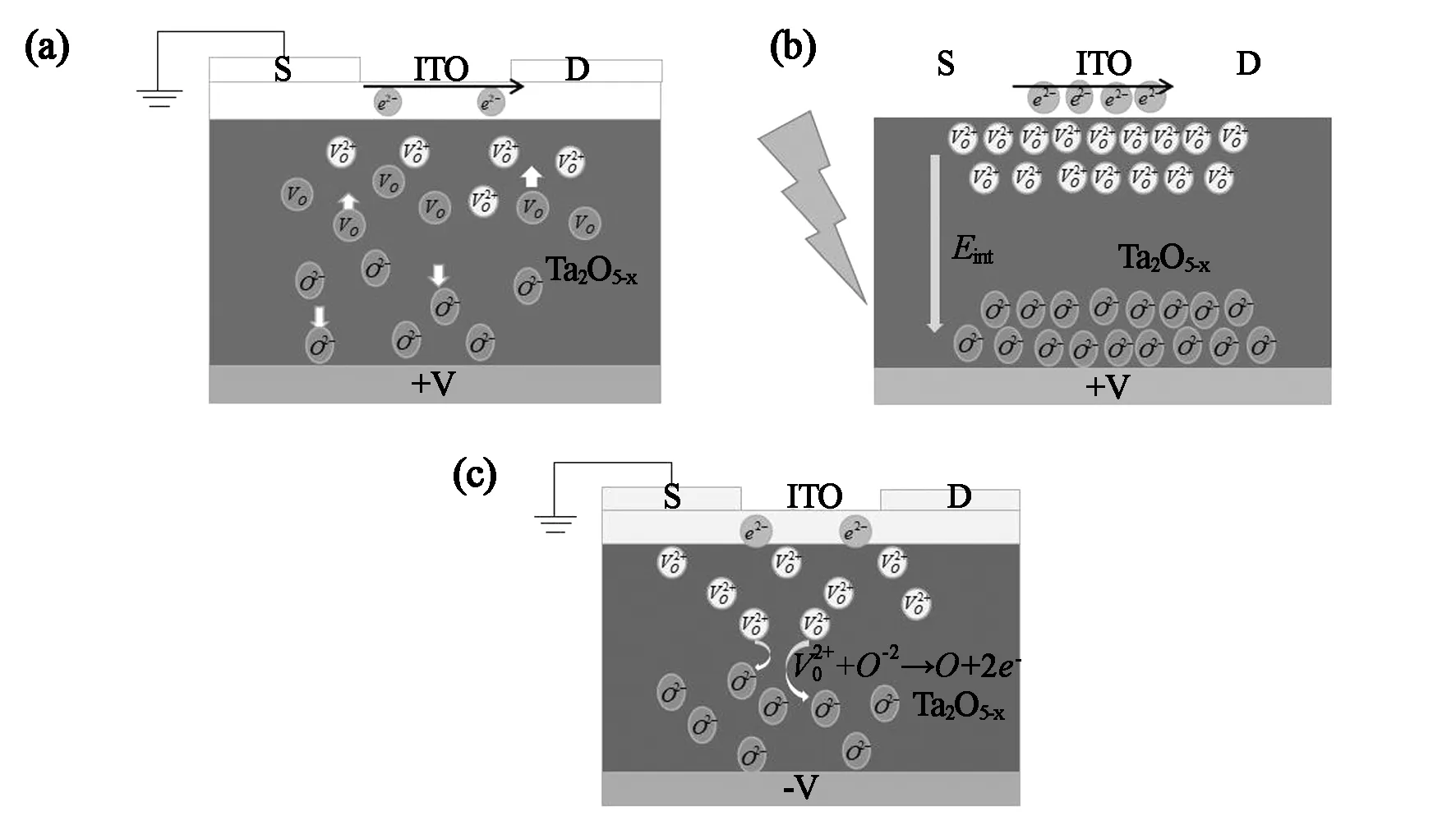
图7 Ta2O5/ITO TFT的工作机理。(a)底电极施加正栅压;(b)激光照射在有源层/绝缘层界面引入更多的氧空位;(c)底电极施加负栅压。Fig.7 Working mechanism of Ta2O5/ITO TFT.(a)Positive gate voltage is applied to the bottom electrode; (b) Laser irradiation induces more oxygen vacancies accumulated at the semiconductor/insulator interface; (c) Negative gate voltage is applied to the bottom electrode.
3.3 激光对固态电解质MOTFT突触性能的影响
基于本文制备的固态电解质Ta2O5/ITO TFT的特性,利用固态电解质绝缘层的迟滞效应以及激光对Ta2O5薄膜中氧空位含量的调控效果,进一步探索了不同激光强度对Ta2O5/ITO TFT突触行为的影响。图8(a)展示了基于Ta2O5/ITO的突触晶体管的典型兴奋性后突触电流(Excitatory Post Synaptic Current,EPSC),突触后电流是通过突触前脉冲(即栅电压脉冲VG)触发的,脉冲电压VG为3 V,脉冲宽度为150 ms。突触前脉冲结束时,EPSC信号高达9.5 μA,然后衰减到2.4 μA。这是由于正离子氧空位在Ta2O5/ITO界面上积累,从而调节了沟道电导,导致EPSC的增加;而EPSC的缓慢衰减则是由于突触前脉冲结束后带正电的氧空位离子和带负电的氧离子缓慢复合过程导致的。
图8(b)所示为在突触前脉冲VG为3 V,脉冲宽度为150 ms时,Ta2O5/ITO晶体管在3种不同激光强度下后突触电流EPSC的变化。在脉冲宽度一定时,EPSC值随激光强度的增加而逐渐增大,表明激光诱导产生的离子数量增加。同时,当激光强度从263 mJ/cm2增加到309 mJ/cm2时,EPSC值发生了显著变化,而当激光强度超过309 mJ/cm2时,EPSC值变化减慢。这种行为和电解质中自上而下的内建电场的建立有关,这种电场是由绝缘层/半导体层上的氧空位累积引起的,从而削弱了栅极电场的影响。

图8 (a) Ta2O5/ITO TFT的EPSC响应(VG=3 V,脉宽150 ms); (b) 不同激光强度下Ta2O5/ITO TFT的EPSC响应VG=3 V,脉宽150 ms)。Fig.8 (a) EPSC response of Ta2O5/ITO TFT(VG=3 V, pulse width=150 ms);(b)EPSC response of Ta2O5/ITO TFT under different laser intensities(VG=3 V, pulse width=150 ms).
4 结 论
本文探究了激光对Ta2O5/ITO TFT电学性能的影响,在沉积半导体层和电极之前,采用飞秒激光对Ta2O5绝缘层薄膜进行照射处理。研究发现,随着激光强度的提高,Ta2O5/ITO TFT的开态电流增加,阈值电压负向漂移,并且,晶体管的兴奋性后突触电流(EPSC)随着激光强度的增强而增加。XPS测试表明,激光照射可以调控Ta2O5薄膜中氧空位的含量,进而调节了载流子浓度。本文提出了一种简单、快速、低温的方式调控晶体管性能,为今后基于固态电解质金属氧化物薄膜晶体管的更加广泛应用奠定了基础。

