纳米尺寸膜厚标准样片的椭偏分析
张晓东 韩志国 李锁印 梁法国

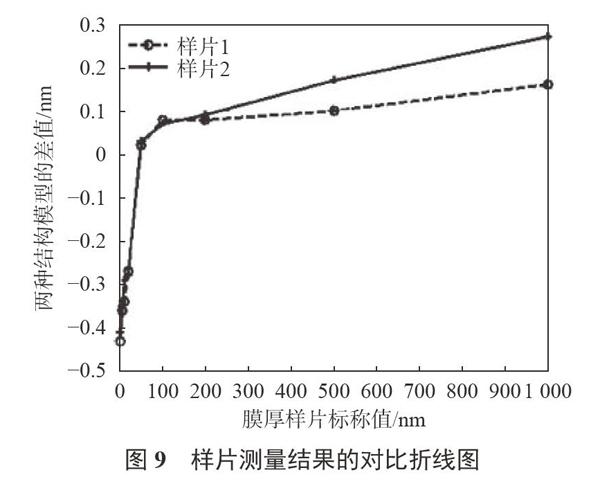

摘要:针对膜厚标准样片的高精度测量问题,基于光谱型椭偏仪测量系统,提出对膜厚标准样片逐层分析的方法。利用相应的匹配算法,对比硅上二氧化硅模厚标准样片的等效结构模型和四相结构模型,实现对薄膜样片的厚度表征和椭偏分析。其次,通过对样片进行为期12周的测量考核,完成对薄膜样片表层分子吸附机理的分析。实验结果表明:针对研制的标称值为2~1000nm硅上二氧化硅膜厚标准样片,中间层的厚度存在先递减后递增的趋势。其中,在标称值为50~500mm范围内,等效结构模型与四相结构模型测量结果的绝对误差在±0.2mm以内,因此,可以采用等效结构模型的方法开展仪器的校准工作。另外,提出通过加热实现对标准样片解吸附的方案,有效解决超薄膜样片的储存问题。
关键词:光谱型椭偏仪;等效结构模型;四相结构模型;表层分子吸附
中图分类号:O436.3 文献标志码:A 文章编号:1674-5124(2019)08-0014-05
收稿日期:2018-07-14;收到修改稿日期:2018-08-25
作者简介:张晓东(1992-),男,山东菏泽市人,硕士,主要从事微纳尺寸标准样片的研制与定标研究。
0 引言
随着微电子、半导体工艺的发展,薄膜厚度作为器件的重要参数,将直接影响到器件的性能。因此,保证膜厚量值的准确性十分重要。通常,纳米尺寸膜厚标准样片是校准椭偏仪等膜厚类测量仪器的标准样片,其主要分为硅上二氧化硅(Sioz/Si)和硅上氮化硅(Si3N4/Si)膜厚标准样片[1]。通过研制纳米尺寸膜厚标准样片,可以实现膜厚类测量仪器的溯源,提升半导体器件工艺的稳定性、重复性和可靠性。
国内外学者采用四相结构模型的理论来测量纳米尺寸膜厚标准样片[2]。但在微纳尺寸计量领域,通常采用等效结构模型的理论对样片进行定标。因此,本文通过比较两种结构模型下的测量结果,找出等效模型的有效范围。其次,利用光谱型椭偏仪对SiO2/Si膜厚标准样片进行逐层分析,完成对中间层和表层分子吸附机理的研究,不仅提高样片的定标准确度,并对指导膜厚标准样片的制作工艺提供了技术支撑。
1 椭偏仪系统测量原理
光谱型椭偏仪的基本原理是:利用偏振光在薄膜上下表面的反射原理,并通过菲涅尔公式得到薄膜参数与偏振态的关系,进而计算出薄膜的折射率和厚度[3]。其中,橢圆偏振法光路如图1所示,入射光可以分解为P平面偏振分量Eip和S平面偏振分量Eis,反射光可以分解为P平面偏振分量Erp和S平面偏振分量Ers,则反射系数Rp和Rs如公下式所示:
用薄膜的椭偏函数ρ表示薄膜反射而形成椭圆偏振光的特性为其中,tanψ=Rp/Rs,代表反射光的P平面偏振分量和S平面偏振分量的振幅系数之比,ψ代表偏振角,△=ψP-ψS表示两个偏振量的相位差。折射率n1与膜厚d2是ρ的变量,因此,通过ψ和△可以拟合求解薄膜的折射率与厚度[4]。
2 SiO2/Si腊厚标准样片的椭偏分析
2.1 椭偏测量系统
本文测量膜厚样片所用的仪器是J.A.Woollam光谱型椭偏仪,其包括光源系统、起偏器、样品台、检测系统等,如图2所示。光源系统发出的自然光经过起偏器变为线偏振光。然后,在薄膜表面反射后,以椭圆偏振光的形式入射到检偏器进而变为线偏振光[5]。最后,探测器将光信号转化为电信号,输送到计算机中。该系统具有非接触式、高精度的优点,适用于对膜厚标准样片进行椭偏分析。
待测样片是标称值为2~1000nm的SiO2/Si膜厚标准样片,该套样片采用热氧化工艺制备,通过控制氧化剂分压、氧化温度以及氧化时间等参数,来保证薄膜的均匀性[6]。SiO2/Si膜厚标准系列样片的颜色不同表示其厚度不同如图3所示。
如图4所示,椭偏分析的过程包括:1)测量过程,完成膜厚样片的数据采集;2)建模过程,建立准确的测量模型;3)数据拟合,采用均方根误差最小法,保证拟合的效果;4)输出结果,获取薄膜样片的膜厚和光学常数。2.2等效结构模型分析
根据膜厚标准样片的制作工艺,建立四相结构模型,如图5所示。其中,中间层是热氧化工艺不可避免的产物,主要成分是硅和氧的不同配比化合物。与二氧化硅膜层相比,中间层具有不同的光学性质。此外,SiO2膜层上表面存在粗糙度层,该层可以等效为SiO2-Void混合层,通过EMA有效介质方程[7]计算为式中:ε——等效介电常量;
ε1、ε2——SiO2、Void的介电常量;
f1、f2——混合层中SiO2、Void的体积分数。
项目组提出采用等效结构模型来测量SiO2/Si膜厚标准样片,即将硅衬底上的所有结构等效为一层二氧化硅结构,以便开展校准测量仪器和比对工作[8],如图6所示。依据四相结构模型的概念,膜厚标准样片的厚度为中间层、SiO2层和SiO2-Void混合层叠加的厚度。相比之下,依据等效结构模型的概念,膜厚标准样片的厚度为等效结构层的厚度。在两种结构模型下,结合相应算法和数学模型,对研制的两组SiO2/Si膜厚标准样片进行测量[9]。其中,由公式(1)和(2)可知&ψ代表偏振角,△表示两个偏振量的相位差,其分别的拟合效果如图7图8所示。
根据图7和图8可知,利用光谱型椭偏仪,在两种结构模型下,拟合效果都十分理想。而实际的测量结果如表1所示。此外,标准样片厚度的差值与标称值的关系如图9所示。
根据表1和图9可知,针对研制的两套标称值为2~1000mm SiO2/Si膜厚标准样片,厚度差值的变化趋势相同。其中,膜厚标称值在50~500nm范围内,两种结构模型的测量差值在±0.2mm以内。根据美国VLSI公司给出的样片测量不确定度可知,1000nm以内的膜厚样片的不确定度在0.4mm以内,因此,可以采用等效结构模型的方法开展仪器的校准工作。相比之下,针对研制的标称值为2~50nm和500~1000nm的SiO2/Si膜厚标准样片,则不适合采用等效结构模型来校准膜厚类测量仪器。
2.3 中间层分析
针对SiO2/Si膜厚标准样片,中间层是一个不可忽略的膜层[10]。分析中间层对薄膜厚度的影响对指导半导体工艺十分关键。因此,针对研制的2~1000mm SiO2/Si膜厚标准样片,借鉴四相结构模型的理论,对样片的中间层进行测量[11]。其中,椭偏分析的结果如图10所示。
根据图10可知,针对研制的标称值为2~1000mm的膜厚标准样片,中间层的厚度存在先递减后递增的趋势。此外,针对研制的超薄膜厚标准样片,中间层所占的比例很大。因此,改进工艺,降低中间层厚度对于关键尺寸膜厚标准样片的制作十分必要。
2.4 表层分子吸附
由于膜厚标准样片存在分子吸附现象[12],样片的厚度值会随着时间的推移发生变化。对于超薄膜厚标准样片而言,表层分子吸附现象对样片厚度的影响更大。因此,针对标称值为2nm的SiO2/Si膜厚标准样片,利用J_A.Woollam光谱型椭偏仪,进行为期12周的样片测量考核。其中,实验样片为同批次生产的2片2nm的膜厚标准样片,两个样片同时存放在20℃环境下。针对样片1,每周进行150℃的高温加热,然后测量其厚度值。针对样片2,每4周进行150℃的高温加热,然后记录其厚度值,如表2所示。因此,可以通过定量分析的方式,来研究表层分子吸附现象对SiO2/Si膜厚标准样片的影响。
根据图11可知,样片1在12周内的厚度值保持在1.9~2nm之间,误差在0.1nm之间。样片2在每4周内,薄膜厚度会不断增加,通过150℃的高温加热,厚度值會降到1.9~2mm之间。因此,通过周期性考核试验可知,加热可以实现膜厚标准样片的解吸附。
3 结束语
作为校准膜厚类仪器的标准片,纳米尺寸膜厚标准样片的高精度测量问题是亟待解决的问题。首先,本文分析了光谱型椭偏仪测量系统的测量原理。其次,通过定量分析膜厚标准样片的两种结构模型和中间层,解决了膜厚标准样片等效结构模型适用范围的问题。最后,针对标称值为2mm的SiO2/Si膜厚标准样片存在表层分子吸附现象,进行为期12周的样片考核,提出了通过加热实现膜厚标准样片解吸附的方案。
接下来要开展的工作有:1)膜厚标准样片测量模型的优化;2)分析超薄膜厚标准样片中间层的主要成分;3)研究表层分子吸附现象的替代解决方案等。这些问题的解决对膜厚标准样片的研制与定标工作提供了重要技术支撑,有助于提升微电子生产工艺的重复性、稳定性和可靠性,促进相关高新技术领域的技术转化和产业化发展。
参考文献
[1]赵琳,李锁印,韩志国,等.硅上氮化硅膜厚样片的制备[J].计测技术,2016(s1):309-310.
[2]徐均琪,冯小利.多层薄膜光学常数的椭偏法研究[J].光电工程,2009,36(2):29-33.
[3]余平,张晋敏.椭偏仪的原理和应用[J].合肥学院学报(综合版),2007,17(1):87-90.
[4]HIROYUKI FUJIWARA.Spectroscopic ellipsometry:principles and applications[M].Tokyo:Maruzen Co.Ltd,2007:178-182.
[5]韩志国,李锁印,赵琳,等.一种光谱型椭偏仪的校准方法[J].中国测试,2017,43(12):1-6.
[6]王多书,李佑路,李凯朋,等.红外光学薄膜材料折射率温度特性的研究方法[J].红外与激光工程,2018,47(4):111-115.
[7]林书玉,吴峰,陈长清,等.使用椭偏光谱研究氮化铝薄膜在不同温度下的光学性质[J].红外与毫米波学报,2017,36(3):276-279.
[8]刘华松,杨霄,刘丹丹,等.SiO2薄膜光学常数物理模3[J].红外与激光工程,2017,46(9):286-291·
[9]周毅,吴国松,代伟,等.椭偏与光度法联用精确测定吸收薄膜的光学常数与厚度[J].物理学报,2010,59(4):2356-2363.
[10]VENKATACHALAM S,SOUNDARARAJAN D,PERANANTHAM P,et al.Spectroscopic ellipsometry(SE)studies on vacuum-evaporated ZnSe thin films[J].MaterialsCharacterization,2007,58(8):715-720.
[11]吴慧利,唐义,白延柱,等.紫外薄膜光学常数的多层模型椭偏测量[J].光电工程,2015,42(9):89-94.
[12]YU G,TORTONESE M.Metrology standards forsemiconductor manufacturing[C]//Intemational Conference onSolid-State and Integrated Circuits Technology,2004.Proceedings.IEEE,2004:588-593.
(编辑:徐柳)

