大容量Flash存储器空间辐射效应试验研究
张洪伟 于庆奎 张大宇 孟猛 唐民
(中国空间技术研究院,北京 100094)
1 引言
Flash高密度存储器以大容量、高速率、低功耗、低质量的特点引领着商业电子的革命。随着航天器性能要求的逐步提高,使用这种器件作为航天器数据采集的存储模块,一方面可以为航天器节省更多成本,另一方面可以提供更大容量的存储空间。目前,Flash存储器仍属于商用器件,应用于航天器中还有许多技术问题需要解决,其中,空间环境中的电离总剂量(TID)效应和单粒子效应(SEE)是影响Flash存储器应用于航天器的主要问题之一[1-2]。电离总剂量效应会造成器件漏电流增大、存储信息丢失等,甚至产生部分坏块[3]。单粒子效应包括单粒子翻转(SEU)、单粒子锁定(SEL)和单粒子功能中断(SEFI)等[3]。单粒子翻转会造成存储数据位发生翻转;单粒子锁定是破坏性的,若不及时切断电源,可能烧毁器件;单粒子功能中断会造成连续整页或整块存储数据出错[4-5]。美国国家航空航天局(NASA)和欧洲航天局(ESA)均对Flash器件进行了包括辐射试验在内的可靠性评估试验。NASA的D.N.Nguyen等[3]对2GFlash(K9F2GO8UOM)进行的辐射试验表明:器件在总剂量达到20krad(Si)后出现一些坏块,坏块随剂量的增大逐渐增多;单粒子试验则发现了单粒子翻转和单粒子功能中断,没有发现单粒子锁定。T.R.Oldham 等[5]对4G Flash(K9F4G08U0A)进行的辐射试验表明:器件在总剂量达到75krad(Si)后出现部分数据丢失,重新配置刷新后没有错误产生,达到100krad(Si)后出现功能失效;单粒子试验时则发现单粒子翻转和单粒子功能中断,没有发现单粒子锁定。ESA辐射效应与分析技术组(REATS)2004年发布的一份辐照试验报告中显示:Flash器件抗辐射性能存在差异性[6](抗总剂量能力范围为10~20krad(Si));出现单粒子翻转、锁定和功能中断等现象。由于商用器件的辐射和质量差异性问题,目前国内外航天器还没有开始普遍应用Flash非易失性存储器技术。
韩国三星(Samsung)公司生产的Flash存储器在全球市场的占有率已经达到了61%[5],因此,本文选择该公司生产的大容量SLC NAND-Flash K9XXG08UXA系列存储器,进行了电离总剂量和单粒子效应辐照试验,以了解Flash K9XXG08UXA系列存储器的抗辐射性能,评估商用Flash存储器空间应用的可行性。
2 器件概述
三星公司大容量Flash存储器K9XXG08UXA系 列 包 括K9K8G08UOA(8G)、K9WAG08U1A(16G)和K9NBG08U5A(32G)3 种型号产品,生产工艺采用63nm CMOS技术,器件工作电压为3.3V,工作电流最大为35mA,工作温度为-40~+125℃,外部采用48管脚TSOP塑料封装[7]。其中:8GFlash K9K8G08UOA采用2块K9F4G08U0A(4G)芯片反面组装工艺,见图1;16G Flash K9WAG08U1A和32G Flash K9NBG08U5A分别 采 用4 块 和8 块K9F4G08U0A(4G)多层芯片组装工艺,见图2。

图1 8GFlash芯片表面形貌和侧面X 光照片Fig.1 External and X-ray photo of 8GFlash memory chips

图2 16GFlash芯片表面形貌和侧面X 光照片Fig.2 External and X-ray photo of 16GFlash memory chips
Flash存储器的基本存储单元结构不同于普通的场效应管结构(FET),其特点是:在栅级与漏极/源级之间存在浮栅,浮栅周边采用氧化膜进行了绝缘处理;当编程为“0”时,电荷通过隧穿效应(Fowler-Nordheim)[8]被注入到浮栅中存储起来,当编程为“1”时,浮栅中的电荷被释放至沟道中,从而根据浮栅中是否积累了电荷判断是“0”还是“1”;单元之间按顺序相连,末端连接分别为位线和源线或选择线,读写方式必须按顺序进行[9-10]。
3 试验原理
当Flash存储器应用于空间环境时,其浮栅结构单元受到穿透电子和质子的辐照而引起氧化层的电离。随着电荷的积累,栅源间漏电流增加,器件性能发生退化;浮栅漏电流增加到一定程度后,势必导致存储信息的丢失,甚至功能失效,产生电离总剂量效应。在遭受电离总剂量效应的同时,Flash 存储器对单粒子效应也很敏感。在遭受空间宇宙射线或质子的攻击时,Flash存储器栅源以及PN 结之间会形成电流脉冲。当其注入的电荷超过改变存储单元所需的临界电荷时,浮栅存储信息即发生改变,即产生单粒子翻转现象;若电流脉冲触发内部可控硅结构保持开启状态,即发生单粒子锁定现象。
为了解Flash存储器在实际应用中的抗辐照特性和失效模式,试验选取了三星公司生产的具有浮栅结构的大容量SLC NAND-Flash K9XXG08UXA系列存储器作为研究对象,进行电离总剂量和单粒子效应辐照试验研究。
4 试验程序
4.1 电离总剂量试验程序
试验根据Flash存储器电离总剂量效应原理,模拟空间辐射环境,采用钴-60γ 射线源,室温下以0.1rad/s(Si)的低剂量率对样品进行辐照,辐照累积总剂量为50krad(Si)。试验选择K9K8G08UOA(8G)和K9WAG08U1A(16G)器件各3只作为被试器件,辐照前对器件进行性能和功能测试,并写入代码“AA”,试验过程中器件采用静态直流偏置,用电流表监测静态功耗电流,定期进行读写测试,判断存储单元信息是否丢失,读写功能是否正常。
4.2 单粒子效应试验程序
试验根据Flash单粒子效应原理,模拟空间辐射环境,采用中国科学院近代物理研究所回旋加速器(HIRFL)和中国原子能研究院串列静电加速器,利用不同能量的F、Cl、Ti和Kr试验离子产生不同线性能量传递(LET)值,试验离子特性见表1。

表1 试验离子特性Table1 Characteristics of ions used in test
试验选择3只K9K8G08UOA(8G)器件作为被试器件进行单粒子效应试验,实时监测被测器件电源电流,由FPGA负责控制Flash的读写操作和数据比对,并将检测结果通过串口通信上传至上位机进行存储、显示,检测装置示意图见图3。
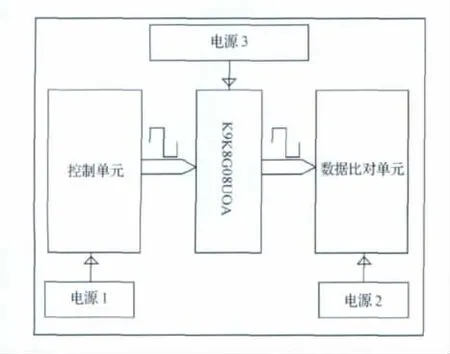
图3 辐射试验检测装置功能示意图Fig.3 Diagram of test facilities function
器件工作模式包括以下3种。
(1)动态读取模式:辐照前对器件进行性能和功能测试,并将指定数据写入Flash存储器;辐射试验过程中进行数据读取比对;记录器件工作电流和单粒子翻转位数。
(2)静态模式:试验前对器件进行性能和功能测试,并将指定数据写入Flash存储器;不加电状态下进行辐射试验;试验完毕后关闭辐射源,对所存储数据进行读取比对,记录单粒子翻转位数。
(3)动态读写模式:试验前对器件进行性能和功能测试;辐射过程中对器件进行数据擦除、写入和读取比对;记录器件工作电流和单粒子翻转位数。
5 辐照试验结果及其分析
5.1 电离总剂量效应试验
当辐照累积总剂量为30krad(Si)时,所有样品静态电流没有显著变化,8GFlash和16GFlash数据完整,没有新的坏块产生,读取和写入功能正常。当辐照累积总剂量为50krad(Si)时,所有样品静态电流没有显著变化;8GFlash数据完整,没有坏块产生,读取和写入功能正常;16GFlash中有1只样品部分数据丢失,重新配置刷新后,数据读取无误,没有新的坏块产生,读取和写入功能正常;其他2只样品数据完整,没有新的坏块产生,读取和写入功能正常。
辐照累积总剂量达到50krad(Si)时,出现部分数据丢失的16G Flash样品,其部分存储单元数据“1”被改写为“0”,分析认为,其原因之一是存储单元漏电。Flash存储器的使用寿命决定于其存储单元的数据保持力,即浮栅结构的漏电特性。电离辐射致使器件浮栅结构中氧化层的正电荷缺陷增多,可以俘获更多电荷,使浮栅结构中隧道氧化物的绝缘性能下降,漏电流增大,从而形成浮栅内电荷泄漏的路径。
5.2 单粒子效应试验
试验在室温环境下进行,辐照过程中器件分别在静态、动态读取和动态读写3种工作模式下进行单粒子效应检测。结果显示:线性能量传递值小于38MeV·cm2/mg时,没有出现单粒子锁定和功能中断现象,单粒子翻转采用ADAMS模型,太阳同步轨道高度为965km,置信度90%的最坏情况下,错误发生率大约为2×10-2次/(天·器件)。其中:静态模式检测时,器件辐照过程没有加电,辐照后进行读取比对,结果显示部分存储单元发生翻转;动态读取和动态读写模式检测时,辐照过程中器件功耗电流保持不变,器件功能正常,但是结果显示部分存储单元发生翻转,没有发现单粒子锁定和功能中断。试验还发现,器件单粒子效应与所存储内容相关。当写入代码为“55”时,辐照后检测发现部分存储单元信息“0”被改写为“1”,发生了单粒子翻转;而当写入状态为“FF”时,辐照后发现存储单元的信息没有被改写,未发生单粒子翻转。
单粒子效应试验静态模式线性能量传递-器件翻转截面曲线如图4所示。随着线性能量传递值的增大,翻转截面逐渐增大;当线性能量传递值为26MeV·cm2/mg时,曲线逐渐趋于平缓;当线性能量传递值为38MeV·cm2/mg时,翻转截面达到最大,为1.15平方厘米/器件。取截面最大值为饱和截面,10%饱和截面对应的线性能量传递值为阈值,利用SPACE RADIATION 在轨预计软件计算在轨单粒子事件发生率,空间辐射环境采用Adams 90%最坏情况模型,太阳同步轨道高度965km,单粒子事件发生率为2.69×10-2次/(天·器件)。
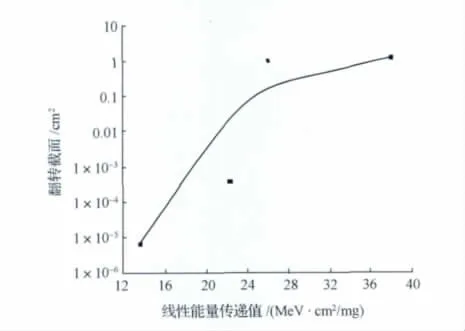
图4 静态模式线性能量传递-器件翻转截面曲线Fig.4 LET-cross section curve of static mode
单粒子效应试验动态读取模式线性能量传递-器件翻转截面曲线见图5所示。随着线性能量传递值的增大,翻转截面逐渐增大;当线性能量传递值为26MeV·cm2/mg时,曲线逐渐趋于平缓;当线性能量传递值为38MeV·cm2/mg时,翻转截面达到最大,为1.11平方厘米/器件。辐照过程中,器件功耗电流保持不变,读取和写入功能正常,没有发现单粒子锁定和功能中断。取截面最大值为饱和截面,10%饱和截面对应的线性能量传递值为阈值,利用SPACERADIATION 预计在轨单粒子事件发生率,空间辐射环境采用ADAMS 90%最坏情况模型,太阳同步轨道高度965km,单粒子事件发生率为2.95×10-2次/(天·器件)。
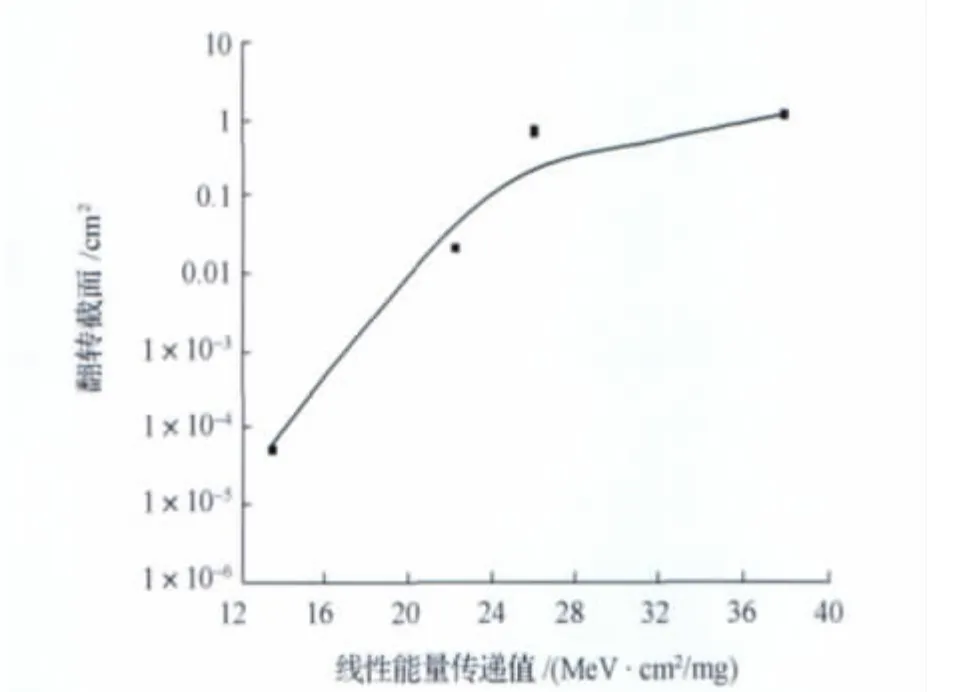
图5 动态读取模式线性能量传递-器件翻转截面曲线Fig.5 LET-cross section curve of dynamic reading mode
单粒子效应试验动态读写模式线性能量传递-器件翻转截面曲线见图6所示。随着线性能量传递值的增大,翻转截面逐渐增大;当线性能量传递值为26MeV·cm2/mg时,曲线逐渐趋于平缓;当线性能量传递值为38MeV·cm2/mg时,翻转截面达到最大,为3.6×10-1平方厘米/器件。辐照过程中,器件功耗电流保持不变,功能正常,没有发现单粒子锁定和功能中断。取截面最大值为饱和截面,10%饱和截面对应的线性能量传递值为阈值,利用SPACE RADIATION 在轨预计软件计算在轨单粒子事件发生率,空间辐射环境采用ADAMS 90%最坏情况模型,太阳同步轨道高度965km,单粒子事件发生率为1.17×10-2次/(天·器件)。
通过试验结果分析可以发现,由于Flash 存储单元为浮栅结构,Flash器件在写入状态为“FF”时,器件存储二进制数据为“11111111”,所有浮栅内电荷被挤出,浮栅内没有存储电荷,器件不易受重离子影响而向浮栅内“充电”;当写入状态为“55”时,器件存储二进制数据为“01010101”,部分浮栅俘获电荷,即为“0”,此时,器件容易受重粒子影响而驱使浮栅“放电”。
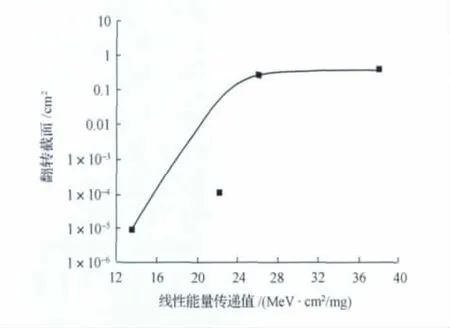
图6 动态读写模式线性能量传递-器件翻转截面曲线Fig.6 LET-cross section curve of dynamic writing mode
6 结论
选择采用浮栅结构作为存储单元的三星公司Flash K9XXG08UXA系列存储器,进行电离总剂量试验和单粒子试验。从试验结果可见:当受到一定量空间辐射影响后,浮栅内存储电荷发生改变,性能发生退化,产生了电离总剂量效应;当频繁受到重离子或质子攻击时,在栅源以及PN 结之间形成电流脉冲,易发生单粒子效应,同时,当器件存储数据为“1”时,所有浮栅内电荷被挤出,浮栅内没有存储电荷,器件不易受重离子影响而向浮栅内“充电”,即不易发生单粒子翻转效应,当器件存储数据为“0”时,浮栅俘获电荷,此时,器件容易受重粒子影响而驱使浮栅“放电”,即容易发生单粒子翻转效应。试验表明:Flash K9XXG08UXA系列存储器抗电离总剂量能力低于50krad(Si),单粒子效应试验在线性能量传递值小于38MeV·cm2/mg时,没有发现单粒子锁定现象,空间辐射环境采用ADAMS 90%最坏情况模型,太阳同步轨道高度965km,单粒子翻转错误发生率大约为2×10-2次/(天·器件)。因此,空间应用Flash K9XXG08UXA系列存储器时,应考虑进行抗辐射加固设计。
(References)
[1]安德鲁·霍姆斯·西德.辐射效应手册[Z].北京控制工程研究所,北京卫星环境工程研究所,译.北京:北京控制工程研究所,北京卫星环境工程研究所,2000:34-42
Andrew Holmes-Siedle.Handbook of radiation effects[Z].Beijing Institute of Control Engineering,Beijing Institute of Spacecraft Environment Engineering,translated.Beijing:Beijing Institute of Control Engineering,Beijing Institute of Spacecraft Environment Engineering,2000:34-42(in Chinese)
[2]Nguyen D N,Guertin S M,Patterson J D.Radiation tests on 2Gb NAND Flash memories[C]//Proceedings of the 2006IEEE Radiation Effects Data Workshop.New York:IEEE,2006:121-125
[3]Kayali S.Reliability challenges for the utilization of non-volatile memories in space systems[R].California:NASAJet Propulsion Laboratory,2000
[4]Schwartz H R,Nichols D K,Johnston AH.Single-event upset in Flash memories[J].IEEE Transactions On Nuclear Science,1997,44(6):2315-2324
[5]Oldham T R,Friendlich M,Howard J W.TID and SEE response of an advanced Samsung 4Gb NAND Flash memory[C]//Proceedings of the 2007IEEE Radiation Effects Data Workshop.New York:IEEE,2007:221-225
[6]Harboe-S∅rensen R,Guerre F X,Loqut J G.Radiation SEE evaluation of candidate components for new ERC32 SC VME board design[C]//Internal ESTEC working paper.New York:ESTEC,2004:145-147
[7]Sheldon D,Freie M.Disturb testing in Flash memories[R].California:NASAJet Propulsion Laboratory,2008
[8]Nguyen D N,Lee C I,Johnston AH.Total ionizing dose effects on Flash memories[C]//Proceedings of the IEEE Radiation Effects Data Workshop.New York:IEEE,1998:100-103
[9]桑野雅彦.存储器IC的应用技巧[M].北京:科学出版社,2006:19-34 Masahiko Kuwano.Application instruction of memory IC[M].Beijing:Science Press,2006:19-34(in Chinese)
[10]克拉艾,西蒙恩.先进半导体材料及器件的辐射效应[M].刘忠立,译.北京:国防工业出版社,2008:341-345
Claeys C,Simoen E.Radiation effects on advanced semiconductor materials and devices[M].Liu Zhongli,translated.Beijing:National Defense Industry Press,2008:341-345(in Chinese)

