夹层结构P(VDF-HFP)/BN纳米复合材料的介电性能
刘亚楠,陈 杰,江平开,黄兴溢
(上海交通大学 上海市电气绝缘与热老化重点实验室,上海 200240)
0 引言
薄膜电容器能在上千伏工作电压下保持高功率密度和低损耗,是高电压电力传输系统的重要组件[1]。由于薄膜电容器的介电层所使用的双轴取向聚丙烯(BOPP)储能密度很低(仅为2 J/cm3),为了匹配电力设备设计的储能容量,薄膜电容器需要占用大量的体积和质量,这与电子器件小型化的发展方向矛盾。为了实现更高的能量存储和输出效率,必须提高介电材料的介电常数和储能密度[2-4]。向聚合物中添加高介电常数铁电陶瓷能提高介电常数,但会造成击穿强度降低和泄漏电流增加[5]。聚偏氟乙烯基聚合物如聚偏氟乙烯-六氟丙烯P(VDF-HFP)具有高介电常数和能量密度,但在高电场下极化电滞严重,储能效率降低[6-7]。
向PVDF基聚合物中间插入绝缘层能够解决其高介电常数和低击穿强度的矛盾[8]。根据电容器的串联模型,绝缘层能承受更高的电场,还能阻止界面处的电树生长,从而减缓局部区域击穿[9]。
六方氮化硼(h-boron nitride,h-BN)是一种宽带隙(约为6 eV)的绝缘体,具有类似石墨的层状结构,其击穿强度高达800 MV/m[10]。h-BN经液相剥离后厚度减小,击穿强度进一步提高[11]。向聚合物中添加氮化硼纳米片能有效减小泄漏电流和空间电荷传导,从而提高击穿强度并降低介质损耗[12-13]。A AZIZI等[14]通过化学气相沉积(CVD)和转移工艺成功地在聚醚酰亚胺(PEI)薄膜的两面涂覆了薄的BN层,在150℃下400 MV/m电场中保持了90%的充放电效率。ZHU Y等[15]制备了含有平行排列的氮化硼夹层的PVDF复合膜,发现氮化硼夹层能大幅减轻局部电场畸变并抑制击穿路径的生长,降低了泄漏电流,提高了击穿强度和储能密度。
本研究从调控基体中的填料分布出发,首先制备由极性基团硫脲改性的氮化硼纳米片(BNNSs-THU),随后制得一系列具有夹层结构的P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)复合薄膜。对BNNSs化学改性的优势有两点:①增加夹层与基体的界面粘结性,有助于减少低频下的介质损耗;②表面的硫脲基团在电场中具有较高的偶极子极化强度[16-17],可避免材料复合后介电常数下降,同时提高放电能量和储能效率。
1 实验
1.1 主要原材料
聚偏氟乙烯-六氟丙烯(P(VDF-HFP)),上海索尔维试剂公司;γ-氨丙基乙氧基硅烷(γ-APS)、过氧化氢水溶液(质量分数为30%)、异丙基硫代异氰酸酯、N,N-二甲基甲酰胺(DMF)、异丙醇、二甲苯和其他有机溶剂,分析纯,国药集团化学试剂有限公司;氮化硼粉末(h-BN),密度约为2.25 g/cm3,平均尺寸为3 μm,3M Technical Ceramics(USA)。
1.2 试样制备
对h-BN粉末的剥离参考文献[18]。首先,将h-BN粉末加入到异丙醇和去离子水的混合溶液中,置于超声装置中处理4 h,超声频率为200 kHz。通过离心去除未剥落的h-BN,收集上层清液后抽滤,经真空干燥得到氮化硼纳米片(BNNSs)。对BNNSs表面的化学改性步骤如图1所示,将氮化硼纳米片加入到过氧化氢水溶液中,超声30 min,再在105℃下回流4 h。反应后的溶液在9 500 r/min下离心5 min,倒掉上层清液,得到表面羟基化的氮化硼纳米片(BNNSs-OH),随后将其分散在γ-APS的甲苯溶液中,在N2保护下80℃恒温搅拌24 h,得到表面氨基化的氮化硼纳米片(BNNSs-NH2)。将BNNSs-NH2在DMF中超声分散,再加入异丙基硫代异氰酸酯,室温下搅拌24 h后,离心得到硫脲改性的氮化硼纳米片BNNSs-THU。

图1 BNNSs-THU的合成示意图Fig.1 Synthesis scheme of BNNSs-THU
最后,配置P(VDF-HFP)的DMF溶剂,使用四方制备器在玻璃板上刮涂,在50℃烘箱中真空干燥12 h。将4种不同质量的BNNSs-THU加入到异丙醇中超声分散获得浓度分别为0.6、0.8、1.0、1.2 mg/mL的均匀溶液。在第一层P(VDF-HFP)完全干燥后,在上面涂上BNNSs-THU溶液作为第二层,在40℃真空烘箱干燥24 h。最后,再涂第三层P(VDF-HFP),在50℃真空烘箱中放置24 h去除溶剂,将玻璃板置于200℃的烘箱中烘焙7 min,然后在冰水中淬火。夹层结构复合膜剥离后干燥24 h。4个夹层结构复合膜根据BNNSs溶液的浓度分别命名为PBP-6、PBP-8、PBP-10和PBP-12。
1.3 测试与表征
使用声西公司FS-450N型超声棒剥离氮化硼片和分散溶液;使用因浦公司TGL-15B型超速离心机分离氮化硼纳米片;采用PerkinElmer公司Paragon 1000型傅里叶变换红外光谱仪(FTIR)表征氮化硼纳米片的特征峰;采用NETZSCH公司TG-209型热重分析仪测试样品的热失重(TGA)曲线,表征氮化硼纳米片表面的化学基团接枝率和复合材料的热分解温度;采用NETZSCH公司200-F3型差示扫描量热仪(DSC)在氮气气氛下对聚合物薄膜的熔点及结晶行为进行表征;采用FEI公司Nova NanSEM 450型扫描电子显微镜观察聚合物横截面的微观形貌;使用科晶公司MSK-AFA-I型流延涂覆机制备夹层结构复合材料;电性能测试前,使用泰科诺公司ZHD-300型高真空电阻蒸发镀膜机对样品表面镀上铜电极,然后采用Novocontrol公司Alpha-A(Concept 40)型高分辨率宽频介电谱测试样品的介电性能;使用Radiant Inc公司 Precision Premier II型铁电极化测试仪获得电位移-电场(D-E)曲线和泄漏电流-电场强度(I-V)曲线,材料的充放电能量密度通过D-E曲线计算。
2 结果与讨论
2.1 BNNSs-THU的合成与表征
化学改性前后BNNSs的红外光谱如图2所示。从图2可以看到,在3 424 cm-1处的伸缩振动宽峰是BNNSs-OH上羟基的特征峰,经过γ-APS改性后,BNNSs-NH2的红外光谱显示在2 925 cm-1处新出现亚甲基的伸缩振动峰,在1 135 cm-1和1 035 cm-1处新出现硅氧键的伸缩振动峰,说明烷偶联剂成功接枝在BNNSs表面[19-20]。C=S的伸缩振动峰出现在1 250~1 300 cm-1,但在BNNSs-THU的红外光谱中,此处的特征峰与其他基团伸缩振动峰重叠,因此需结合其他表征手段证明异丙基硫代异氰酸酯接枝到BNNSs表面。为了进一步分析BNNSs表面的基团接枝率,在N2氛围中分别对BNNSs、BNNSs-OH、BNNSs-NH2和BNNSs-THU进行了热失重分析,结果如图3所示。从图3可以看出,当温度达到800℃时,BNNSs-OH失重7.81%,对应的是BNNSs表面的羟基,根据BNNSs-OH的热失重质量分数和羟基相对原子质量可以计算得到BNNSs表面羟基的总数。对于BNNSs-NH2,热失重分析中相对损失的质量分数和对应基团的相对原子质量之比为参与反应的该基团数量,与BNNSs表面羟基总数之比即为接枝率,同理可以得到BNNSs-THU的接枝率。BNNSs-NH2失重12.29%,对应的是BNNSs-OH表面的羟基和聚硅氧烷层,则接枝率为10.3%;BNNSs-THU失重13.97%,高于上一步反应后的结果,说明硫代异氰酸酯已与BNNSs-NH2表面的氨基反应,根据失重率计算得到接枝率为43.7%。
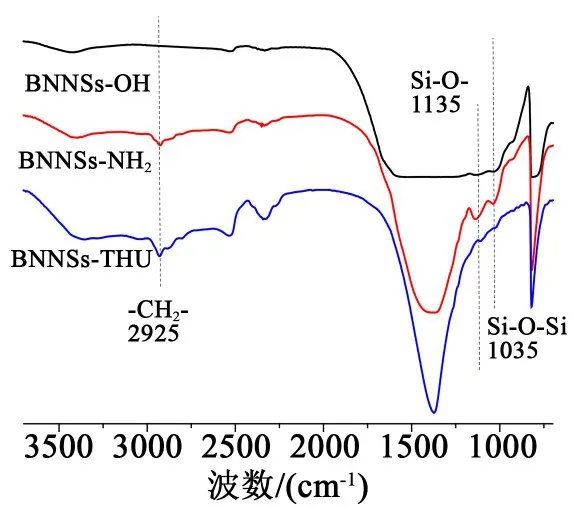
图2 BNNSs、BNNSs-OH和BNNSs-THU的红外光谱Fig.2 FT-IR spectra of BNNSs,BNNSs-OH,and BNNSs-THU

图3 N2氛围下BNNSs、BNNSs-OH、BNNSs-NH2和BNNSs-THU的热失重曲线Fig.3 TGA curves of BNNSs,BNNSs-OH,BNNSs-NH2,and BNNSs-THU in N2
2.2 BNNSs-THU的形貌表征
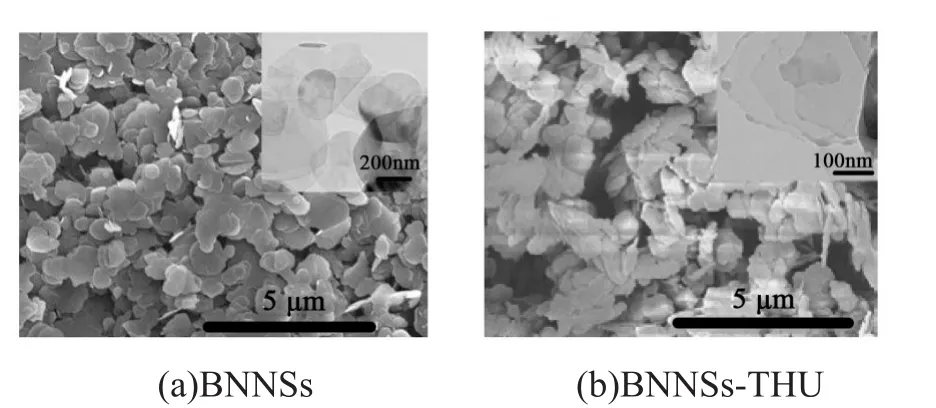
图4 BNNSs和BNNSs-THU的扫描电镜图和透射电镜图Fig.4 SEM images and TEM images of BNNSs and BNNSs-THU
图4(a)、(b)分别为 BNNSs和 BNNSs-THU 的SEM和TEM图,样品测试前在异丙醇中超声分散。对比图4(a)、(b)可以看出,BNNSs-THU边缘出现了明显的聚合物包裹。硅烷偶联剂常用于改善纳米填料在聚合物基体中的分散性,但会造成纳米填料整体介电常数下降。本研究使用异硫氰酸异丙酯进行后续改性,这是因为硫脲基团具有高偶极矩(4.89 D),能在电场中发生较强的偶极子极化,从而避免纳米填料的介电常数下降。
图5为BNNSs-THU的EDAX谱图。从图5可以看出,EDAX谱图中出现了C、N、Si和S的信号峰。Si元素的存在说明硅烷偶联剂成功与BNNSs表面羟基反应,而异丙基硫代异氰酸酯与氨基反应后会向BNNSs表面引入S元素。由EDAX谱图的X射线强度可获得样品表面各种元素的浓度,结果汇总在表1中。根据Si的相对质量分数及相对原子质量能够计算出BNNSs表面引入的硅烷偶联剂数量,而通过S的相对质量分数和相对原子质量能够计算出参与反应的异丙基硫代异氰酸酯的数量,由此可以计算出第三步接枝率为46.6%,与TGA计算结果接近,进一步证明硫脲基团已经成功接枝在BNNSs-THU纳米片表面。

图5 BNNSs-THU的EDAX谱图Fig.5 EDAX map of BNNSs-THU

表1 BNNSs-THU表面各元素的相对质量分数Tab.1 Relative mass fraction of each element on BNNSs-THU surface
2.3 P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)的形貌表征
图6为夹层复合薄膜在液氮中脆断后断面的SEM图。
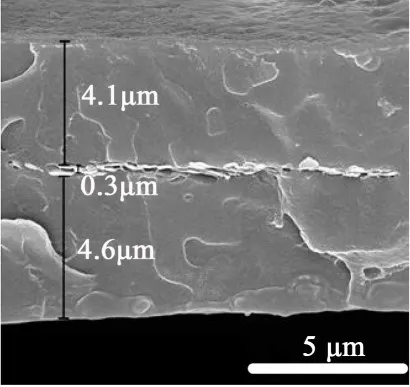
图6 夹层复合膜的扫描电镜图Fig.6 SEM image of P(VDF-HFP)/BNNSs/P(VDF-HFP)
由图6可见,复合薄膜共有3层,BNNSs-THU中间层的厚度约为0.3 μm,上、下层P(VDF-HFP)的厚度分别为4.1 μm和4.6 μm,BNNSs-THU层沿着与平面平行的方向排列。研究表明,平行排列的纳米片比垂直排列的纳米片更能提升复合材料的击穿强度,而且还能抑制泄漏电流与电树生长[15]。
2.4 P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)的结晶性研究
为了研究BNNSs-THU夹层对P(VDF-HFP)结晶行为的影响,对聚合物薄膜进行了反射红外及X射线衍射测试,结果如图7所示。
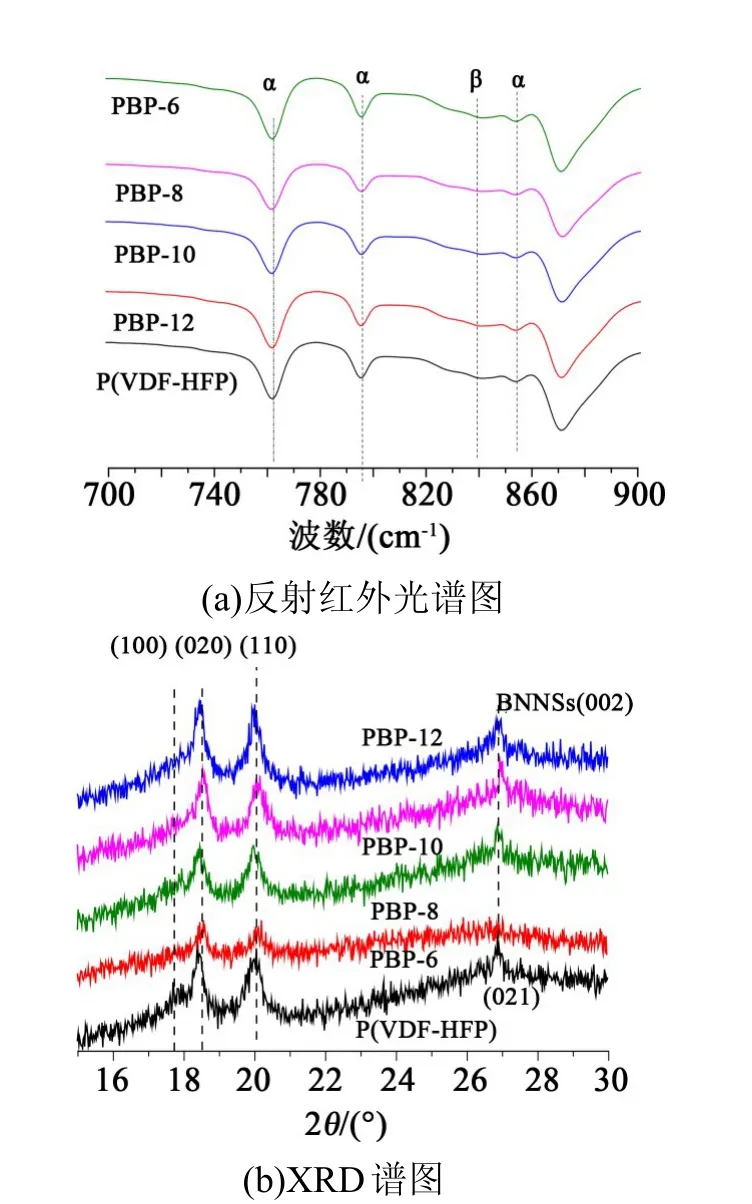
图7 P(VDF-HFP)及其夹层复合膜的反射红外光谱图和XRD谱图Fig.7 Infrared spectra and XRD of the P(VDF-HFP)and P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)
从图7(a)可以看出,经过淬火的P(VDF-HFP)均只含有α相而不含β相,引入夹层BNNSs-THU后,P(VDF-HFP)夹层结构的复合材料薄膜晶型仍为α相。PVDF基聚合物的α相为顺电性,与铁电相的β相相比,极化小且剩余极化低,所以有利于储能[21]。淬火能够降低P(VDF-HFP)的结晶性,并减少β相的含量和晶区尺寸。从图7(b)可以看出,P(VDF-HFP)主要含有(100)、(020)、(110)、(021)4种α相晶面,引入夹层BNNSs-THU后可能会影响晶体生长的方向[15]。
图8(a)、(b)分别为P(VDF-HFP)及其夹层结构复合膜的升温熔融曲线和降温结晶曲线。
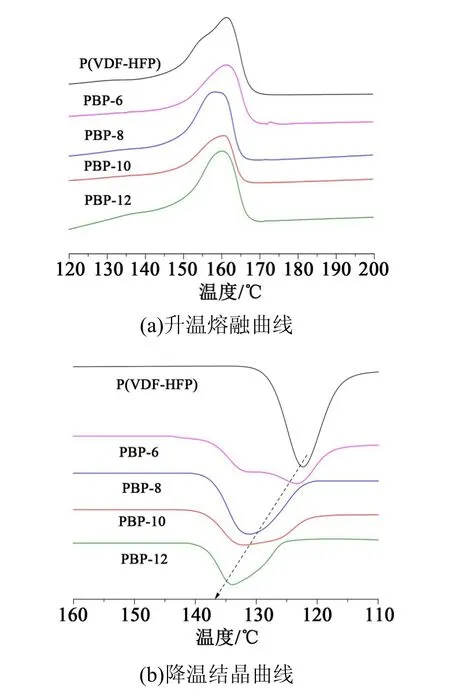
图8 P(VDF-HFP)及其夹层结构复合膜的DSC曲线Fig.8 DSC curves of P(VDF-HFP)and P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)
根据χc=ΔHf/ΔHf*×100%,对图8(a)曲线的面积积分可计算出复合膜的熔融焓ΔHf,ΔHf*取104 J/g作为100%结晶的P(VDF-HFP)的熔融焓,将结晶度χc计算结果汇总于表2中。从表2可以看出,P(VDF-HFP)初始的结晶度为21.9%,当BNNSs-THU添加量从0.6 mg/mL增至1.2 mg/mL时,复合膜的结晶度从11.3%增至17.3%,这可能是由于BNNSs-THU能充当P(VDF-HFP)的异相成核剂[15]。
通过热失重分析确认不同浓度的BNNSs-THU溶液制得的夹层复合膜中填料的含量,结果如图9所示。从图9可以看出,PBP-12、PBP-10、PBP-8和PBP-6的质量残留率依次降低,分别为9.9%、7.4%、5.3%和2.5%,这与制备时配置的BNNSs-THU混合溶液的浓度变化趋势基本一致。

表2 夹层结构复合膜的熔融温度、结晶温度和结晶度Tab.2 Melting temperature,crystallization temperature and crystaline of P(VDF-HFP)and P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)
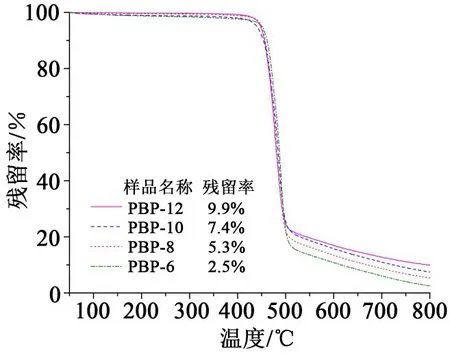
图9 夹层结构复合膜的热失重曲线Fig.9 TGA curves of P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)
2.5 P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)夹层结构复合膜的介电性能表征
采用宽频介电谱测试研究P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)复合薄膜的介电性能,结果如图10所示。从图10可以看出,P(VDF-HFP)基薄膜的介电性能具有频率依赖性,在100 Hz时,PBP膜的介电常数高于11,介质损耗因数在0.08左右。与纯P(VDF-HFP)相比,虽然BNNSs介电常数仅有5左右,但是BNNSs-THU夹层表面修饰了偶极矩较高(4.89 D)的硫脲基团,能在电场中发生较高的偶极极化[22],因此PBP系列薄膜的介电常数没有明显降低。
从图10(b)和图10(c)可以看出,在低频范围内(10-1~100Hz),PBP薄膜的介质损耗因数和电导率随着BNNSs-THU添加量的增加而降低,在10-1Hz下,介质损耗因数从0.27降至0.13,电导率从4.80×10-13S/cm降至1.24×10-13S/cm。这是因为BNNSs-THU夹层能够有效抑制导电路径的形成和空间电荷的迁移,从而降低复合材料的介质损耗因数[15]。
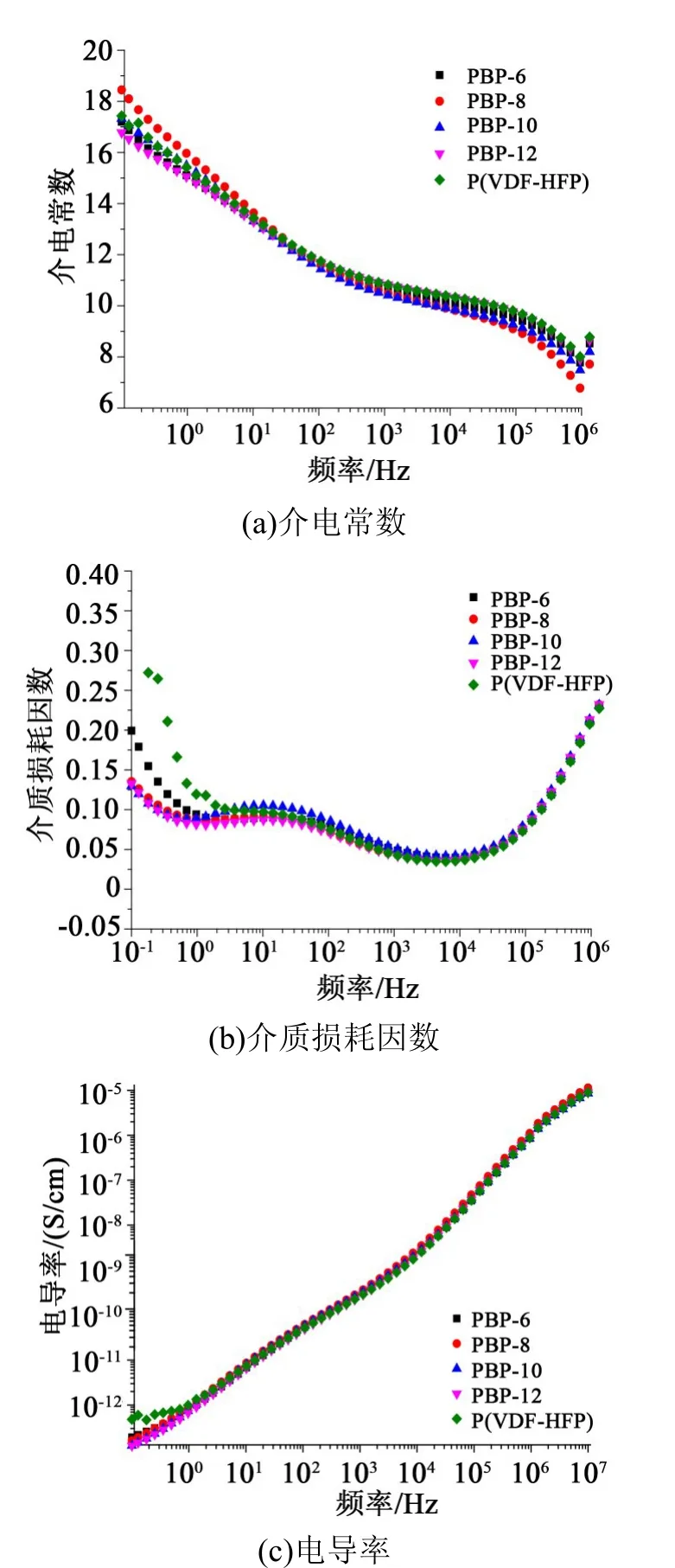
图10 P(VDF-HFP)及其夹层结构复合膜的介电性能随频率变化图Fig.10 Frequency dependence of dielectric properties of P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)
2.6 P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)夹层结构复合膜的泄漏电流及电气强度表征
电气强度(Eb)是介电材料重要的电性能参数,储能密度(U)与Eb的二次方成正比,所以提高Eb可提高U,而降低载流子迁移率可以防止雪崩倍增,从而提高Eb。测试了不同场强下PBP系列薄膜的泄漏电流(I-V曲线),结果如图11所示。从图11可以看出,相比于纯P(VDF-HFP),引入BNNSs-THU夹层后薄膜的泄漏电流均降低,其中PBP-8薄膜的泄漏电流下降最明显,在100 MV/m电场中泄漏电流仅为3.7×10-8A/cm2,比P(VDF-HFP)(1.16×10-6A/cm2)低了一个数量级。
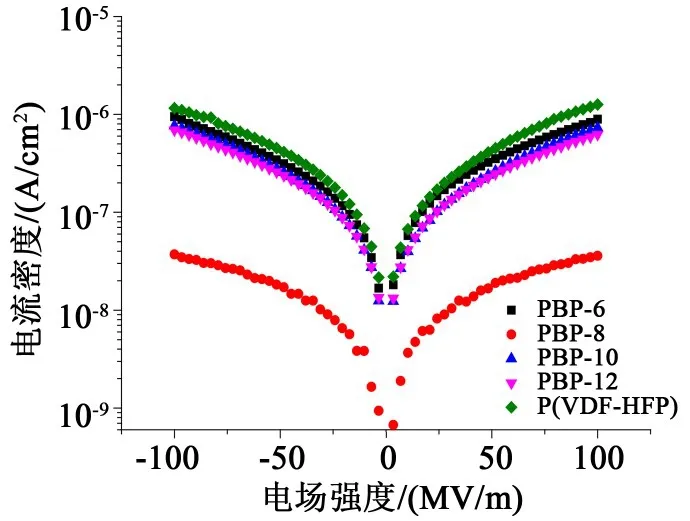
图11 P(VDF-HFP)及其夹层结构复合膜不同电场强度下的泄漏电流密度Fig.11 Leakage current density of P(VDF-HFP)and P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)under different electric field strengths
通过测试各个样品的Eb,并用Weibull分布进行处理,其表达式为式(1)。

式(1)中:P(E)是累计击穿概率;E为电场强度;Eb是累计击穿概率为63.2%时的电气强度;β是形状因子,可表征Eb的分布。
图12为P(VDF-HFP)及其夹层结构复合膜的电气强度,表3为薄膜的电气强度Weibull处理结果。

图12 P(VDF-HFP)及其夹层结构复合膜的电气强度Fig.12 Electric strength of P(VDF-HFP)and P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)
由表3可知,P(VDF-HFP)的Eb为472.37 MV/m,形状因子β为15.0,而PBP-8的Eb高达529.13 MV/m,形状因子β为22.1,说明样品稳定性提升。为了提高复合材料的Eb,需要延迟起始区域的击穿并阻碍击穿路径的生长,平行排列的BNNSs-THU导热网络能够避免高电场下焦耳热聚集而发生热失控[23],并且BNNSs-THU的介电常数小于P(VDF-HFP),因此P(VDF-HFP)层的电压比单独在电场中更低,所以材料总体的电气强度明显提升[24]。

表3 薄膜的电气强度和形状因子Tab.3 Electric strength and shape factor of the films
由图11~12及表3结果可得,PBP-8的泄漏电流最低且电气强度最高。这是因为增大BNNSs-THU的浓度有利于形成相互连接的BNNSs-THU网络结构,从而提高材料的绝缘性能,但是在制备高填充量的夹层复合膜时,BNNSs-THU易在P(VDF-HFP)表面团聚,导致夹层中BNNSs-THU分布不均匀,在层与层间形成缺陷。而电场中空间电荷易在界面处聚集,因此继续增大BNNSs-THU的浓度,泄漏电流反而增大。此外,界面处的缺陷也会降低复合膜的力学性能,造成电气强度下降[25]。介电材料的储能密度与电气强度的平方正相关,由直流电导和空间电荷迁移导致的介质损耗会降低储能效率。综合以上分析,选择PBP-8完成后续的储能性质测试。
2.7 P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)夹层结构复合膜电介质储能性质表征
电位移-电场(D-E)曲线可用于研究介电材料的储能性质。图13(a)、(b)分别为PBP-8和P(VDF-HFP)在不同电场强度下的单极电场-电位移曲线,不同颜色的曲线对应的最大电场强度不同。从图13(a)、(b)可以看出,相比于P(VDF-HFP),PBP-8的测试场强可达400 MV/m。为了进一步研究BNNSs-THU夹层对于材料极化的影响,绘制了PBP-8与P(VDF-HFP)剩余极化(Pr)与电场的关系,结果如图13(c)所示。从图13(c)可以看出,在所有电场条件下,PBP-8的Pr均低于P(VDF-HFP),且在350 MV/m电场下更加明显。这是因为引入BNNSs-THU夹层后,材料的结晶度下降,有利于降低Pr并减少回滞损耗。
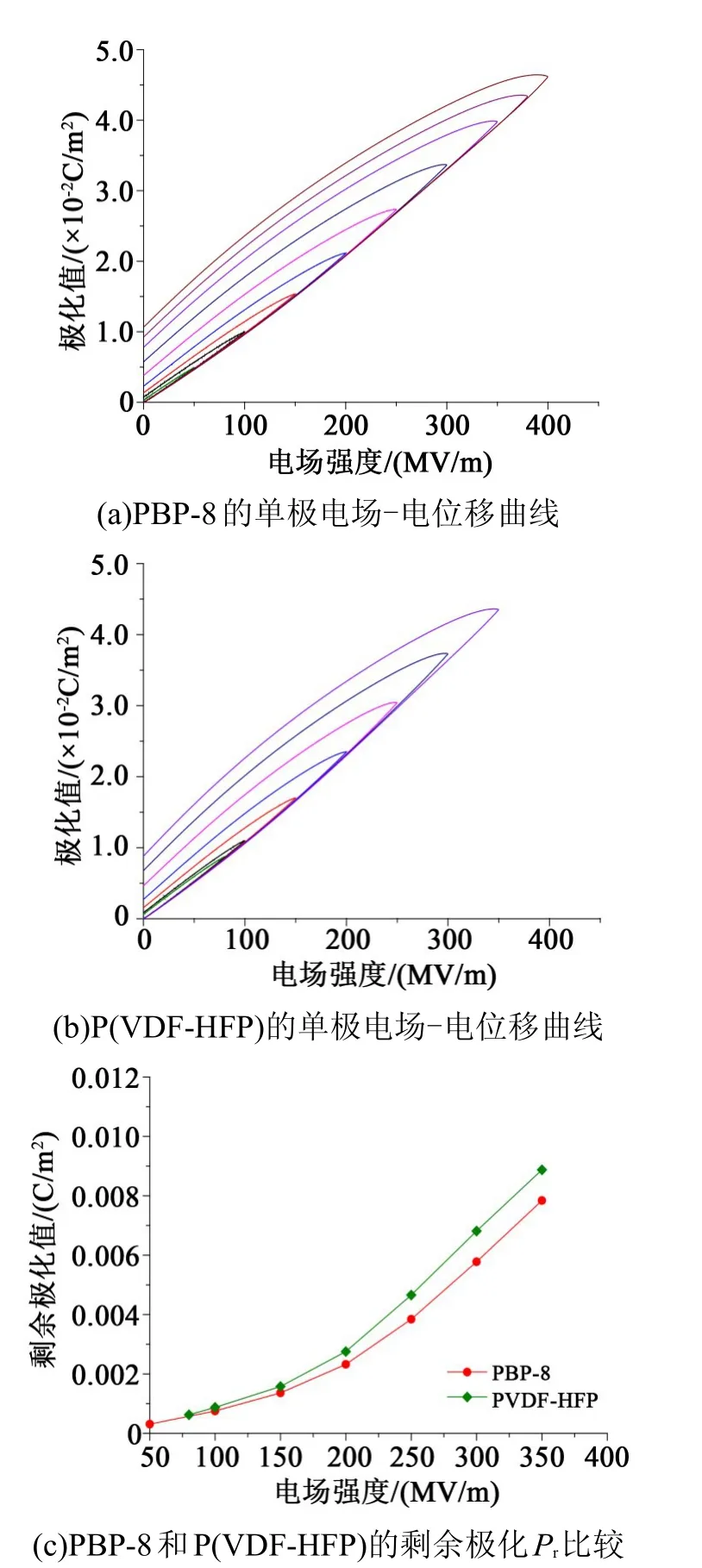
图13 PBP-8及P(VDF-HFP)在不同电场强度下的单极电场-电位移曲线和剩余极化PrFig.13 The monopolar D-E hystersis loops and remnant polarization of P(VDF-HFP)and PBP-8 films under different electric field
储能密度和储能效率是评价静电容器性能的两个重要指标。对D-E曲线积分可以得到材料的充放电能量密度,结果如图14(a)所示。由2.6可知,引入BNNSs-THU后PBP膜的电气强度提高,其中PBP-8的最高测试场强高于P(VDF-HFP),可达400 MV/m,因此其放电能量密度达到5.63 J/cm3。
介电材料的储能效率为放电能量密度与储能密度之比,PBP-8及P(VDF-HFP)在不同电场强度下的储能效率如图14(b)所示。从图14(b)可以看出在整体测试电场范围内,PBP-8的储能效率均高于纯P(VDF-HFP)。在350 MV/m下,PBP-8的储能效率为61.4%,比P(VDF-HFP)提升了4.5%,提升效果明显。引入BNNSs-THU夹层后,P(VDF-HFP)的Pr减小,因此储能效率提高。
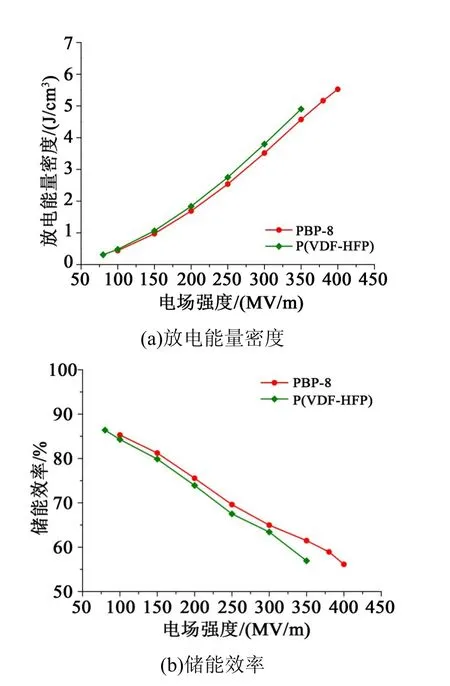
图14 PBP-8及P(VDF-HFP)在不同电场强度下的放电能量密度和储能效率Fig.14 The discharge energy density and energy storage efficiency of PBP-8 and P(VDF-HFP)
3 结论
(1)成功制备了硫脲基团改性的BNNSs-THU,并制备了P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)夹层结构复合膜,中间层的BNNSs-THU呈平行排列。
(2)引入BNNSs-THU夹层后,夹层结构复合膜的泄漏电流密度从1.16×10-6A/cm2下降至3.7×10-8A/cm2,电气强度度从472.37 MV/m提升至529.13 MV/m,提高了材料的绝缘性能,且夹层结构复合膜的介电常数不低于P(VDF-HFP)。
(3)P(VDF-HFP)/BNNSs-THU/P(VDF-HFP)夹层结构复合膜的放电能量和储能效率比纯P(VDF-HFP)膜明显提高,放电能量密度最高达到5.63 J/cm3。在350 MV/m下,夹层结构复合膜的储能效率比P(VDF-HFP)最高提升了4.5%。

