一种新型二维MEMS扭转镜的设计及实现
王松杰 张玉冲 张国庆
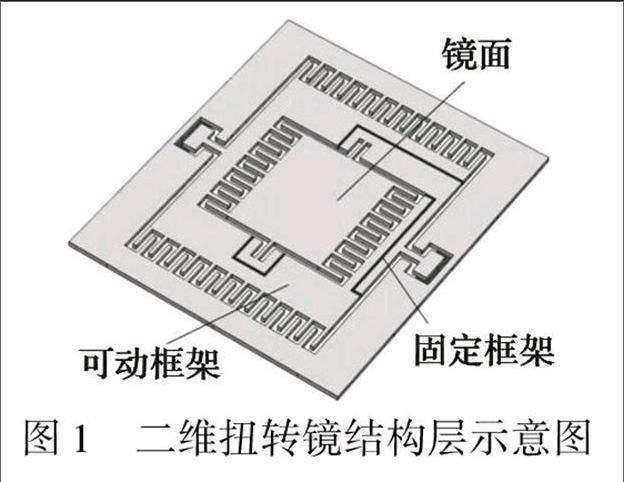

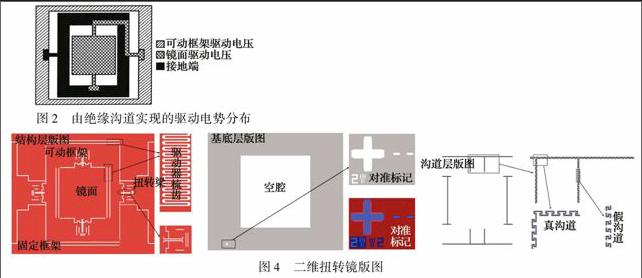
摘要:二维MEMS扭转镜广泛应用于光纤通讯、投影显示、数据存储、精密测量、医疗成像和生物技术等国防和民用领域。在分析二维MEMS扭转镜工作原理的基础上,利用L-edit软件对二维MEMS扭转镜器件的版图进行了设计。基于SOI(Silicon-On-Insulator)制作工艺,确定了扭转镜器件加工工艺流程,按照工艺流程成功制造出二维扭转镜样件,并对制作完成后的器件进行初步的性能测试,获得了不同的扫描图形。
关键词:微光机电系统(MEMS);二维扭转镜;SOI工艺;静电驱动
中图分类号:TP271+.4 文献标识码:A 文章编号:1673-5048(2014)02-0038-03
0、引言
二维MEMS扭转镜作为一种重要的光学MEMS器件,在光纤通讯、投影显示、数据存储、精密测量、医疗成像和生物技术等国防和民用领域都有着广泛的应用。作为一种新型的偏转扫描微反射镜,与一维MEMS扫描镜相比,反射面具有两个自由度,根据光的反射工作原理,通过反射面的位置不断发生变化,改变入射光的方向,对某一区域进行二维扫描。目前研制的二维MEMS扭转镜主要采用电磁驱动方式、磁致伸缩驱动方式、压电驱动方式、电热驱动方式和静电驱动方式五种主要的形式。相对于其他四种驱动类型,静电驱动方式具有功耗低、工艺相对简单、无需外部磁体及PZT等额外的材料辅助,且与IC工艺完全兼容等优点,已成为国内外的一个研究热点。目前,静电驱动方式主要包括类平行板电容、平面梳齿和垂直扭转梳齿三种,每种驱动方式都各有其优缺点,但是垂直扭转梳齿凭借出色的运动特性成为大多数静电驱动MEMS扭转镜的驱动方式。
1、设计
1.1 工作原理
二维MEMS扭转镜由SOI硅片制作而成,包括结构层、绝缘层和基底层。可动结构(镜面和万向架)制作在SOI的顶层,去除可动结构下面的绝缘层和基底层从而为镜面的转动提供空间。
图1所示为二维扭转镜结构层的示意图,结构层主要有三个部分构成:镜面、可动框架和固定框架。镜面由可动框架内的两根扭转梁悬空固定,可动框架由固定框架内垂直于镜面扭转梁的两根扭转梁悬空固定,从而实现两个方向的扭转。
可动框架和固定框架之间由锚点连接,锚点周围由绝缘沟道隔离,实现可动框架和固定框架的电隔离;同理,镜面和可动框架之间由包括填充物的绝缘沟道隔离,实现镜面和可动框架之间的电隔离。从而能够实现镜面、可动框架、固定框架之间的电隔离,提供不同的电势能,如图2所示。图包括方形镜面质量块、两根镜面扭转梁、可动框架质量块、两个可动框架扭转梁、固定框架、梳齿等;基底层版图结构简单,主要用来制作空腔;沟道层版图包括假沟道和真沟道,沟道采用燕尾互锁形式,并在可动框架上对称排布,以实现镜面振动时的动态对称。
为了保证对准精度,版图上设计有十字对准标记、胖瘦标记、标记号以及对准线。器件单元尺寸为6.2 mm×5.1 mm。结构尺寸参数见表1。
2、制造
本文所研究的二维MEMS扭转镜是利用垂直
该二维扭转镜的驱动信号可以是正弦波、方波、锯齿波等。以方波激励为例,如图3所示,虚线是方波激励信号,实线是镜面扭转角随时间变化的正弦曲线。在镜面向正向最大角度运动时,方波信号电压为0,没有静电力矩作用;镜面达到正向最大偏转角度位置后,方波信号跳跃到峰值电压,在静电力矩作用下,镜面朝着平衡位置加速运动;在经过平衡位置瞬间,方波信号电压降为0,镜面依靠自身惯性继续向反向最大角度运动,当镜面达到反向最大偏转角度时,方波信号再次跳跃到峰值电压。如此循环驱动镜面往复转动,激励信号的频率是镜面机械振动频率的两倍。
1.2 版图设计
本文所研究二维扭转镜采用SOI工艺制作,根据其结构特点,版图共有三层:结构层版图、基底层版图和沟道层版图。其中结构层版图和基底层版图为阳版,沟道层版图为阴版。
图4所示为L-Edit软件设计的二维扭转镜的结构版图。由于二维扭转镜为对称结构,结构层版梳齿驱动,采用标准清洗、光刻、刻蚀、沟道填充等微机械加工工艺制造的一种谐振式微机械扭转镜。根据二维MEMS扭转镜的结构和性能要求以及SOI材料的结构特点,确定基于SOI的加工工艺流程。主要包括:一是在硅片器件层制作沟道层版图的沟道:二是在硅片基底层制作扭转镜旋转所需要的空腔结构;三是在硅片器件层制作结构层版图的结构;四是去除可动结构下方的氧化层。SOI硅片各层厚度可根据需要定制,器件层厚度应为镜面及扭转梁厚度,绝缘层应能提供足够的抵抗ICP刻蚀时间,以保证其下方器件层硅不被破坏,基底层应提供足够的镜面旋转所需空间。具体加工工艺流程如图5所示。
图5中,(a)为SOI硅片前处理,用BHF溶液去除表面原生氧化层,去离子水清洗之后干燥:(b)为光刻,在SOI硅片器件层表面涂覆光刻胶,使用沟道层掩膜版进行光刻,图案化的光刻胶将作为沟道ICP刻蚀的掩膜;(c)为刻蚀器件层硅,在ICP刻蚀系统中干法刻蚀器件层硅,直至刻蚀到氧化层形成沟道结构;(d)为去胶,使用氧等离子清洗或者丙酮去胶液超声等方法去除光刻胶;(e)为氧化,利用湿法氧化,在ICP刻蚀出的沟道侧壁形成氧化绝缘层,厚度约为100 nm;(f)为多晶硅填充,用LPCVD在ICP刻蚀出的沟道中回填多晶硅介质,形成最终的隔离结构;(g)为化学机械抛光,在SOI硅片的器件层和基底层分别进行抛光,去除硅片表面形成的氧化层和LPCVD沉积的多晶硅层;(h)为溅射铝膜,使用磁控溅射设备在硅片的器件层表面溅射沉积一层铝膜;(i)为刻蚀铝,在一定浓度配比的铝刻蚀液中湿法腐蚀铝,将基底层版图图案进一步复制到铝膜;(i)为刻蚀基底层硅,用铝掩膜在ICP刻蚀系统中干法刻蚀基底层硅,直至刻蚀到氧化层形成背腔;(k)为去除铝掩膜,并在器件层涂覆光刻胶,利用结构层版图进行光刻,图案化的光刻胶将作为结构层ICP刻蚀的掩膜;(1)为刻蚀器件层硅,在ICP刻蚀系统中干法刻蚀器件层硅,直至刻蚀到氧化层形成扭转镜结构;(m)为释放,使用氢氟酸溶液腐蚀掉可动结构下面的氧化硅,干燥后完成微扭转镜器件制作。
最终研制的二维扭转镜芯片,其尺寸为6.2mm×5.1 mm,图6所示为方形镜面二维扭转镜正面照片和背面照片。
在光学平台上搭建测试系统(如图7),通过搭建的二维扫描成像系统样机,得到如图8所示的图案,说明初步实现了二维图案的投影显示。

